前端設計(Front-end Design):聚焦于電路的邏輯功能實現。本質上是在“紙上”設計電路,....
集成電路產業通常被分為芯片設計、芯片制造、封裝測試三大領域。其中,芯片制造是集成電路產業門檻最高的行....
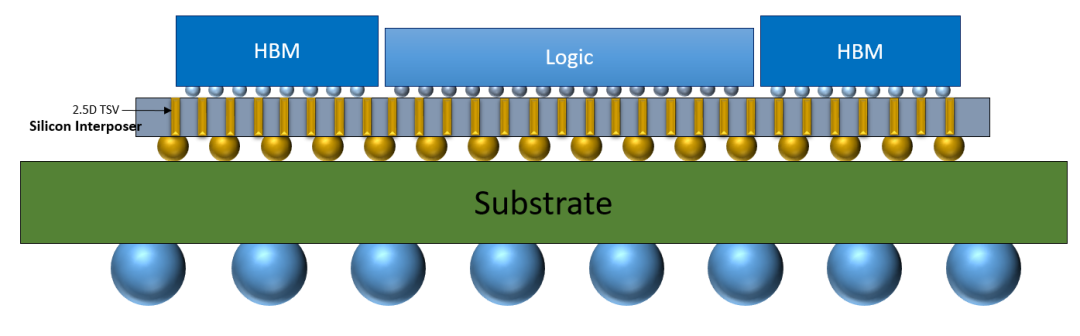
前端設計是數字芯片開發的初步階段,其核心目標是從功能規格出發,最終獲得門級網表(Netlist)。這....
在現代芯片中,數十億晶體管通過金屬互連線連接成復雜電路。隨著制程進入納米級,一個看似“隱形”的問題逐....

十九世紀末,科學家首次觀察到軸對稱磁場對陰極射線示波器中電子束產生的聚焦作用,這種效應與光學透鏡對可....

化學機械拋光液是化學機械拋光(CMP)工藝中關鍵的功能性耗材,其本質是一個多組分的液體復合體系,在拋....
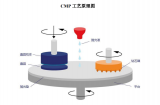
在指甲蓋大小的芯片上,數十億晶體管需要通過比頭發絲細千倍的金屬線連接。隨著制程進入納米級,一個看似微....
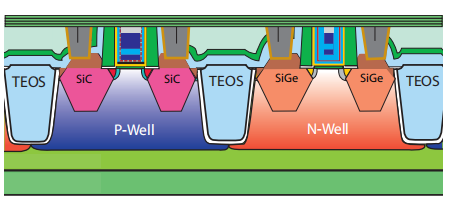
在現代電子工業領域,依據使用環境、性能參數及可靠性標準,電子器件可以被系統劃分為商業級、工業級、汽車....
我們看下一個先進封裝的關鍵概念——晶圓級封裝(Wafer Level Package,WLP)。

簡單來說:晶向就是晶體內部原子沿某種方向排列的“路徑”。晶向通常用方括號 [hkl] 表示方向,用圓....

CVD 技術是一種在真空環境中通過襯底表面化學反應來進行薄膜生長的過程,較短的工藝時間以及所制備薄膜....

光纖激光器是一種放大介質為光纖的激光器。它是一個需要供電的有源模塊(就像電子產品中的有源電子元件),....
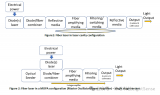
微電子封裝技術每15年左右更新迭代一次。1955年起,晶體管外形(TO)封裝成為主流,主要用于封裝晶....
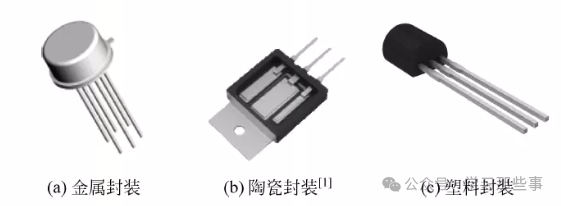
業界普遍認為,倒裝封裝是傳統封裝和先進封裝的分界點。

FPGA(Field Programmable Gate Array,現場可編程門陣列),是一種可在....
在半導體芯片中,數十億晶體管需要通過金屬互連線(Interconnect)連接成復雜電路。隨著制程進....
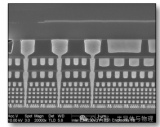
直拉硅單晶生長的過程是熔融的多晶硅逐漸結晶生長為固態的單晶硅的過程,沒有雜質的本征硅單晶的電阻率很高....

在半導體制造流程中,晶圓在前端工藝階段需保持一定厚度,以確保其在流片過程中的結構穩定性,避免彎曲變形....
Plating(電鍍)是一種電化學過程,通過此過程在基片(wafer)表面沉積金屬層。在微電子領域,....
隨著極紫外光刻(EUV)技術面臨光源功率和掩模缺陷挑戰,X射線光刻技術憑借其固有優勢,在特定領域正形....

本文介紹了通過LPCVD制備氮化硅低應力膜 氮化硅膜在MEMS中應用十分廣泛,可作為支撐層、....
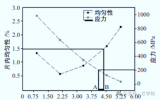
CPU Socket是連接中央處理單元(CPU)與計算機主板之間的關鍵部件,它充當著傳遞電信號、電源....
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、....

當激光器導通時,開始產生自發輻射的光子直到載流子密度超過一個閾值。因而,產生受激輻射,也就是說,真實....
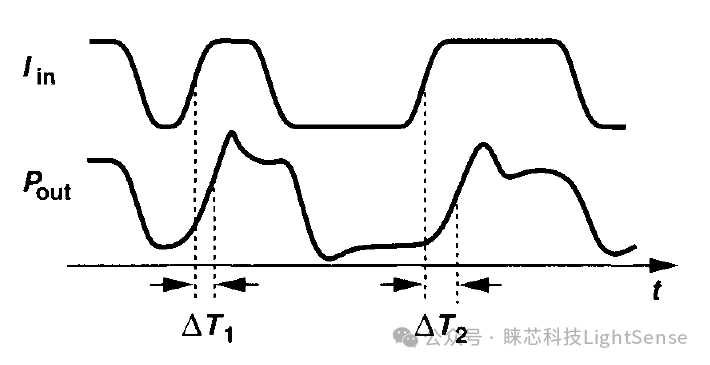
圓片級封裝(WLP),也稱為晶圓級封裝,是一種直接在晶圓上完成大部分或全部封裝測試程序,再進行切割制....

計量學是推動當前及未來幾代半導體器件開發與制造的重要基石。隨著技術節點不斷縮小至100納米,甚至更小....
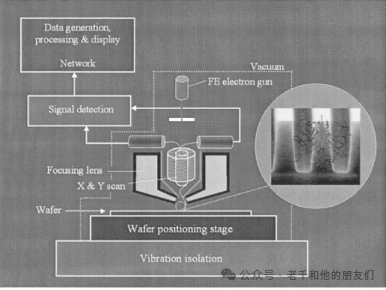
晶圓制備是材料科學、熱力學與精密控制的綜合體現,每一環節均凝聚著工程技術的極致追求。而晶圓清洗本質是....

在半導體存儲器測試中,測試圖形(Test Pattern)是檢測故障、驗證可靠性的核心工具。根據測試....

本文介紹了在芯片銅互連工藝中需要阻擋層的原因以及關鍵工藝流程。
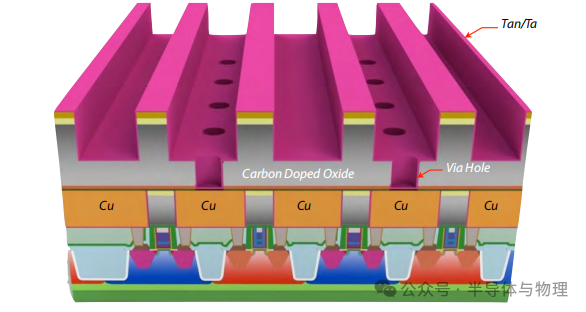
選擇性外延生長(SEG)是當今關鍵的前端工藝(FEOL)技術之一,已在CMOS器件制造中使用了20年....
