文章來源:半導體與物理
原文作者:jjfly686
本文介紹了芯片中金屬互連線的各個層級的不同設計。
在半導體芯片中,數十億晶體管需要通過金屬互連線(Interconnect)連接成復雜電路。隨著制程進入納米級,互連線的層次化設計成為平衡性能、功耗與集成度的關鍵。芯片中的互連線按長度、功能及材料分為多個層級,從全局電源網絡到晶體管間的納米級連接,每一層都有獨特的設計考量。
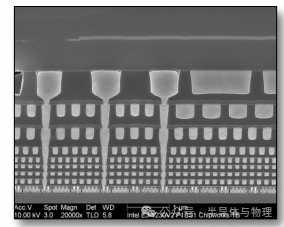
全局互連(Global Wires)
層級范圍:通常為最高層金屬(如M8、M9),最多2層。
長度:5-10mm,覆蓋整個芯片區域。
材料:采用摻氟硅酸鹽玻璃(FSG,k≈3.5)或傳統氧化物(SiO?,k≈3.9)作為絕緣介質,銅(Cu)為導體。
設計優勢:高層金屬厚度可達1-3μm,電流承載能力是低層金屬的2-3倍,適合大電流傳輸。
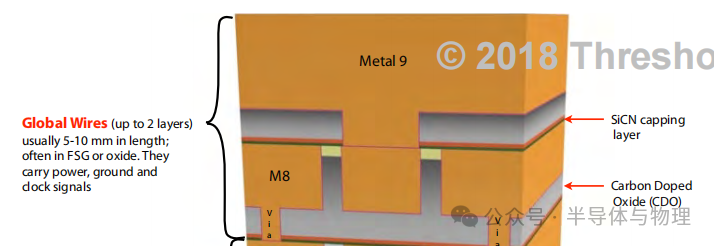
半全局互連(Semi-Global Wires)
層級范圍:中間層金屬(如M4-M7),最多4層。
長度:0.5-5mm,連接不同功能模塊(如CPU核心與緩存)。
材料:絕緣介質為碳摻雜硅氧化物(CDO,k≈2.8-3.2),銅互連搭配氮化鉭(TaN)阻擋層。
性能優化:CDO的碳摻雜降低介電常數,減少信號串擾,同時保持機械強度。
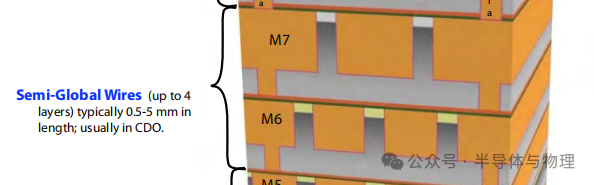
中間互連(Intermediate Wires)
層級范圍:低層金屬(如M2-M3),最多5層。
長度:<100μm,實現模塊內局部連接。
材料:同樣使用CDO介質,銅互連需更薄的阻擋層(1-2nm TaN)。
工藝挑戰:深寬比>5:1的通孔需原子層沉積(ALD)銅籽晶層,避免電鍍空洞。
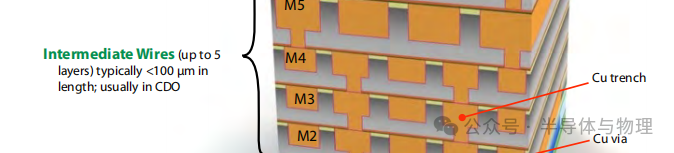
局部互連(M1 & Contacts)
層級范圍:最底層金屬(M1),直接連接晶體管源/漏極。
長度:<50μm,納米級線寬(10-20nm)。
材料:CDO介質,鈷(Co)或釕(Ru)逐步替代銅,減少電阻飆升問題。
關鍵技術:選擇性外延填充接觸孔,結合化學機械拋光(CMP)確保平坦化。

-
芯片
+關注
關注
459文章
52013瀏覽量
434572 -
半導體
+關注
關注
335文章
28435瀏覽量
230890 -
晶體管
+關注
關注
77文章
9929瀏覽量
140374
原文標題:半導體芯片中的互連層次
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
芯片,集成電路,半導體含義
芯片,半導體,集成電路,傻傻分不清楚?
半導體芯片內部結構詳解
半導體元件與芯片的區別有哪些
半導體元件與芯片的區別
半導體封裝革新之路:互連工藝的升級與變革






 半導體芯片中的互連層次
半導體芯片中的互連層次
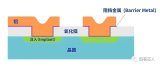











評論