金鋁效應是集成電路封裝中常見的失效問題,嚴重影響器件的可靠性。本文系統解析其成因、表現與演化機制,并....

本文圍繞單晶硅、多晶硅與非晶硅三種形態的結構特征、沉積技術及其工藝參數展開介紹,重點解析LPCVD方....

本文深入解析了焊盤起皮的成因、機制及其與工藝參數之間的關系,結合微觀形貌圖和仿真分析,系統探討了劈刀....
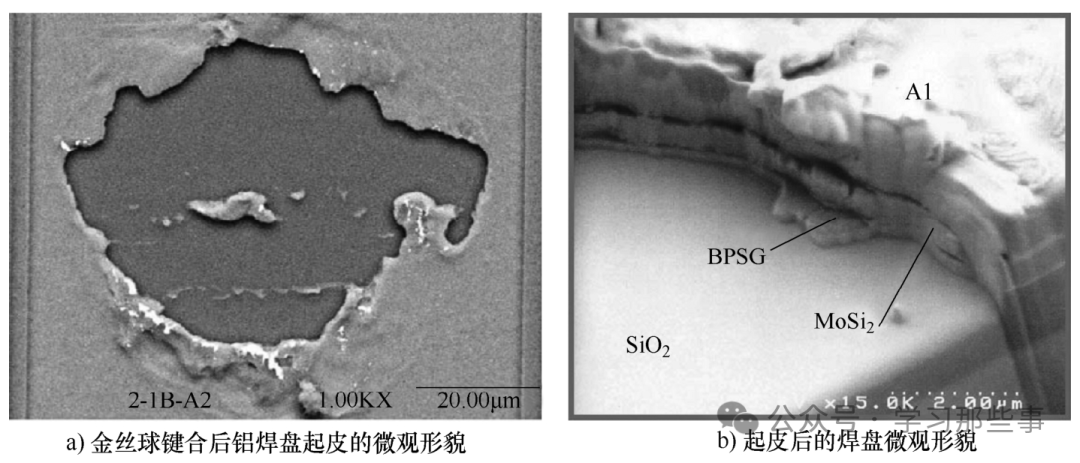
激光固化技術采用紅外激光器,首先使靜電噴涂在零件表面的粉末涂料顆粒快速凝膠化,隨后完成最終固化。熔化....
粘片作為芯片與管殼間實現連接和固定的關鍵工序,達成了封裝對于芯片的固定功能,以及芯片背面電連接功能。....
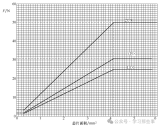
當加斯頓·普朗特在160多年前發明鉛酸電池時,他可能未曾預料到這一發明將催生一個價值數十億美元的產業....

封裝方案制定是集成電路(IC)封裝設計中的關鍵環節,涉及從芯片設計需求出發,制定出滿足功能、電氣性能....
PA(Power Amplifier,功率放大器)通信系統的重要組成模塊,負責將射頻信號的放大與功率....

本文介紹了High-K材料的物理性質、制備方法及其應用。

經過封裝與測試的芯片,理論上已具備使用條件。然而在現實生活里,一個集成電路產品通常需要眾多芯片共同組....
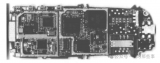
多晶硅(Polycrystalline Silicon,簡稱Poly)是由無數微小硅晶粒組成的非單晶....

3D閃存有著更大容量、更低成本和更高性能的優勢,本文介紹了3D閃存的制造工藝與挑戰。

本文介紹了MOS集成電路中的等比例縮小規則和超大規模集成電路的可靠性問題。

在集成電路設計中,版圖(Layout)是芯片設計的核心之一,通常是指芯片電路的物理實現圖。它描述了電....
本文介紹了多晶硅作為晶體管的柵極摻雜的原理和必要性。
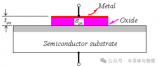
本文介紹了集成電路設計領域中混合信號設計的概念、挑戰與發展趨勢。
本文通過分析器件制造中的影響因素,提出了版圖設計技術與匹配原則及其應用。
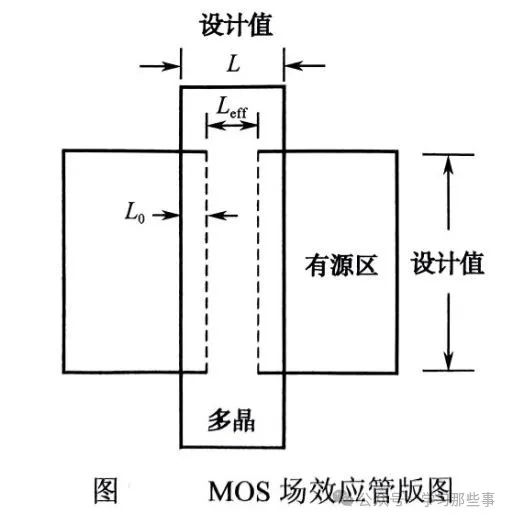
本文介紹了集成電路制造工藝中的柵極的工作原理、材料、工藝,以及先進柵極工藝技術。
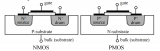
Low-K材料是介電常數顯著低于傳統二氧化硅(SiO?,k=3.9–4.2)的絕緣材料,主要用于芯片....
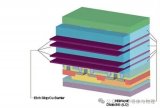
光刻工藝貫穿整個芯片制造流程的多次重復轉印環節,對于集成電路的微縮化和高性能起著決定性作用。隨著半導....

半導體集成電路失效機理中除了與封裝有關的失效機理以外,還有與應用有關的失效機理。

在材料納米力學性能測試的眾多方法中,納米壓痕技術憑借其獨特的優勢脫穎而出,成為當前的主流測試手段。

Bi-CMOS工藝將雙極型器件(Bipolar)與CMOS工藝結合,旨在融合兩者的優勢。CMOS具有....
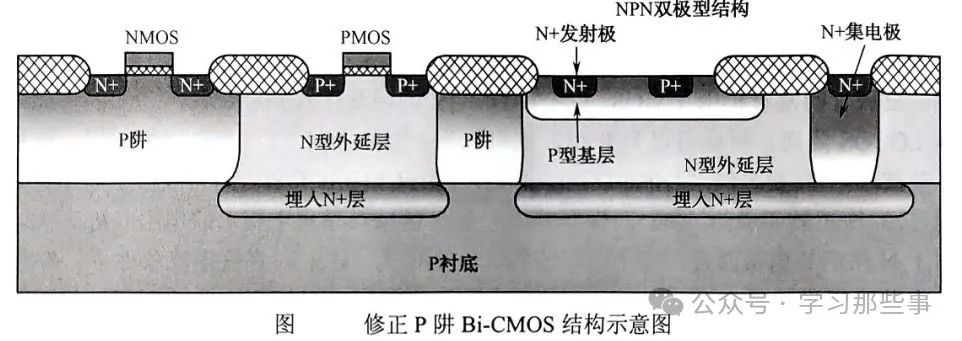
化學元素鋰于1817年由Johan August Arfwedson通過分析礦物鋰長石(LiAlSi....

本文主要介紹CMOS集成電路基本制造工藝,特別聚焦于0.18μm工藝節點及其前后的變化,分述如下:前....

封裝設計圖紙是集成電路封裝過程中用于傳達封裝結構、尺寸、布局、焊盤、走線等信息的重要文件。它是封裝設....
無線通信系統從 1980 年代的第一代發展到最近的第五代 (5G),一直是推動這項技術在通信和我們日....
薄膜外延生長是一種關鍵的材料制備方法,其廣泛應用于半導體器件、光電子學和納米技術領域。
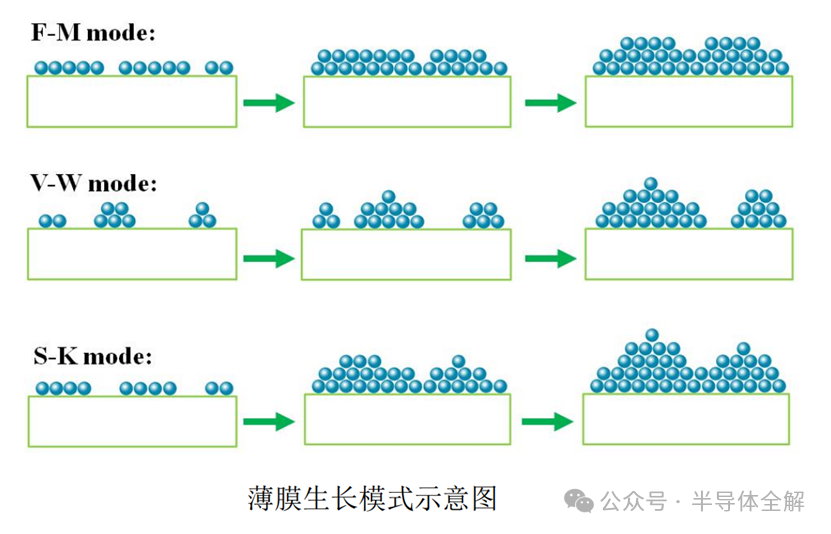
本文介紹了N型單晶硅制備過程中拉晶工藝對氧含量的影響。
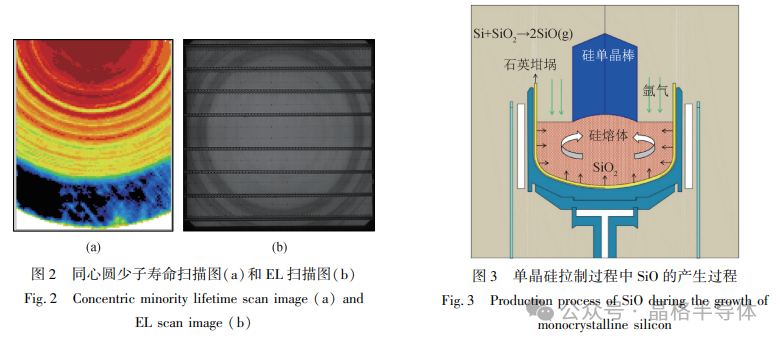
本文介紹了晶圓清洗的污染源來源、清洗技術和優化。
