文章來源:學習那些事
原文作者:趙先生
本文主要介紹粘片工藝。
粘片工藝介紹
粘片作為芯片與管殼間實現連接和固定的關鍵工序,達成了封裝對于芯片的固定功能,以及芯片背面電連接功能。在行業里,這一工序常被叫做粘片。由于其核心作用是固定芯片,因而也被稱作固晶工藝或貼片工藝,英文表述為“Die Bonding”或“Die Attach”。
在日常生活中,“粘”通常意味著借助膠水實現兩個物體的連接,這屬于物理連接過程。所以,用粘片來描述芯片的導熱膠粘接工藝,既生動又恰當。與之不同,另一種借助合金料片,將芯片焊接到管殼、基板或載體上的工藝,被稱作芯片燒結、合金燒結或合金粘片。這一過程涉及多種金屬間的復雜反應。
芯片與外殼或基板的貼裝方法,主要有導熱膠粘接和合金料燒結(此處不探討倒裝焊)。導熱膠對被粘接的芯片和外殼要求相對寬松,只要確保原材料潔凈,導熱膠就能順利固化并完成粘接。而燒結則需要用到合金焊料,焊料的可焊性、熔點、機械強度以及熱膨脹系數等,都會對焊接質量和可靠性造成影響。這些是材料生產廠家需要考慮和優化的內容。封裝廠的任務是挑選合適的成熟焊料片,并應用于器件生產。每種焊料片因成分配比和自身性質固定,所需的焊接條件也相對固定。封裝廠無需開展過多研究,只需按照對應的燒結曲線,完成焊料與芯片的焊接。由此可見,粘片工藝對后期技術研發的依賴程度較低。
然而,國內外仍有大量研究聚焦于粘片工藝。這主要是因為設備波動、物料變質、原材料缺陷以及背面金屬化層質量問題等,都會干擾粘接和焊接的正常進行,必須通過研究分析找出問題。早期,原材料氧化、人員手工貼片手法差異、設備真空度限制以及保護氣氛施加方式等問題,極大地影響了粘片工藝的穩定性,導致為獲得良好焊接效果所需的粘片工藝參數存在較大不確定性。此外,粘片在封裝工序中處于靠前位置,后續工序會對粘片的可靠性產生影響。因此,在設計封裝工藝方案時,需要全面考慮包括粘片在內的各工序之間的匹配關系,比如溫度梯度和應力疊加等,避免后續工藝對粘片質量造成影響。同時,粘片也會對其他工序產生影響。例如,粘片過程中的偏移,是器件小型化進程中需要解決的難題,導熱膠的膠暈會影響鍵合絲與管殼的鍵合強度。
無論如何,粘片工序都是集成電路封裝工藝中最為基礎且關鍵的環節之一。值得注意的是,后續篩選考核中的熱沖擊、溫度循環、機械沖擊、掃頻振動、恒定加速度等試驗,都是在檢驗粘片的可靠性,這充分說明了該工藝可靠性的重要性 。
粘片工藝的選型
導熱膠粘接和合金燒結這兩種粘片技術,各有優劣。
導熱膠粘接:該工藝適用性廣泛,能用于絕大多數芯片與器件的粘接。然而,導熱膠熱膨脹系數偏高,與陶瓷、金屬以及硅芯片在熱性能匹配上,不及焊料,容易引發熱失配問題。此外,導熱膠等膠粘劑會吸附氣體,并在使用過程中緩慢分解釋放有害氣體,對器件內部造成損害。
合金燒結:此工藝可靠性極佳,具備較高的焊接強度,以及出色的電導率和熱導率。對于高可靠性要求的器件,通常采用合金焊料燒結粘片,使其能適應大溫區變化、高應力沖擊等嚴苛的服役環境。不過,部分合金料在燒結過程中,可能出現顆粒飛濺現象。
另外,不同類型的導熱膠,固化溫度和耐受環境溫度有所不同。一旦超出耐受溫度,導熱膠粘接就容易失效。而經過合金燒結的器件,若再次處于超過固化溫度的環境中,焊接材料會重新熔化,可能導致芯片脫落,還會引發氧化、產生更多焊接空洞等問題。
因此,在選擇粘片工藝時,需依據產品性能指標要求,選擇適配的工藝。
粘片質量標準——剪切強度。
剪切應力試驗是評估粘片質量的常用方法。芯片經粘接或燒結后所具備的強度,即芯片粘結強度。可依照GJB 548B - 2005中方法2019.2“芯片剪切強度”規定的流程開展試驗。芯片粘結強度與芯片面積密切相關,該方法給出了粘結強度是否合格的判斷標準,具體如圖1所示。
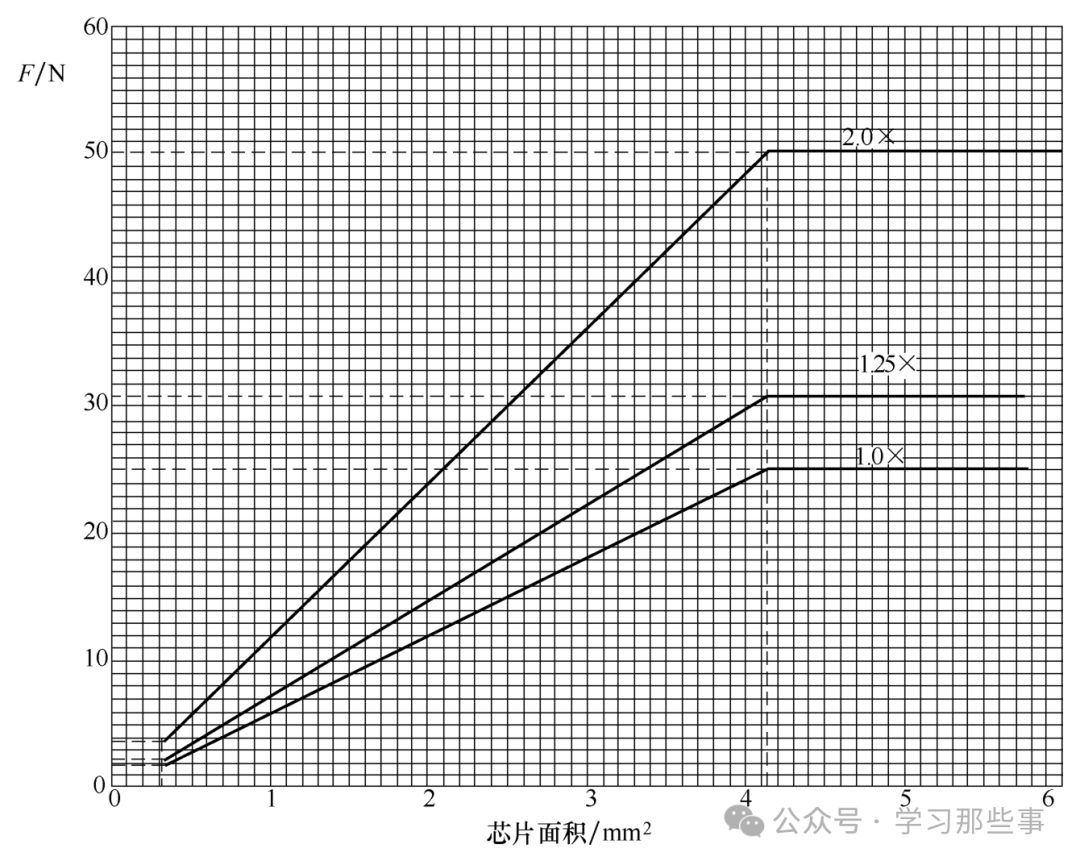
圖1:芯片剪切強度標準
當芯片粘結面積大于4.13mm2,需至少承受25N的力,或其相應倍數的力。
當芯片粘結面積介于0.32mm2(含)至3.14mm2之間時,芯片承受的最小剪切強度,可參照圖1所示標準確定。
當芯片粘結面積小于0.32mm2,最小剪切強度應為1倍時6N/mm2,或2倍時12N/mm2 。
粘片質量指標——空洞率
在高可靠性集成電路產品生產中,常采用燒結粘片,并對芯片焊接空洞率作出嚴格要求。出現以下任意一種情況,即判定粘片空洞率不合格:
接觸區空洞面積超過整個接觸面積的二分之一。
單個空洞橫跨半導體芯片的整個長度或寬度范圍,且超過整個預定接觸面積的10% 。
導熱膠粘片
粘接原理:芯片粘片工藝,核心在于利用膠粘劑在芯片與管殼、基板等承載物之間搭建起互連層。通過升溫,促使膠粘劑內部發生復雜的化學變化,歷經液相階段,逐步凝膠化,最終轉變為固相。借助這一過程,不但能達成穩固的機械連接,讓芯片與載體緊密結合,還能賦予連接層優良的電學和熱學性能。在當前環保要求愈發嚴格的背景下,導熱膠和AuSn焊料憑借自身優勢,成為替代傳統SnPb合金料的首選材料。在集成電路封裝行業,環氧樹脂憑借出色的綜合性能,成為應用最為普遍的膠粘劑。環氧樹脂本質上是高分子聚合物,分子式為(C??H??O?)?,指分子內含有兩個或更多環氧基團的一類聚合物。它由環氧氯丙烷與雙酚A或者多元醇,經過縮聚反應制備而成。由于環氧基具有較高的化學活性,能夠與多種含活潑氫的化合物發生開環反應,通過固化交聯,構建起網狀結構,因此環氧樹脂歸屬于熱固性樹脂。其中,雙酚A型環氧樹脂產量最大、種類最豐富,并且隨著技術的不斷進步,新的改性產品不斷問世,產品質量也在持續提升。未經填料改性的環氧樹脂,導熱性能差,且不具備導電特性。向環氧樹脂中添加Al?O?、AlN等陶瓷填料后,能夠顯著提高其熱導率。按照導電性能的差異,膠粘劑可分為導電膠和絕緣膠。在環氧樹脂中摻入銀粉,制成的導電膠可實現導電連接功能。對于背面設置有電極的芯片,導電膠可實現芯片背面電極與基板盤之間的電氣連通。在實際生產中,導電膠還常用于電阻、電感、電容等阻容元件的粘接。絕緣膠則主要用于芯片背面無需導通的場景。大多數芯片粘片時,會選用不導電膠。這類膠粘劑除了能滿足導熱需求外,還可以提升絕緣性能。在這里,將用于集成電路芯片粘片的膠粘劑,統一稱作導熱膠。胺類化合物是環氧樹脂常用的固化劑,一般以粉末形式均勻分散在環氧樹脂體系中。在常溫條件下,固化劑與環氧基團之間的反應非常緩慢。當溫度升高到一定程度,固化劑吸收足夠的能量開始溶解,并與環氧樹脂分子上的環氧基團發生化學反應,使得分子鏈之間不斷交聯。在反應過程中,環氧基團轉化為醇鹽結構。當溫度進一步升高,醇鹽基團會與其他環氧基團繼續反應,在相鄰聚合物鏈之間形成新的醚鍵,逐步構建起高度交聯的三維網狀結構。隨著分子鏈的不斷增長,膠粘劑的黏度逐漸增大,從最初的線性聚合物交聯成為網狀結構,最終固化為熱固性聚合物 。
導電膠的固化
按照固化方式的差異,導電膠可劃分為熱固化和光固化兩大類型。其中,熱固化依據固化溫度的不同,又可細分為室溫固化、中溫固化(150℃左右)和高溫固化(150 - 300℃)。
室溫固化耗時較長,通常需要數小時甚至數天,在工業生產中應用較少。高溫固化速度較快,但在電子工業領域,過高的溫度可能對器件性能造成影響,因此一般盡量避免使用。中溫固化一般只需數分鐘到一小時,在實際生產中應用最為廣泛。光固化導電膠的固化,主要依賴紫外線照射引發樹脂基體發生固化反應。這種固化方式速度快,且樹脂基體在避光條件下可長期保存,目前已成為研究的熱點方向。
玻璃化轉變溫度Tg
玻璃態與橡膠態
環氧樹脂導熱膠隸屬有機聚合物范疇,玻璃化轉變溫度,即非晶態高聚物(包含晶態聚合物的非晶區域)在玻璃態和橡膠態之間相互轉變的特定溫度。以玻璃化轉變溫度Tg作為分界線,聚合物在不同溫度環境下,會呈現出玻璃態和橡膠態兩種特性迥異的狀態。玻璃態本質上是一種無定形的固體形態。在此狀態下,原子在結構上既不存在長程有序排列,也不具備平移對稱性。可以將其理解為一種保留了液體結構特征的固體。而橡膠態指的是,聚合物內鏈段能夠自由運動,但整個分子鏈不會產生相對位移的狀態。處于橡膠態時,只需施加較小的外力,聚合物就能產生較大的形變,并且當外力移除后,形變能夠迅速恢復。在部分學術研究資料中,也將玻璃態和橡膠態表述為玻璃態和高彈態。大多數高分子聚合物常態下處于玻璃態。玻璃化轉變溫度,是聚合物大分子鏈擺脫束縛、實現自由運動所需達到的最低溫度。值得注意的是,該溫度并非一個精確的固定值,而是分布在一定的溫度區間內。當聚合物所處溫度高于Tg時,材料展現出顯著的高彈性;當溫度低于Tg時,材料則表現出脆性。因此,Tg對于工業生產和材料性能調控而言,是一個至關重要的參數。
Tg與材料性質
玻璃化轉變溫度并非某一個確切的溫度點,而是一個溫度范圍。盡管學界針對玻璃化轉變現象提出了眾多理論,但到目前為止,還沒有任何一種理論能夠對這一復雜現象做出全面、完善的解釋。目前,測定Tg的方法主要分為四類,分別通過監測材料的體積變化、熱力學性質變化、力學性質變化以及電磁效應來實現。當聚合物發生玻璃化轉變時,其多項物理性質會發生劇烈變化。以比體積、比熱容、膨脹系數、導熱系數為例,這些參數在玻璃化轉變過程中都會出現不連續的變化。以H35導電膠為例,當溫度低于其玻璃化轉變溫度時,熱膨脹系數為31×10??in/(in·℃);而當溫度高于玻璃化轉變溫度后,熱膨脹系數大幅上升至97×10??in/(in·℃)。從分子結構的角度分析,Tg轉變實質上是高聚物無定形部分從凍結狀態向解凍狀態過渡的一種松弛現象。與傳統的相轉變不同,玻璃化轉變過程中并不伴隨相變熱的產生。當溫度低于Tg時,高聚物處于玻璃態,此時分子鏈和鏈段都被“凍結”,無法自由移動,僅有構成分子的原子(或原子團)在其平衡位置附近做微小振動。當溫度達到Tg時,雖然分子鏈整體仍無法移動,但鏈段開始獲得足夠的能量,能夠進行相對運動,材料因而呈現出高彈性質。當溫度進一步升高,整個分子鏈都開始運動,材料逐漸轉變為具有粘性流動特性的熔融體或液體。玻璃化轉變溫度是表征聚合物特性的重要參數之一。一般來說,聚合物的玻璃化轉變溫度越低,其分子鏈的柔性就越大;反之,玻璃化轉變溫度越高,分子鏈的剛性就越強。此外,在玻璃化轉變溫度附近,聚合物膠粘劑的導電性等關鍵性能,也可能發生顯著變化 。
-
芯片
+關注
關注
459文章
52174瀏覽量
436139 -
集成電路
+關注
關注
5420文章
11950瀏覽量
367143 -
封裝
+關注
關注
128文章
8497瀏覽量
144785 -
工藝
+關注
關注
4文章
669瀏覽量
29248
原文標題:粘片工藝概述
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
運算放大器選型指南中文版
機器視覺光學系統的介紹和選型指南詳細概述

精通芯片粘接工藝:提升半導體封裝可靠性






 粘片工藝介紹及選型指南
粘片工藝介紹及選型指南



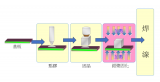










評論