文章來源:學習那些事
原文作者:趙先生
本文深入解析了焊盤起皮的成因、機制及其與工藝參數之間的關系,結合微觀形貌圖和仿真分析,系統探討了劈刀狀態、超聲參數、滑移行為等關鍵因素的影響,并提出了優化建議,為提高芯片封裝質量和可靠性提供了重要參考。
焊盤起皮現象
部分焊盤表面(有時還會連帶一部分焊盤下方的氧化層)與焊球一同從焊盤上剝離的現象,被稱作焊盤起皮(Bond Pad Metal Peeling Off)。
圖1a展示了金絲球鍵合后鋁焊盤起皮的微觀形貌。圖1b所示的焊盤,從上到下依次為AI層、MoSi?層、硼磷硅玻璃(BPSG)層和SiO?層。可以清晰地看到,發生起皮現象后,上面的3層從焊盤上剝離,露出了底部的SiO?層。
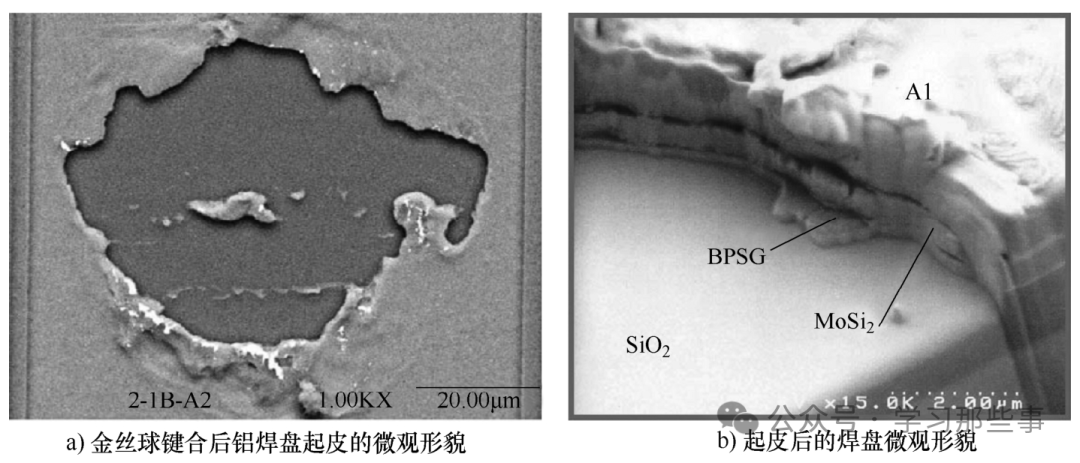
圖1 鋁焊盤脫落的SEM圖
圖2呈現了AI-Si-Cu焊盤和TiW層組成的多層復合焊盤起皮現象及其微觀形貌。
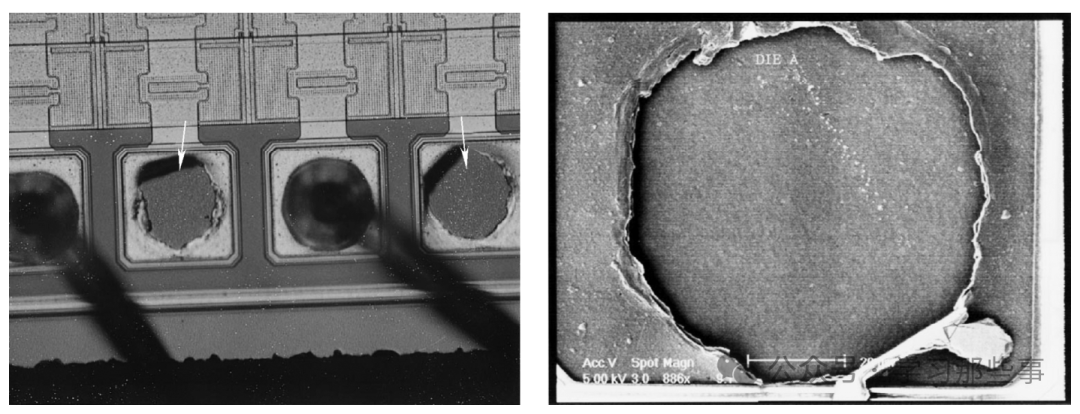
圖2 AI-Si-Cu焊盤和TiW層組成的多層復合焊盤起皮現象及微觀形貌
鍵合焊盤位于半導體器件的表面,會受到化學和機械載荷的作用。化學載荷由前道晶圓制造過程引發,例如鈍化層開窗、介質層開窗以及表面清洗等操作;機械載荷則由后道工序中的電測試和封裝過程所誘導。因此,焊盤需要具備足夠的強度,以承受這些載荷。
焊盤起皮問題的核心,是焊球與焊盤表面鋁層之間的結合力,和焊盤表面鋁層及其附著層與硅基體之間的附著力之間的競爭關系。在這種競爭關系中,當焊球受到外力作用時,如果焊盤表面鋁層及其附著層與硅基體之間的附著力足夠強,那么就會表現為焊球與焊盤剝離或者焊球自身斷裂,這屬于正常情況。反之,當焊盤表面鋁層與硅基體之間的附著力不夠大時,焊球與焊盤表面鋁層之間的結合力就會占據優勢。此時,在外力的作用下,焊球會帶著焊盤表面鋁層及其附著層一起從硅基體上剝離,從而出現焊盤起皮現象。
一般來說,焊球與焊盤表面鋁層之間的結合力是有限的。在承受外來載荷時,鍵合絲斷裂、焊球剝離應該先于焊盤起皮發生。所以,如果在這種競爭關系中焊盤處于劣勢,就意味著鋁焊盤的附著力較弱,存在質量風險。
起皮現象的出現,往往伴隨著焊盤的內傷。這些內傷被認為是在封裝鍵合過程中或者電性能探針測試時造成的。焊盤內傷是引線鍵合過程中一種難以察覺的質量隱患,嚴重的內傷會導致焊盤分層或者直接剝離。存在這些質量隱患的集成電路,在電性能測試中有可能被發現并剔除。然而,更多的內傷處于臨界狀態,初始的電性能衰退并不明顯,只有在后續的篩選試驗中,經過溫度循環、熱沖擊、老化、機械振動等測試后,才會暴露出問題,表現為焊盤起皮、坑陷、引線脫鍵、電性能開路等情況。
雖然在大多數情況下,可以通過優化超聲參數、清潔劈刀、完善鍵合工藝過程等方式,來降低鍵合過程對焊盤產生的應力。但在某些情況下,后道封裝工序所采取的措施,并不能完全解決焊盤起皮的問題。這是因為在一些情況下,焊盤在芯片制造過程中由于控制不當,本身就存在質量隱患,這種內傷是先天性的。在這種情況下,不應該為了避免焊盤起皮而盲目降低工藝參數,因為這樣不僅無法彌補內傷缺陷,反而會降低鍵合絲與焊盤之間的鍵合可靠性。對于這類器件,比較合理的做法是進行批次性檢查或者直接報廢,以防止這些薄弱環節在后續的篩選或使用過程中引發問題。
超聲參數
有研究指出,焊盤起皮這一過程,最初源于鋁焊盤表面及其內部金屬層出現裂紋,而不恰當的鍵合功率、鍵合力、時間以及溫度等參數組合是導致這種損傷的原因。在這些因素中,超聲功率的影響最為顯著,因為它所提供的能量會帶動焊盤表層與內層產生剪切作用。當超聲功率過大時,會對焊盤金屬層造成損傷,進而引發焊盤起皮現象。
對于鍵合力而言,由于劈刀對焊球施加的壓力能夠抑制剪切運動的趨勢,使得球-焊盤整個鍵合體系需要更大的能量才能夠產生滑動。所以,在引發焊盤起皮現象方面,增大壓力實際上起到了抑制超聲功率影響的作用,即增大壓力會減少焊盤起皮現象的發生。
預熱溫度能夠對焊盤起到軟化作用,在相同條件下,提高預熱溫度有助于降低焊盤起皮的失效率。綜上所述,選用合適的超聲參數是避免因鍵合而導致焊盤內傷的關鍵前提。
有研究人員針對138kHz超聲頻率下超聲振幅對焊盤應力分布的影響進行了有限元仿真分析,結果如圖3所示。從圖中可以看出,在鍵合過程中,應力會隨著劈刀的移動而變化,只有當劈刀移動到中心區域時,才會出現應力分布對稱的情況。進一步的仿真分析顯示,焊盤中的鍵合應力會隨著超聲振幅的提高而增大,具體情況如圖4所示。這些結果表明,超聲振幅在金屬絲鍵合過程中,對其應力和變形有著顯著的影響。
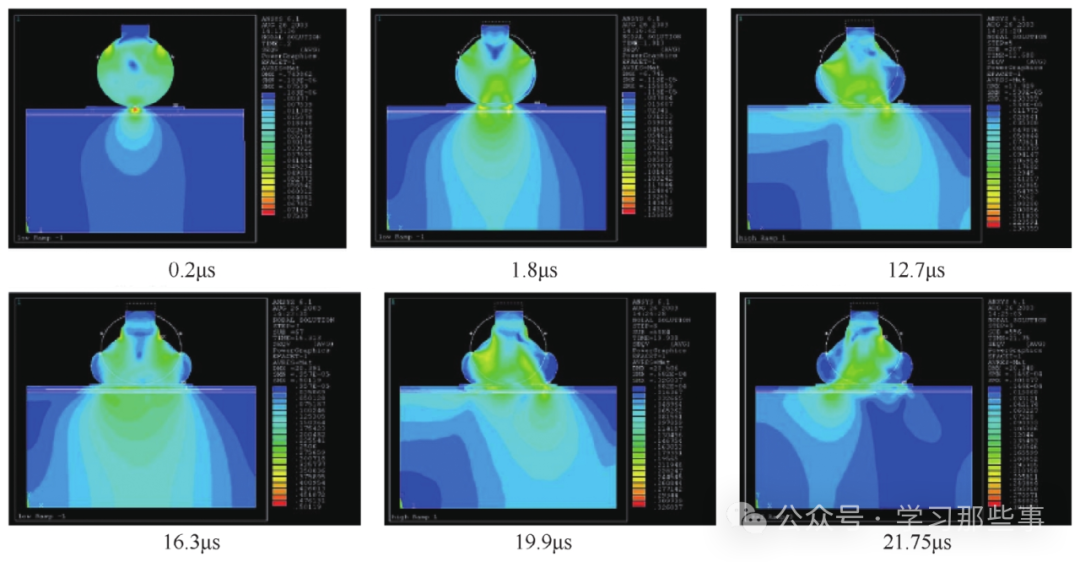
圖3 不同時間應力分布
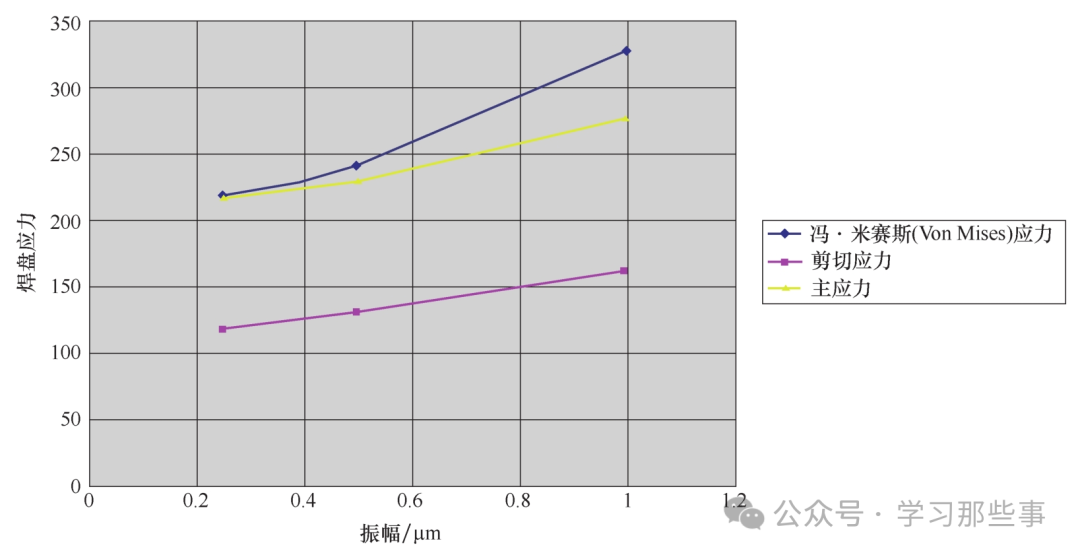
圖4 超聲振幅對焊盤應力的影響
劈刀
在鋁制程芯片的鍵合過程中,劈刀扮演著至關重要的角色。它作為將超聲參數精準施加到焊盤上的關鍵載體,是整個能量傳遞環節中不可或缺的部分。倘若劈刀出現異常狀況,那么超聲功率與壓力就難以均勻且穩定地作用于焊盤,從而嚴重干擾超聲能量的正常傳播,對鍵合質量產生負面影響。
從另一個角度來看,據研究人員分析,當劈刀經歷了大量的鍵合操作后,受到污染的劈刀頭會發生一些變化。由于污染使得劈刀頭與焊球的接觸表面積增大,這就導致劈刀頭與焊球之間的附著力增強,同時垂直張力載荷的大小也會相應增大。在劈刀抬起的過程中,垂直方向的載荷會依次傳遞,從劈刀傳遞至變形的焊球,隨后再傳導至焊盤。而這一垂直載荷,正是引發焊盤起皮的直接動力來源。當垂直方向的載荷作用于焊盤時,會促使焊盤產生裂紋。這些裂紋首先在區域a處萌生,隨后沿著界面向焊盤下方的氧化層延伸擴展,最終導致焊盤起皮現象的發生,如圖5所示的情況清晰地展示了這一過程。此外,統計數據也反映出一個明顯的趨勢,在焊盤出現起皮現象的案例中,高達87%的情況里,所使用的劈刀其使用次數已經超過了20萬次,這進一步表明了劈刀的使用狀況與焊盤起皮之間存在著緊密的聯系。
研究成果還表明,對于改善鋁制程芯片的焊盤起皮問題,合理地選擇劈刀型號是一個關鍵的解決策略。當我們選用錐角CA=70°且端部直徑CD較小的劈刀,并適度增大鍵合壓力時,能夠對焊點的塑形產生積極影響。這樣可以使焊點與焊盤之間實現良好、均勻且充分的接觸,有效避免了因焊點凸起而引發的局部應力集中問題。不僅如此,CA=70°的劈刀所形成的焊球,其擠壓斜面體積相對較薄,這一特性使得它在傳導超聲能量時的損耗較小。而且,與CA=120°的劈刀相比,CA=70°的劈刀在焊球中心區域的能量聚集程度更弱,從而能夠顯著緩解鍵合功率對焊盤中心區域鋁層的破壞程度,具體的差異和優勢如圖6所示。
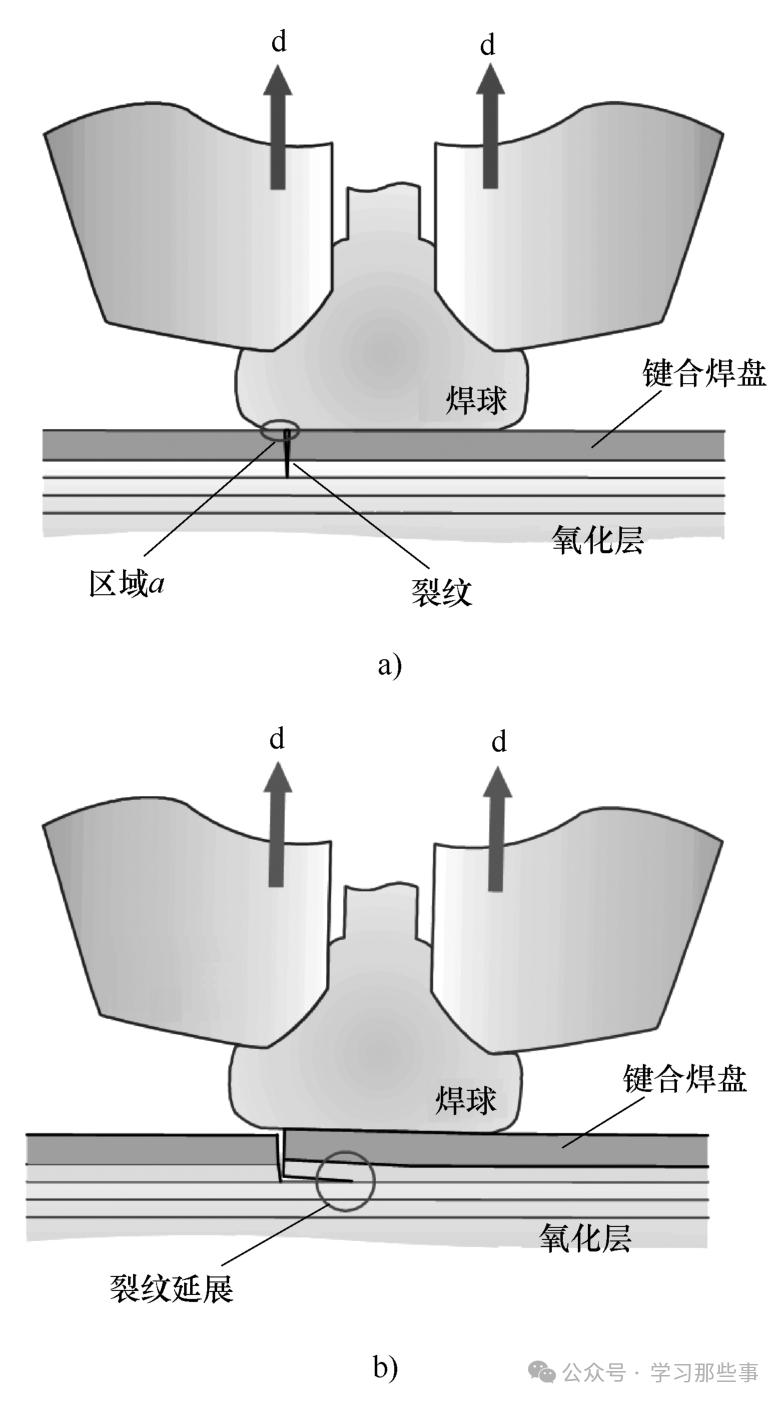
圖5焊盤起皮原因示意圖
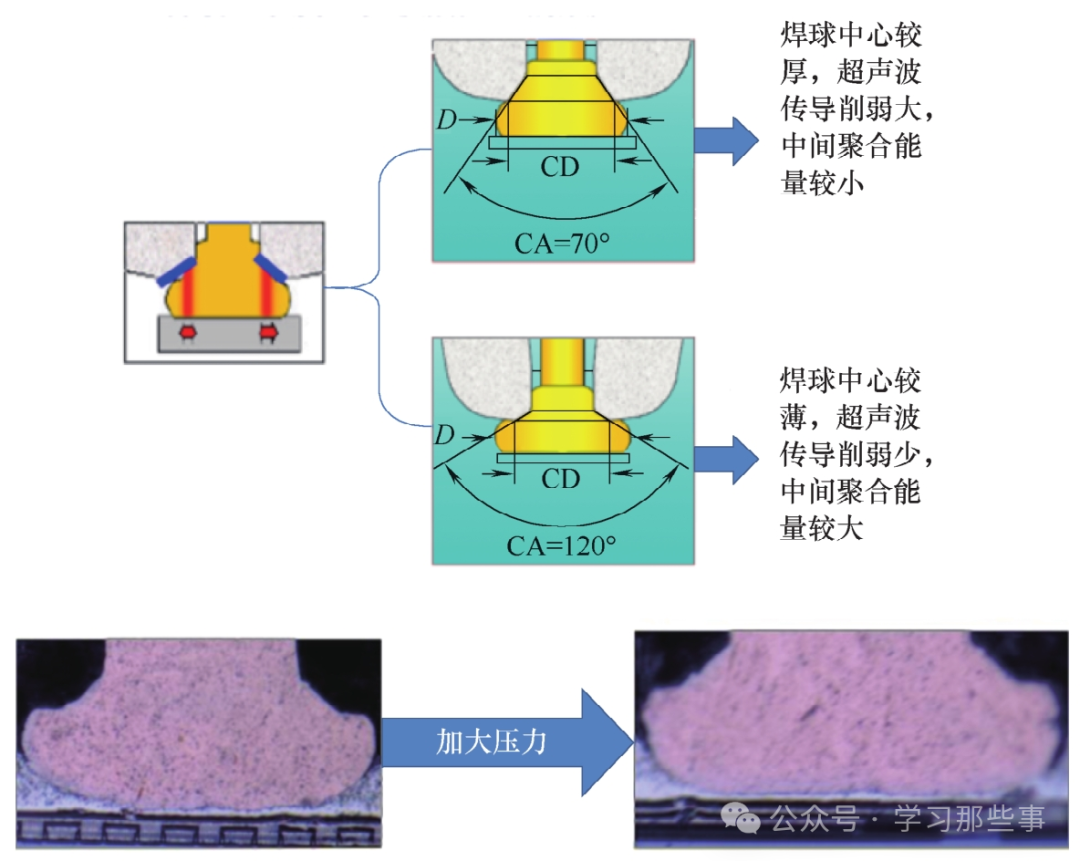
圖6 不同錐角劈刀對鍵合影響對比
滑移
在某些情況下,即便對超聲功率、壓力以及預熱溫度進行了優化,鋁盤脫落(ABPO)率依舊無法降至零,這表明該批次產品出現ABPO現象至少還存在其他影響因素。研究人員經探索發現,通過對軟件系統進行優化,減少鍵合過程中出現的滑移(Skidding)現象,能夠顯著減輕劈刀與焊球之間的滑移程度。如此一來,焊盤內部所承受的剪切應力會大幅降低,從而有效避免焊盤出現內傷,進而消除ABPO現象。
圖7展示了焊球的滑移情況,從圖中可以清晰地看到滑移在金絲球上留下的痕跡。圖8則呈現了軟件優化前后鍵合劈刀動作的對比情況。
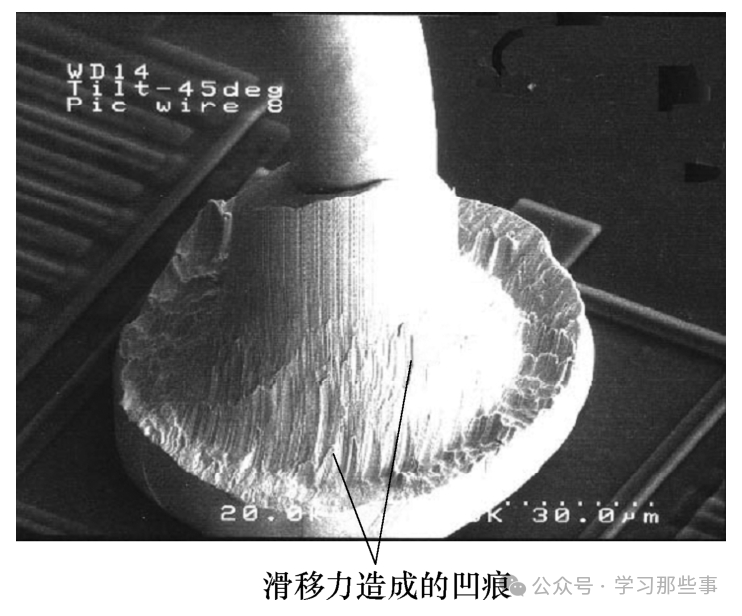
圖7 焊球滑移情況
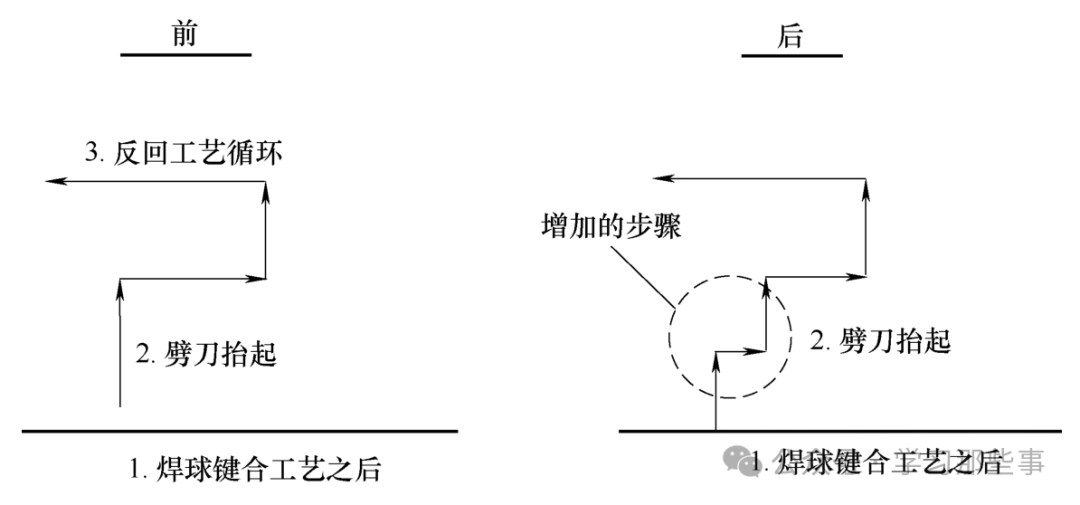
圖8 軟件優化前后鍵合劈刀動作對比
研究人員借助激光共聚焦技術進行觀察,發現發生焊盤起皮的單元,其平均滑移深度為9.6μm;而在軟件優化減少滑移后,平均滑移深度降至7.44μm。通過對金的維氏硬度進行計算得出,發生焊盤起皮的單元,平均滑移力為48.7gf;軟件優化減少滑移后,平均滑移力下降至29.2gf。有限元仿真結果顯示,由于滑移力的存在,發生ABPO的單元中BPSG的剪切強度為1.74GPa,而未發生ABPO的單元其剪切強度為1.29GPa。
工藝參數
部分研究人員認為,預熱溫度、鍵合功率以及鍵合力等因素對焊盤起皮現象存在影響。具體的影響情況見表1。
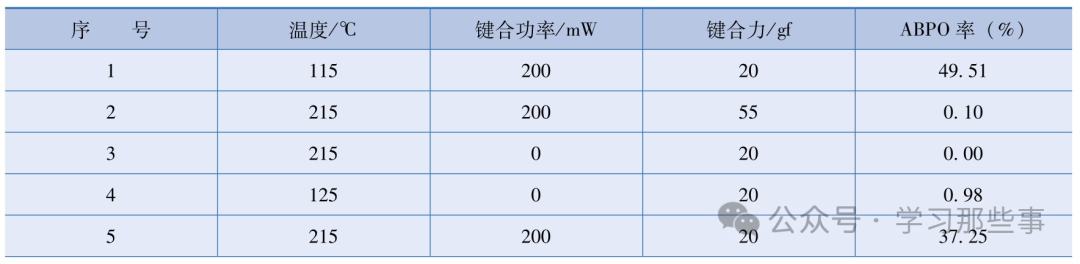
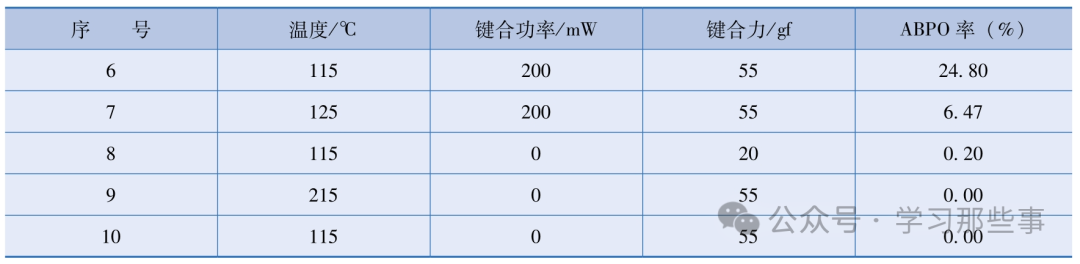
表1預熱溫度、鍵合功率和鍵合力對焊盤起皮的影響
晶圓制造
在晶圓制造過程中,鹵族元素的殘留會對鋁焊盤及其氧化膜產生腐蝕作用。同時,盤內金屬層會因吸潮,在升溫后出現汽化膨脹的現象,進而導致分層,這些因素都對焊盤內部金屬層附著力的下降產生了作用。通過對化學鍍鎳鈀浸金(ENEPIG)焊盤鍵合起皮后的SEM/EDX分析可知,氧化是致使Pd、Ni分層的主要原因。圖9展示了ENEPIG焊盤脫鍵后焊盤和引線的微觀形貌,圖10所示的聚焦離子束(FIB)截面圖分別呈現了穿過掉鋁區域、離開掉鋁區域稍遠一點引線脫離的區域以及常規參考區域這三個不同區域的情況。
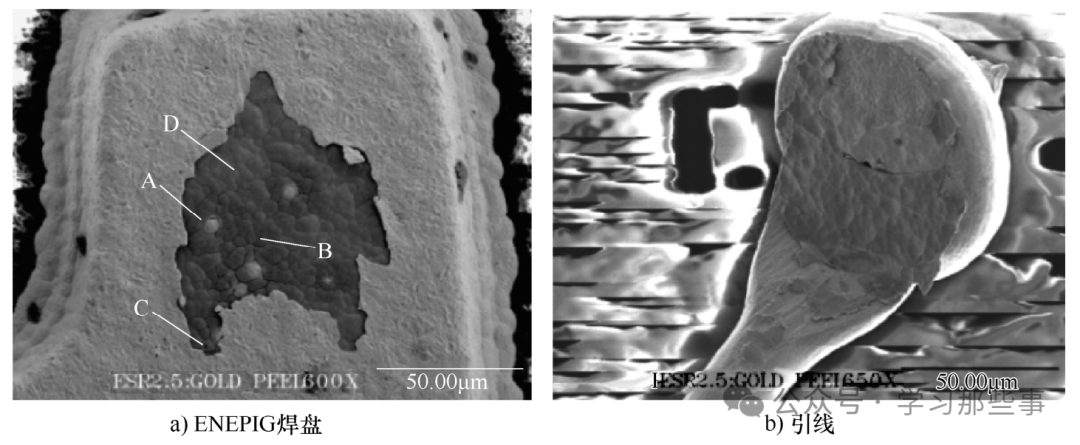
圖9 ENEPIG焊盤脫鍵后焊盤和引線的微觀形貌
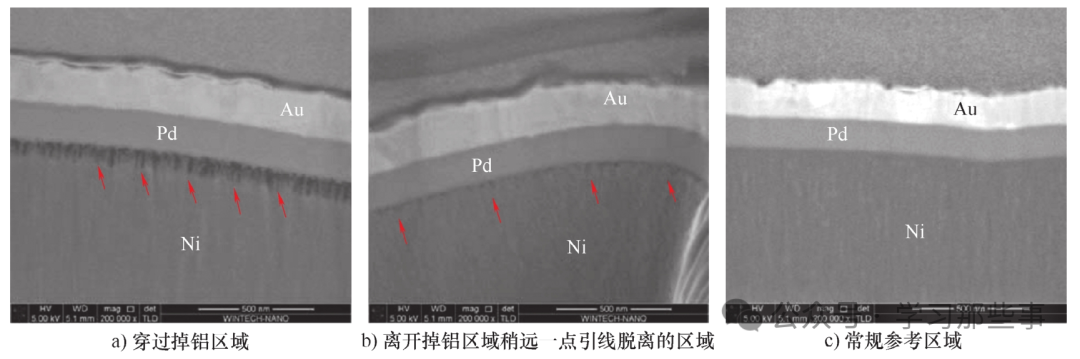
圖10 FIB截面圖
有研究指出,對于多層焊盤結構,設置了250nm、330nm、450nm、550nm和650nm這五種不同厚度的表面鋁層(M2)。經過200℃、3h的老化處理后,結果表明,較薄的M2層更容易出現球頸破壞、起墊和起球失效等情況,具體可參考圖11 - 圖13。
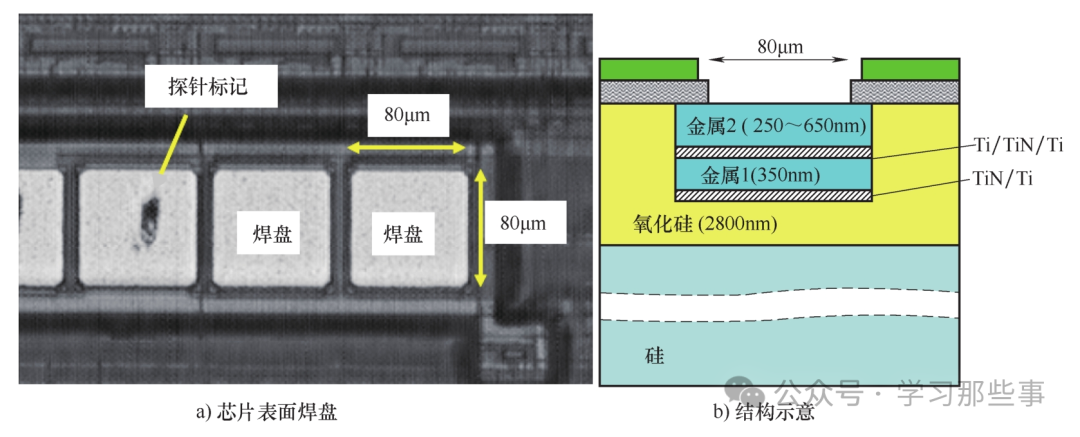
圖11 芯片鋁焊盤
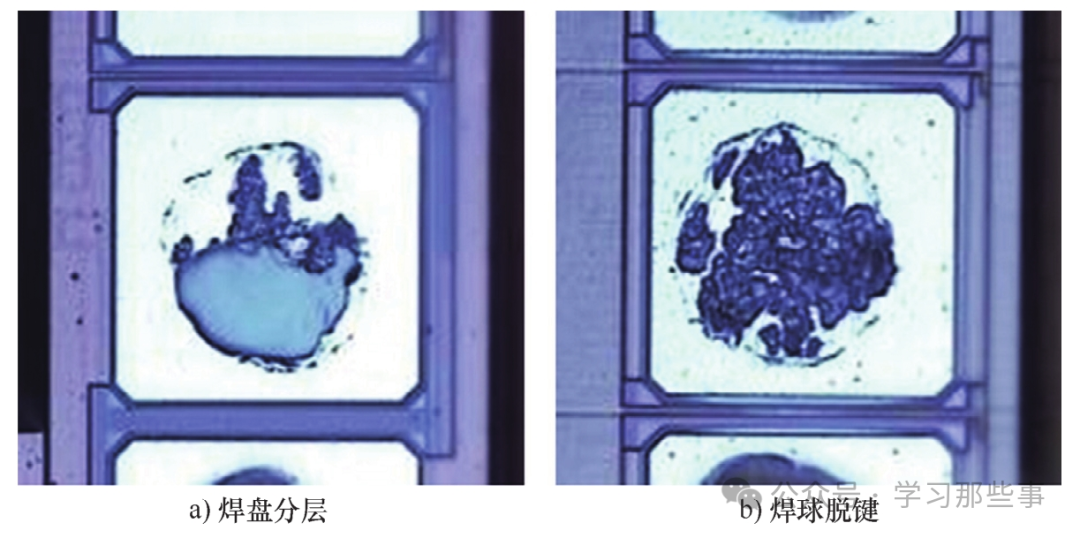
圖12 拉力測試中的典型失效模式
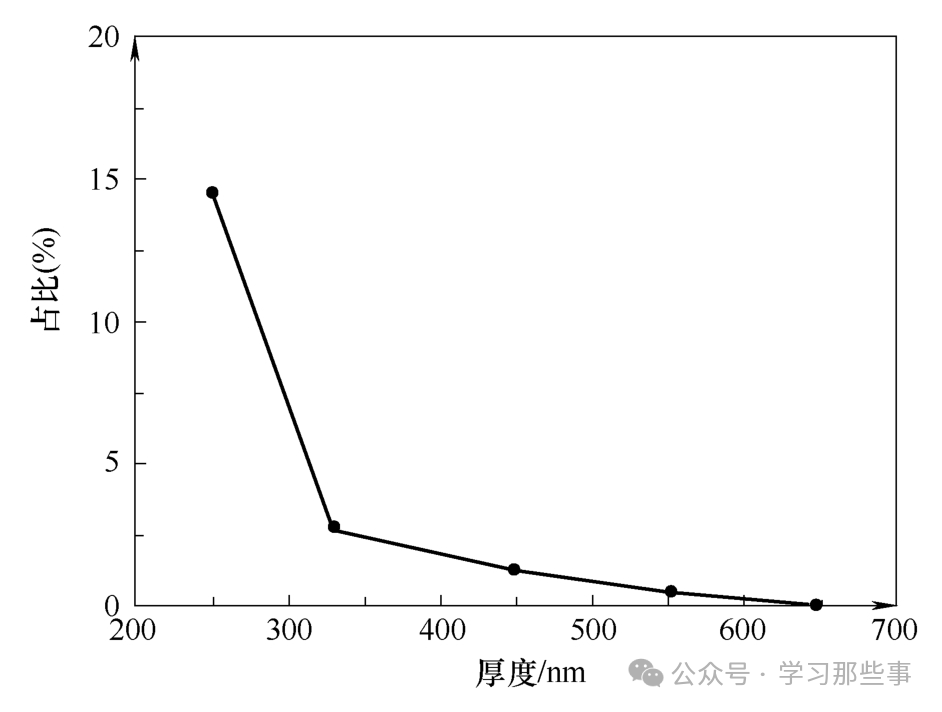
圖13 鍵合拉力試驗中起皮和焊球脫鍵失效模式占總體失效模式比例隨M2厚度變化
-
芯片
+關注
關注
459文章
52169瀏覽量
436096 -
封裝
+關注
關注
128文章
8494瀏覽量
144779 -
工藝
+關注
關注
4文章
669瀏覽量
29248 -
焊盤
+關注
關注
6文章
588瀏覽量
38695
原文標題:芯片焊盤起皮
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
LED小芯片封裝技術難點解析
請問TAS5760L底部的BGA焊盤起什么作用?
波峰焊點拉尖現象的成因與解決策略
PCB焊盤的形狀+功能 集錦
dsp芯片虛焊的原因及解決方法
焊球類/芯片/焊線類的剝離與拉力的功能原理
解析PCBA加工中焊點拉尖的成因與解決方案
LED芯片溫度成因與半導體照明散熱技術解析

芯片互連技術深度解析:焊球、銅柱與微凸點的奧秘

揭秘元器件立碑現象:成因解析與預防策略
詳解錫膏工藝中的虛焊現象
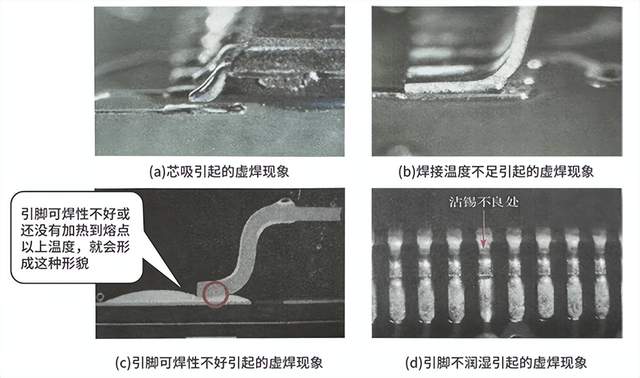





 芯片焊盤起皮的成因解析
芯片焊盤起皮的成因解析











評論