本節將介紹 CMOS 超大規模集成電路制造工藝流程的基礎知識,重點將放在工藝流程的概要和不同工藝步驟....

在高k金屬柵之外,另一種等效擴充的方法是增加通過器件溝道的電子或空穴的遷移率。表2.5列舉了一些提高....

源漏區的單晶硅和柵極上的多晶硅即使在摻雜后仍然具有較高的電阻率,自對準硅化物(salicide)工藝....
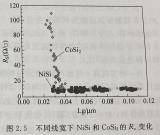
源漏擴展結構(Source/Drain Extension,SDE)在控制 MOS 器件的短溝道效應....

為了有效抑制短溝道效應,提高柵控能力,隨著MOS結構的尺寸不斷降低,就需要相對應的提高柵電極電容。提....

隨著集成電路技術節點的不斷減小以及互連布線密度的急劇增加,互連系統中電阻、電容帶來的 RC耦合寄生效....
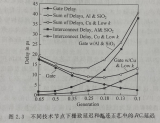
圖2.2是現代CMOS 器件剖面的示意圖。一般來說,水平方向的尺寸微縮幅度比垂直方向的幅度更大,這將....
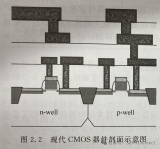
2010年,愛爾蘭 Tyndall 國家研究所的J.P.Colinge 等人成功研制了三柵無結場效應....
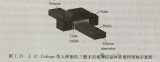
當代所有的集成電路芯片都是由PN結或肖特基勢壘結所構成:雙極結型晶體管(BJT)包含兩個背靠背的PN....

MESFET 熱穩定性較差、漏電流較大、邏輯擺幅較小、抗噪聲能力較弱。隨著頻率、功率容限以及低噪聲容....

結型場效應晶體管(Junction Field-Effect Transistor, JFET)是在....

一對N溝道和P溝道 MOS 管以推挽形式工作,構成互補的金屬氧化物半導體器件(Complementa....
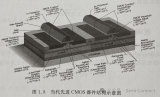
在混合式氮化鎵?VCSEL?的研究,2010年本研究團隊優化制程達到室溫連續波操作電激發氮化鎵?VC....
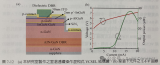
上述實驗結果為近年來局限在光激發的氮化鎵?VCSEL?的結果,一直到2008年,作者實驗室首次在77....

在氮化鎵藍光?VCSEL?發展方面,1996年?Redwing?等人成功制作了第一個室溫下光激發的氮....

在氮化鎵發光二極體的發展過程中已受到許多的阻礙,其中包含缺少晶格匹配的基板、p型氮化鎵鎂的低活化率、....

東京大學荒川泰彥教授(Y. Arakawa)在1982年提出量子點結構的概念,在1994年柏林工業大....
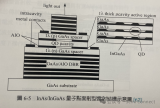
由上述 InP 系列材料面射型雷射發展可以發現,要制作全磊晶結構的長波長面射型雷射難度較高,因此在1....
為了應用在光纖通訊上有效提升訊號傳輸距離,對于發光波長1310nm?與1550nm的面射型雷射需求也....

在完成選擇性氧化制程后,通常會將蝕刻后殘留在磊晶片表面繼續作為氧化制程保護層的?SiO2或?SiNx....

采用氧化局限技術制作面射型雷射元件最關鍵的差異在于磊晶成長時就必須在活性層附近成長鋁含量莫耳分率高于....

制作氧化局限面射型雷射與蝕刻空氣柱狀結構一樣都需要先將磊晶片進行蝕刻,以便暴露出側向蝕刻表面(etc....

為了改善上述蝕刻柱狀結構以及離子布植法制作面射型雷射的缺點,在1994年從德州大學奧斯丁分校獲得博士....
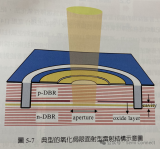
目前市場上普遍采用的面射型雷射元件主流技術為選擇性氧化法,絕大多數面射型雷射操作特性紀錄均是由選擇性....

由于蝕刻柱狀結構有上述金屬電極制作困難且需要額外的蝕刻制程步驟等問題,因此早期業界及學術研究單位最常....
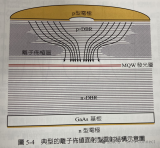
半導體材料被蝕刻移除后,剩余的柱狀結構與周遭的空氣之間折射率差異也因此增加,因此在柱狀結構中電子電洞....

其中蝕刻空氣柱法將大多數可以導通電流的半導體材料以物理性或化學方式蝕刻移除后,僅保留直徑數微米至數十....
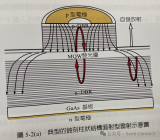
從前面一小節對半導體雷射線寬的討論可以知道,即使半導體雷射操作在穩態的狀況下,還是會有因為自發輻射所....

從前面的例子中,可以知道線寬增強因子會讓半導體雷射在動態操作時譜線變寬,接下來我們要討論的是半導體雷....

為要了解半導體雷射的大信號響應,我們先針對單模雷射的速率方程式求解,我們將使用線性增益近似以及考慮到....
