在半導體、光學鍍膜及新能源材料等領域,精確測量薄膜厚度和光學常數是材料表征的關鍵步驟。Flexfilm光譜橢偏儀(Spectroscopic Ellipsometry, SE)作為一種非接觸、非破壞性的光學測量技術,通過分析光與材料相互作用后偏振態的變化,能夠同時獲取薄膜的厚度、折射率、消光系數等參數。本文將從原理、測量流程及實際應用三個方面,解析橢偏儀如何實現薄膜厚度的精準測量。
1
橢偏儀的基本原理
flexfilm
橢偏儀的核心原理基于光波的偏振特性。當一束偏振光入射到薄膜表面時,會在空氣/薄膜、薄膜/基底等多個界面發生反射和透射。由于不同偏振態(p偏振光和s偏振光)的反射行為差異,光的振幅和相位會發生變化。橢偏儀通過測量這種偏振態變化,推導出薄膜的光學參數。

表面增強(SE)測量與分析的基本原理圖
其數學基礎為橢偏方程:

式中,Rp和Rs分別為p偏振光和s偏振光的菲涅耳反射系數,Ψ和Δ是橢偏參數,分別表示反射后兩偏振光的振幅比和相位差。通過實驗測量這兩個參數,結合光學模型,即可反推出薄膜的厚度與光學常數。
2
SnO?薄膜的厚度測量
flexfilm
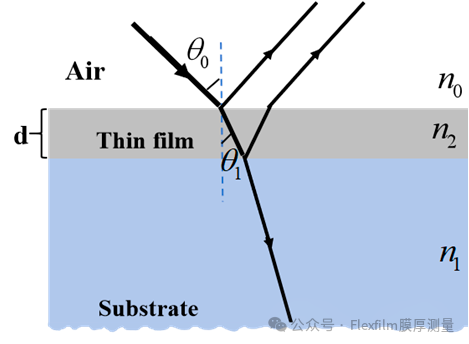
SnO?薄膜的光學模型
以透明導電材料SnO?薄膜為例,其高透光性(可見光區消光系數趨近于零)和導電性使其廣泛應用于太陽能電池的電子傳輸層。測量步驟如下:
1.樣品制備:通過旋涂法在玻璃基底上沉積SnO?薄膜,并通過退火工藝提高結晶度。
2. 橢偏儀測量:在入射角55°、60°、65°下,采集400-800 nm范圍內的Ψ和Δ曲線。
3. 模型選擇:
基底(玻璃)的光學常數采用Cauchy模型或Cauchy-Urbach模型描述。
SnO?薄膜的復折射率通過Tauc-Lorentz色散模型擬合。
4.參數優化:使用WOA或LM算法擬合厚度和折射率,直至實驗曲線與理論曲線吻合
實驗結果表明,WOA與LM算法得到的膜厚一致性較高(如SnO?-FQ薄膜厚度分別為34.52 nm與33.94 nm),驗證了WOA在全局搜索中的有效性。
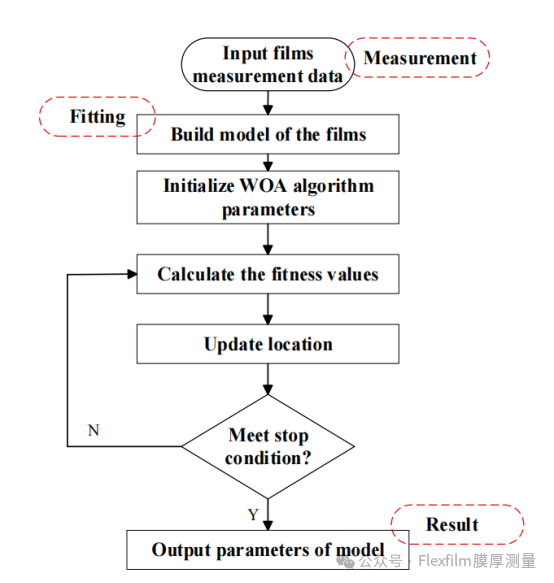
基于WOA的橢圓偏振數據擬合方法流程圖
3
橢偏儀的優勢
flexfilm
高精度:可檢測亞納米級膜厚變化。
非破壞性:無需接觸樣品,適用于脆弱或功能性薄膜。
多參數獲取:單次測量可同時得到厚度、折射率、消光系數等信息。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(如厚度)和物理參數(如折射率n、消光系數k)
1.先進的旋轉補償器測量技術:無測量死角問題。
2.粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
3.秒級的全光譜測量速度:全光譜測量典型5-10秒。
4.原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀通過偏振光與薄膜的相互作用,結合優化算法,為薄膜厚度的精確測量提供了高效解決方案。隨著智能算法(如WOA)的引入,橢偏儀的數據分析過程逐漸自動化,降低了用戶門檻。未來,該技術有望在柔性電子、光伏器件等新興領域發揮更大作用,推動材料科學的精細化發展。
-
測量
+關注
關注
10文章
5275瀏覽量
113616 -
薄膜厚度
+關注
關注
0文章
12瀏覽量
1735
發布評論請先 登錄
VirtualLab Fusion應用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
全光譜橢偏儀測量:金屬/半導體TMDs薄膜光學常數與高折射率特性

生物聚合物薄膜厚度測定:從傳統觸探輪廓儀到全光譜橢偏儀






 橢偏儀測量薄膜厚度的原理與應用
橢偏儀測量薄膜厚度的原理與應用















評論