在微電子制造與光伏產業中,大面積薄膜的均勻性與質量直接影響產品性能。傳統薄膜表征方法(如濺射深度剖析、橫截面顯微鏡觀察)雖能提供高精度數據,但測量范圍有限且效率較低,難以滿足工業級大面積表面的快速檢測需求。本文聚焦光學表征技術的革新,重點闡述橢偏儀等光學方法在大面積薄膜映射與成像中的突破性應用。其中,Flexfilm全光譜橢偏儀以其獨特的技術優勢,在大面積薄膜表征中展現出顯著的應用潛力。
1
薄膜表征方法
flexfilm
根據測量原理與適用場景,薄膜表征方法可分為:深度剖析技術
- 濺射深度剖面分析(如二次離子質譜[SIMS]、X射線光電子能譜[XPS]):需通過物理濺射逐層剝離樣品,雖精度高但破壞性強,且無法實現實時監測。
- 非破壞性技術(如光譜橢偏儀[SE]、盧瑟福背散射譜[RBS]):通過光學或粒子束與物質相互作用獲取信息,單點測量耗時較長,但部分光學配置可將單點測量時間縮短至秒級。
- 橫截面微納尺度映射(如掃描透射電子顯微鏡[TEM]):依賴精細樣品制備,分辨率可達納米級,但僅適用于微觀區域分析,難以擴展至宏觀尺度。
涂層厚度測定方法
- 傳統方法(庫侖法、X射線熒光[XRF]):需離線操作,適用于實驗室級精密分析。
- 離線方法(原子力顯微鏡[AFM]):可提供納米級形貌信息,但測量速度較慢。
- 在線方法(反射率測量、干涉測量法、橢偏儀):反射率測量與干涉測量法適用于簡單結構,而橢偏儀因其非破壞性、高速潛力及對復雜層狀結構的適應性,成為在線檢測的首選。
2
光學映射技術
flexfilm
- 橢圓偏振光譜法(SE)
橢偏儀通過測量光在薄膜表面的反射特性(振幅比與相位差),實現薄膜厚度、折射率等參數的快速測定。其在大面積映射中的優勢如下:逐點掃描:通過移動光源與檢測器單元,覆蓋米級面積。例如,在太陽能電池板檢測中,單點光譜測量僅需數秒,但數千點測量仍需數小時。卷對卷(RtR)配置:利用襯底移動實現光斑掃描,適用于柔性襯底的在線檢測。例如,在光伏多層結構(如CdS/CdSe/CdTe)的均勻性優化中,可實時調整工藝參數。

室溫沉積CdSe薄膜的65mm×65mm區域制圖
- 反射、透射光譜與散射測量
高光譜成像(HSIM):提供表面區域的空間與光譜信息,用于二維材料(如石墨烯、MoS?)的厚度和激子行為分析,在生命科學和鈣鈦礦材料中亦有應用。共聚焦顯微鏡:適用于數百微米厚度的透明雙層膜檢測,空間分辨率達納米級,可在線監測柔性襯底上的多層涂層。散射測量:通過衍射圖案重建復雜光柵結構,暗場配置可成像亞波長等離子體納米顆粒。
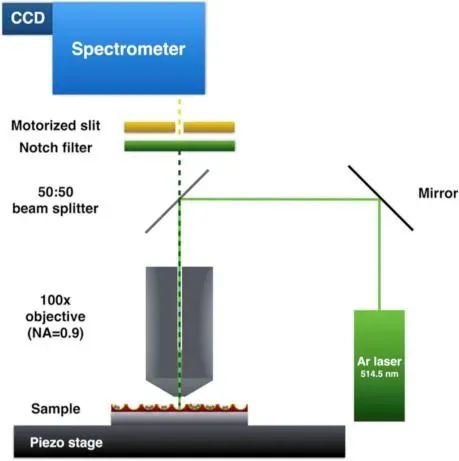
單顆粒制圖光譜儀示意圖
- 其他方法
毛細管橋法量化超低接觸角(精度達0.1°),汞探針肖特基電容-電壓法(MCV)用于硅外延層載流子密度的大面積剖面分析。
3
成像技術
flexfilm
- 橢圓偏振成像

發散光源橢圓偏振術裝置示意圖
發散光源配置:利用球面鏡和針孔相機,實現大面積表面的多角度、多波長橢圓偏振參數成像,單次測量可覆蓋 1000 mm×500 mm 區域,速度比傳統逐點掃描快 10 倍以上。光譜分析:結合光柵色散,可在一維方向實現連續光譜測量,適用于卷對卷工藝中的實時監控。例如,在柔性電子制造中,發散光源橢偏儀可實時監測透明導電氧化物(TCO)層的厚度均勻性。

卷對卷壓印納米結構尺寸分析在線散射儀
- 反射與散射成像
實時散射成像:用于納米壓印結構的在線計量,結合光譜散射法實現納米級結構深度測量,誤差僅數納米。斑點干涉法:通過激光反射產生的顆粒圖案變化,監測生物組織(如大鼠血管)中的血流動力學參數。
4
應用案例
flexfilm
- 300mm晶圓厚度測量

機械臂移動過程中測量的a-NiSi厚度圖與商業橢偏儀參考測量結果
配置:機械臂搭載橢偏儀,在晶圓移動過程中完成厚度映射。結果:與商業儀器對比,誤差小于1nm,滿足半導體制造需求。
- 擴展光束橢偏儀的性能驗證

由九個不同氧化處理的4英寸硅片組成的大面積映射結果
數據:發散光束橢偏儀在2分鐘內完成300mm晶圓厚度映射,分辨率達10nm。對比:傳統點掃描需15分鐘以上,效率提升顯著。本文系統總結了大表面薄膜的光學映射與成像技術,重點分析了橢圓偏振法的進展與優勢。為工業級大面積薄膜檢測提供了高效解決方案,推動大表面薄膜技術的工業化應用。推動了光伏、半導體等領域的質量控制革新。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(如厚度)和物理參數(如折射率n、消光系數k)
- 先進的旋轉補償器測量技術:無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀憑借其高靈敏度探測單元和秒級全光譜測量速度,進一步推動了大規模薄膜技術的工業化應用。原文出處:《Mapping and Imaging of Thin Films on Large Surfaces》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
測量
+關注
關注
10文章
5275瀏覽量
113616 -
薄膜光伏
+關注
關注
0文章
6瀏覽量
9578
發布評論請先 登錄
大面積白光OLED器件
大面積均勻電子束產生實驗研究
薄膜光學實時成像儀的設計概念
教授研究組在大面積制備鈣鈦礦LED領域取得重要進展
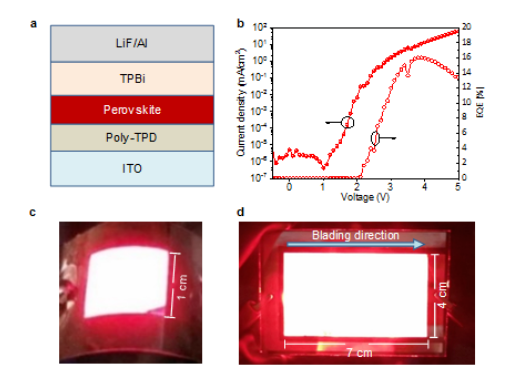
大面積甲脒銫基鈣鈦礦薄膜與高效穩定模組

全光譜橢偏儀測量:金屬/半導體TMDs薄膜光學常數與高折射率特性

橢偏儀原理和應用 | 精準測量不同基底光學薄膜TiO?/SiO?的光學常數






 大面積薄膜光學映射與成像技術綜述:全光譜橢偏技術
大面積薄膜光學映射與成像技術綜述:全光譜橢偏技術













評論