橢偏儀作為表征光學(xué)薄膜性能的核心工具,在光學(xué)薄膜領(lǐng)域具有不可替代的作用。本研究聚焦基底類型(K9玻璃、石英玻璃、單晶硅)對溶膠-凝膠法制備的TiO?和SiO?薄膜光學(xué)性能的調(diào)控機(jī)制。Flexfilm費(fèi)曼儀器作為國內(nèi)領(lǐng)先的薄膜材料檢測解決方案提供商,致力于為全球工業(yè)智造提供精準(zhǔn)測量解決方案。
其中全光譜橢偏儀可以精確量化薄膜的折射率、消光系數(shù)及厚度參數(shù),揭示基底結(jié)構(gòu)差異對薄膜微觀形貌與光學(xué)常數(shù)的內(nèi)在影響規(guī)律,為高性能減反膜及光學(xué)器件的基底選型提供理論支撐。
1
橢偏測量原理
flexfilm
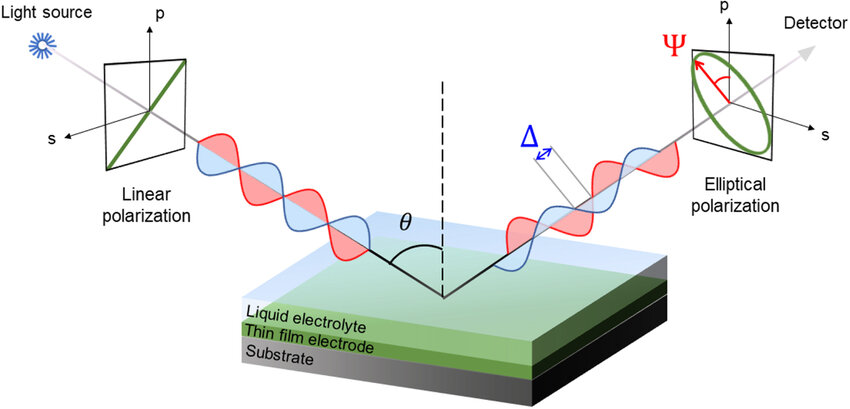
Δ 是橢偏法的位相參量, 反映了反射前后 p 波和 s 波位相差的變化;ψ 是橢偏法的振幅參量,反映了 p 波與 s 波的振幅比在反射前后的變化。橢圓偏振儀的原理是利用 p 分量與 s 分量間具有一定相位差的等幅橢圓偏振光入射到樣品表面,使反射光成為線偏振光,通過對入射 p 與 s 分量間相位差及反射線偏振方位角的測量獲得涵蓋樣品光學(xué)參量的相關(guān)信息。

式中:rp和 rs分別為對于 p 分量和 s 分量材料的反射系數(shù);εs和 εa別為樣品和環(huán)境的介電常數(shù),環(huán)境通常為空氣,εa=1;φ為入射角。
通過對光強(qiáng)信號隨偏振器方位角的變化作傅里葉變換,求得橢偏參數(shù) ψ 和 Δ;再利用兩組模型計(jì)算樣品的表觀介電常數(shù),進(jìn)而可得到其他光學(xué)參數(shù)。折射率和消光系數(shù)分別表示為:


單晶硅基底上 TiO?(a, b)和 SiO?(c, d)薄膜的橢偏參量測量和擬合結(jié)果
同時(shí)通過前期分別對TiO?/單晶硅薄膜、SiO?/單晶硅薄膜橢偏參數(shù)的擬合分析發(fā)現(xiàn):單晶硅基底上的兩種薄膜誤差最小。 因此選用單晶硅基底上的TiO?與SiO?薄膜進(jìn)行擬合分析。
2
不同基底對薄膜折射率的影響
flexfilm

不同基底上TiO?、SiO?薄膜的折射率
由橢偏儀測量結(jié)果可知,單晶硅基底上的 TiO?和 SiO?薄膜折射率均為最大,TiO?薄膜在三種基底上折射率順序?yàn)?/span>單晶硅>K9 玻璃>石英玻璃,SiO?薄膜則為單晶硅>石英玻璃>K9 玻璃。這是因?yàn)閱尉Ч杌拙Ц衿ヅ涠雀摺⒋植诙刃。∧じ旅埽着c薄膜的線膨脹系數(shù)、化學(xué)組成等也影響折射率。
3
不同基底對薄膜消光系數(shù)的影響
flexfilm
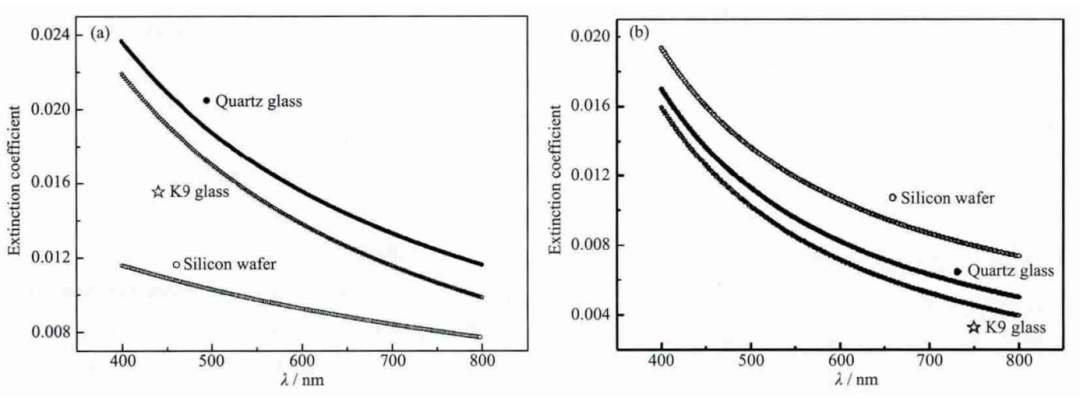
不同基底上 TiO?、SiO?薄膜的消光系數(shù)
橢偏數(shù)據(jù)揭示消光系數(shù)(k)隨波長增大而遞減,且基底依賴性顯著:
TiO?薄膜:單晶硅基底k值最低(@400 nm: 0.015±0.003),K9玻璃次之(0.028±0.005)
SiO?薄膜:所有基底k<0.005(可忽略吸收),但單晶硅基底表面裂紋少
熱失配效應(yīng):石英玻璃與TiO?線膨脹系數(shù)差(Δα=1.39×10??/℃)引發(fā)界面張力,導(dǎo)致膜層缺陷增多→k值升高。
4
不同基底對薄膜透光率的影響
flexfilm

不同基底上TiO?、SiO?薄膜的透光率
透光率方面,K9 玻璃基底上 TiO?薄膜透光率高于石英玻璃基底,SiO?薄膜在兩種非晶基底上透光率峰值相差不大,這與基底對薄膜晶粒生長、表面狀態(tài)的影響有關(guān)。
橢偏儀定量揭示了基底-薄膜匹配機(jī)制:單晶硅基底因低晶格失配度(界面粗糙度σ<1 nm)使TiO?/SiO?薄膜折射率提升(n=2.27/1.43),而熱膨脹系數(shù)差異導(dǎo)致非晶基底上TiO?光學(xué)常數(shù)分散性增大(Δn>0.6)。該研究為光學(xué)薄膜體系中基底選擇提供了橢偏數(shù)據(jù)支撐,尤其在高精度減反膜設(shè)計(jì)場景中,單晶硅基底可優(yōu)化界面光學(xué)性能。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領(lǐng)域中單層或多層納米薄膜的層構(gòu)參數(shù)(如厚度)和物理參數(shù)(如折射率n、消光系數(shù)k)
- 先進(jìn)的旋轉(zhuǎn)補(bǔ)償器測量技術(shù):無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進(jìn)的光能量增強(qiáng)技術(shù),高信噪比的探測技術(shù)。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達(dá)0.05nm。
Flexfilm全光譜橢偏儀可以高精度橢偏測量不同基底上 TiO?與 SiO?薄膜的折射率n、消光系數(shù)k及其誤差。Flexfilm費(fèi)曼儀器致力于幫助客戶實(shí)現(xiàn)工藝優(yōu)化、性能提升及合規(guī)認(rèn)證,以創(chuàng)新技術(shù)賦能智能制造,助力全球薄膜材料領(lǐng)域的高質(zhì)量發(fā)展。
原文參考:《不同基底對 TiO2 和 SiO2 薄膜的光學(xué)性能的影響》
*特別聲明:本公眾號所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時(shí)間核實(shí)并處理。
-
測量
+關(guān)注
關(guān)注
10文章
5275瀏覽量
113619 -
儀器
+關(guān)注
關(guān)注
1文章
3955瀏覽量
51013
發(fā)布評論請先 登錄
光學(xué)薄膜的特性原理及分類
光學(xué)薄膜技術(shù)
什么是光學(xué)薄膜和PAL
九種光學(xué)薄膜的細(xì)分詳述

光學(xué)薄膜激光損傷機(jī)理的研究背景與意義
光學(xué)薄膜有哪些類型?光學(xué)薄膜在光學(xué)系統(tǒng)上的作用
基于超構(gòu)表面陣列的微型單次曝光光譜橢偏儀研究

全光譜橢偏儀測量:金屬/半導(dǎo)體TMDs薄膜光學(xué)常數(shù)與高折射率特性

大面積薄膜光學(xué)映射與成像技術(shù)綜述:全光譜橢偏技術(shù)

薄膜厚度測量技術(shù)的綜述:從光譜反射法(SR)到光譜橢偏儀(SE)

橢偏儀測量薄膜厚度的原理與應(yīng)用






 橢偏儀原理和應(yīng)用 | 精準(zhǔn)測量不同基底光學(xué)薄膜TiO?/SiO?的光學(xué)常數(shù)
橢偏儀原理和應(yīng)用 | 精準(zhǔn)測量不同基底光學(xué)薄膜TiO?/SiO?的光學(xué)常數(shù)













評論