透明薄膜在光學器件、微電子封裝及光電子領域中具有關鍵作用,其厚度均勻性直接影響產品性能。然而,工業級微米級薄膜的快速測量面臨挑戰:傳統干涉法設備龐大、成本高,分光光度法易受噪聲干擾且依賴校準樣品。本文本文基于FlexFilm單點膜厚儀的光學干涉技術框架,提出一種基于共焦光譜成像與薄膜干涉原理的微型化測量系統,結合相位功率譜(PPS)算法,實現了無需校準的高效厚度測量,為工業現場檢測提供了新方案。
1
測量系統設計
flexfilm

薄膜厚度測量原理示意圖本文設計的測量系統基于共聚焦光譜成像與薄膜干涉原理,其核心在于通過分析反射干涉光譜提取薄膜厚度信息。系統采用發光二極管(LED)、微型光譜儀以及自設計的共聚焦消色差探頭,實現測量系統的微型化。在該系統中,干涉信號的產生源于薄膜上下表面反射光的相干疊加,其光程差與薄膜厚度緊密相關。LED 光源發出的光經探頭聚焦到薄膜表面,反射光再通過光譜儀進行探測與分析。此設計不僅降低了系統成本,還提升了測量靈活性,使其更易集成于工業生產線上。
2
薄膜厚度計算算法
flexfilm
- 相位功率譜分析(PPS)
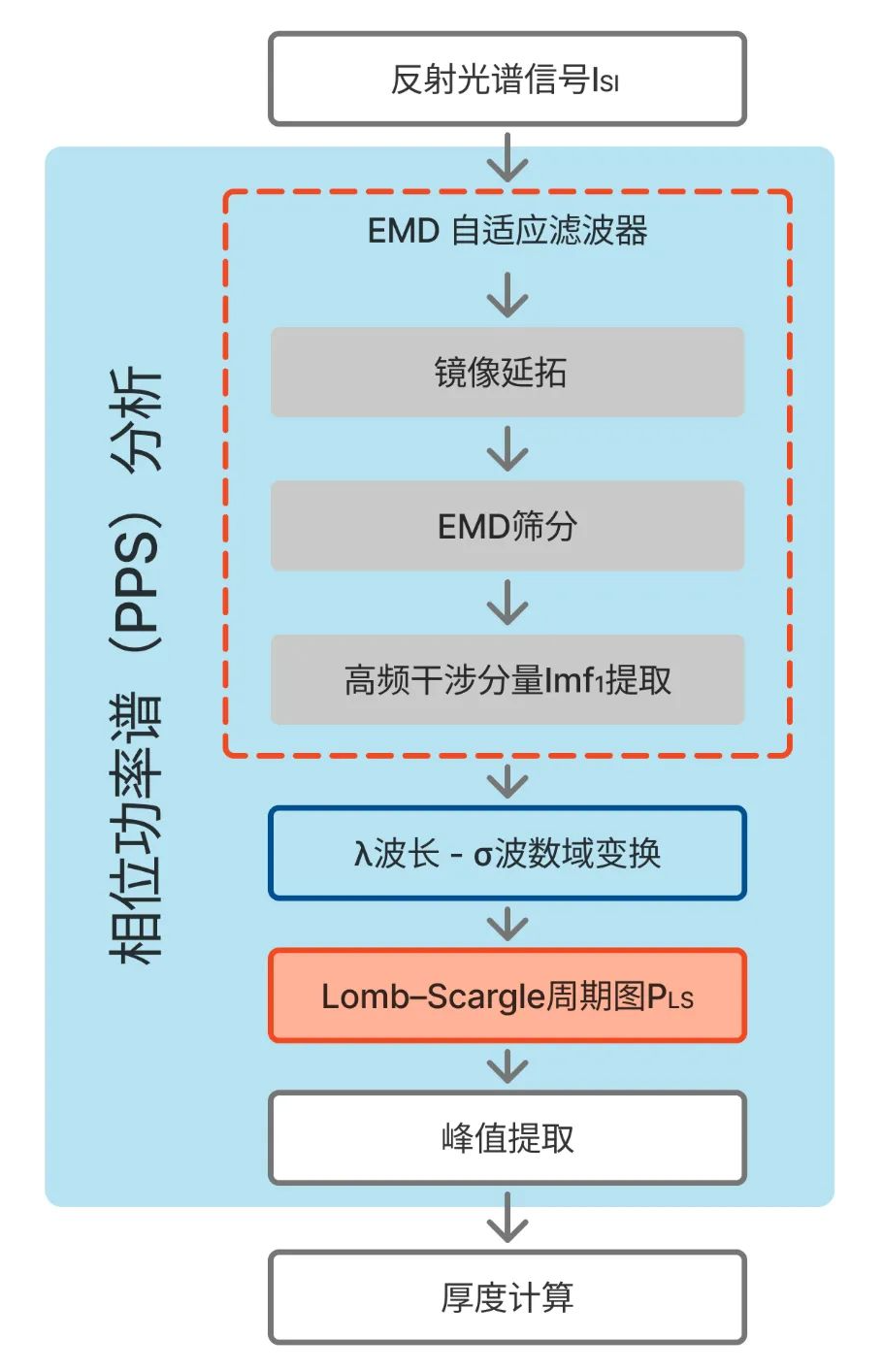
相位功率譜(PPS)算法流程圖
- EMD濾波:利用經驗模態分解自適應提取高頻干涉分量,消除LED光源非均勻性影響。
- 波數域轉換:將反射光譜從波長λλ轉換至波數σ,增強相位項敏感性。
- LSP分析:通過改進的Lomb-Scargle周期圖計算相位功率譜密度,抑制局部噪聲。
- 厚度解算:定位功率譜峰值z????,結合折射率n?計算厚度 d=z????/2n?。
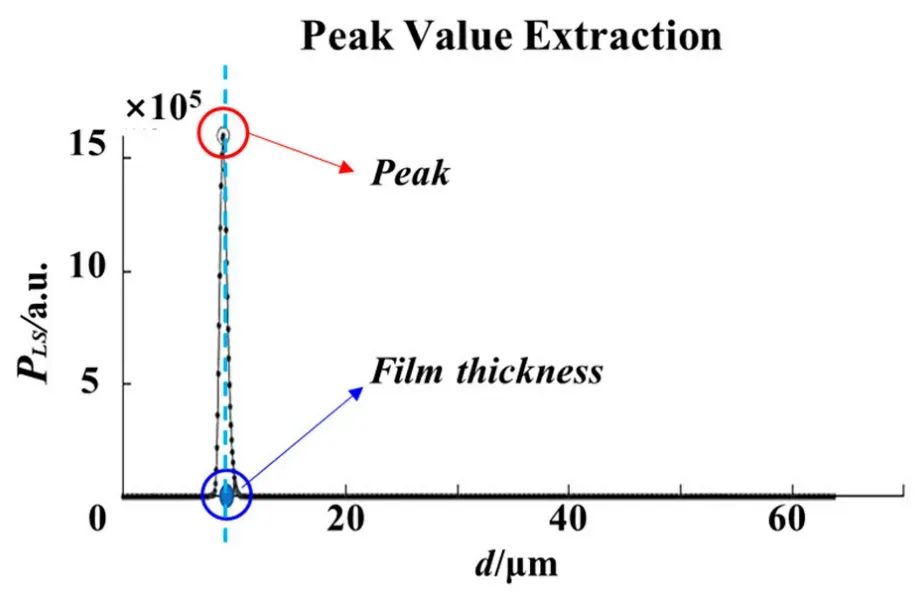
峰值提取和薄膜厚度計算
3
薄膜干涉模型驗證
flexfilm

9 μm 厚度薄膜干涉仿真圖(a)高斯光源下的反射光譜仿真圖;(b)反射光譜仿真與測量信號對比

薄膜厚度對計算誤差的影響
在高斯光源(中心波長660 nm,帶寬80 nm)下,對1–100 μm薄膜進行仿真。結果顯示,1–75 μm范圍內固有誤差≤±50 nm,超過75 μm后因光譜儀分辨率限制誤差增大。

干涉條紋對比度對計算厚度偏差的影響
信號對比度(K=0.1–1.0)變化對厚度計算偏差影響小于20 nm,證明算法對材料特性不敏感。 局部高斯噪聲對計算厚度偏差的影響
局部高斯噪聲對計算厚度偏差的影響
引入局部高斯噪聲后,LSP算法誤差(16 nm)僅為CIFFT算法(114 nm)的14%,抗噪魯棒性顯著。
4
薄膜厚度測量
flexfilm
- 標準薄膜樣品測量

標準薄膜的 CIFFT 和 LSP 算法結果對比(a)單點重復性測量;(b)4×4 網格點測量
使用厚度范圍 2 – 50 μm 的聚氯乙烯(PVC)標準薄膜樣品進行測量。單點重復性測量實驗表明,PPS 算法的標準差僅為 0.076 μm,遠優于立方樣條插值結合快速傅里葉變換(CIFFT)方法。區域測量穩定性驗證中,最大絕對誤差控制在0.9202 μm 以內,重復性不超過 2.5%,證明了系統在工業重復性要求下的可靠性。
- 鍺基 SiO?標準薄膜測量
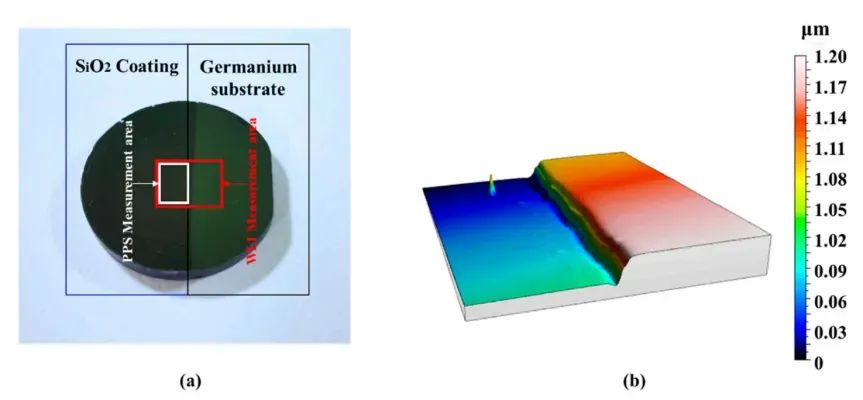
(a)鍺基底上具有 1 μm 臺階的 SiO? 薄膜(b)白光干涉儀測量的臺階三維形貌
針對鍺基底上1 μm 厚度的 SiO? 薄膜臺階結構進行測量,與白光干涉測量結果對比發現,PPS 方法的平均厚度測量值僅比白光干涉結果小約 50 nm,但測量速度更快,滿足快速測量需求。
- PCB 芯片薄膜厚度測量
對PCB 板上不同區域1 – 30 μm 厚度的透明薄膜進行測量,結果顯示測量值與工廠提供的參考值高度吻合,絕對厚度誤差均在100 nm 以內。這驗證了該測量系統在實際工業場景中對不同類型薄膜厚度測量的準確性和適用性。本文構建的微型化薄膜厚度測量系統實現了1–75 μm范圍、0.1 μm不確定度的高精度測量,單次測量僅需10 ms,且無需校準樣品,顯著提升工業檢測效率。EMD與LSP的協同作用有效抑制光源波動、噪聲及非均勻采樣的影響,為微米級薄膜測量提供了高效方案。
FlexFilm單點膜厚儀
flexfilm

FlexFilm單點膜厚儀是一款專為納米級薄膜測量設計的國產高精度設備,采用光學干涉技術實現無損檢測,測量精度達±0.1nm,1秒內即可完成測試,顯著提升產線效率。
高精度測量:光學干涉技術,精度±0.1nm,1秒完成測量,提升產線效率。
智能靈活適配:波長覆蓋380-3000nm,內置多算法,一鍵切換材料模型。
穩定耐用:光強均勻穩定(CV<1%)年均維護成本降低60%。
便攜易用:整機<3kg,軟件一鍵操作,無需專業培訓。
本文研究技術已應用于FlexFilm單點膜厚儀,未來通過高分辨率光譜儀(如0.1 nm級)可擴展至亞微米級測量,結合多波長融合算法動態補償折射率,進一步提升FlexFilm單點膜厚儀等在半導體、光學鍍膜領域的在線檢測精度。原文出處:《A Miniaturized and Fast System for Thin Film Thickness Measurement》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
pcb
+關注
關注
4369文章
23503瀏覽量
410053 -
半導體
+關注
關注
335文章
28952瀏覽量
238632 -
高精度測量
+關注
關注
0文章
12瀏覽量
4345
發布評論請先 登錄
一種基于梳狀濾波器的固體腔厚度測量方法
應用于光學測量的高性能薄膜厚度檢測設備

美能Poly在線膜厚測試儀?:光伏行業中的微納米薄膜光學測量創新

芯片制造中的膜厚檢測 | 多層膜厚及表面輪廓的高精度測量






 薄膜厚度高精度測量 | 光學干涉+PPS算法實現PCB/光學鍍膜/半導體膜厚高效測量
薄膜厚度高精度測量 | 光學干涉+PPS算法實現PCB/光學鍍膜/半導體膜厚高效測量















評論