隨著物聯網(IoT)和人工智能(AI)驅動的半導體器件微型化,對多層膜結構的三維無損檢測需求急劇增長。傳統橢偏儀僅支持逐點膜厚測量,而白光干涉法等技術難以分離透明薄膜的多層反射信號。本文提出一種單次曝光光譜分辨干涉測量法,通過偏振編碼與光譜分析結合,首次實現多層膜厚度與3D表面輪廓的同步實時測量。并使用Flexfilm探針式臺階儀對新方法的檢測精度進行驗證。
1
技術原理:單次曝光干涉測量系統
flexfilm
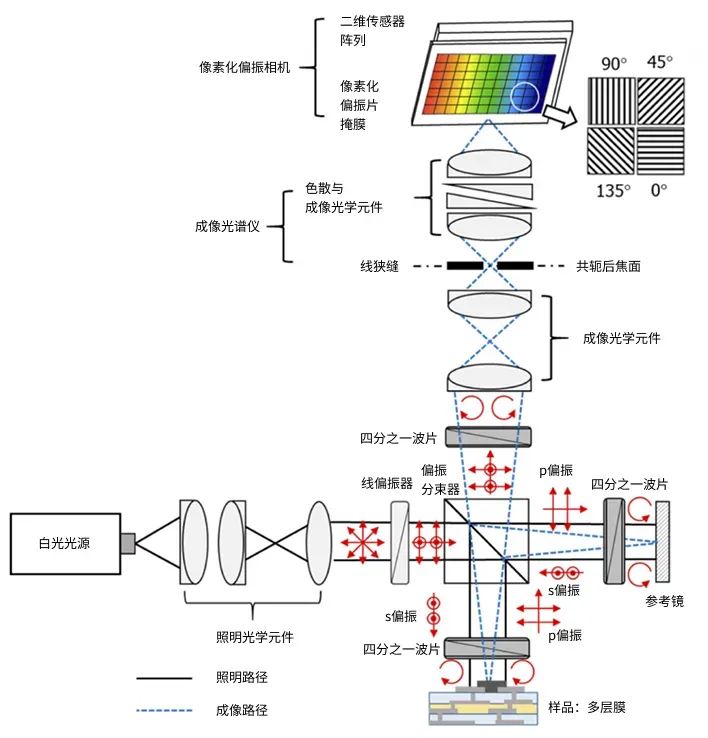
實時測量多層膜3D厚度輪廓的動態單次干涉測量系統原理圖
該技術的核心在于將像素化偏振相機(PPC)與成像光譜儀耦合,構建了能夠單次測量獲取寬光譜范圍內四組相移干涉圖的光學系統。光源采用400-800nm 的鎢鹵素燈,通過柯勒照明實現均勻照度,線性偏振器與消色差四分之一波片組合調控光束偏振狀態,使從樣本和參考鏡反射的正交圓偏振光在 PPC 的微偏振器陣列(0°、45°、90°、135°)上形成相移干涉圖案。
- 數據處理
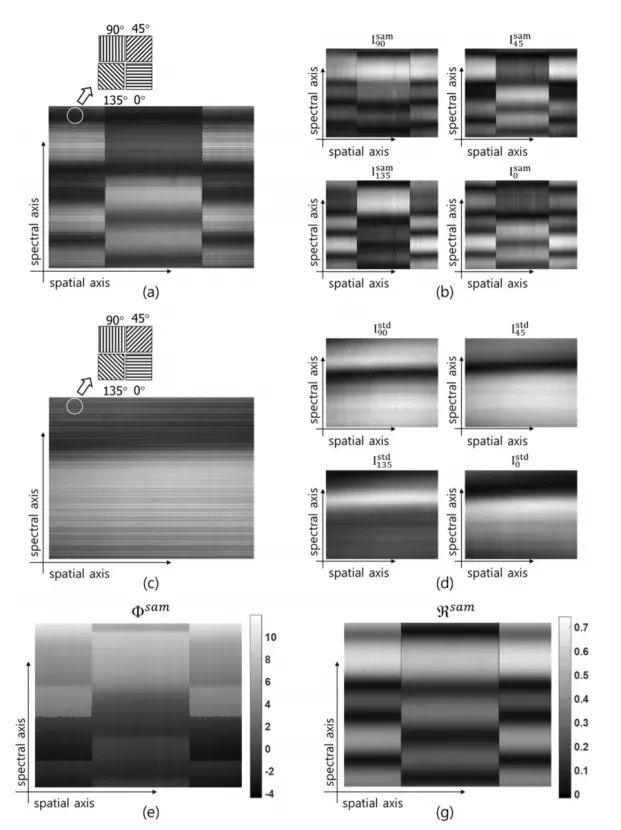
單次光譜分辨干涉測量原理
- 相位計算:通過以下公式從四個相移子圖中提取光譜相位,分離線性與非線性分量。非線性相位反映薄膜厚度變化,線性相位對應表面高度。

- 反射率校準:以裸硅片為標準參考,通過下面公式計算樣品的絕對反射率。

- 聯合反演:構建目標函數,結合非線性相位與反射率數據,優化各層厚度;

- 再通過下面公式擬合總相位,確定表面輪廓。

2
實驗驗證:五層膜3D計量
flexfilm
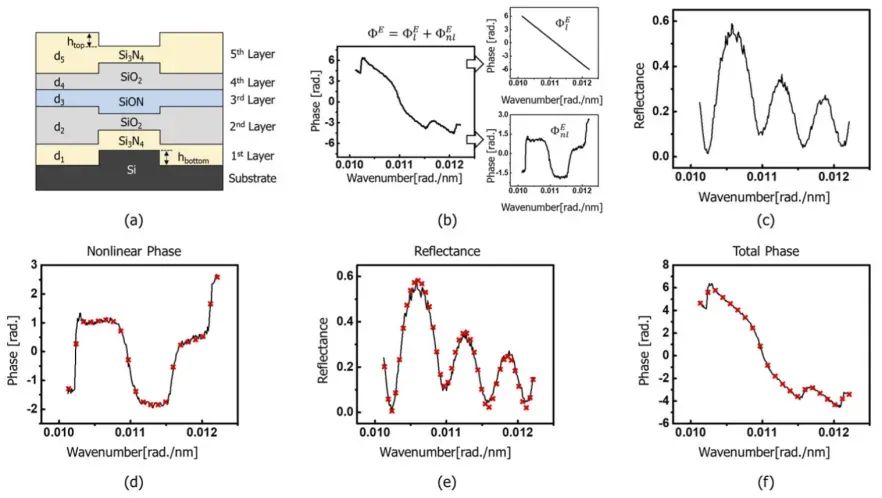 測量流程示例
測量流程示例
樣品與校準:五層薄膜(Si?N?-SiO?-SiON-SiO?-Si?N?)通過光刻工藝制備,每層沉積后均用橢偏儀和探針式臺階儀記錄厚度與表面數據。為了確保測量的準確性,實驗前使用HgAr燈校準光譜軸,并以裸硅片為參考進行反射率歸一化。
- 膜厚精度
五層膜膜厚測量結果對比(單位:nm) 與橢偏儀對比:10次測量標準差<1.6nm,最大偏差14nm(第4層SiO?)例如第5層Si?N?:橢偏儀1343.6nm vs 本文方法1344.7±0.8nm
與橢偏儀對比:10次測量標準差<1.6nm,最大偏差14nm(第4層SiO?)例如第5層Si?N?:橢偏儀1343.6nm vs 本文方法1344.7±0.8nm
- 表面輪廓精度
表面臺階高度測量對比(單位:nm)

五層膜3D厚度輪廓測量結果(a-e) 各層膜厚分布(第1-5層), (f) 頂層表面形貌, (g) 三維重構厚度輪廓, (h) A-A'線各層截面輪廓

A-A'線表面輪廓測量結果對比(a)硅基底 (b)第1層Si?N? (c)第2層SiO?(d)第3層SiON (e)第4層SiO? (f)第5層Si?N?
表面輪廓:重構的三維厚度分布與探針式臺階儀的對比顯示,最大偏差小于12 nm,表面臺階高度一致。本文提出了一種新型光譜分辨干涉技術,通過單次測量獲取光譜干涉條紋,并從中分析得到寬波長范圍的光譜相位和反射率變化,從而同步、無損地測量多層膜各層的膜厚和表面輪廓。該技術基于線掃描,通過橫向掃描和拼接即可實現3D厚度輪廓測量。使用標準樣品進行校準后,通過對五層膜樣本的測量,并與商用橢圓偏振儀和探針式臺階儀的獨立測量結果對比,驗證了該方法的可行性和準確性。這種單脈沖干涉法有望應用于半導體和顯示領域的在線檢測。
Flexfilm探針式臺階儀
flexfilm

在半導體、光伏、LED、MEMS器件、材料等領域,表面臺階高度、膜厚的準確測量具有十分重要的價值,尤其是臺階高度是一個重要的參數,對各種薄膜臺階參數的精確、快速測定和控制,是保證材料質量、提高生產效率的重要手段。
- 配備500W像素高分辨率彩色攝像機
- 亞埃級分辨率,臺階高度重復性1nm
- 360°旋轉θ平臺結合Z軸升降平臺
- 超微力恒力傳感器保證無接觸損傷精準測量
在本文研究中,Flexfilm探針式臺階儀作為表面輪廓測量的金標準,通過與新方法的測量結果對比(最大偏差<12nm),直接驗證了單次曝光干涉技術對多層膜三維表面輪廓的無損檢測精度。原文出處:《Single-shot spectrally resolved interferometry for the simultaneous measurement of the thickness and surface profile of multilayer films》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
半導體
+關注
關注
335文章
28963瀏覽量
238717 -
芯片制造
+關注
關注
11文章
690瀏覽量
29778 -
測量
+關注
關注
10文章
5275瀏覽量
113616
發布評論請先 登錄
怎么區分電阻是薄膜還是厚膜






 芯片制造中的膜厚檢測 | 多層膜厚及表面輪廓的高精度測量
芯片制造中的膜厚檢測 | 多層膜厚及表面輪廓的高精度測量

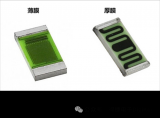

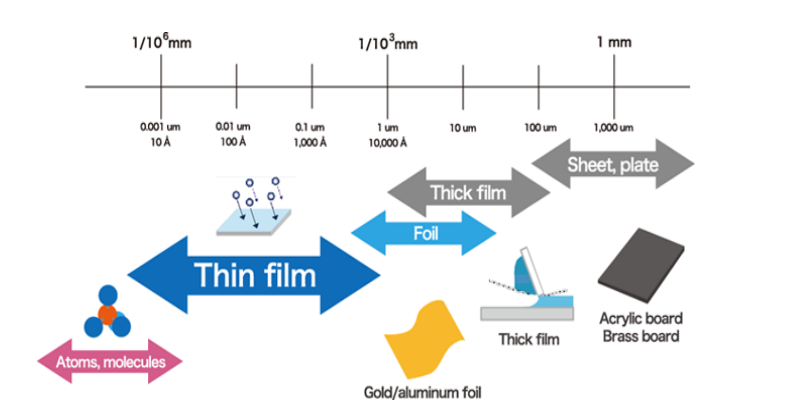












評論