在半導體制造中,薄膜的沉積和生長是關鍵步驟。薄膜的厚度需要精確控制,因為厚度偏差會導致不同的電氣特性。傳統的厚度測量依賴于模擬預測或后處理設備,無法實時監測沉積過程中的厚度變化,可能導致工藝偏差和良率下降。為此,研究團隊開發了一種基于激光反射率的光學傳感器,能夠在真空環境下實時測量氧化膜(SiO?)、氮化膜(Si?N?)和多晶硅(p-Si)的厚度。
FlexFilm單點膜厚儀可方便搭建各種光譜實驗平臺,實現對各種材料的光學特性、膜厚、材料的反射率、透過率等光譜特性的測試和分析實驗。
1
光學原理
flexfilm

激光在薄膜界面反射和折射的光路圖
入射光束(I)在薄膜上表面反射為(I?),另一部分折射后在下表面反射并再次折射為(I?)。
光程差公式:Δp = 2ndcosθ?(n為折射率,d為厚度,θ?為折射角)。
相位差(ΔΦ)導致干涉,影響反射光強度,從而關聯到薄膜厚度。
2
薄膜厚度測量裝置
flexfilm
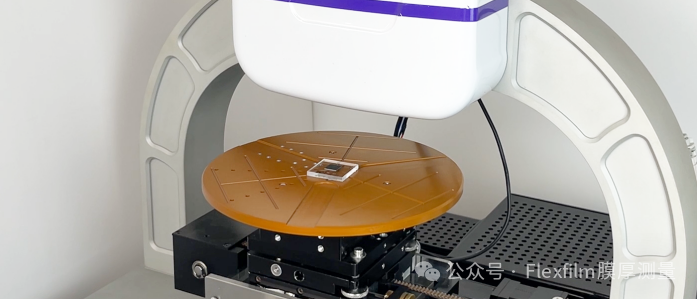

激光入射角設置為30°、45°、60°,反射光信號轉換為電壓值(參考入射光電壓8.14 V)。
測量原理:通過測量反射光的強度,并結合薄膜的光學性質,計算出薄膜的反射率,進而推導出薄膜的厚度。
測量目標:驗證基于光學反射率的薄膜厚度測量方法的可行性和準確性。
3
材料制備與表征
flexfilm

三種不同類型薄膜厚度的測量結果
氧化物薄膜的測量誤差在1.2%以內,顯示出較高的測量精度。
氮化物薄膜的測量誤差在1.6%到2.2%之間,整體誤差也較小。
多晶硅薄膜的測量誤差在-0.2%到3.6%之間,其中150 nm厚度的薄膜誤差最大,可能與其光學性質與硅片相似有關。

氧化物、氮化物、多晶硅和單晶硅的光學性質
氧化物和氮化物薄膜:折射率分別為1.47和2.02,消光系數均為0,表明這些薄膜是透明的,沒有吸收。
多晶硅薄膜:折射率為4.05,消光系數為0.05,表明多晶硅薄膜具有一定的吸收特性。
單晶硅薄膜:折射率為3.88,消光系數為0.019,表明單晶硅薄膜的吸收較小。
4
理論模型
flexfilm

多層薄膜結構中第N層薄膜的折射和反射過程
多層薄膜結構:展示了多層薄膜的折射和反射過程,特別關注第N層薄膜的行為。
光程差和相位差:通過計算光程差和相位差,可以推導出反射光的強度變化,進而用于薄膜厚度的測量。
反射率計算:反射率是反射光強度與入射光強度的比值,通過反射率的變化可以推導出薄膜的厚度。
5
入射角依賴性分析
flexfilm

不同角度下的反射率曲線
反射率的周期性變化:
氧化物和氮化物薄膜的反射率隨厚度變化呈現出明顯的周期性波動,這與薄膜的干涉效應有關。
多晶硅薄膜的反射率變化較為復雜,周期性不明顯,主要由于其吸收特性。
入射角度的影響:
在較小的入射角度(45°和60°)下,反射率的變化較為明顯,對薄膜厚度的變化更為敏感。
在較大的入射角度(80°、85°和89°)下,反射率的變化逐漸趨于平緩,但仍能觀察到厚度對反射率的影響。
薄膜類型的差異:
氧化物和氮化物薄膜的反射率變化較為相似,主要由于它們都是透明薄膜,消光系數為零。
多晶硅薄膜的反射率變化較為復雜,主要由于其吸收特性。
6
反射率與厚度關系
flexfilm
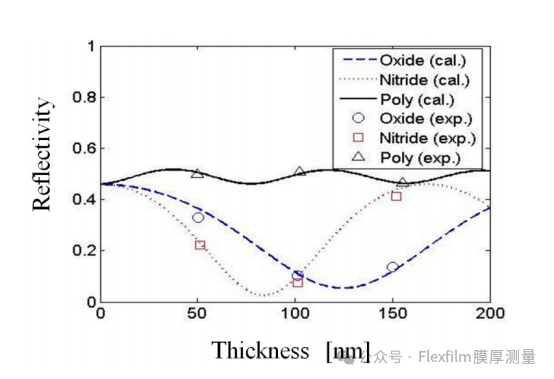
三種薄膜的實測與理論反射率對比
薄膜厚度測量:
通過分析反射率的變化,可以精確測量薄膜的厚度,特別是對于透明薄膜(如氧化物和氮化物)。
對于半透明薄膜(如多晶硅),雖然反射率變化復雜,但仍然可以通過選擇合適的波長和入射角度進行測量。
實驗裝置的設計提供了理論基礎,幫助優化半導體制造工藝中的薄膜沉積和生長過程,確保薄膜厚度在控制范圍內。
7
多角度測量驗證
flexfilm

氧化物、氮化物、多晶硅三種薄膜反射率隨厚度的變化

材料光學特性決定測量效果:
透明/半透明材料(氧化膜、氮化膜)因干涉效應顯著,反射率與厚度強相關。
不透明材料(多晶硅)因光吸收(k≠0)導致干涉失效,反射率無厚度信息。
入射角選擇策略:
高折射率材料(如氮化膜)適合低角度(30°),低折射率材料(如氧化膜)適合高角度(60°)。
8
對比度分析
flexfilm

氧化物、氮化物和多晶硅薄膜的對比度
通過對比度的分析,展示了不同薄膜類型在不同入射角度下的反射率變化的明顯程度。對比度越高,反射率的變化越明顯,薄膜厚度的測量越容易。從而優化測量方法,提高薄膜厚度測量的精度和可靠性。
一種基于光學反射率的薄膜厚度測量方法,能夠在半導體制造過程中實時監測薄膜的沉積和生長厚度。通過激光反射率測量技術,成功實現了氧化膜(SiO?)和氮化膜(Si?N?)薄膜厚度的實時、高精度監測,誤差可控制在10 nm以內,最小誤差低至0.68%。
該技術不僅為半導體行業提供了一種高效、低成本的厚度測量方案,也為光學薄膜表征領域的發展提供了新的思路,具有重要的工程應用價值和科學研究意義。
FlexFilm單點膜厚儀
flexfilm

FlexFilm單點膜厚儀是一款專為納米級薄膜測量設計的國產高精度設備,采用光學干涉技術實現無損檢測,測量精度達±0.1nm,1秒內即可完成測試,顯著提升產線效率。
1.高精度測量:光學干涉技術,精度±0.1nm,1秒完成測量,提升產線效率。
2.智能靈活適配:波長覆蓋380-3000nm,內置多算法,一鍵切換材料模型。
3.穩定耐用:光強均勻穩定(CV<1%)年均維護成本降低60%。
4.便攜易用:整機<3kg,軟件一鍵操作,無需專業培訓。
FlexFilm單點膜厚儀可基于光學反射率的薄膜厚度測量方法,在半導體制造過程中實時監測薄膜的沉積和生長厚度。搭建各種光譜實驗平臺,實現對各種材料的光學特性、膜厚、材料的反射率、透過率等光譜特性的測試和分析實驗。
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
傳感器
+關注
關注
2567文章
53053瀏覽量
767990 -
半導體
+關注
關注
335文章
28963瀏覽量
238692 -
測量
+關注
關注
10文章
5275瀏覽量
113613
發布評論請先 登錄
半導體薄膜厚度檢測設備設備出售
半導體晶圓形貌厚度測量設備
薄膜厚度高精度測量 | 光學干涉+PPS算法實現PCB/光學鍍膜/半導體膜厚高效測量






 半導體薄膜厚度測量丨基于光學反射率的厚度測量技術
半導體薄膜厚度測量丨基于光學反射率的厚度測量技術















評論