透明薄膜在生物醫學、半導體及光學器件等領域中具有重要應用,其厚度與光學特性直接影響器件性能。傳統接觸式測量方法(如觸針輪廓儀)易損傷樣品,而非接觸式光學方法中,像散光學輪廓儀(基于DVD激光頭設計)雖具備高分辨率全場掃描能力,但對厚度小于25 μm的薄膜存在信號耦合問題。本研究通過結合FlexFilm單點膜厚儀的光學干涉技術,開發了一種覆蓋15 nm至1.2 mm的全尺度薄膜表征系統,實現無損、高精度厚度測量與三維成像。
1
厚度計算方法
flexfilm
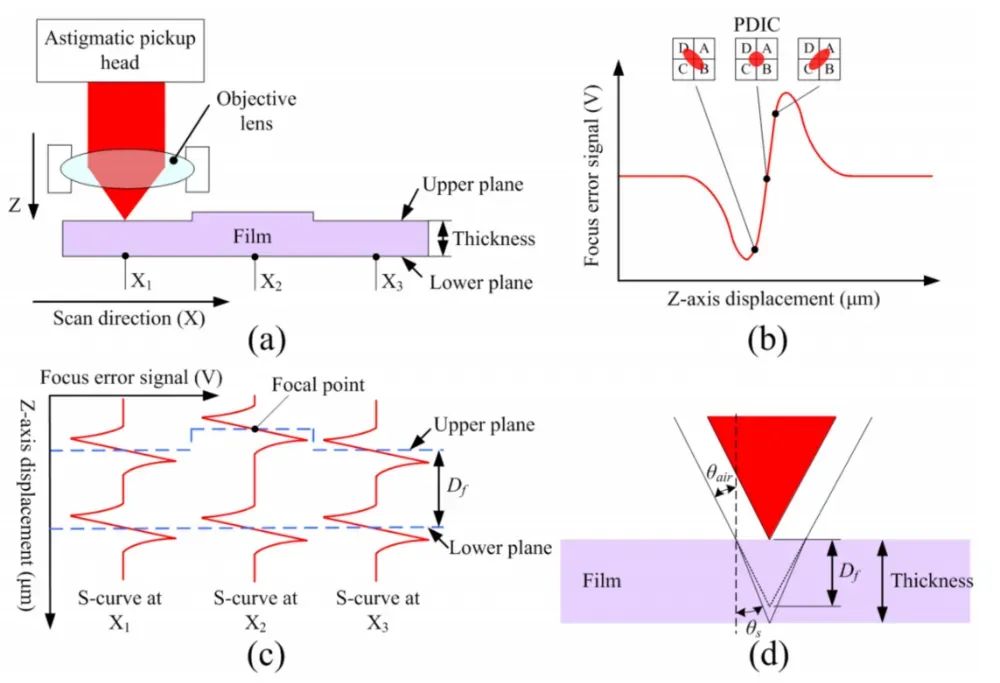
像散光學輪廓儀的厚度計算模型
激光通過像散拾音器聚焦于樣品表面,反射光由四象限光電探測器(PDIC)接收,通過聚焦誤差信號(FES)與 z 軸位移的非線性關系(S 曲線)定位上下表面焦點。厚度計算需考慮光的折射效應,公式為:

其中,θair= 36.87°為入射角(由物鏡數值孔徑 NA=0.6 計算得出),ns為樣品折射率。
2
S曲線解耦算法
flexfilm

存在耦合問題的FES-z軸位移曲線;(b) 由兩條S曲線合成的疊加曲線;(c) 平方誤差和與位移偏移量D?的關系
對于厚度 < 25 μm 的薄膜,上下表面反射光的 S 曲線會發生耦合,無法直接分離。本研究提出解耦方法:通過 Matlab 將原始 FES 數據擬合為 8 個正弦函數疊加的曲線Cf(i),并利用同材料厚膜的純凈 S 曲線合成疊加信號Cs(i)。通過計算不同位移偏移量Ds下的均方誤差(SSE),最小值對應的Ds即為真實厚度。對于解耦難度極高的薄膜,可引入單點膜厚儀的光譜數據優化擬合模型,例如通過其測量的折射率ns修正 S 曲線形狀,提升解耦精度。硬件系統設計:系統采用共振掃描器(頻率1.6 kHz,行程87 μm)提升成像速度,結合XYZ壓電平臺(行程100 μm)實現三維掃描。FPGA控制器與定制放大器確保信號實時處理。
3
單點厚度測量
flexfilm
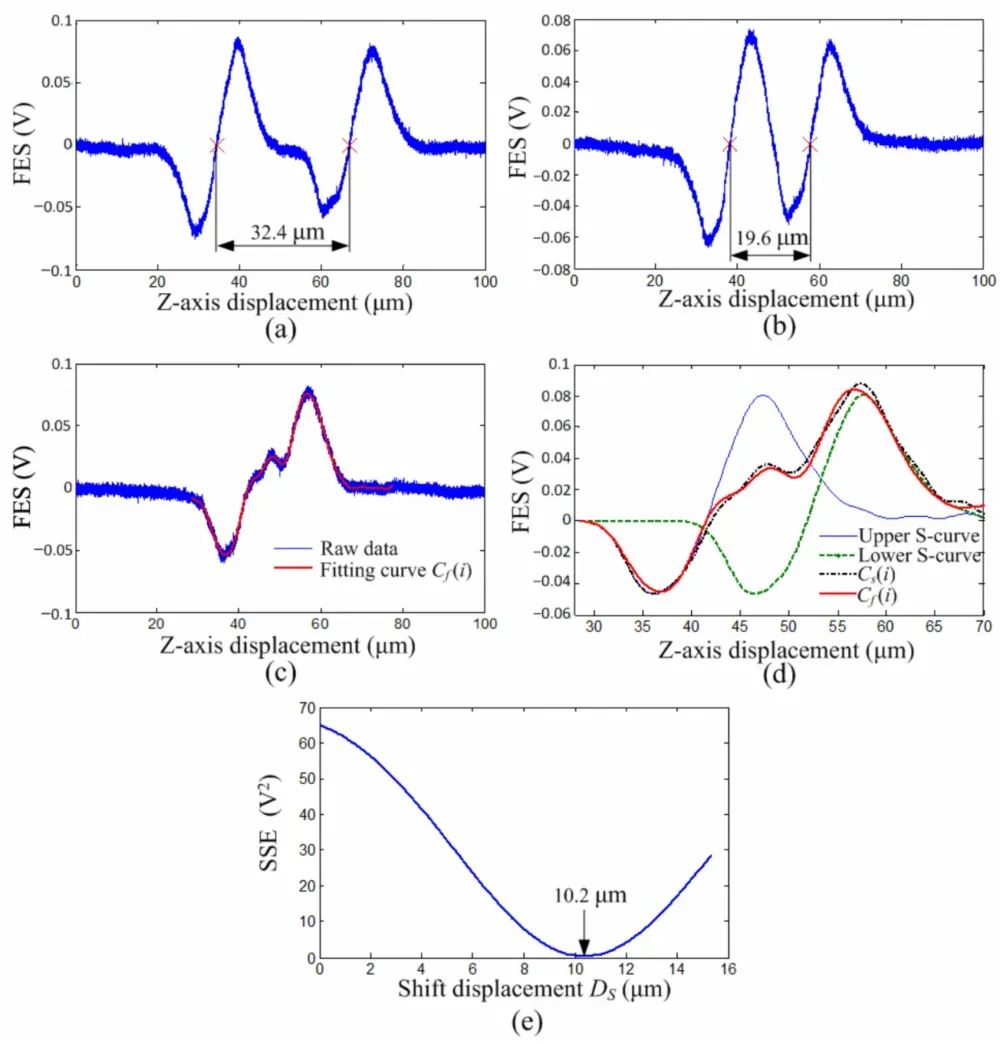
OPP薄膜(厚度55 μm、33 μm、18 μm)的FES-z軸位移曲線
- 像散光學輪廓儀結果:
對55 μm 和 33 μm的聚丙烯薄膜(OPP),直接通過 S 曲線線性擬合計算厚度分別為55.2 μm 和 33.4 μm,與共聚焦顯微鏡結果(53.2 μm 和 32.7 μm)吻合。對18 μmOPP 薄膜,通過解耦算法得到厚度17.4 μm,SSE 最小值對應Ds=10.2 μm。
- 單點膜厚儀交叉驗證:
利用單點膜厚儀對 18 μm OPP 薄膜進行反射光譜測量,通過 Tauc-Lorentz 模型反演厚度為 17.6±0.1 μm,與像散法結果誤差 < 1.2%。同時,單點膜厚儀測得 OPP 薄膜折射率ns=1.49±0.01,為像散法的折射角計算θs=23.75°提供精確參數,進一步降低厚度計算誤差。
4
3D 成像與光學特性分析
flexfilm
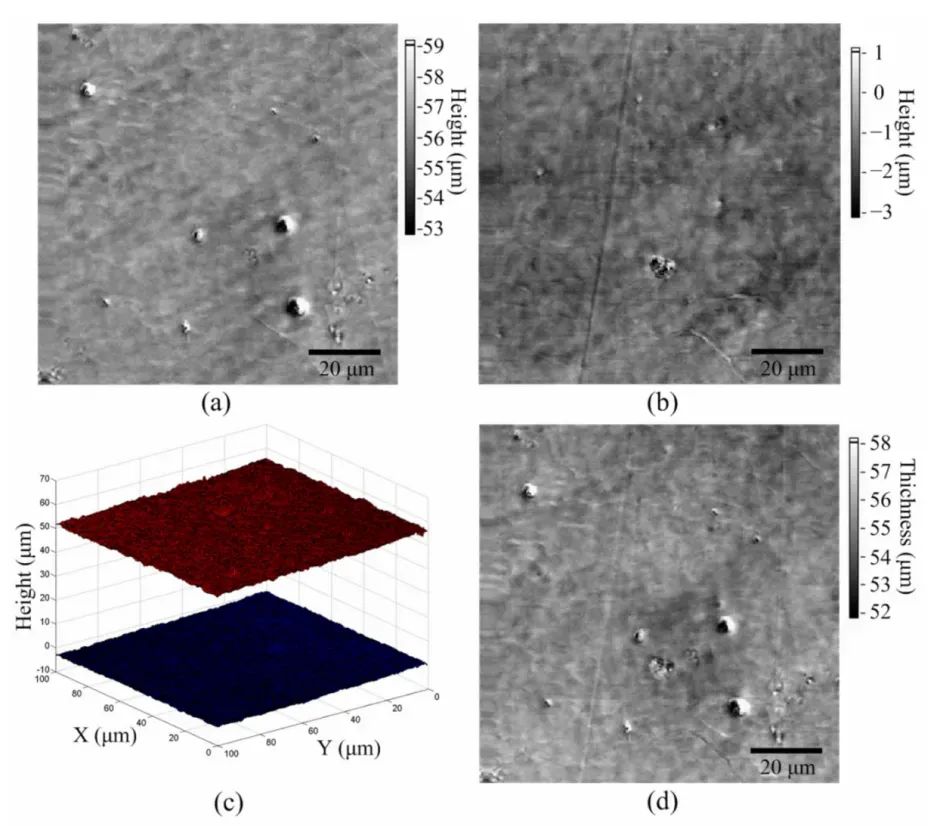
(a)上表面高度圖像;(b)下表面高度圖像;(c)上下表面三維圖像;(d)厚度分布圖像
像散光學輪廓儀對 55 μm OPP 薄膜進行 100 μm×100 μm 區域掃描,獲取上下表面 3D 圖像,顯示表面顆粒與劃痕缺陷,厚度均勻性為 55.2±0.6 μm。結合單點膜厚儀對缺陷區域的光譜分析,可同步獲取局部光學常數變化(如缺陷處折射率波動 < 0.03),揭示形貌與光學性能的關聯性。本研究開發的像散光學輪廓儀實現了 18–100 μm 透明薄膜的厚度測繪與 3D 成像,結合單點膜厚儀的光學干涉技術,進一步覆蓋了 15 nm–70 μm 的薄薄膜測量,形成全尺度表征能力。其中,像散法適用于微米級厚膜的全場掃描,單點膜厚儀則通過光譜分析為薄薄膜測量提供精準驗證與光學常數支持。
FlexFilm單點膜厚儀
flexfilm

FlexFilm單點膜厚儀是一款專為納米級薄膜測量設計的國產高精度設備,采用光學干涉技術實現無損檢測,測量精度達±0.1nm,1秒內即可完成測試,顯著提升產線效率。
- 高精度測量:光學干涉技術,精度±0.1nm,1秒完成測量,提升產線效率。
- 智能靈活適配:波長覆蓋380-3000nm,內置多算法,一鍵切換材料模型。
- 穩定耐用:光強均勻穩定(CV<1%)年均維護成本降低60%。
- 便攜易用:整機<3kg,軟件一鍵操作,無需專業培訓。
像散光學輪廓儀與FlexFilm單點膜厚儀的協同應用,為透明薄膜的非接觸式測量提供了互補方案,其結合光學反射的全場掃描能力與光學干涉的精準定量特性,對半導體、光學器件及生物醫學領域的薄膜研發與生產具有重要意義。
-
測量
+關注
關注
10文章
5275瀏覽量
113616 -
光學器件
+關注
關注
1文章
150瀏覽量
12221 -
表面輪廓儀
+關注
關注
0文章
70瀏覽量
748
發布評論請先 登錄
輪廓儀有幾種,光學輪廓儀、接觸式輪廓儀什么時候用

CP系列臺階儀測量ITO導電薄膜厚度
微觀特征輪廓尺寸測量:光學3D輪廓儀、共焦顯微鏡與臺階儀的應用
芯片制造中的膜厚檢測 | 多層膜厚及表面輪廓的高精度測量






 基于像散光學輪廓儀與單點膜厚技術測量透明薄膜厚度
基于像散光學輪廓儀與單點膜厚技術測量透明薄膜厚度














評論