在先進光學、微電子和材料科學等領域,透明薄膜作為關鍵工業組件,其亞微米級厚度的快速穩定測量至關重要。芯片制造中,薄膜襯底的厚度直接影響芯片的性能、可靠性及功能實現,而傳統紅外干涉測量方法受機械振動、環境光干擾及薄膜傾斜等因素限制,測量精度難以滿足高精度工業需求。為此,本研究提出一種融合紅外干涉與激光校準的薄膜厚度測量新方法,旨在突破傳統技術瓶頸,實現更精準、魯棒的厚度檢測。FlexFilm單點膜厚儀憑借其卓越的光學干涉技術,在薄膜厚度測量中展現出高精度、快速檢測的優勢,為本文研究提供了有力的數據支撐。
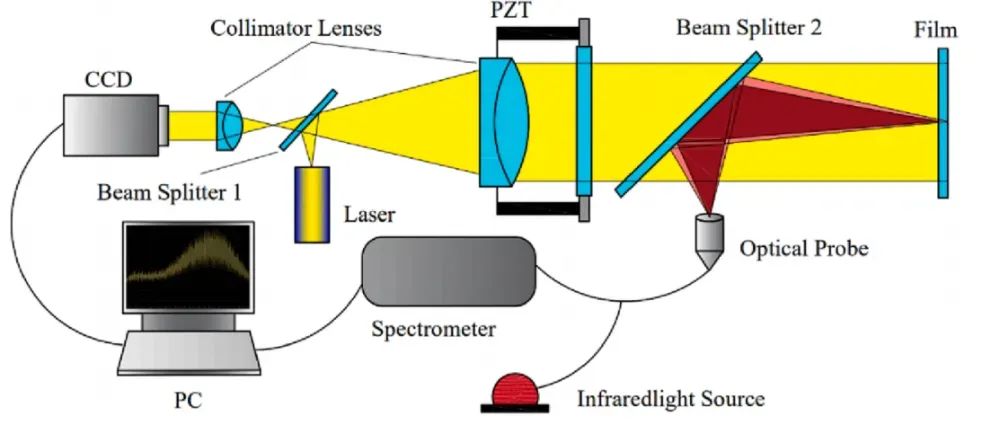
整體光路設計:包含紅外測厚系統(左)和激光校正系統(右)
1
傳統測量方法局限
flexfilm
薄膜基板(如藍寶石、硅片)是芯片制造的核心部件,其厚度均勻性直接影響器件性能。現有測量技術存在顯著局限:
- 掃描電鏡(SEM):精度達納米級,但破壞樣本且無法在線檢測;
- 橢偏儀:對厚膜(>500μm)測量失效,多層反射導致相變復雜化;
- 紅外干涉法:雖適于工業環境,但受限于兩大痛點:
- 環境噪聲(振動/雜散光)使原始頻譜最大頻率提取誤差達±1.5μm;
- 薄膜傾角僅1°即可引入0.3μm誤差(以500μm膜為例),難以滿足高精度產線需求。

紅外測厚原理
2
厚度測量原理
flexfilm

方案流程圖
- EMD-LSP算法(ELA)

ELA算法流程
基于光的干涉原理,紅外干涉測量通過分析薄膜上下表面反射光的干涉光譜計算厚度。理論模型中,干涉光強 I(λ) 與波長 λ 的關系可表示為: 其中,n 為薄膜折射率,d 為厚度。為解決傳統 FFT 算法在非平穩信號處理中的局限性,本研究提出EMD-LSP 算法(ELA),通過經驗模態分解(EMD)過濾原始光譜噪聲,再利用 Lomb-Scargle 周期圖提取最大頻率fj_peak,最終厚度公式為:
其中,n 為薄膜折射率,d 為厚度。為解決傳統 FFT 算法在非平穩信號處理中的局限性,本研究提出EMD-LSP 算法(ELA),通過經驗模態分解(EMD)過濾原始光譜噪聲,再利用 Lomb-Scargle 周期圖提取最大頻率fj_peak,最終厚度公式為: 該算法有效提升了頻率提取精度,為厚度計算奠定基礎。
該算法有效提升了頻率提取精度,為厚度計算奠定基礎。
- 激光干涉傾角校準系統

厚度校正方案
針對工業生產中薄膜放置傾斜問題,構建基于激光干涉的厚度校正系統。通過斐索干涉光路檢測薄膜前表面形狀,利用澤尼克多項式擬合波前相位,獲取 x 和 y 方向的傾斜分量 βx、βy,并通過幾何關系推導校正公式: 其中,dm為紅外干涉測量值,dr為校正后的實際厚度。該系統實現了對機械振動或操作誤差引起的傾斜誤差的自適應校正。
其中,dm為紅外干涉測量值,dr為校正后的實際厚度。該系統實現了對機械振動或操作誤差引起的傾斜誤差的自適應校正。
- 系統集成設計
雙光路架構:紅外測量光路:960–1080nm波段獲取厚度原始光譜;激光校準光路:632.8nm激光監測薄膜傾角;兩通路光譜分離避免干擾,計算機統一控制實現實時反饋。
3
工業級精度驗證
flexfilm
測量精度對比實驗
 藍寶石基底AFM圖像(a)二維;(b,c)三維使用 6 組不同厚度的藍寶石襯底(82.03μm 至 751.88μm)進行實驗,分別采用 FFT、LSP 和 ELA 算法處理原始光譜。
藍寶石基底AFM圖像(a)二維;(b,c)三維使用 6 組不同厚度的藍寶石襯底(82.03μm 至 751.88μm)進行實驗,分別采用 FFT、LSP 和 ELA 算法處理原始光譜。 不同厚度薄膜的測量結果
不同厚度薄膜的測量結果 測厚實驗數據分析:(a)平均誤差;(b)方差
測厚實驗數據分析:(a)平均誤差;(b)方差
結果表明,ELA 算法較 LSP 提升測量精度約87.92%,較 FFT 提升約95.6%;測量穩定性較 LSP 和 FFT 分別提升67.96%和93.86%。這得益于 EMD 對環境噪聲的有效過濾及 LSP 對非平穩信號的適應性。
- 傾角校正效果
 傾斜薄膜厚度校正結果
傾斜薄膜厚度校正結果
- 未校準時:傾角3°時751μm膜誤差達4.7μm;
- 校正后:誤差降至0.07μm(修正率97.87%),證實系統對≤3.75°傾角耐受性。
實驗數據證明,該方法在復雜工業環境中具有可靠的抗干擾能力。本研究提出的紅外干涉與激光校準融合方法,通過EMD-LSP 算法提升了光譜分析精度,結合激光干涉實現了傾斜誤差的自適應校正。實驗結果顯示,該方法較傳統技術測量精度提升約 90%,穩定性提升約 70%,且對傾斜薄膜的測量誤差校正效果顯著。其高精度、緊湊低成本的系統特性,滿足了工業生產中高效快速的測量需求。
FlexFilm單點膜厚儀
flexfilm
FlexFilm單點膜厚儀是一款專為納米級薄膜測量設計的國產高精度設備,采用光學干涉技術實現無損檢測,測量精度達±0.1nm,1秒內即可完成測試,顯著提升產線效率。
高精度測量:光學干涉技術,精度±0.1nm,1秒完成測量,提升產線效率。
智能靈活適配:波長覆蓋380-3000nm,內置多算法,一鍵切換材料模型。
穩定耐用:光強均勻穩定(CV<1%)年均維護成本降低60%。
便攜易用:整機<3kg,軟件一鍵操作,無需專業培訓。
本研究通過算法-光路協同創新借助FlexFilm 單點膜厚儀的先進技術,實現了工業薄膜厚度的“測量-校準”一體化。ELA算法解決了噪聲敏感痛點,激光干涉傾角校正攻克了機械振動下的精度退化難題,為國產芯片制造裝備的膜厚監測模塊提供了新范式。原文出處:《A method for measuring and calibrating the thickness of thin films based on infrared interference technology》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
芯片制造
+關注
關注
11文章
690瀏覽量
29778 -
測量
+關注
關注
10文章
5275瀏覽量
113616
發布評論請先 登錄
功率型LED熱阻測量的新方法
激光干涉儀檢測應用——重復定位精度測量
高精度非接觸測量轉速新方法研究
膜厚測試儀的使用方法 膜厚測試儀的校準步驟
芯片制造中的膜厚檢測 | 多層膜厚及表面輪廓的高精度測量






 芯片制造中高精度膜厚測量與校準:基于紅外干涉技術的新方法
芯片制造中高精度膜厚測量與校準:基于紅外干涉技術的新方法

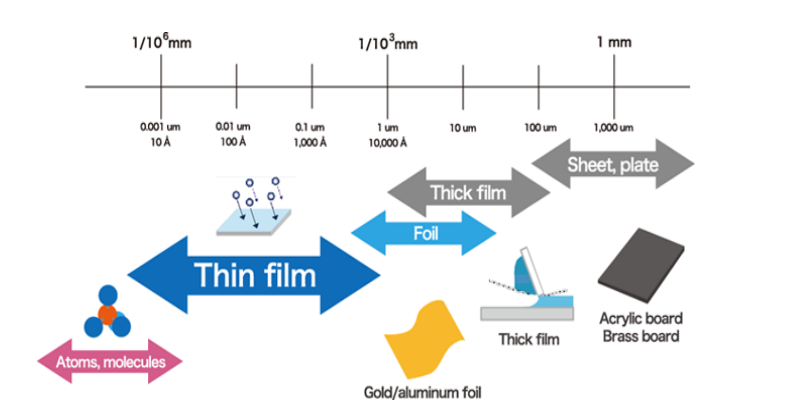
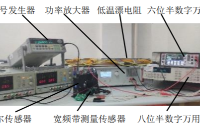
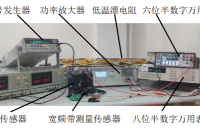












評論