薄膜結構在半導體制造中扮演著至關重要的角色,廣泛應用于微電子器件、光學涂層、傳感器等領域。隨著半導體技術的不斷進步,對薄膜結構的檢測精度和效率提出了更高的要求。傳統的檢測方法,如橢圓偏振法、反射法和白光掃描干涉法等,雖然在一定程度上能夠滿足測量需求,但存在一些局限性。針對這些現有技術的不足,本文提出了一種基于白光色散干涉法(WLDI)的高精度測量系統。該系統具有非接觸、高精度、抗振動等優勢,能夠同時測量薄膜的表面輪廓和膜厚,為半導體制造中的薄膜檢測提供了一種新的解決方案,FlexFilm自動膜厚儀基于白光色散干涉技術開發,可同時實現表面形貌與膜厚的納米級測量。
1
白光色散干涉法(WLDI)原理
flexfilm
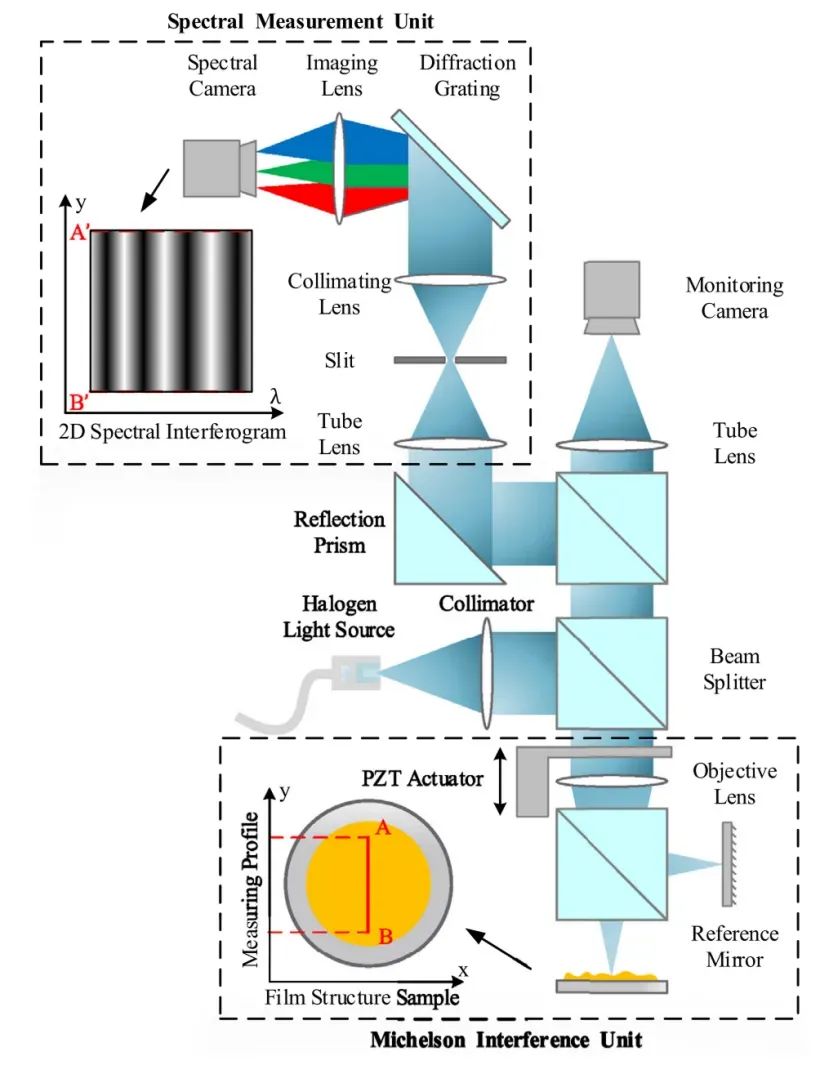
自主研發的白光色散干涉法示意圖
本文搭建的白光色散干涉法系統主要由以下幾部分組成:高功率鹵素燈作為光源,提供足夠的光譜帶寬;光學探頭用于生成樣品和參考鏡之間的干涉信號;光譜相機用于捕獲二維光譜干涉圖;以及逐行光譜校準方法用于提高測量精度。
- 測量原理
在測量過程中,樣品表面反射的光與參考鏡反射的光發生干涉,形成二維光譜干涉圖。每條線光譜信號包含了樣品表面高度和膜厚的信息。通過對光譜信號的處理,可以提取出總相位分布,進而分解為表面相位和膜厚相位。
- 膜厚計算
對于薄膜結構,總相位分布可以表示為表面相位和膜厚相位之和。膜厚相位與膜厚之間存在非線性關系,通過Levenberg-Marquardt非線性擬合方法,可以精確地計算出膜厚。具體計算過程如下:
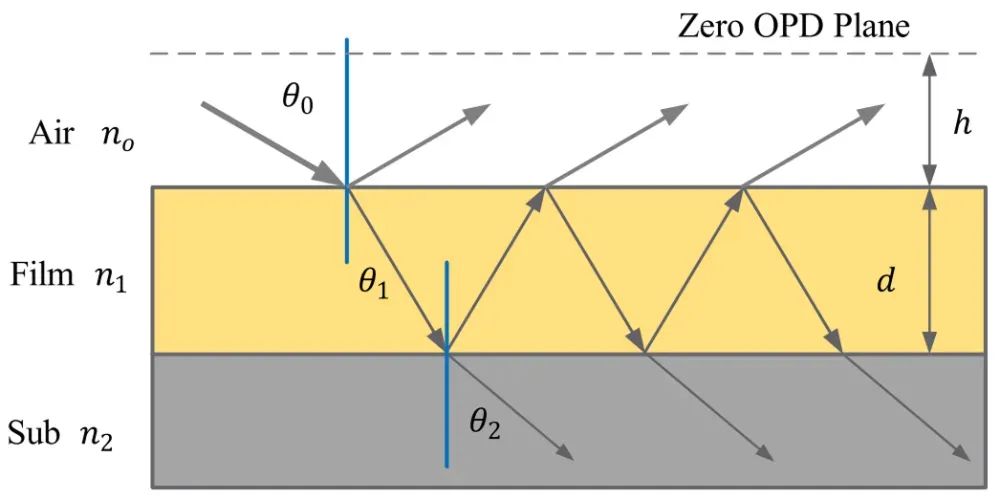
單層膜結構的多次反射模型
首先,建立薄膜的多次反射模型,計算理論非線性相位。然后,將測量得到的非線性相位與理論相位進行擬合,通過調整膜厚參數,使擬合殘差最小化,從而得到精確的膜厚值。
- 表面輪廓計算
表面輪廓的計算基于總相位分布中的表面相位部分。采用單波數法引入干涉級次,可以有效提高表面輪廓的測量精度。具體計算公式為: 其中,Φsur(h, k)為表面相位,FN(i)為干涉級次,k為波數。通過引入干涉級次,可以避免其他波數的噪聲干擾,從而提高測量精度。
其中,Φsur(h, k)為表面相位,FN(i)為干涉級次,k為波數。通過引入干涉級次,可以避免其他波數的噪聲干擾,從而提高測量精度。
- 逐行光譜校準
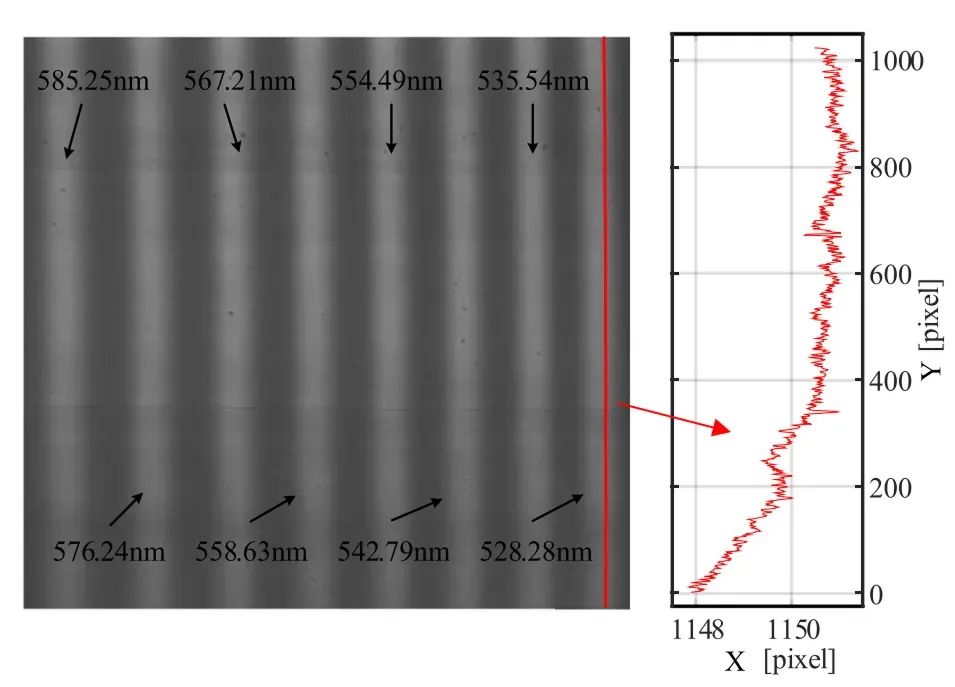
校準光源成像及中心波長528.28nm的質心像素位置
在實際測量中,由于光學系統和色散元件的影響,光譜干涉圖中會出現“微笑畸變”,導致波數校準不準確,進而影響測量結果。為了解決這一問題,本文提出了一種逐行光譜校準方法。通過確定每行的波數與像素位置之間的關系,可以有效校正“微笑畸變”,提高波數校準的精度,從而提高表面輪廓的測量精度。
2
表面輪廓測量
flexfilm
- 噪聲評估

(a,c)多次測量的相對高度 (b,d)斜率法(a,b)與單波數法(c,d)的分布
為了評估系統的測量噪聲,對平滑硅片進行了多次重復測量。結果表明,單波數法的測量噪聲顯著低于斜率法,95%的數據點的測量噪聲在0.3納米以內,表明系統的垂直分辨率達到了納米級。
- 臺階標準測量
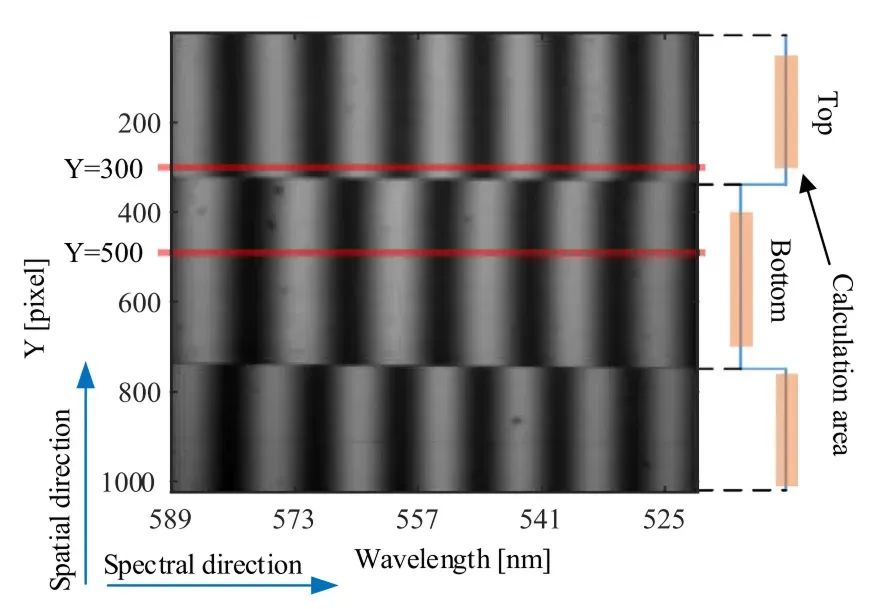 臺階標準的二維光譜干涉圖
臺階標準的二維光譜干涉圖

斜率法與改進精度的單波數法計算的臺階輪廓
使用臺階高度標準進行測量,驗證了系統的測量精度。臺階高度標準的認證高度為1.806±0.011微米。通過比較斜率法和單波數法的測量結果,單波數法的測量精度更高,標準偏差更小,能夠有效減少測量誤差。
3
膜厚測量
flexfilm

(a)薄膜標準的二維光譜干涉圖 (b)y=500像素處的線光譜信號
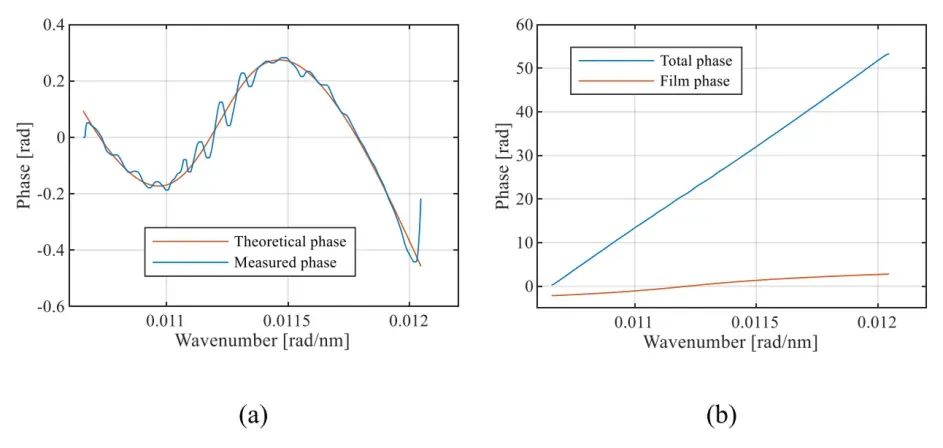
膜厚擬合結果:(a)理論相位與測量非線性相位的比較(b)確定膜厚后的總相位和膜相位

薄膜標準測量結果:(a)膜厚 (b)單波數法獲得的表面與基底界面輪廓
對經過NIST校準的VLSI膜標準進行測量,膜標準的認證厚度為1052.2±0.9納米。通過非線性相位擬合,精確計算出膜厚為1053.2納米,與認證值高度一致。同時,利用單波數法重建了膜標準的三維表面形貌,驗證了系統的高精度測量能力。本文提出的基于白光色散干涉法的測量系統,通過逐行光譜校準和單波數法,實現了薄膜表面輪廓和膜厚的高精度同時測量。實驗結果表明,系統具有納米級的垂直分辨率,單波數法和逐行校準在提高測量精度方面發揮了關鍵作用。
3
FlexFilm自動膜厚儀
flexfilm

對樣品進行無損、快速、高精度測量,可用于反射率、透射率、膜厚等參數測量。廣泛應用于光學鍍膜、半導體薄膜、液晶顯示、薄膜層和生物醫學等厚度的測量方案中。
FlexFilm自動膜厚儀作為白光色散干涉法技術的工程化產品,未來將通過多方法融合進一步拓展薄膜測量的厚度范圍與應用場景,滿足半導體制造中不斷升級的檢測需求。原文出處:《High-accuracy simultaneous measurement of surface profile and film thickness using line-field white-light dispersive interferometer》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
測量
+關注
關注
10文章
5275瀏覽量
113616 -
表面輪廓儀
+關注
關注
0文章
70瀏覽量
748
發布評論請先 登錄
白光干涉儀只能測同質材料嗎?
白光干涉儀在半導體封裝中對彈坑的測量
微觀特征輪廓尺寸測量:光學3D輪廓儀、共焦顯微鏡與臺階儀的應用
基于像散光學輪廓儀與單點膜厚技術測量透明薄膜厚度






 白光色散干涉:實現薄膜表面輪廓和膜厚的高精度測量
白光色散干涉:實現薄膜表面輪廓和膜厚的高精度測量



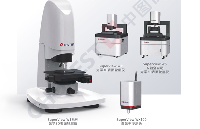












評論