發(fā)光二極體(LED)封裝廠在生態(tài)系統(tǒng)將日趨邊緣化。上游LED晶粒廠為降低制造成本與微型化晶片尺寸,競相展開晶粒尺寸封裝(Chip Scale Package, CSP)技術(shù)布局,且該技術(shù)省略封裝制程,遂讓磊晶廠未來營運模式將跳過封裝廠,直接與下游燈具系統(tǒng)商合作,導致封裝廠在供應鏈的重要性大幅下降。
2014-05-06 09:03:50 1776
1776 LED封裝技術(shù)出現(xiàn)新面孔。一般半導體廠商已經(jīng)相當熟悉的芯片級封裝(Chip Scale Package, CSP),正逐漸滲透到LED領域,如手機閃光燈與液晶電視背光用的LED皆已開始導入此一技術(shù)。
2017-03-27 09:32:36 2770
2770 
SiP的關注點在于:系統(tǒng)在封裝內(nèi)的實現(xiàn),所以系統(tǒng)是其重點關注的對象,和SiP系統(tǒng)級封裝對應的為單芯片封裝;先進封裝的關注點在于:封裝技術(shù)和工藝的先進性,所以先進性的是其重點關注的對象,和先進封裝對應的是傳統(tǒng)封裝。
2021-03-15 10:31:53 8490
8490 
1. BGA和CSP封裝技術(shù)詳解 2.?干貨分享丨BGA開路金相切片分析 (BGA Open Cross-Section) ? ? ? 審核編輯:彭靜
2022-07-26 14:43:18 5181
5181 先進封裝是“超越摩爾”(More than Moore)時代的一大技術(shù)亮點。當芯片在每個工藝節(jié)點上的微縮越來越困難、也越來越昂貴之際,工程師們將多個芯片放入先進的封裝中,就不必再費力縮小芯片了。本文將對先進封裝技術(shù)中最常見的10個術(shù)語進行簡單介紹。
2023-07-12 10:48:03 625
625 
? 半導體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標一代比一代先進。總體說來
2023-08-28 09:37:11 1072
1072 
的發(fā)展潮流,是極具市場競爭力的高密度封裝形式。本文從CSP的特點、類別和制作上藝以及生產(chǎn)和研發(fā)等幾個方面詳細論述這種先進的封裝技術(shù),并提出幾點建議。
2023-09-06 11:14:55 566
566 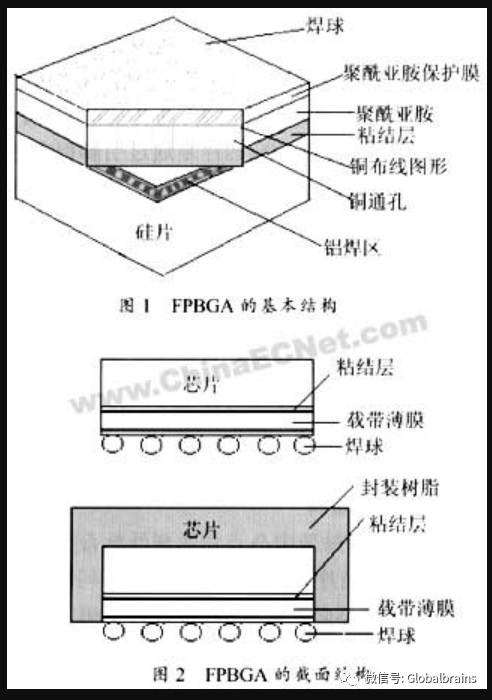
隨著晶圓級封裝技術(shù)的不斷提升,眾多芯片設計及封測公司開始思考并嘗試采用晶圓級封裝技術(shù)替代傳統(tǒng)封裝。其中HRP(Heat?Re-distribution?Packaging)晶圓級先進封裝
2023-11-30 09:23:24 1124
1124 
半導體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標一代比一代先進。總體說來,半導體
2024-01-16 09:54:34 606
606 
請問大家,0.4pitch的CSP封裝是怎么布線的,間距太小了
2016-06-29 21:36:01
FCCSP - a flip chip solution in a CSP package format. - Amkor Technology
2022-11-04 17:22:44
csp模式不知道是哪里出現(xiàn)了問題?csp模式為什么不能讓電機轉(zhuǎn)起來?
2021-09-24 06:24:56
摘 要:先進封裝技術(shù)不斷發(fā)展變化以適應各種半導體新工藝和材料的要求和挑戰(zhàn)。在半導體封裝外部形式變遷的基礎上,著重闡述了半導體后端工序的關鍵一封裝內(nèi)部連接方式的發(fā)展趨勢。分析了半導體前端制造工藝的發(fā)展
2018-11-23 17:03:35
、無阻抗IC白/藍膜片、長期高價求購封裝測試廠淘汰的廢舊QFN、PLCC、BGA、CSP、WL-CSP等各種封裝后的IC芯片、Blue tape、chip、wafer.藍膜片、白膜片、IC硅片、IC晶
2020-12-29 08:27:02
淺析STM32之printf重定向
2021-12-02 06:19:33
初學者,請老師們幫忙解疑!PBGA,CSP,SOP分別是什么意思.
2013-01-17 16:52:09
本帖最后由 gk320830 于 2015-3-7 12:48 編輯
SMT最新技術(shù)之CSP及無鉛技術(shù)只要關注一下如今在各地舉辦的形形色色的專業(yè)會議的主題,我們就不難了解電子產(chǎn)品中采用
2013-10-22 11:43:49
的熱門先進技術(shù)。 比如說,如何處理在CSP和0201組裝中常見的超小開孔(250um)問題,就是焊膏印刷以前從未有過的基本物理問題。板級光電子組裝,作為通信和網(wǎng)絡技術(shù)中發(fā)展起來的一大領域,其工藝非常精細
2018-09-10 15:46:13
小,擊穿電壓穩(wěn)定,良率高,鉗位 電壓一般,電容有低容,普容和高容,6寸可以做回掃型ESD產(chǎn)品;第三代TVS主要以8寸晶圓流片為主,以CSP晶圓級封裝為主(DFN),這種產(chǎn)品是高性能的ESD,采用8寸的先進
2020-07-30 14:40:36
由于先進IC上板技術(shù)已從BGA、QFN、QFP等慢慢演進成WLCSP、CSP、SoC、SiP等高階制程,造成可靠度驗證有許多的改變,為了更能符合先進IC封裝技術(shù)之可靠度驗證,iST宜特科技上板可靠度
2018-12-27 11:28:34
`什么? 你對CSP的了解還不夠?趕快來圍觀吧! 首先,得知道什么叫CSPCSP(Chip Scale Package),又稱為芯片級封裝器件, 其技術(shù)性主要體現(xiàn)為讓芯片面積與封裝面積之比超過1
2017-02-24 16:36:32
無線手持設備、掌上電腦以及其他移動電子設備的增加導致了消費者對各種小外形、特征豐富產(chǎn)品的需要。為了滿足越來越小的器件同時具有更多功能的市場趨勢和移動設計要求,業(yè)界開發(fā)了芯片級封裝(CSP)形式的特定
2018-11-23 16:58:54
怎么選擇晶圓級CSP裝配工藝的錫膏?
2021-04-25 08:48:29
。如比較小的阻抗值、較強的抗干擾能力、較小的信號失真等等。芯片的封裝技術(shù)經(jīng)歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM。技術(shù)指標和電器性能一代比一代先進。
2011-10-28 10:51:06
1 前言 電路產(chǎn)業(yè)已成為國民經(jīng)濟發(fā)展的關鍵,而集成電路設計、制造和封裝測試是集成電路產(chǎn)業(yè)發(fā)展的三大產(chǎn)業(yè)之柱。這已是各級領導和業(yè)界的共識。微電子封裝不但直接影響著集成電路本身的電性能、機械性能
2018-09-12 15:15:28
基于NXP的77G毫米波雷達之先進輔助駕駛系統(tǒng)有哪些核心技術(shù)優(yōu)勢?怎樣去設計一種基于NXP的77G毫米波雷達之先進輔助駕駛系統(tǒng)的電路?
2021-07-30 07:19:43
而造成電氣性能下降。另一方面,封裝后的芯片也更便于安裝和運輸。由于封裝技術(shù)的好壞還直接影響到芯片自身性能的發(fā)揮和與之連接的PCB(印制電路板)的設計和制造,因此它是至關重要的。 衡量一個芯片封裝
2009-09-21 18:02:14
,20世紀最后二十年,隨著微電子、光電子工業(yè)的巨變,為封裝技術(shù)的發(fā)展創(chuàng)造了許多機遇和挑戰(zhàn),各種先進的封裝技術(shù)不斷涌現(xiàn),如BGA、CSP、FCIP、WLP、MCM、SIP等,市場份額不斷增加,2000年已達
2018-08-23 12:47:17
1 前言
電路產(chǎn)業(yè)已成為國民經(jīng)濟發(fā)展的關鍵,而集成電路設計、制造和封裝測試是集成電路產(chǎn)業(yè)發(fā)展的三大產(chǎn)業(yè)之柱。這已是各級領導和業(yè)界的共識。微電子封裝不但直接影響著集成電路本身的電性能、機械性能、光
2023-12-11 01:02:56
芯片封裝測試流程詳解ppt?按封裝外型可分為:SOT 、QFN 、SOIC、TSSOP、QFP、BGA、CSP等;? 決定封裝形式的兩個關鍵因素:?封裝效率。芯片面積/封裝面積,盡量接近1:1
2012-01-13 11:46:32
請問ADN4670BCPZ焊接溫度曲線有么?以及這種CSP封裝的焊接需要注意的事項有哪些?
2019-01-18 16:44:20
先進性主要對機器主要參數(shù)進行比較和對未來器件的應對能力。機器參數(shù)不僅參看供應商提供的數(shù)據(jù),例如,能否貼裝0402(公制)元件,Pitch 0.3 mm間距的CSP和QFP元件,或QFP元件引腳
2018-09-06 11:04:52
由于疊層CSP封裝的復雜性,其振動特性很難用精確的理論模型表示。同時,由于傳統(tǒng)的共振準則沒有考慮到系統(tǒng)的變異性和模糊性,導致分析結(jié)果與真值具有較大偏差。該文利用
2009-02-27 15:37:11 9
9 基于進程代數(shù)的CSP 方法是一種重要的形式化協(xié)議分析驗證方法。本文首先簡單介紹了CSP 相關理論,并以NSPK 協(xié)議為例系統(tǒng)概述了安全協(xié)議的CSP 建模方法。為更好的查明協(xié)議的安全缺
2009-08-06 11:22:16 12
12 論文綜述了自 1990 年以來迅速發(fā)展的先進封裝技術(shù),包括球柵陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝(WLP)、三維封裝(3D)和系統(tǒng)封裝(SiP)等項新技術(shù);同時,敘述了我國封
2009-12-14 11:14:49 28
28 半導體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標一代比一代先進。總體
2010-11-14 21:35:09 54
54 可以解決眾多封裝難題的CSP-ASIP
無線手持設備、掌上電腦以及其他移動電子設備的增加導致了消費者對各種小外形、特征豐富產(chǎn)品的需要。為了滿足越來越小的器件同時具有
2009-03-28 17:02:02 927
927 摘要:本文詳細討論了Maxim的晶片級封裝(WL-CSP),其中包括:晶圓架構(gòu)、卷帶包裝、PCB布局、安裝及回流焊等問題。本文還按照IPC和JEDEC標準提供了可靠性測試數(shù)據(jù)。 注
2009-04-21 11:30:27 8552
8552 
SMT最新技術(shù)之CSP及無鉛技術(shù)
CSP、0201無源元件、無鉛焊接和光電子,可以說是近來許多公司在PCB上實踐和積極*價的熱門先進技術(shù)。
2009-11-16 16:41:10 1405
1405 晶圓級CSP的返修工藝
經(jīng)底部填充的CSP裝配,其穩(wěn)健的機械連接強度得到很大的提升。在二級裝配中,由于底部填充,其抵御 由于
2009-11-20 15:42:17 483
483 CSP封裝內(nèi)存
CSP(Chip Scale Package),是芯片級封裝的意思。CSP封裝最新一代的內(nèi)存芯片封裝技術(shù),其技術(shù)性能又有了新的提升。CSP封裝可以讓芯片面積與封裝面積之比超
2009-12-25 14:24:49 636
636 什么是CSP封裝
近幾年的硬件發(fā)展是日新月異,處理器已經(jīng)進入G赫茲時代,封裝形式也是經(jīng)歷了數(shù)種變化。不過,光有一顆速急力猛的芯還遠遠不夠
2010-03-04 11:43:25 14777
14777 SIP(封裝系統(tǒng)),SIP(封裝系統(tǒng))是什么意思封裝概述 半導體器件有許多封裝型式,從DIP、SOP、QPF、PGA、BGA到CSP再到SIP,技術(shù)指標一代比一代先進,這些都是前
2010-03-26 17:04:25 19237
19237 CSP封裝芯片的量產(chǎn)測試采用類似晶圓測試的方法進行,但是兩者的區(qū)別在于:晶圓的測試,探針是扎在管芯的PAD(通常情況下為鋁金屬)上,而CSP封裝的測試座,探針是扎到CSP封裝的錫
2012-05-02 10:00:40 1546
1546 芯片級封裝介紹本應用筆記提供指引使用與PCB安裝設備相關的芯片級封裝。包括系統(tǒng)的PCB布局信息制造業(yè)工程師和制造工藝工藝工程師。 包概述 倒裝芯片CSP的包概述半導體封裝提供的芯片級封裝代表最小
2017-03-31 10:57:32 45
45 超級CSP——讓倒裝芯片獲得最大可靠性一種晶圓片級封裝
2017-09-14 11:31:37 22
22 CSP封裝的芯片測試,由于其封裝較小,采用普通的機械手測試無法實現(xiàn),目前主要采用類似晶圓測試的方法,在芯片完成置球封裝后,先不做劃片,而直接用探針卡進行測試,測試完成后,再實行劃片、分選和包裝。
2017-10-27 15:11:10 7297
7297 CSP(chip scale package)封裝是指一種封裝自身的體積大小不超過芯片自身大小的20%的封裝技術(shù)(下一代技術(shù)為襯底級別封裝,其封裝大小與芯片相同)。為了達成這一目的,LED制造商
2018-06-07 15:40:00 945
945 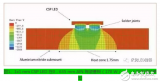
近幾年大陸背光產(chǎn)品價格持續(xù)下滑,億光等LED廠商在背光市場出貨比重仍不低,為避開陸廠價格競爭,今年億光將以mini LED、CSP封裝產(chǎn)品搶攻高端背光應用。
2018-04-27 11:20:00 2560
2560 目前CSP LED的主流結(jié)構(gòu)可分為有基板和無基板,也可分為五面發(fā)光與單面發(fā)光。所說的基板自然可以視為一種支架。很顯然,為了滿足CSP對封裝尺寸的要求,傳統(tǒng)的支架,如2835,的確不能使用,但并不
2018-07-12 14:34:00 10628
10628 CSP(chip scale package)封裝是指一種封裝自身的體積大小不超過芯片自身大小的20%的封裝技術(shù)(下一代技術(shù)為襯底級別封裝,其封裝大小與芯片相同)。為了達成這一目的,制造商盡可能
2018-08-10 15:43:52 14433
14433 CSP(chip scale package)封裝是指一種封裝自身的體積大小不超過芯片自身大小的20%的封裝技(下一代技術(shù)為襯底級別封裝,其封裝大小與芯片相同)。
2018-09-05 08:36:00 13375
13375 CSP封裝是最新一代的內(nèi)存芯片封裝技術(shù),其技術(shù)性能又有了新的提升。CSP封裝可以讓芯片面積與封裝面積之比超過1:1.14,已經(jīng)相當接近1:1的理想情況,絕對尺寸也僅有32平方毫米,約為普通的BGA的1/3,僅僅相當于TSOP內(nèi)存芯片面積的1/6。與BGA封裝相比,同等空間下CSP封裝可以將存儲容量提高三倍。
2019-06-24 14:12:36 19779
19779 CSP、0201無源元件、無鉛焊接和光電子,可以說是近來許多公司在PCB上實踐和積極*價的熱門先進技術(shù)。
2019-09-11 17:54:20 781
781 今日,長電科技中國區(qū)研發(fā)中心副總經(jīng)理李宗懌在中國集成電路設計業(yè)2020年會--封裝與測試分論壇上發(fā)表了主題為《先進封裝的協(xié)同設計與集成開發(fā)》的演講。
2020-12-11 15:24:38 3063
3063 臺積電和三星于先進封裝的戰(zhàn)火再起。2020年,三星推出3D封裝技術(shù)品牌X-Cube,宣稱在7納米芯片可直接堆上SRAM內(nèi)存,企圖在先進封裝拉近與臺積電的距離。幾天之后,臺積電總裁魏哲家現(xiàn)身,宣布推出自有先進封裝品牌3D Fabric,臺積電最新的SoIC(系統(tǒng)集成芯片)備受矚目。
2021-01-04 10:37:09 1269
1269 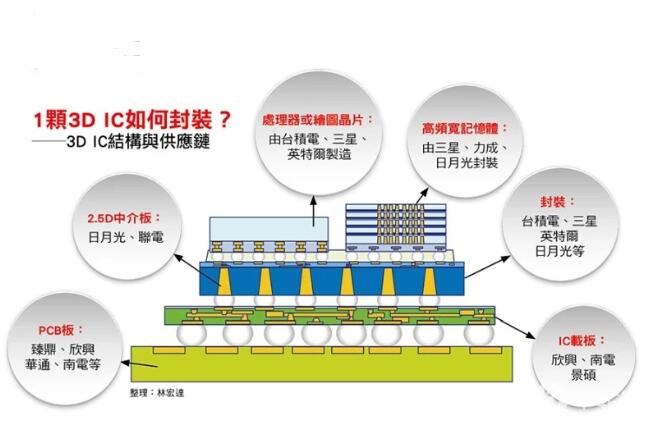
先進封裝大部分是利用「晶圓廠」的技術(shù),直接在晶圓上進行,由于這種技術(shù)更適合晶圓廠來做,因此臺積電大部分的先進封裝都是自己做的。
2021-02-22 11:45:21 2200
2200 
一項技術(shù)能從相對狹窄的專業(yè)領域變得廣為人知,有歷史的原因,也離不開著名公司的推波助瀾,把SiP帶給大眾的是蘋果(Apple),而先進封裝能引起公眾廣泛關注則是因為臺積電(TSMC)。 蘋果
2021-04-01 16:07:24 32556
32556 
電子發(fā)燒友網(wǎng)為你提供TE(ti)CAT-CSP-5T相關產(chǎn)品參數(shù)、數(shù)據(jù)手冊,更有CAT-CSP-5T的引腳圖、接線圖、封裝手冊、中文資料、英文資料,CAT-CSP-5T真值表,CAT-CSP-5T管腳等資料,希望可以幫助到廣大的電子工程師們。
2021-07-08 21:00:04
隨著集成電路的廣泛應用,集成度越來越高,在BGA技術(shù)開始推廣的同時,另外一種從BGA發(fā)展來的CSP封裝技術(shù)正在逐漸展現(xiàn)它的生力軍本色。作為新一代的芯片封裝技術(shù),CSP封裝可以讓芯片面積與封裝面積之比
2021-12-03 13:58:36 2405
2405 先進封裝形式μBGA、CSP的回流焊接技術(shù)介紹說明。
2022-05-06 15:17:46 4
4 倒裝芯片 CSP 封裝
2022-11-14 21:07:58 19
19 近年來,先進封裝技術(shù)的內(nèi)驅(qū)力已從高端智能手機領域演變?yōu)楦咝阅苡嬎愫腿斯ぶ悄艿阮I域,涉及高性能處理器、存儲器、人工智能訓練和推理等。當前集成電路的發(fā)展受“四堵墻”(“存儲墻”“面積墻”“功耗
2022-12-28 14:16:29 3295
3295 SiP是一個非常寬泛的概念,廣義上看,它囊括了幾乎所有多芯片封裝技術(shù),但就最先進SiP封裝技術(shù)而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及異構(gòu)Chiplet封裝技術(shù)。
2023-03-20 09:51:54 1037
1037 
芯片升級的兩個永恒主題:性能、體積/面積。芯片技術(shù)的發(fā)展,推動著芯片朝著高性能和輕薄化兩個方向提升。而先進制程和先進封裝的進步,均能夠使得芯片向著高性能和輕薄化前進。面對美國的技術(shù)封裝,華為
2023-04-15 09:48:56 1953
1953 就收入而言,倒裝芯片BGA、倒裝芯片CSP和2.5D/3D是主要的封裝平臺,其中2.5D/3D技術(shù)的增長率最高。2.5D/3D 市場預計將從 2022 年的 92 億美元增長到 2028 年的 258 億美元,實現(xiàn) 19% 的復合年增長率。
2023-04-24 10:09:52 770
770 
SiP系統(tǒng)級封裝(System in Package),先進封裝HDAP(High Density Advanced Package),兩者都是當今芯片封裝技術(shù)的熱點,受到整個半導體產(chǎn)業(yè)鏈的高度關注
2023-05-19 09:54:26 1326
1326 
CSP(Chip Scale Package)封裝芯片是一種高密度、小尺寸的封裝形式,它在集成電路行業(yè)中具有廣泛的應用。對于CSP封裝芯片的測試方法而言,主要涉及到以下幾個方面:
2023-06-03 10:58:16 1142
1142 先進封裝是對應于先進圓晶制程而衍生出來的概念,一般指將不同系統(tǒng)集成到同一封裝內(nèi)以實現(xiàn)更高效系統(tǒng)效率的封裝技術(shù)。
2023-06-13 11:33:24 282
282 
一、核心結(jié)論 ?1、先進制程受限,先進封裝/Chiplet提升算力,必有取舍。在技術(shù)可獲得的前提下,提升芯片性能,先進制程升級是首選,先進封裝則錦上添花。 2、大功耗、高算力的場景,先進封裝
2023-06-13 11:38:05 747
747 
今天我們來介紹PLCSP(Panel Level Chip Scale Packaging)。同理,PLCSP是一種將面板級封裝(PLP)和芯片尺寸封裝(CSP)合為一體的封裝技術(shù)。芯片尺寸封裝(CSP)是指整個package的面積相比于silicon總面積不超過120%的封裝技術(shù)。
2023-06-19 11:31:46 867
867 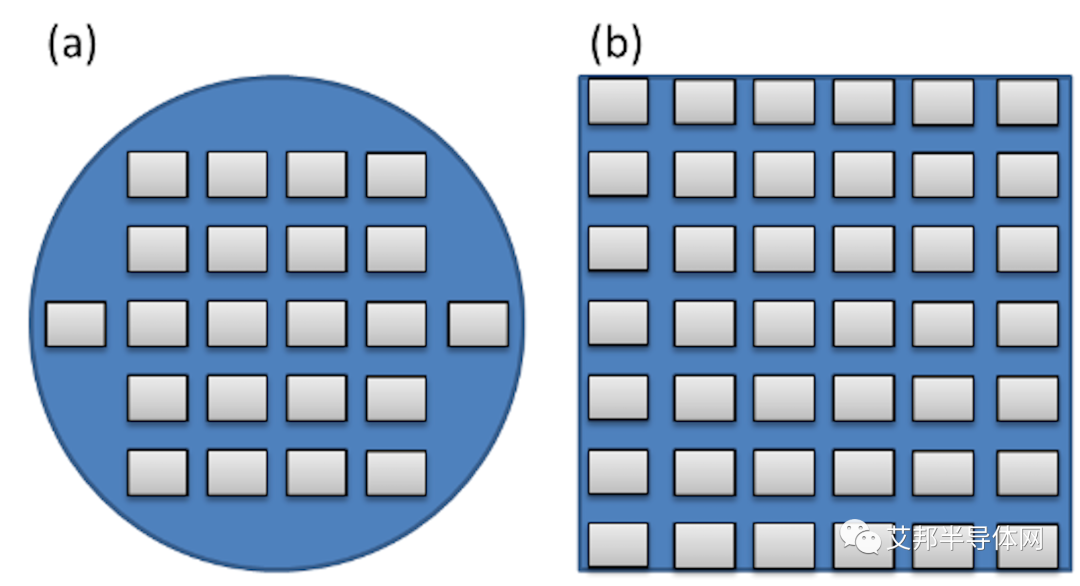
緊密相連。在業(yè)界,先進封裝技術(shù)與傳統(tǒng)封裝技術(shù)以是否焊線來區(qū)分。先進封裝技術(shù)包括FCBGA、FCQFN、2.5D/3D、WLCSP、Fan-Out等非焊線形式。先進
2022-04-08 16:31:15 641
641 
光電傳感器WL-CSP封裝芯片底部填充膠應用由漢思新材料提供光電傳感器芯片(CCD)經(jīng)過聯(lián)系客戶工程技術(shù)和研究其提供的封裝工藝流程。了解到以下信息。客戶用膠項目是:光電傳感器芯片(CCD
2023-05-18 05:00:00 546
546 
電子封裝是現(xiàn)代電子產(chǎn)品中不可或缺的一部分,它將電子元件組裝在一起,形成了一個完整的電子系統(tǒng)。其中,BGA和CSP是兩種常見的電子封裝技術(shù),它們各有優(yōu)缺點,廣泛應用于半導體制造、LCD顯示器等領域
2023-06-14 09:11:18 850
850 
在異質(zhì)異構(gòu)的世界里,chiplet是“生產(chǎn)關系”,是決定如何拆分及組合芯粒的方式與規(guī)則;先進封裝技術(shù)是“生產(chǎn)力”,通過堆疊、拼接等方法實現(xiàn)不同芯粒的互連。先進封裝技術(shù)已成為實現(xiàn)異質(zhì)異構(gòu)的重要前提。
2023-06-26 17:14:57 601
601 1. 先進制程受限,先進封裝/Chiplet提升算力,必有取舍。
2023-07-07 09:42:04 1693
1693 
Chiplet技術(shù)是一種利用先進封裝方法將不同工藝/功能的芯片進行異質(zhì)集成的技術(shù)。這種技術(shù)設計的核心思想是先分后合,即先將單芯片中的功能塊拆分出來,再通過先進封裝模塊將其集成為大的單芯片。
2023-07-17 09:21:50 2309
2309 
半導體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標一代比一代先進。
2023-08-11 09:43:43 1796
1796 
半導體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標一代比一代先進。
2023-08-14 09:59:17 1086
1086 
短1/5~1/6左右,同時CSP的抗噪能力強,開關噪聲只有DIP(雙列直插式封裝)的1/2。這些主要電學性能指標已經(jīng)接近裸芯片的水平,在時鐘頻率己超過雙G的高速通信領域,LSI芯片的CSP將是十分理想的選擇。
2023-08-20 09:42:07 1110
1110 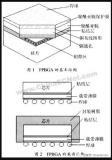
CSP是近幾年才出現(xiàn)的一種集成電路的封裝形式,目前已有上百種CSP產(chǎn)品,并且還在不斷出現(xiàn)一些新的品種。盡管如此,CSP技術(shù)還是處于發(fā)展的初期階段,因此還沒有形成統(tǒng)一的標準。不同的廠家生產(chǎn)不同的CSP
2023-09-08 14:09:40 294
294 BGA和CSP封裝技術(shù)詳解
2023-09-20 09:20:14 951
951 
先進封裝增速高于整體封裝,將成為全球封裝市場主要增量。根據(jù)Yole的數(shù)據(jù),全球封裝市場規(guī)模穩(wěn)步增長,2021 年全球封裝 市場規(guī)模 約達 777 億美元。其中,先進封裝全球市場規(guī)模約 350 億美元,占比約 45%, 2025 年,先進封裝在全部封裝市場的 占比將增長至 49.4%。
2023-09-22 10:43:18 1189
1189 
先進封裝技術(shù)以SiP、WLP、2.5D/3D為三大發(fā)展重點。先進封裝核心技術(shù)包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術(shù)的組合各廠商發(fā)展出了滿足多樣化需求的封裝解決方案,SiP系統(tǒng)級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發(fā)展重點。
2023-09-28 15:29:37 1614
1614 
簡要解讀BGA、CSP封裝中的球窩缺陷
2023-10-08 08:47:53 339
339 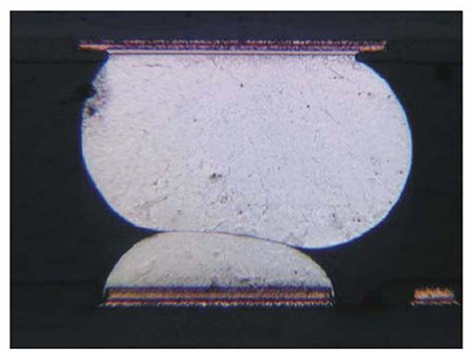
CSP的高效優(yōu)點體現(xiàn)在:用于板級組裝時,能夠跨出細間距(細至0.075mm)周邊封裝的界限,進入較大間距(1,0.8,0.75,0.5,0.4mm)區(qū)域陣列結(jié)構(gòu)。 已有許多CSP器件在消費類電信領域
2023-10-17 14:58:21 321
321 半導體產(chǎn)品在由二維向三維發(fā)展,從技術(shù)發(fā)展方向半導體產(chǎn)品出現(xiàn)了系統(tǒng)級封裝(SiP)等新的封裝方式,從技術(shù)實現(xiàn)方法出現(xiàn)了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術(shù)。
2023-10-31 09:16:29 836
836 
電子發(fā)燒友網(wǎng)站提供《太陽能電池晶體硅光伏組件封裝淺析(工藝控制篇).doc》資料免費下載
2023-11-03 10:21:41 1
1 先進封裝基本術(shù)語
2023-11-24 14:53:10 362
362 
為了實現(xiàn)集成電路芯片的電通路,一般需要將芯片裝配到在塑料或陶瓷載體上,這一過程可以稱為CSP。CSP的尺寸只是略大于芯片,通常封裝尺寸不大于芯片面積的1.5倍或不大于芯片寬度或長度的?1.2
2023-12-22 09:08:31 535
535 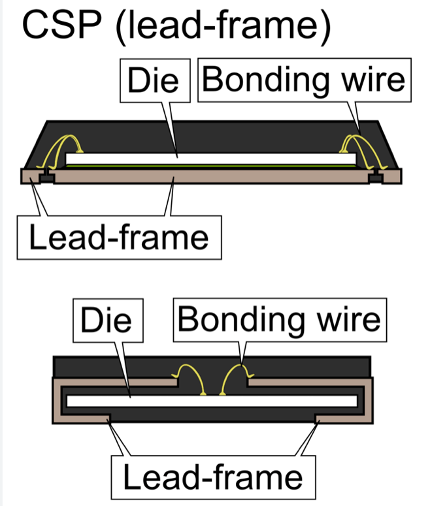
電子發(fā)燒友網(wǎng)站提供《BV0264AA 264-FCCSP包裝外形圖包裝代碼.pdf》資料免費下載
2024-01-31 10:02:56 0
0 不斷增加封裝中的輸入/輸出(I/O)數(shù)量,封裝解決方案正從傳統(tǒng)的線鍵封裝向倒裝芯片互連遷移,以滿足這些要求。對于具有多種功能和異構(gòu)移動應用的復雜和高度集成的系統(tǒng)而言,倒裝芯片封裝(FCCSP)被認為一種有效的解決方案。
2024-03-04 10:06:21 176
176 
立錡推出的低壓輸入、CSP 小封裝降壓轉(zhuǎn)換器系列,不僅滿足各式小型穿戴式和 IoT 物聯(lián)網(wǎng)應用的需求,更在性能和尺寸上取得了絕佳平衡。
2024-03-14 15:03:10 192
192
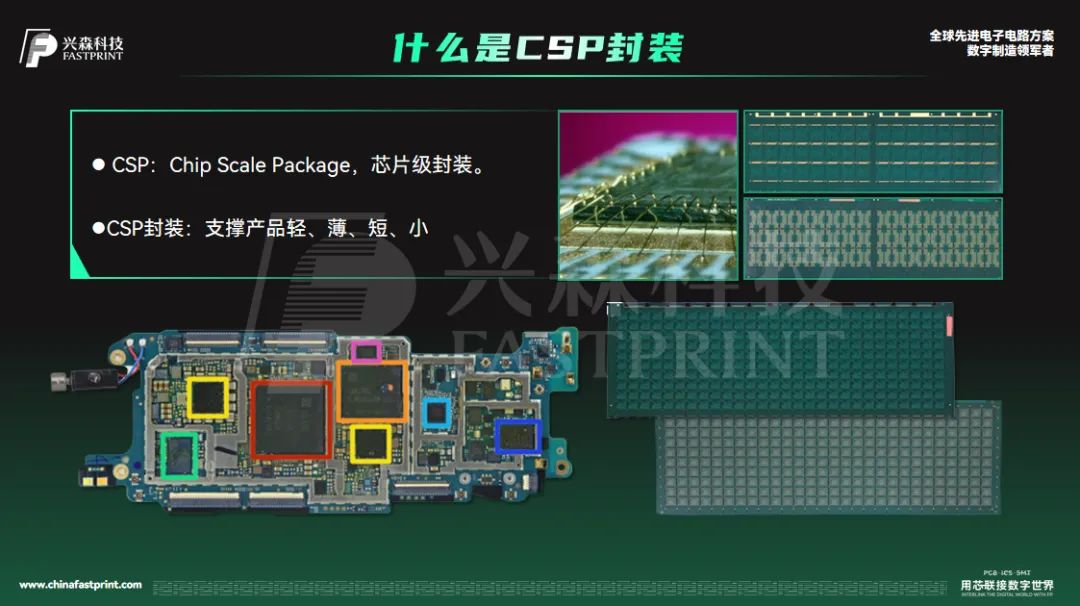
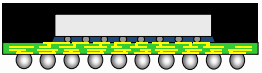


 電子發(fā)燒友App
電子發(fā)燒友App













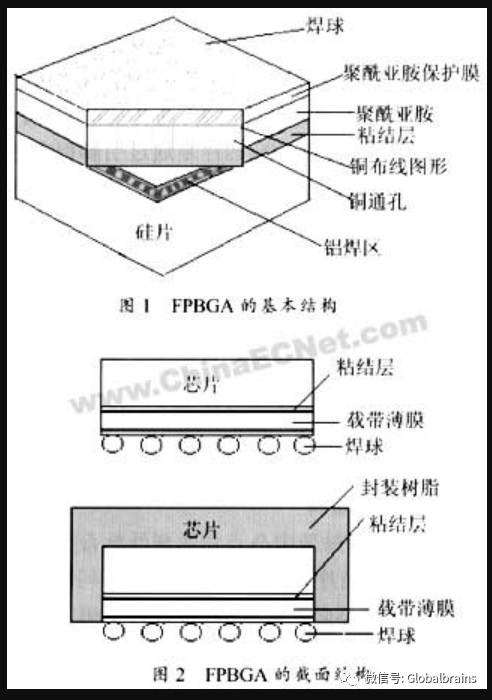







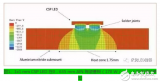
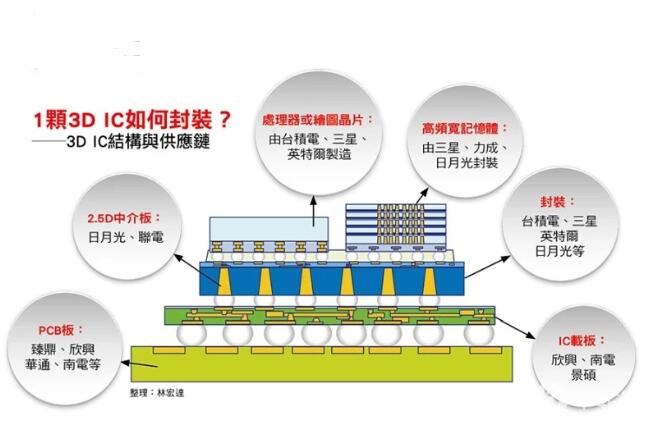







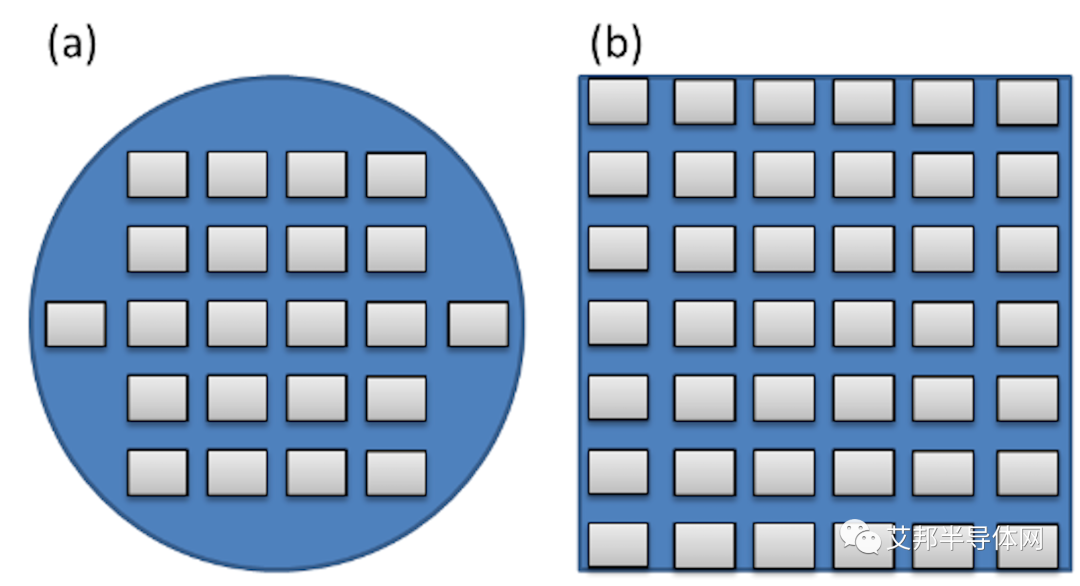






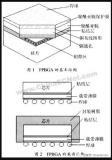



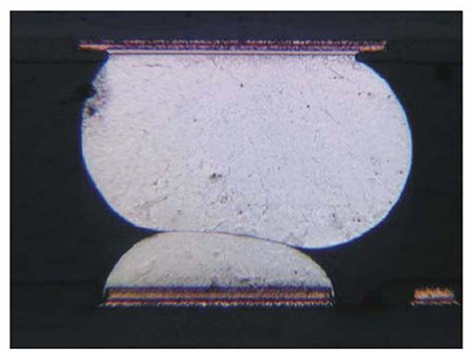


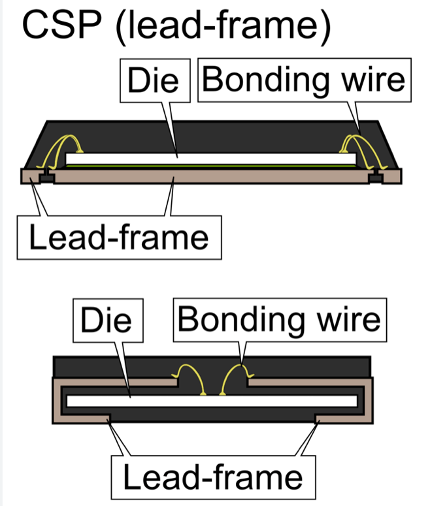











評論