據(jù)Yole 分析, 先進(jìn)封裝 (AP) 收入預(yù)計(jì)將從 2022 年的 443 億美元增長(zhǎng)到 2028 年的 786 億美元,年復(fù)合增長(zhǎng)率為 10%。
報(bào)告指出,2022年AP營(yíng)收增長(zhǎng)10%,超過(guò)半導(dǎo)體市場(chǎng)2%的增速。由于移動(dòng)和消費(fèi)市場(chǎng)需求疲軟,AP 市場(chǎng)的封裝單位增長(zhǎng)了 0.3%。采用具有高平均售價(jià) (ASP) 的更先進(jìn)和復(fù)雜的封裝正在推動(dòng) AP 市場(chǎng)的增長(zhǎng),而 AP 市場(chǎng)是由 AI、HPC、汽車電氣化和 5G 采用等大趨勢(shì)推動(dòng)的。
就收入而言,倒裝芯片BGA、倒裝芯片CSP和2.5D/3D是主要的封裝平臺(tái),其中2.5D/3D技術(shù)的增長(zhǎng)率最高。2.5D/3D 市場(chǎng)預(yù)計(jì)將從 2022 年的 92 億美元增長(zhǎng)到 2028 年的 258 億美元,實(shí)現(xiàn) 19% 的復(fù)合年增長(zhǎng)率。


先進(jìn)封裝,推動(dòng)了內(nèi)存封裝行業(yè)
Yole表歐式,到 2022 年,不包括測(cè)試,內(nèi)存封裝總收入144億美元。我們預(yù)測(cè)到 2028 年收入將達(dá)到318億美元,22-28的CAGR為 13%。
在封裝收入方面,DRAM 將以 13% 左右的 CAGR22-28 增長(zhǎng),而 NAND 增長(zhǎng)更快,22-28的CAGR為 17%。
其他存儲(chǔ)器技術(shù),如 NOR 閃存、EEPROM、SRAM 和新興的非易失性存儲(chǔ)器 (NVM),預(yù)計(jì)將在22-28間將以 3% 左右的 CAGR 增長(zhǎng)。
先進(jìn)封裝(AP)已成為NAND和DRAM技術(shù)進(jìn)步的關(guān)鍵推動(dòng)力。在不同的 AP 方法中,混合鍵合已成為制造更高位密度和更高性能存儲(chǔ)設(shè)備的最有前途的解決方案。
無(wú)論其使用目的是為了實(shí)現(xiàn)更高的性能還是更小的外形尺寸,先進(jìn)封裝都是內(nèi)存價(jià)值方程式中越來(lái)越重要的因素。從 2022 年約占內(nèi)存封裝收入的 47% 到 2028 年,先進(jìn)封裝將占 77%。

引線鍵合是主要的封裝方法。它廣泛用于移動(dòng)內(nèi)存和存儲(chǔ)應(yīng)用,其次是倒裝芯片封裝,繼續(xù)在 DRAM 業(yè)務(wù)中擴(kuò)展。
采用具有短互連的倒裝芯片封裝對(duì)于實(shí)現(xiàn)每個(gè)引腳的高帶寬至關(guān)重要。雖然引線鍵合封裝可能仍能滿足 DDR5 的性能要求,但我們預(yù)計(jì)倒裝芯片封裝將成為 DDR6 的必備條件。
引線框架仍然廣泛用于 NOR 閃存和其他存儲(chǔ)器技術(shù),并且是單位出貨量最高的封裝。
WLCSP 正越來(lái)越多地用于需要小尺寸的消費(fèi)/可穿戴應(yīng)用,例如真無(wú)線立體聲耳塞。它存在于 NOR 閃存、EEPROM 和 SLC NAND 等低密度存儲(chǔ)設(shè)備中。
由于以下原因,先進(jìn)封裝在內(nèi)存業(yè)務(wù)中變得越來(lái)越重要:
1、倒裝芯片和 3DS 封裝正在成為數(shù)據(jù)中心和個(gè)人計(jì)算機(jī)中 DRAM 模塊的標(biāo)準(zhǔn)。
2、在人工智能和高性能計(jì)算應(yīng)用的推動(dòng)下,對(duì)高帶寬內(nèi)存 (HBM) 的需求正在快速增長(zhǎng)。
3、混合鍵合是 3D NAND 縮放路徑的一部分。

到 2022 年,我們估計(jì) 66% 的內(nèi)存封裝收入由三星、SK 海力士、美光、鎧俠或西部數(shù)據(jù)等集成設(shè)備制造商內(nèi)存公司產(chǎn)生,其余 34% 由外包半導(dǎo)體封裝和測(cè)試 (OSAT) 公司產(chǎn)生.
內(nèi)存 IDM 也是推動(dòng)內(nèi)存設(shè)備先進(jìn)封裝增長(zhǎng)的關(guān)鍵公司:
1、大多數(shù)NAND制造商都提到他們打算采用晶圓到晶圓堆疊方法,如長(zhǎng)江存儲(chǔ)的Xtacking技術(shù)。
2、未來(lái)幾年將需要混合鍵合以繼續(xù)提高內(nèi)存帶寬、功率效率并最小化 HBM 堆棧厚度。
3、中國(guó)領(lǐng)先的兩家內(nèi)存制造商長(zhǎng)鑫存儲(chǔ)和長(zhǎng)江存儲(chǔ)完全依賴 OSAT 來(lái)封裝和測(cè)試其存儲(chǔ)設(shè)備。他們正在與中國(guó)主要廠商合作進(jìn)行內(nèi)存封裝。因此,由于最近美國(guó)在 2022 年第四季度實(shí)施的商業(yè)限制,他們將面臨不利因素。
其他國(guó)家可以更安全地發(fā)展他們的半導(dǎo)體產(chǎn)業(yè),例如馬來(lái)西亞、越南或印度。后端設(shè)施通常是這些國(guó)家半導(dǎo)體投資的主要選擇。
審核編輯 :李倩
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28563瀏覽量
232295 -
存儲(chǔ)器
+關(guān)注
關(guān)注
38文章
7632瀏覽量
166367 -
封裝
+關(guān)注
關(guān)注
128文章
8474瀏覽量
144756 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
460瀏覽量
500
原文標(biāo)題:先進(jìn)封裝增長(zhǎng)驚人,這類封裝勢(shì)頭最猛
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
淺談Chiplet與先進(jìn)封裝

先進(jìn)封裝,再度升溫

中國(guó)芯片被美國(guó)“卡脖子”?先進(jìn)封裝Chiplet或許就是破局關(guān)鍵!#先進(jìn)封裝 #芯片封裝 #華芯邦 #

傳統(tǒng)封裝你了解多少,小白快捷學(xué)習(xí) | 第1集 #傳統(tǒng)封裝 #先進(jìn)封裝 #芯片封裝 #華芯邦 #

中美貿(mào)易戰(zhàn),國(guó)產(chǎn)芯片發(fā)展艱難,先進(jìn)封裝助力中國(guó)芯突圍!#芯片封裝 #先進(jìn)封裝 #華芯邦 #
全球先進(jìn)封裝市場(chǎng)現(xiàn)狀與趨勢(shì)分析

美光新加坡HBM內(nèi)存封裝工廠破土動(dòng)工
先進(jìn)封裝技術(shù)-19 HBM與3D封裝仿真

CoWoS先進(jìn)封裝技術(shù)介紹

先進(jìn)封裝技術(shù)- 6扇出型晶圓級(jí)封裝(FOWLP)

先進(jìn)封裝技術(shù)推動(dòng)半導(dǎo)體行業(yè)繼續(xù)前行的關(guān)鍵力量

先進(jìn)封裝的重要設(shè)備有哪些

晶圓廠與封測(cè)廠攜手,共筑先進(jìn)封裝新未來(lái)

AI網(wǎng)絡(luò)物理層底座: 大算力芯片先進(jìn)封裝技術(shù)
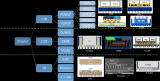
先進(jìn)封裝技術(shù)綜述






 先進(jìn)封裝,推動(dòng)了內(nèi)存封裝行業(yè)
先進(jìn)封裝,推動(dòng)了內(nèi)存封裝行業(yè)










評(píng)論