半導(dǎo)體制程微縮的難度日增,成本也越來越高昂,導(dǎo)致半導(dǎo)體業(yè)者必須走向超越摩爾定律(More than Moore)的道路。在這個(gè)背景下,先進(jìn)封裝與異質(zhì)整合成為Semicon Taiwan2018年的熱門話題。然而,對封裝業(yè)者(OSAT)而言,RDL First這道技術(shù)天險(xiǎn)仍是眼前最大的障礙,必須跟設(shè)備、材料業(yè)者攜手合作,才有機(jī)會早日突破。
***半導(dǎo)體業(yè)界的年度盛事--Semicon Taiwan2018于日前圓滿落幕,本屆展會規(guī)模再創(chuàng)歷屆之最,展出攤位逾2,000個(gè),吸引超過45,000位專業(yè)人士參觀,聚集680家全球領(lǐng)導(dǎo)廠商,舉辦22場國際論壇,超過200位重量級講師蒞臨演說。這也使得Semicon Taiwan正式超越Semicon Korea,成為全球第二大半導(dǎo)體專業(yè)展。
不過,在展覽規(guī)模破紀(jì)錄的同時(shí),參展廠商跟專業(yè)研討會主力探討的議題,已經(jīng)不再是制程微縮,而是如何用先進(jìn)封裝技術(shù)實(shí)現(xiàn)異質(zhì)整合。在聯(lián)電、格芯(GLOBALFOUNDRIES)先后宣布停止先進(jìn)制程研發(fā)后,先進(jìn)封裝料將成為未來帶動半導(dǎo)體產(chǎn)業(yè)發(fā)展的新引擎。
這不是說先進(jìn)制程已經(jīng)不重要,而是在只剩下臺積電、三星(Samsung)跟英特爾(Intel)能提供更先進(jìn)制程,用得起的IC設(shè)計(jì)、系統(tǒng)廠客戶也越來越少的情況下,先進(jìn)制程未來將會變成小眾議題。未能留在先進(jìn)制程競技場的半導(dǎo)體業(yè)者,則必然要尋求其它成長動能。扇出封裝將是基本功RDL First考驗(yàn)OSAT
自從臺積電在2016年成功將InFO推向量產(chǎn)以來,晶圓級扇出封裝(FOWLP)就一直是封裝業(yè)內(nèi)最熱門的技術(shù)話題之一。由于手機(jī)應(yīng)用處理器是封裝業(yè)者獲利空間較大的產(chǎn)品,臺積電的InFO封裝技術(shù)一直讓封裝業(yè)者深感威脅,并試圖發(fā)展出自己的FOWLP技術(shù)。
不過,即便排除掉臺積電分食高階產(chǎn)品訂單的威脅,對封裝業(yè)者來說,F(xiàn)OWLP也是一條必然要走的路。由于芯片的I/O數(shù)量越來越多,裸晶尺寸卻沒有明顯成長,使得凸塊(Bumping)封裝技術(shù)的密度將逼近物理極限。因此,未來封裝業(yè)者必然要設(shè)法把過度密集的I/O散布開來,才能把芯片整合到載板上,而這也是這種技術(shù)被命名為扇出封裝的原因。
然而,對晶圓制造跟封裝業(yè)者來說,一樣是扇出封裝,技術(shù)難度卻是天差地遠(yuǎn)。晶圓制造業(yè)者要做扇出封裝,可以采用芯片優(yōu)先(Chip First)制程,但如果是封裝業(yè)者,卻只能采用RDL優(yōu)先(RDL First)制程。
Chip First制程的步驟如下:首先,在晶圓上挑選出已知合格裸晶(KGD),然后將KGD放到基板上,再以模壓樹脂包覆成重構(gòu)晶圓;接著將重構(gòu)晶圓以暫時(shí)接合材料黏貼到載板,使其平坦化。最后才是在晶圓上制造出線路重布層(Redistribution Layer,RDL)。
RDL First制程(圖1)則是先在載具晶圓上制造出RDL,并涂上暫時(shí)接合材料,然后再將KGD放置在合格的RDL上,隨后進(jìn)行壓模與模具研磨制程。在壓模跟模具研磨制程中,裸晶還要再經(jīng)過金屬化(Metalization)、微影、介電質(zhì)沉積、電鍍等制程,這意味著相關(guān)材料不僅要通過更多道制程,而且會接觸到更多化學(xué)品。
圖1RDL First制程流程
當(dāng)然,RDL Last也有其挑戰(zhàn),因?yàn)橐诰A上制造RDL,相關(guān)材料還是得暴露在高溫環(huán)境跟各種化學(xué)品中,只是在材料跟制程技術(shù)上,其困難度比RDL First來得低。
布魯爾科技(Brewer Science)研發(fā)執(zhí)行總監(jiān)Rama Puligadda表示,使用在RDL First制程上的材料,必須具備更穩(wěn)定的機(jī)械、化學(xué)跟熱特性,才能在后續(xù)多道制程步驟中存活下來。這也意味著暫時(shí)接合材料必須有更強(qiáng)大的性能,方可發(fā)揮保護(hù)元件的效果。事實(shí)上,暫時(shí)接合材料不只是用來把晶圓或RDL暫時(shí)黏貼在載具上而已,該材料本身也是晶圓或RDL的防護(hù)罩,使用具有適當(dāng)特性的暫時(shí)接合材料,對提升制程良率有很大的幫助。
在本屆Semicon Taiwan期間,布魯爾特別發(fā)表一款專為RDL優(yōu)先制程而設(shè)計(jì)的BrewerBUILD材料,該材料就具有比一般暫時(shí)接合材料更強(qiáng)的機(jī)械、化學(xué)與熱性能,可以協(xié)助封裝業(yè)者克服RDL First制程的挑戰(zhàn)。此外,該材料一旦與載具體剝離,建構(gòu)層就會被移除,且可用紫外(UV)雷射剝離。
值得一提的是,該材料不僅可以用在晶圓封裝,同時(shí)也適用于面板封裝,這項(xiàng)特性也是為封裝業(yè)者的需求而開發(fā)的。封裝業(yè)者通常傾向于采用面板封裝,因?yàn)槊姘宸庋b的生產(chǎn)效率優(yōu)于晶圓封裝。RDL線寬或成新摩爾定律
無獨(dú)有偶,檢測設(shè)備與制程控制方案業(yè)者KLA-Tencor在本次展會也主打兩款為封裝應(yīng)用設(shè)計(jì)的缺陷檢測產(chǎn)品。Kronos1080系統(tǒng)為先進(jìn)封裝提供適合量產(chǎn)的、高靈敏度的晶圓檢測,為制程控制和材料處置提供關(guān)鍵資訊。ICOS F160系統(tǒng)在晶圓切割后對封裝進(jìn)行檢查,根據(jù)關(guān)鍵缺陷的類型進(jìn)行準(zhǔn)確快速的芯片分類,其中包括對側(cè)壁裂縫這一新缺陷類型的檢測。
KLA-Tencor資深副總裁暨行銷長Oreste Donzella(圖2)表示,隨著制程線寬微縮的速度逐漸放緩,芯片封裝技術(shù)的進(jìn)步,已成為提升半導(dǎo)體元件性能的重要因素。先進(jìn)封裝技術(shù)不僅可以縮小元件尺寸,也能藉由異質(zhì)整合在有限空間內(nèi)整合更多功能,是推動半導(dǎo)體產(chǎn)業(yè)繼續(xù)往前邁進(jìn)的重要動能。
圖2KLA-Tencor資深副總裁暨行銷長Oreste Donzella指出,先進(jìn)封裝技術(shù)內(nèi)部結(jié)構(gòu)日益復(fù)雜,使得缺陷檢測必須具備更高的解析度與更全面的檢測范圍。
然而,這也意味著先進(jìn)封裝將越來越復(fù)雜。未來的先進(jìn)封裝將具有不同的2D和3D結(jié)構(gòu),并且每一代都會越做越小。與此同時(shí),封裝芯片的價(jià)值在大幅增長,電子制造商對于產(chǎn)品品質(zhì)和可靠性的期望也在不斷地提升。為了滿足這些期望,無論是芯片制造廠的后端還是在封裝業(yè)者的工廠,都需要靈敏度和成本效益更高的檢測、量測和資料分析,同時(shí)需要更準(zhǔn)確地識別不良品。
以目前最受關(guān)注的扇出封裝為例,雖然目前已經(jīng)量產(chǎn)的RDL線間距(L/S)為10/10微米,但做為檢測設(shè)備供應(yīng)商,KLA-Tencor發(fā)現(xiàn)許多客戶的技術(shù)藍(lán)圖上,已經(jīng)存在5/5微米、甚至2/2微米節(jié)點(diǎn)。因此,該公司推出的缺陷檢測方案,必然要跑在客戶之前,支援更高的解析度。以Kronos1080為例,該機(jī)臺對RDL L/S的解析度已經(jīng)有把握可以達(dá)到1/1微米,甚至進(jìn)一步挑戰(zhàn)0.5/0.5微米。
除了更高的解析度之外,未來封裝業(yè)者需要的缺陷檢測方案,還必須更面面俱到。特別是在芯片普遍導(dǎo)入低K介電材料后,在晶圓切割的過程中,很容易出現(xiàn)側(cè)壁裂縫。但傳統(tǒng)的紅外線檢測設(shè)備通常只會從固定角度對裸晶進(jìn)行檢測,不容易偵測到側(cè)壁裂縫這種缺陷。
此外,雷射切割在切割面所留下來的Laser Groove缺陷,也是現(xiàn)有檢測設(shè)備比較不容易偵測到的小瑕疵,而這些都是ICOS F160在功能上特別強(qiáng)化之處。毫米波帶動AiP需求封/測各有挑戰(zhàn)
除了扇出封裝外,將天線整合在芯片封裝內(nèi)的AiP(Antenna in Package,AiP),也是先進(jìn)封裝中的一大熱點(diǎn)。由于毫米波訊號的線路損失非常大,因此對通訊設(shè)備而言,如果要支援毫米波通訊,必須要把天線跟射頻前端間的線路縮到最短,也就是直接把天線整合到射頻前端模組的封裝內(nèi)。
力成科技處長范文正指出,AiP是5G毫米波通訊不可或缺的封裝技術(shù)。
5G使用的通訊頻段可分成6GHz以下與28GHz以上兩大區(qū)塊,6GHz以下所采用的設(shè)計(jì)架構(gòu)跟目前的4G通訊類似,收發(fā)器跟射頻前端仍會獨(dú)立存在,但28GHz以上的毫米波頻段由于訊號損失太大,必須使用收發(fā)器、射頻前端與天線完全整合在單一封裝內(nèi)的超高整合度設(shè)計(jì),而天線的整合則是一大重點(diǎn)。
可以整合在封裝內(nèi)的天線選擇有二,分別是平面陣列(Patch Array)與Yagi-Uda。這兩種天線各有所長,為了提高訊號收發(fā)品質(zhì),業(yè)界未來應(yīng)該會采用在單一封裝內(nèi)整合兩種天線的設(shè)計(jì)。
在基板材料選擇方面,由于Dk跟Df值越低越好,使用玻璃基板會得到更好的材料特性。但由于玻璃基板成本較高,而且會為制程帶來新挑戰(zhàn),故采用傳統(tǒng)導(dǎo)線載板會是比較合理的選擇。
至于在測試方面,毫米波通訊對測試端所帶來的挑戰(zhàn),絲毫不下于封裝。從探針卡起家,近年來成功開發(fā)出自有探針的中華精測就認(rèn)為,針對5G通訊芯片測試,測試廠必然要發(fā)展兩套不同的測試方法。
中華精測總經(jīng)理黃水可(圖3)指出,由于6GHz以下的5G,在射頻端的特性很接近現(xiàn)有的4G,因此可以沿用現(xiàn)有的測試方法,但如果是28GHz以上的毫米波通訊,由于訊號的線路損失太大,因此一定要采用OTA測試手法。目前該公司正在發(fā)展相關(guān)測試方案,但由于許多關(guān)鍵儀器都受到美國政府高度管制,因此在采購方面還要等上一段時(shí)間。
圖3中華精測總經(jīng)理黃水可表示,5G通訊將為半導(dǎo)體測試帶來OTA、高速訊號測試等新的考驗(yàn)。
但黃水可也提醒,由于通訊走向高速化的趨勢非常明顯,因此很多測試技術(shù)跟架構(gòu),都必須與時(shí)俱進(jìn)。傳統(tǒng)半導(dǎo)體測試設(shè)備是以Pogo Tower作為探針卡與待測芯片間的介面,但這種架構(gòu)很難測試高速訊號。
因此,在需要測量高速訊號時(shí),必須改用Direct Docking測試架構(gòu),方能解決訊號衰減的問題。另一方面,傳統(tǒng)的探針片設(shè)計(jì)不太講究電氣特性,只注重機(jī)械特性,這點(diǎn)也不利于高速訊號測試。這也使得中華精測決定自行發(fā)展自有的探針技術(shù)。
經(jīng)過多年努力,中華精測已經(jīng)發(fā)展出自有的MEMS探針,比傳統(tǒng)探針具有更優(yōu)異的熱、電氣與機(jī)械特性,并已經(jīng)有應(yīng)用在量產(chǎn)測試上的實(shí)績。Mini/MicroLED封裝商機(jī)誘人
除了一般的半導(dǎo)體先進(jìn)封裝外,近來話題不斷的Mini/MicroLED顯示、照明,最大的技術(shù)挑戰(zhàn)--巨量轉(zhuǎn)移(Massive Transfer)其實(shí)也跟封裝有關(guān),因此在本屆Semicon Taiwan中,就有封裝設(shè)備業(yè)者推出專為MiniLED設(shè)計(jì)的解決方案。
看好MiniLED背光未來為商機(jī),半導(dǎo)體封裝設(shè)備廠商庫力索法(Kulicke&Soffa,K&S)于近日與Rohinni攜手推出MiniLED轉(zhuǎn)移設(shè)備PIXALUX。該MiniLED解決方案相較于傳統(tǒng)的單顆取放(Pick&Place)轉(zhuǎn)移方法相比,速度可以提升3~5倍。
Kulicke&Soffa(K&S)集團(tuán)高級副總裁張贊彬說明,目前傳統(tǒng)的LED背光電視大約使用50顆LED,然而隨著MIniLED于背光應(yīng)用的普及,LED背光數(shù)量將提升至2萬顆以上。因此,將需要更有效率的轉(zhuǎn)移方式。PIXALUX解決方案一秒能夠轉(zhuǎn)移50顆LED晶粒,轉(zhuǎn)移速度是Pick&Place方法的3~5倍,更重要的是,該解決方案能夠在轉(zhuǎn)移過程同時(shí)完成目揀(Sorting)程序,為轉(zhuǎn)移節(jié)省更多作業(yè)時(shí)間,進(jìn)而降低生產(chǎn)成本。
Rohinni副總裁Brad Telin(圖4)則指出,目前該解決方案可以做到100×100微米(Micrometer,μm)尺寸晶粒的轉(zhuǎn)移工作,并且良率可以達(dá)到99.9999%。在未來,也將隨著MicroLED的發(fā)展持續(xù)推進(jìn)該轉(zhuǎn)移技術(shù),期望能在縮小晶粒尺寸的同時(shí)維持其轉(zhuǎn)移良率。
圖4Rohinni副總裁Brad Teli則指出,在MicroLED的技術(shù)發(fā)展中,主要的技術(shù)局限依然在于晶粒制程的技術(shù)能力,而非轉(zhuǎn)移設(shè)備。
Telin進(jìn)一步提到,事實(shí)上目前PIXALUX設(shè)備已能夠做到50微米MicroLED晶粒的轉(zhuǎn)移,在MicroLED的技術(shù)發(fā)展中,主要的技術(shù)局限依然在于晶粒制程的技術(shù)能力,而非轉(zhuǎn)移設(shè)備。因此,只要晶粒廠商能夠量產(chǎn)MicroLED等級的晶粒,PIXALUX就有能力轉(zhuǎn)移。在未來3年將會是MiniLED的技術(shù)開發(fā)關(guān)鍵時(shí)期,并將由大型顯示器優(yōu)先開始導(dǎo)入MiniLED應(yīng)用,該市場也將是PIXALUX最初實(shí)現(xiàn)的應(yīng)用范疇。先進(jìn)制程考驗(yàn)新材料開發(fā)
為滿足在產(chǎn)量、可靠度及性能方面等要求,先進(jìn)制程對特用化學(xué)及新材料需求大增,對此,英特格(Entegris)副技術(shù)長Montray(圖5)表示,像是在薄膜沉積(Deposition)、過濾器(Filter)和運(yùn)送晶圓的晶圓傳送盒(Front Opening Unified Pod,F(xiàn)OUP)設(shè)計(jì)、要求都有所改變,促使半導(dǎo)體材料商的開發(fā)挑戰(zhàn)也日漸增加。
圖5英特格(Entegris)副技術(shù)長aMontray表示,先進(jìn)制程到來使得半導(dǎo)體材料商的開發(fā)挑戰(zhàn)也日漸增加,像是薄膜沉積、過濾器和晶圓傳送盒設(shè)計(jì)都有所改變。
Montray指出,過往28納米以上的制程,在進(jìn)行薄膜沉積時(shí),多使用液體化學(xué)材料;然而,隨著制程走到10納米以下(如7、5、3納米),不僅所使用的材料越來越稀有,也從原本的液體化學(xué)材料轉(zhuǎn)變成固體化學(xué)材料。也因此,對于材料商而言,要如何將固體化學(xué)材料氣化,并且在芯片上呈現(xiàn)均勻的薄膜層,而不是厚薄不平均導(dǎo)致晶圓良率降低,是一大挑戰(zhàn)。
另一方面,10納米以下的先進(jìn)制程對于雜質(zhì)過濾的要求也越來越高,晶圓廠必須導(dǎo)入效能更強(qiáng)的過濾、凈化產(chǎn)品,才能確保半導(dǎo)體晶圓不受污染,提升生產(chǎn)良率,也因此,過濾器的純凈度勢必得再度提升。
Montray說明,從28納米走到7納米,產(chǎn)品的金屬雜質(zhì)要求須下降100倍,污染粒子的體積也必須要縮小4倍,而隨著制程走到10納米以下,對于潔凈度要求只會愈來愈嚴(yán)格,例如28納米晶圓可能可以有10個(gè)污染粒子,但7納米晶圓上只能有1個(gè)。也就是說,為因應(yīng)先進(jìn)制程,過濾器必須更干凈,這也意味著材料商必須花費(fèi)更多的時(shí)間設(shè)計(jì)產(chǎn)品,確保更高的潔凈度。
除此之外,晶圓運(yùn)送盒也因先進(jìn)制程而產(chǎn)生新的需求。Montray解釋,當(dāng)晶圓擺放至晶圓運(yùn)送盒當(dāng)中時(shí),不代表馬上就會運(yùn)送,可能會經(jīng)過一段時(shí)間待所有準(zhǔn)備就緒后才開始運(yùn)送(約2~3小時(shí))。也因此,在這段期間內(nèi),要如何確保盒內(nèi)環(huán)境對晶圓不會有所影響,便是研發(fā)晶圓運(yùn)送盒時(shí)須考量的關(guān)鍵。
Montray指出,特別是采用先進(jìn)制程的晶圓,其薄膜層非常薄,對氧氣十分敏感,很容易被氧化,也因此,晶圓運(yùn)送盒的設(shè)計(jì)重點(diǎn)便在于如何實(shí)現(xiàn)更嚴(yán)格的“污染控制”,也就是要有更緊密的密合度、更高的排氣、充氣效果,使晶圓在運(yùn)送過程中不至于產(chǎn)生損壞。
總而言之,半導(dǎo)體持續(xù)朝向先進(jìn)制程發(fā)展,連帶使得新材料開發(fā)的挑戰(zhàn)逐漸增加,也因此,英特格不斷提升其技術(shù)能力與業(yè)務(wù)版圖,像是在***技術(shù)中心引進(jìn)KLA SP3晶圓檢測系統(tǒng),讓該公司在***的晶圓檢測能力擴(kuò)展至19納米,得以自行產(chǎn)出晶圓缺陷的數(shù)據(jù),以引導(dǎo)新產(chǎn)品開發(fā)及改善產(chǎn)品性能。電子特殊氣體成就先進(jìn)半導(dǎo)體制程
半導(dǎo)體制程越來越復(fù)雜,未來的3、5納米已經(jīng)進(jìn)入原子等級的尺度,制程的精細(xì)與復(fù)雜不言而喻,再加上許多新興技術(shù)如3D堆疊、異質(zhì)整合系統(tǒng)級封裝(SiP)等,制程中有更多細(xì)節(jié)必須兼顧,電子特殊氣體(Electronic Special Gases,ESGs)將在半導(dǎo)體制程中協(xié)助平坦化、清潔、間隔不同Layer等,聯(lián)華林德看好***半導(dǎo)體產(chǎn)業(yè)發(fā)展,積極投資研發(fā)與生產(chǎn)活動。
專長電子氣體與化學(xué)品技術(shù)的聯(lián)華林德,在Semicon Taiwan推出SPECTRA EM系列的電子材料,強(qiáng)調(diào)純度、包裝和分析技術(shù),該公司電子材料副總裁Anshul Sarda(圖6)表示,其ESGs產(chǎn)品包括全氟丙烷(C3F8)、四氟甲烷(CF4)、一氧化碳(CO)、氟氮混合氣體、溴化氫(HBr)、六氯乙矽烷(HCDS)、三氟化氮(NF3)、六氟化硫(SF6)等。
圖6林德集團(tuán)電子材料副總裁Anshul Sarda(左)、林德電子技術(shù)及創(chuàng)新研發(fā)總監(jiān)Carl Jackson(左二)、聯(lián)亞科技總經(jīng)理周祖庵(右二)、林德電子行銷經(jīng)理Francesca Brava(右)。
一般半導(dǎo)體制程包括:沉積、蝕刻(Etch)/清洗(Cleaning)、摻雜(Doping)、光刻(Lithography)等階段都需要使用電子特殊氣體,聯(lián)亞科技總經(jīng)理周祖庵形容,若將半導(dǎo)體制造過程以做菜來形容,特殊氣體扮演的就是調(diào)味料的角色,SPECTRA-N氮?dú)猱a(chǎn)生器為半導(dǎo)體和面板產(chǎn)業(yè)提供彈性、高效能的氮?dú)夤?yīng);SPECTRA光刻氣體推出可靠、精確的氖氣與鹵素氣體混合物,使得深紫外線(Deep UV,DUV)光刻能夠應(yīng)用于高性能、高效率制造。
聯(lián)華林德近期投入兩種SPECTRA EM新產(chǎn)品的生產(chǎn),氟氣混合氣體及溴化氫。氟氣是一種高活性氣體,與20%的氮?dú)饣旌虾髸a(chǎn)生可用于安全壓縮、包裝和運(yùn)輸?shù)幕旌蠚怏w,可用于清潔半導(dǎo)體制造設(shè)備。此外,也在中國投資建廠,提供電子級溴化氫(HBr)產(chǎn)品,用于選擇性蝕刻劑的壓縮氣體,將其用于去除一種材料物質(zhì)的同時(shí)能保留所需的材料物質(zhì)不受影響,特別會應(yīng)用在3D構(gòu)裝制程中。
另外,芯片制程精細(xì)因此在氣體應(yīng)用時(shí)也不容差錯,林德電子技術(shù)及創(chuàng)新研發(fā)總監(jiān)Carl Jackson解釋,電子特殊氣體純度不夠會使電路產(chǎn)生誤差,尤其在先進(jìn)制程,因此該公司也非常重視氣體的純化程度,希望提供半導(dǎo)體廠純度最高的電子特殊氣體。未來,聯(lián)華林德也將持續(xù)投資***,提供品質(zhì)、可靠度、一致性兼具的電子特殊氣體,并加強(qiáng)安全控管,除了訓(xùn)練客戶使用安全性之外,也透過駐廠人員在嚴(yán)謹(jǐn)?shù)臉?biāo)準(zhǔn)化步驟下,直接操作具危險(xiǎn)性的氣體,確保使用的安全性。
 電子發(fā)燒友App
電子發(fā)燒友App









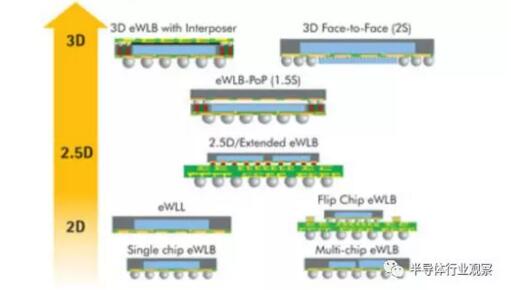













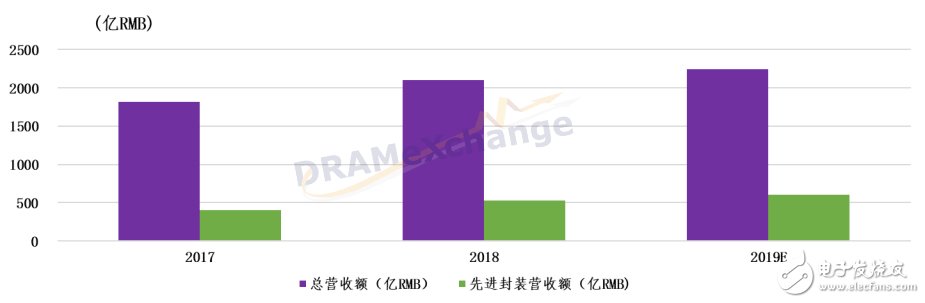
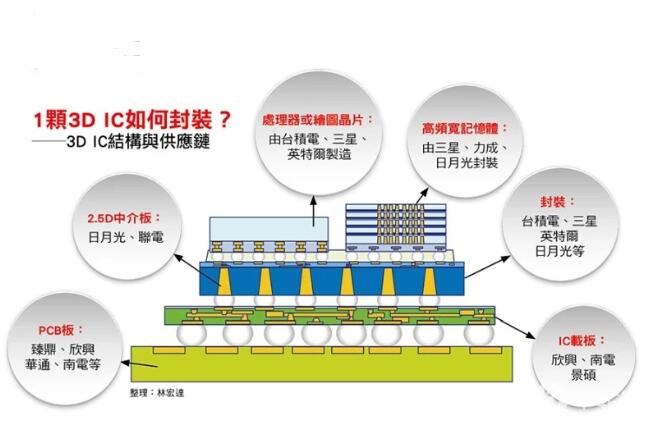


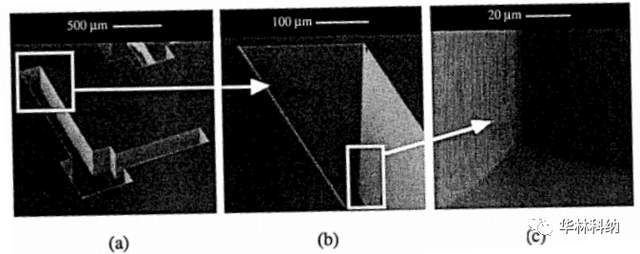
















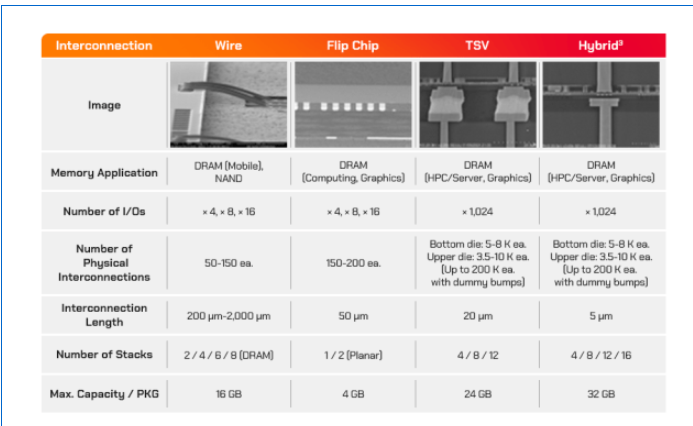

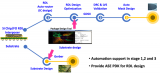










評論