FormFactor處于測(cè)試新的高級(jí)程序包的最前沿,并且與業(yè)界領(lǐng)先者合作,在他們制定解決集成和測(cè)試范圍復(fù)雜性的策略時(shí),我們正在幫助他們應(yīng)對(duì)挑戰(zhàn)。
在先進(jìn)封裝領(lǐng)域,晶圓測(cè)試變得比以往任何時(shí)候都更加重要。我們正在為當(dāng)今最棘手的問(wèn)題提供解決方案。 鑒于摩爾定律已接近尾聲,我們的行業(yè)已將其創(chuàng)造力應(yīng)用于先進(jìn)封裝,以繼續(xù)實(shí)現(xiàn)性能和成本目標(biāo)。在“數(shù)據(jù)時(shí)代”中,先進(jìn)的封裝技術(shù)為計(jì)算能力和內(nèi)存帶寬方面的突破性發(fā)展提供了支持,以支持重要計(jì)劃,例如人工智能,汽車,5G /移動(dòng),高性能計(jì)算和其他高端應(yīng)用。
英特爾,臺(tái)積電和三星等公司正在引領(lǐng)新的先進(jìn)封裝技術(shù)之路。 我們將先進(jìn)封裝定義為2.5D / 3D異構(gòu)集成封裝,其中通過(guò)插入器或混合鍵合過(guò)程將不同類型的芯片或小芯片“粘合”在一起,以允許各種堆疊的芯片相互之間以及與外部進(jìn)行通信。這些小芯片可以根據(jù)需要進(jìn)行混合和匹配,以提供更好的整體性能和更快的上市時(shí)間。
與摩爾定律晶體管收縮類似,高級(jí)封裝的“新”收縮是減小2.5D / 3D互連間距,從而允許在不增加晶粒尺寸的情況下進(jìn)出晶粒的更多信息。反過(guò)來(lái),這大大降低了探針卡間距以測(cè)試這些設(shè)備。正如我們?cè)谶^(guò)去幾年中所看到的,包裝凸點(diǎn)間距已從150um減小到如今的50um以下。
FormFactor處于領(lǐng)先地位,其測(cè)試和測(cè)量解決方案可降低高級(jí)封裝的制造成本。
我們幫助客戶交付高可信度的零件,同時(shí)平衡測(cè)試的復(fù)雜性,覆蓋范圍和成本。我們的探針系統(tǒng)(CM300)和高級(jí)MEMS探針卡(SmartMatrix,Apollo,HFTAP,ALTIUS)不僅用于堆疊中的單個(gè)芯片(例如HBM和處理器),還用于檢驗(yàn)細(xì)間距中介層以及封裝襯底和最終堆疊的電氣性能和成品率,以確保完整的封裝工作。我們的產(chǎn)品使客戶能夠在異構(gòu)集成過(guò)程的任何階段獲得更多的智能,而傳統(tǒng)的在單片硅芯片上進(jìn)行成品率優(yōu)化的方法已不再足夠。如果無(wú)法衡量,就無(wú)法改進(jìn)。
審核編輯:符乾江
 電子發(fā)燒友App
電子發(fā)燒友App











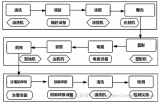









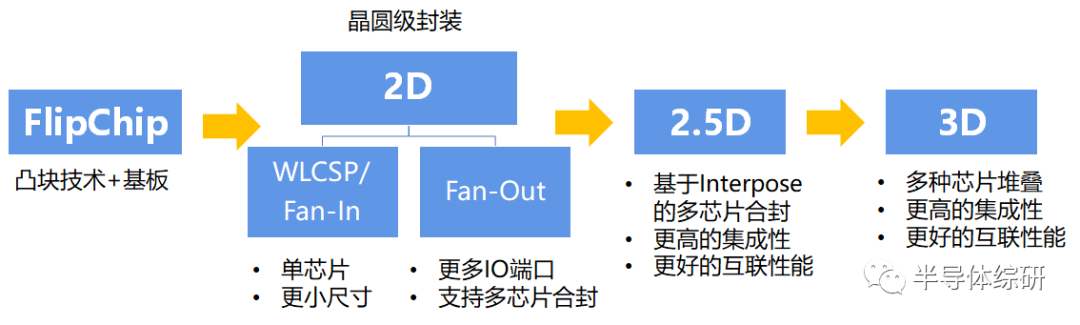








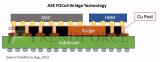




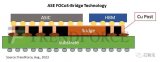























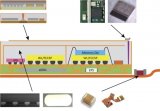















評(píng)論