半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術。


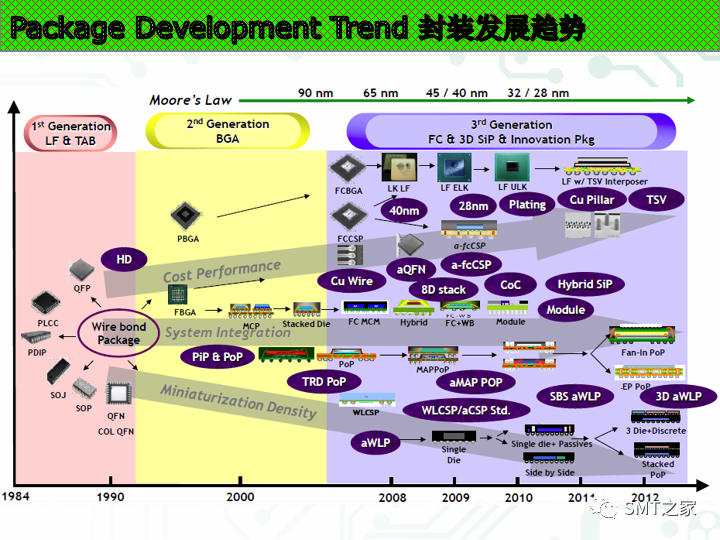

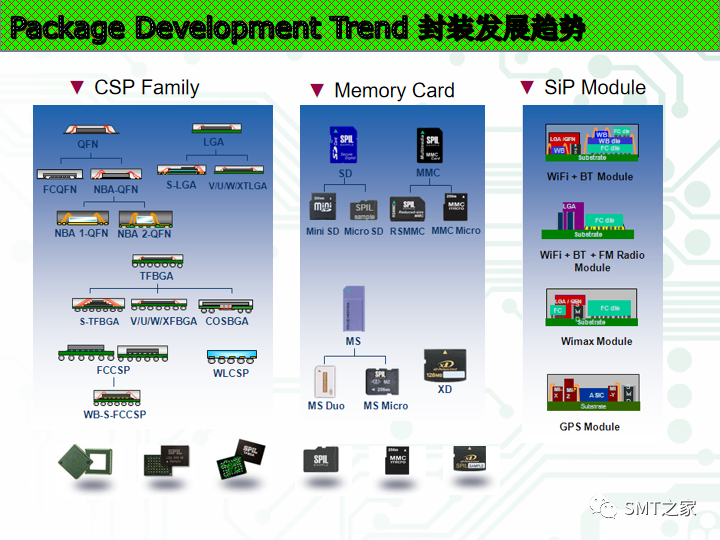

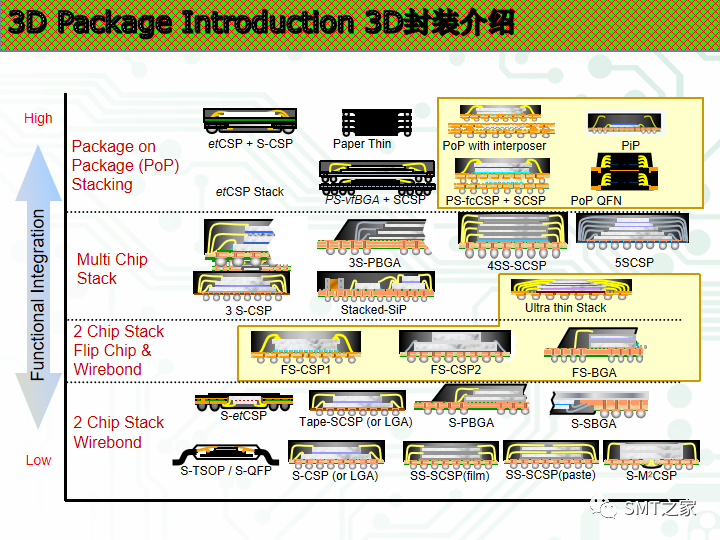
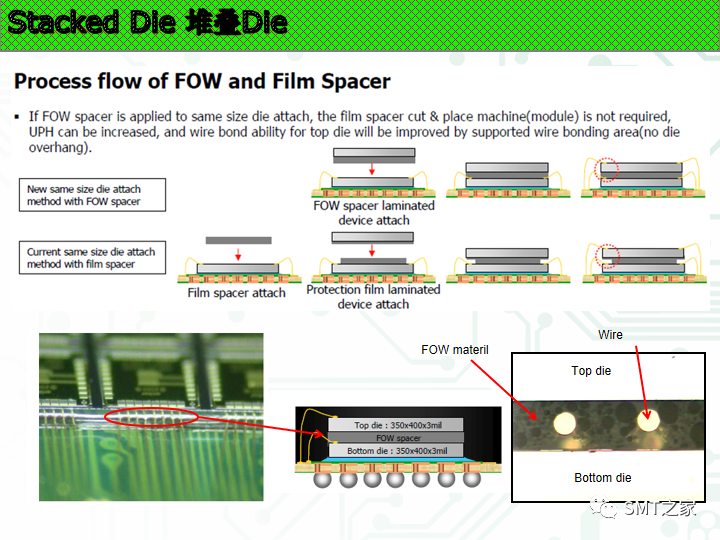
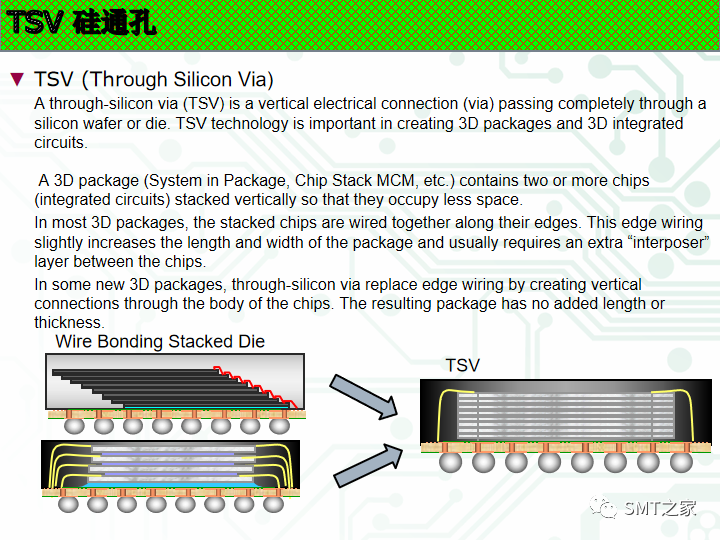
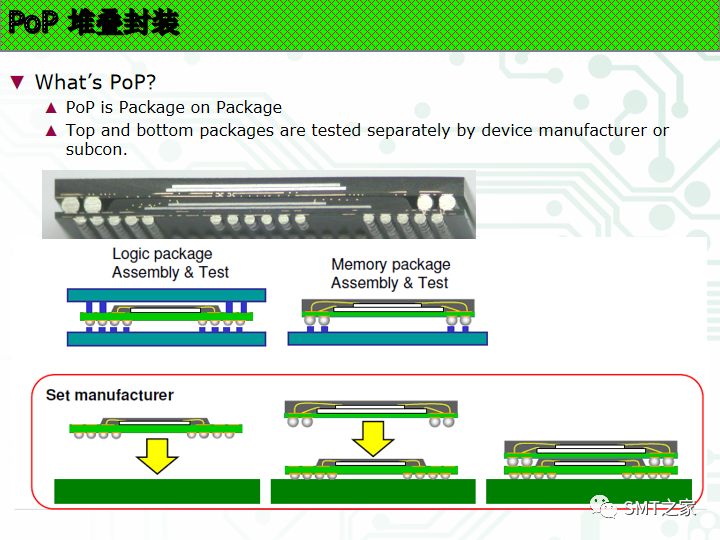
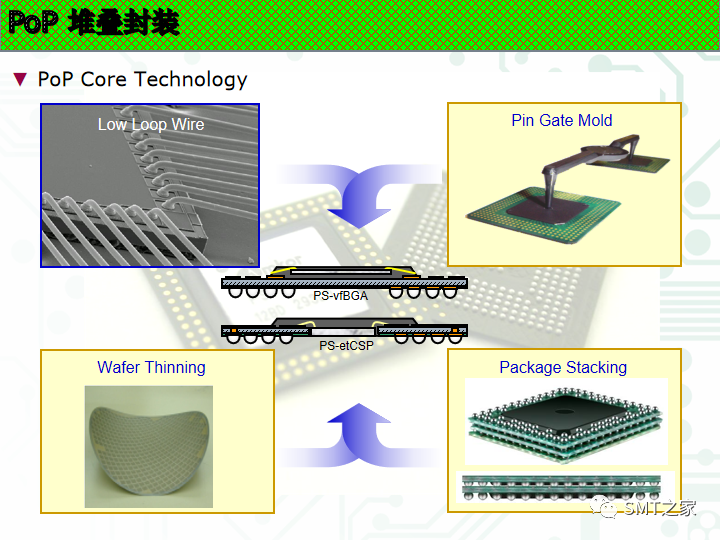
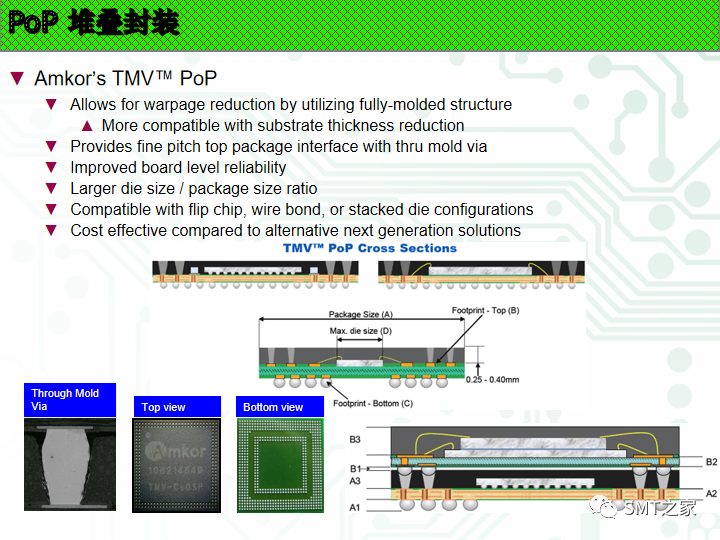
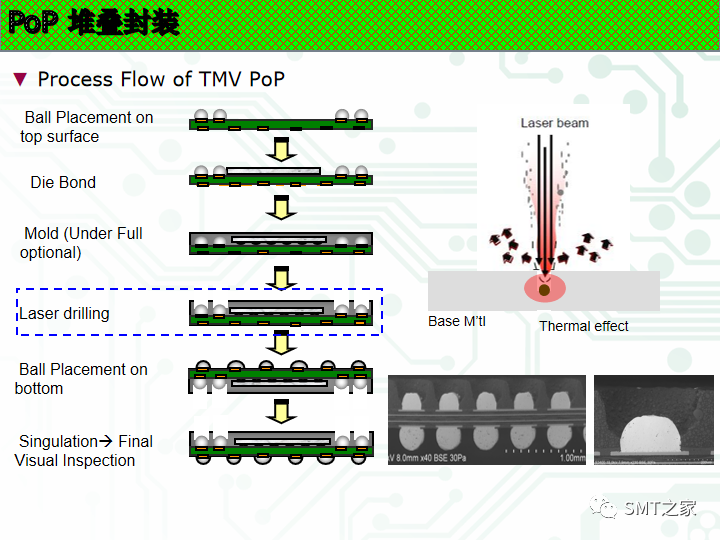


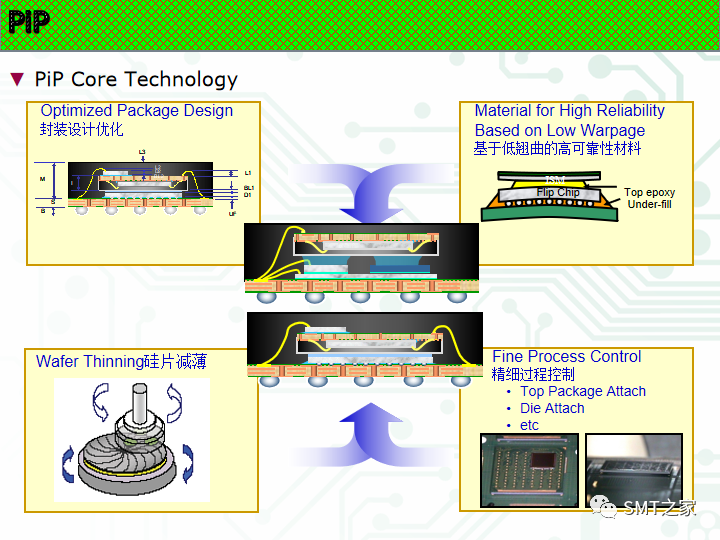
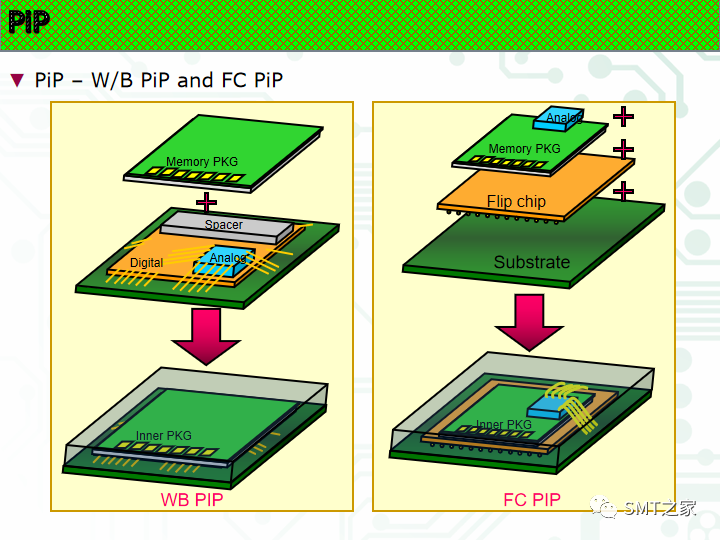

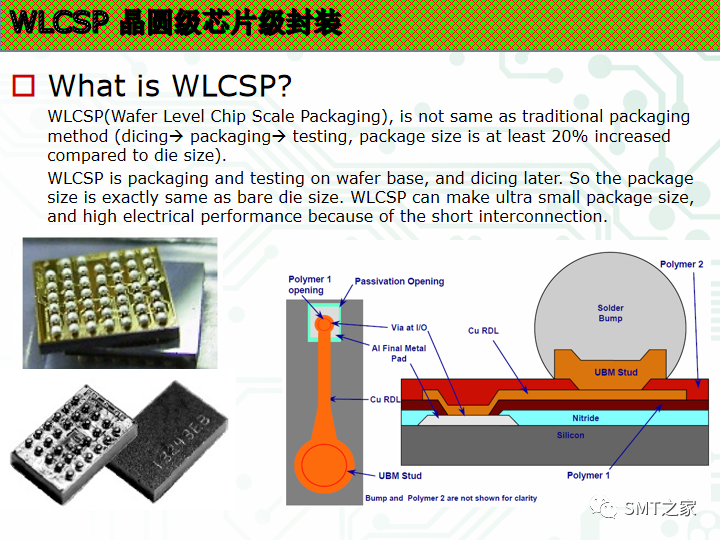


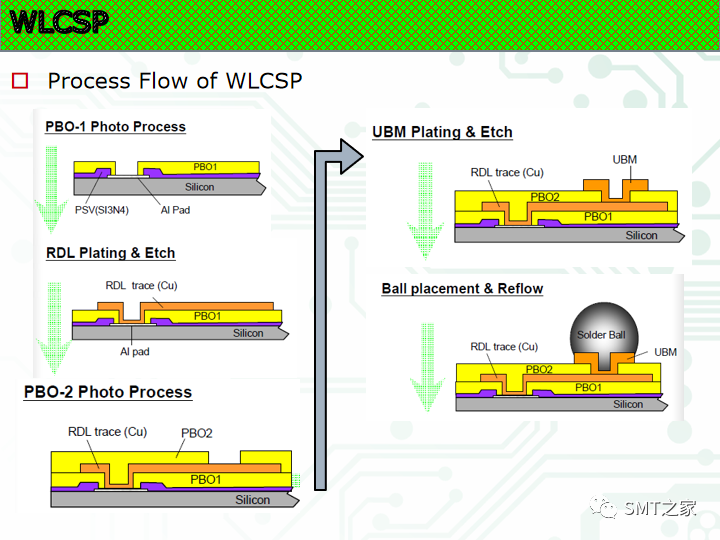

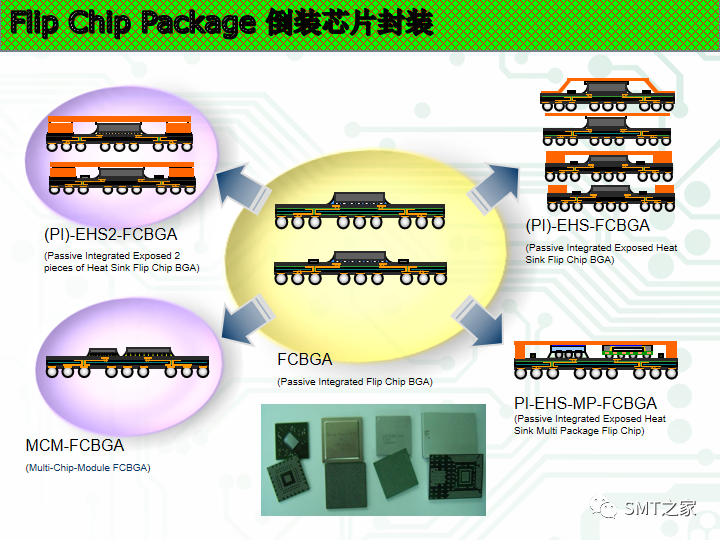
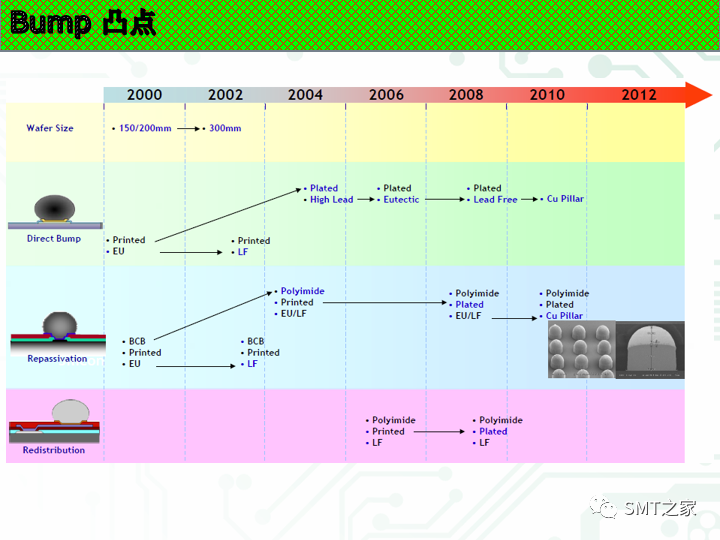

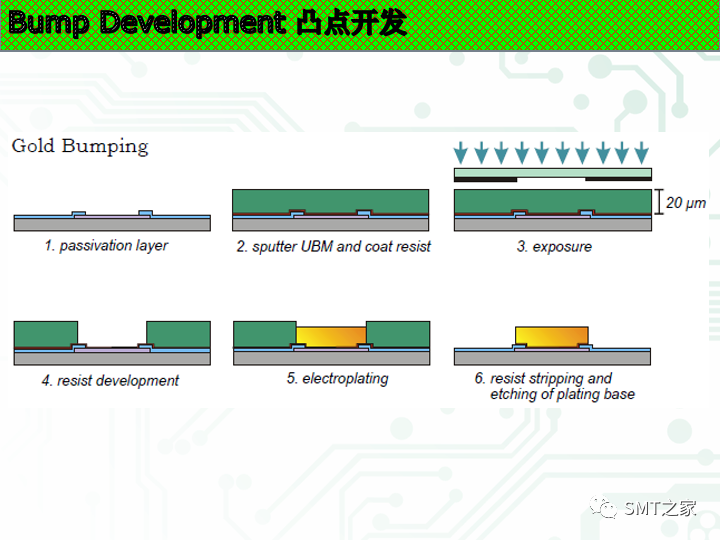
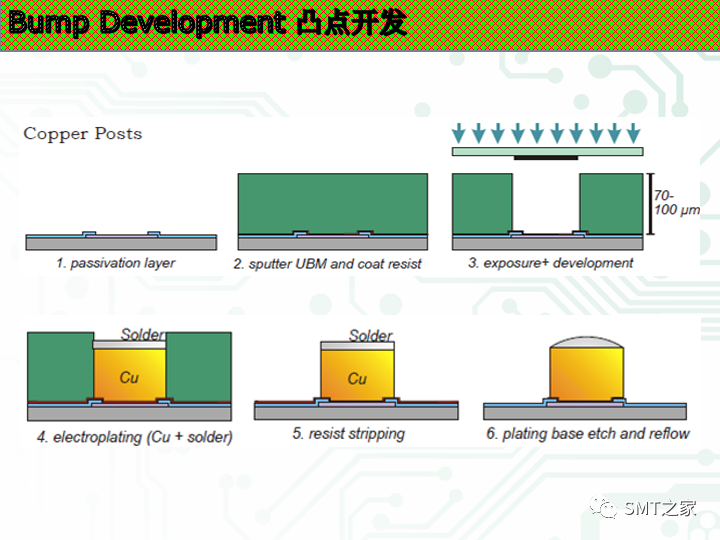
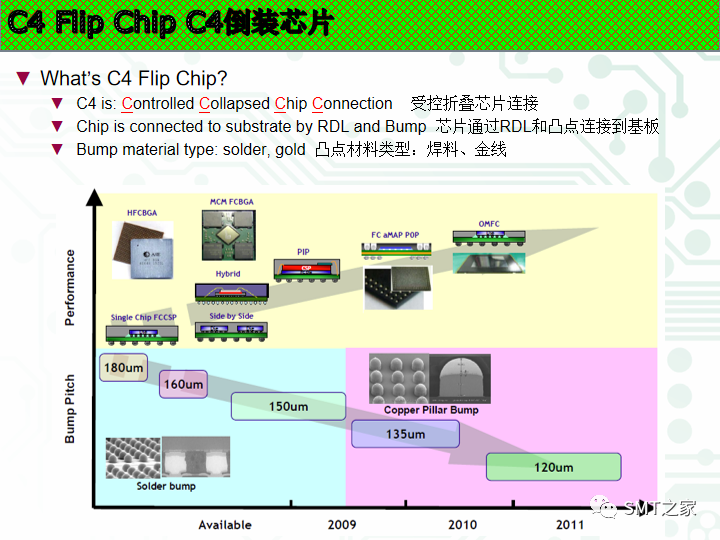
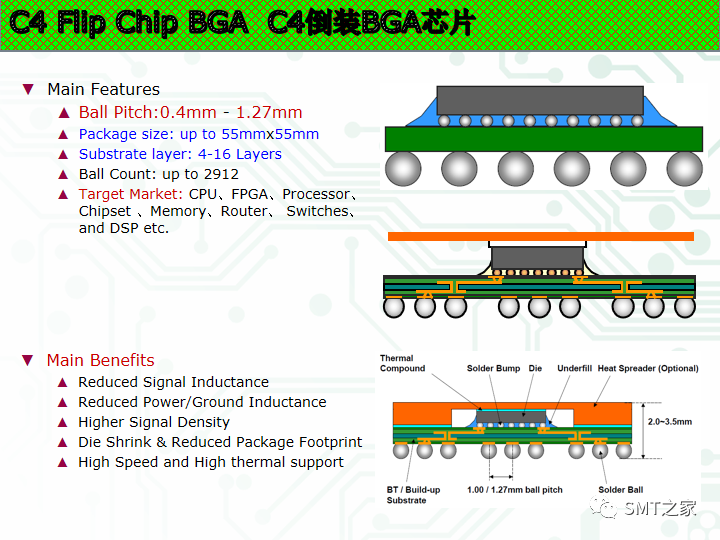
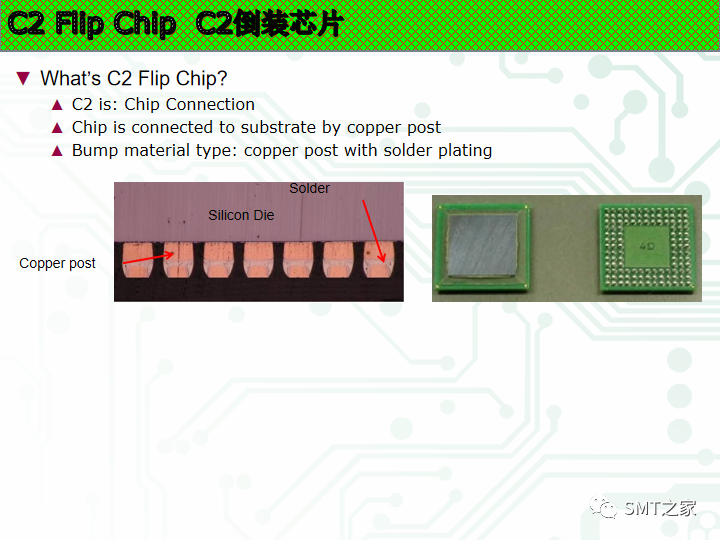
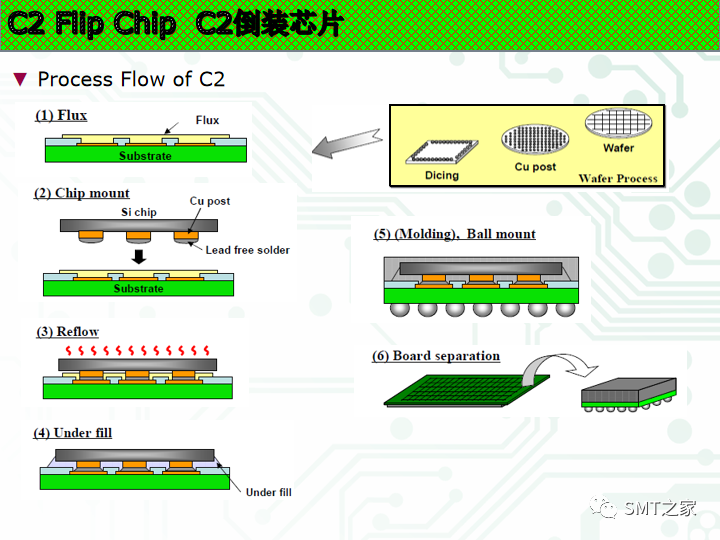
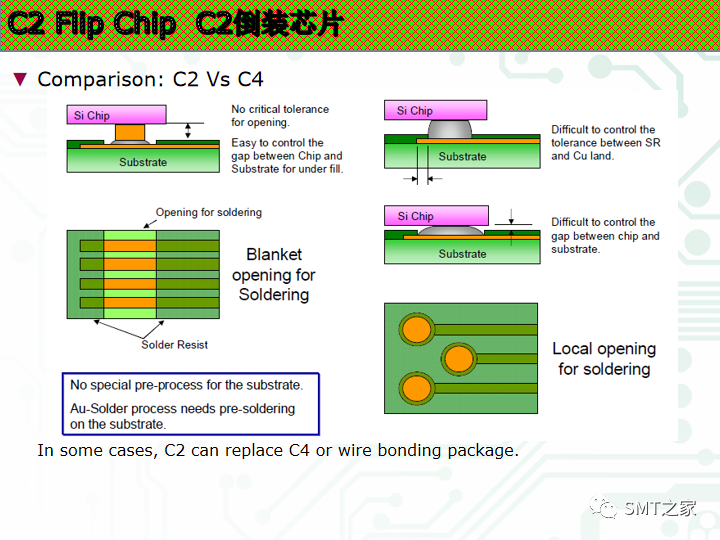
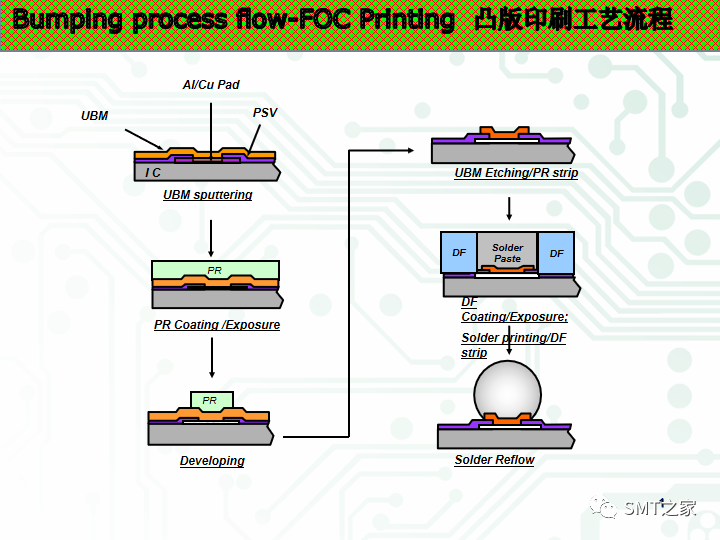
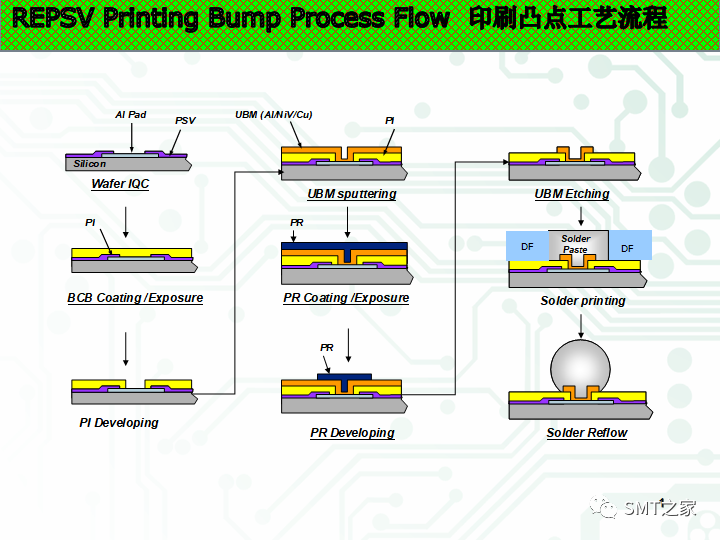
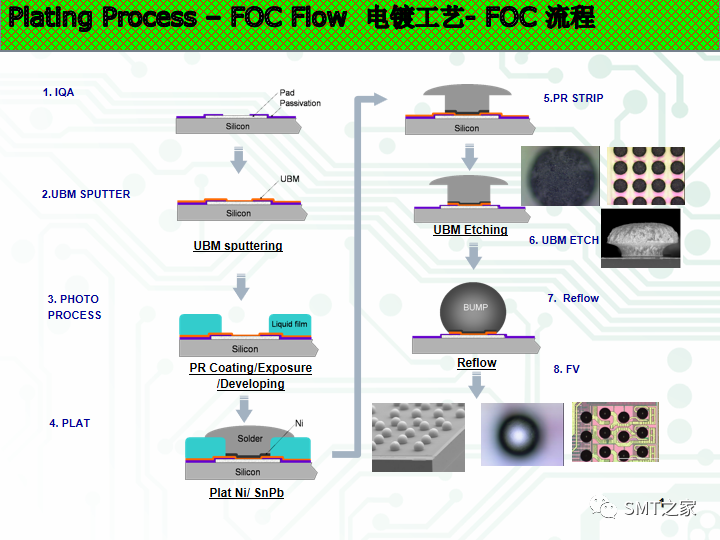
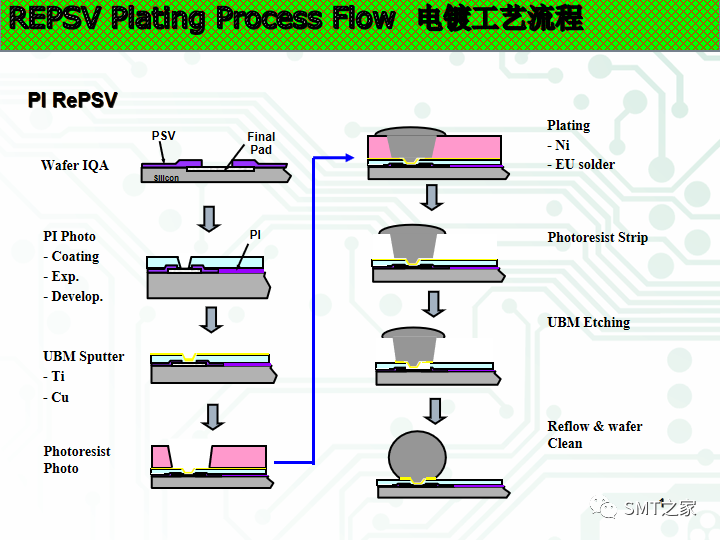
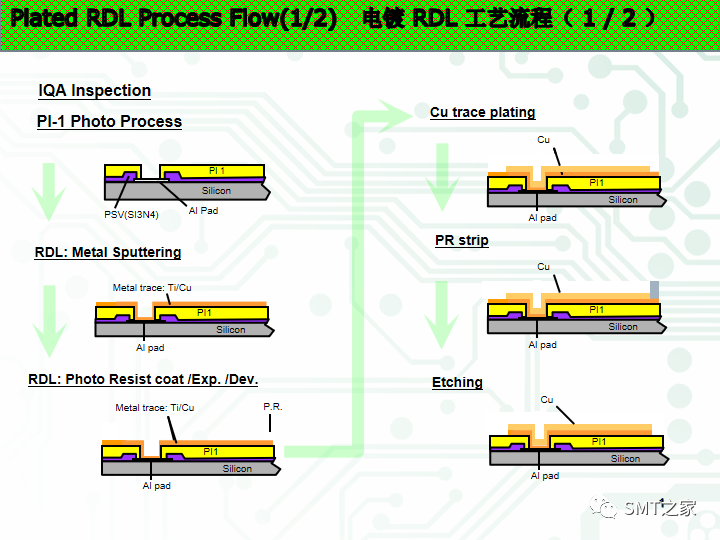
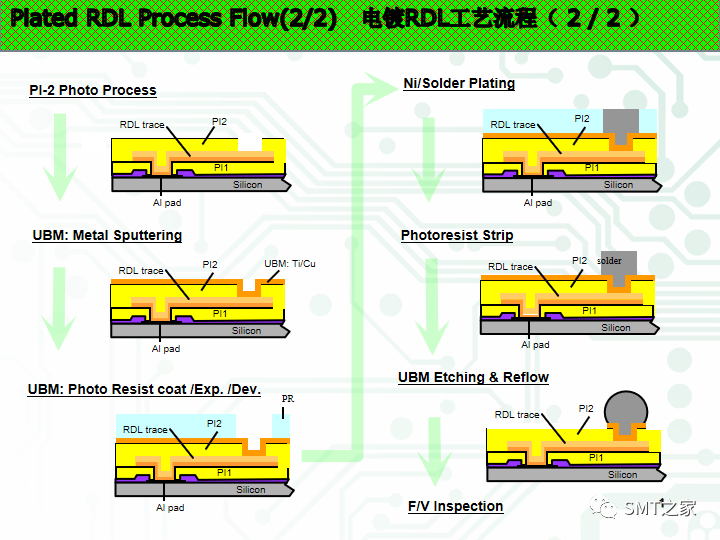
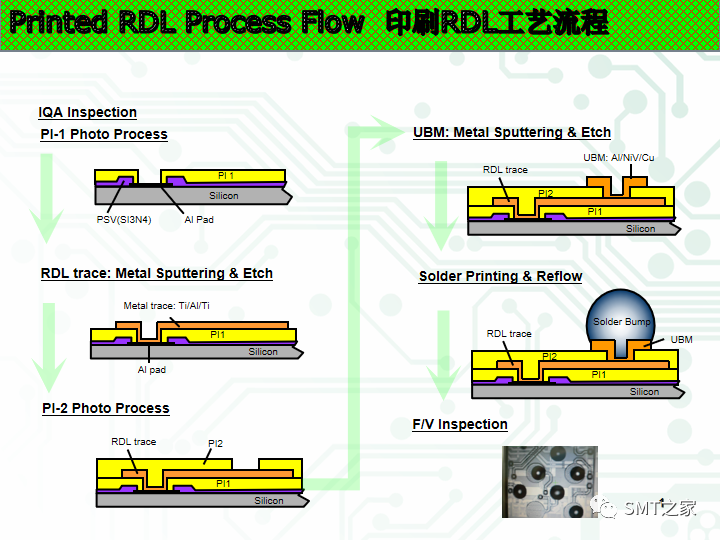
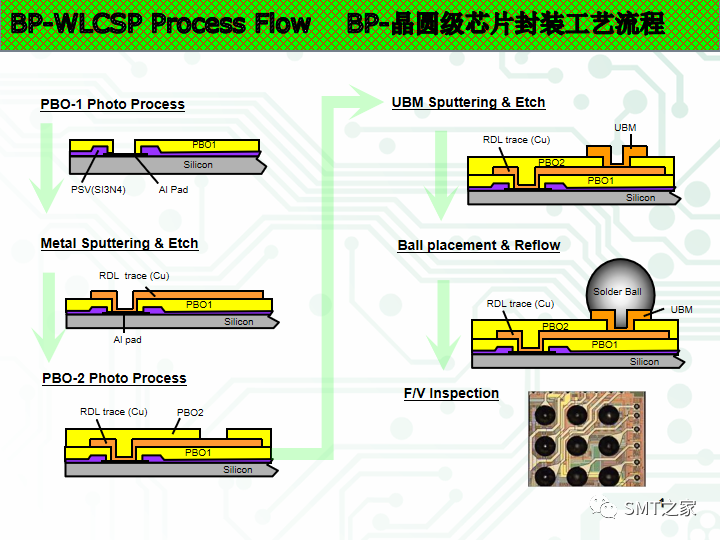
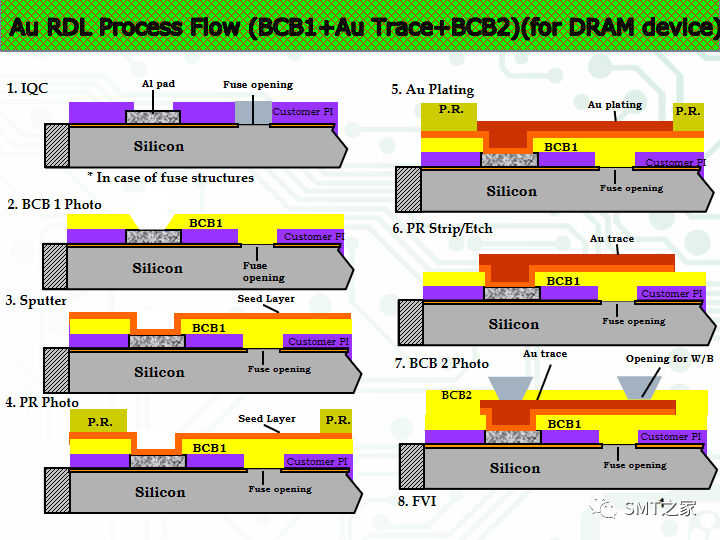
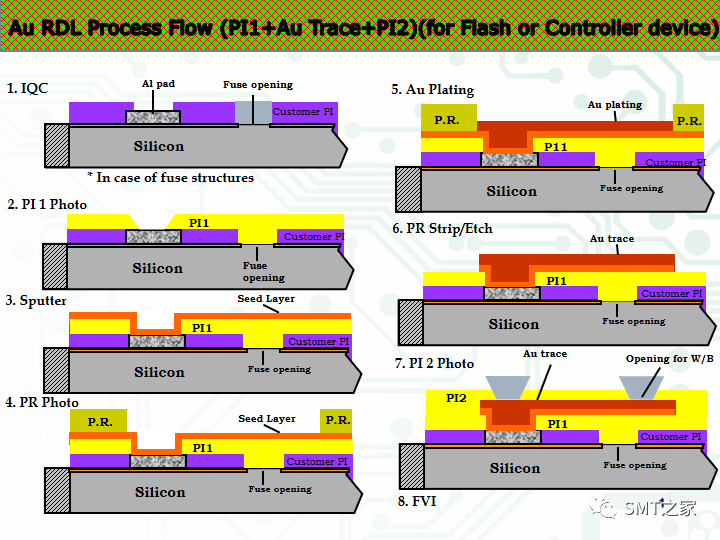
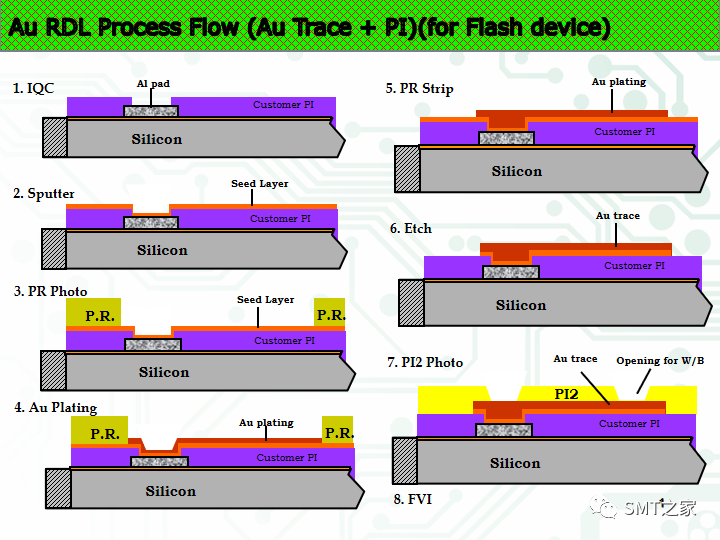
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體
+關注
關注
335文章
28599瀏覽量
232518 -
封裝
+關注
關注
128文章
8494瀏覽量
144783 -
3D封裝
+關注
關注
7文章
139瀏覽量
27660 -
先進封裝
+關注
關注
2文章
461瀏覽量
510
發布評論請先 登錄
相關推薦
熱點推薦
技術科普 | 下一代芯片技術,新突破
一項新研究表明,利用“混沌邊緣”可大大簡化電子芯片,混沌邊緣可使長金屬線放大信號并充當超導體,從而減少對單獨放大器的需求并降低功耗。研究人員發現了“混沌邊緣”如何幫助電子芯片克服信號損失,從而使芯片變得更簡單、更高效。通過在半穩定材料上使用金屬線,該方法可以使長金屬線像超導體一樣發揮作用并放大信號,通過消除對晶體管放大器的需求并降低功耗,有可能改變芯片設計。

先進封裝的技術趨勢
半導體封裝已從傳統的 1D PCB 設計發展到晶圓級的尖端 3D 混合鍵合。這一進步允許互連間距在個位數微米范圍內,帶寬高達 1000 GB/s,同時保持高能效。先進半導體封裝技術的核

先進封裝技術的類型簡述
隨著半導體技術的不斷發展,先進封裝作為后摩爾時代全球集成電路的重要發展趨勢,正日益受到廣泛關注。受益于AI、服務器、數據中心、汽車電子等下游強勁需求,半導體封裝朝著多功能、小型化、便攜

AI真·煉丹:整整14天,無需人類參與
為了科普CPU在AI推理新時代的玩法,量子位開設了《最“in”AI》專欄,將從技術科普、行業案例、實戰優化等多個角度全面解讀。我們希望通過這個專欄,讓更多的人了解英特爾? 架構CPU在AI推理加速
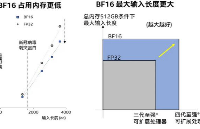
英特爾攜手日企加碼先進封裝技術
英特爾公司近日在半導體技術領域再有大動作,加碼先進封裝技術,并與14家日本企業達成深度合作。此次合作中,英特爾創新性地租用夏普閑置的LCD面板廠,將其作為





 先進封裝技術科普
先進封裝技術科普



















評論