晶圓切割(即劃片)是芯片制造工藝流程中一道不可或缺的工序,在晶圓制造中屬于后道工序。晶圓切割就是將做好芯片的整片晶圓按芯片大小分割成單一的芯片(晶粒)。
最早的晶圓是用切片系統進行切割(劃片)的,這種方法以往占據了世界芯片切割市場的較大份額,特別是在非集成電路晶圓切割領域。鉆石鋸片(砂輪)切割方法是較為常見的晶圓切割方法。新型切割方式有采用激光進行無切割式加工的。
晶圓切割工藝流程主要包括:繃片、切割、UV照射。
晶圓切割將一個晶圓上單獨的die通過高速旋轉的金剛石刀片切割開來,形成獨立的單顆的晶片,為后續工序做準備。晶圓切割需要用到特定的切割機刀片。
繃片是一個切割前的晶圓固定工序,在晶圓的背面貼上一層藍膜,并固定在一個金屬框架上,以利于后面切割。
切割過程中需要用去離子水(DI純水)沖去切割產生的硅渣和釋放靜電,去離子水由專業制備的小型設備「純水機」制備。
UV照射是用紫外線照射切割完的藍膜,降低藍膜的粘性,方便后續挑粒。
P.S.:OFweek君不是技術出身,現學現賣的這種概括文章,對于產業中的各種基礎概念無法做到非常準確的描述。若讀者朋友們對于文章內容準確性有異議,歡迎添加OFweek君微信(hepinggui2010)告知。若相關內容能形成完整的文章,OFweek君也可以署名文章投稿的形式,將相應內容發表在OFweek旗下各個內容平臺上。感謝大家的支持!
-
芯片
+關注
關注
459文章
52165瀏覽量
436087 -
晶圓
+關注
關注
52文章
5118瀏覽量
129160
發布評論請先 登錄
從晶圓到芯片:劃片機在 IC 領域的應用
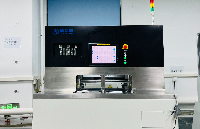





 如何做晶圓切割(劃片),晶圓切割的工藝流程
如何做晶圓切割(劃片),晶圓切割的工藝流程







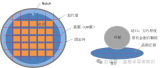













評論