晶圓經過前道工序后芯片制備完成,還需要經過切割使晶圓上的芯片分離下來,最后進行封裝。不同厚度晶圓選擇的晶圓切割工藝也不同:
厚度100um以上的晶圓一般使用刀片切割;
厚度不到100um的晶圓一般使用激光切割,激光切割可以減少剝落和裂紋的問題,但是在100um以上時,生產效率將大大降低;
厚度不到30um的晶圓則使用等離子切割,等離子切割速度快,不會對晶圓表面造成損傷,從而提高良率,但是其工藝過程更為復雜;
在晶圓切割過程中,事先會在晶圓上貼敷膠膜,以便保證更安全的“切單”,其主要作用有下面幾個方面。
固定和保護晶圓在劃片操作時,需要對晶圓進行精確切割。晶圓通常很薄且脆,UV 膠帶能將晶圓牢固地粘貼在框架或載片臺上,防止晶圓在切割過程中發生位移、晃動,確保切割的精度和準確性。 它可以為晶圓提供良好的物理保護,避免切割過程中可能出現的外力沖擊、摩擦等對晶圓造成損傷,如產生裂紋、崩邊等缺陷,保護晶圓表面的芯片結構及電路完好。
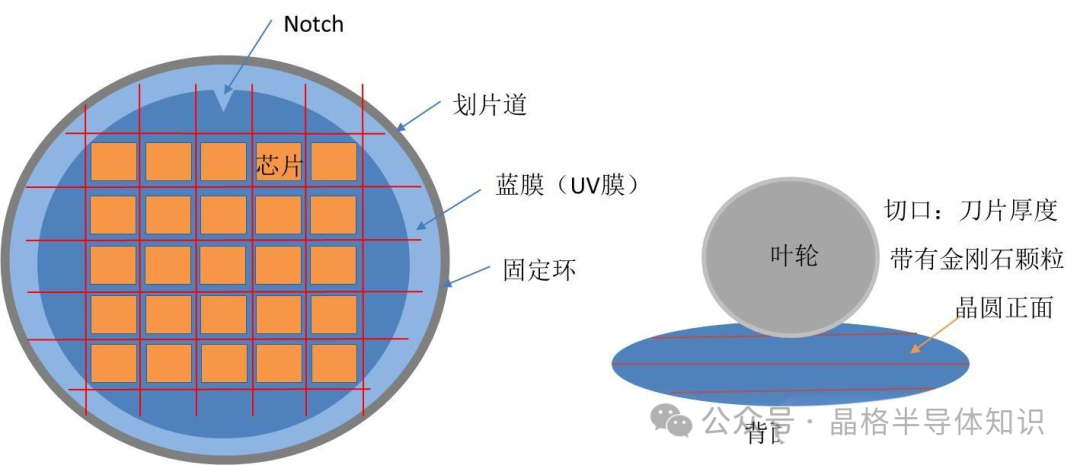
便于切割操作UV 膠帶具有合適的彈性和柔韌性,在切割刀片切入時能夠適度變形,使切割過程更加順暢,減少切割阻力對刀片和晶圓的不良影響,有助于提高切割質量和刀片的使用壽命。 其表面特性能夠使切割產生的碎屑較好地附著在膠帶上,而不會四處飛濺,便于后續對切割區域的清理,保持工作環境相對清潔,也避免了碎屑對晶圓及其他設備造成污染或干擾。
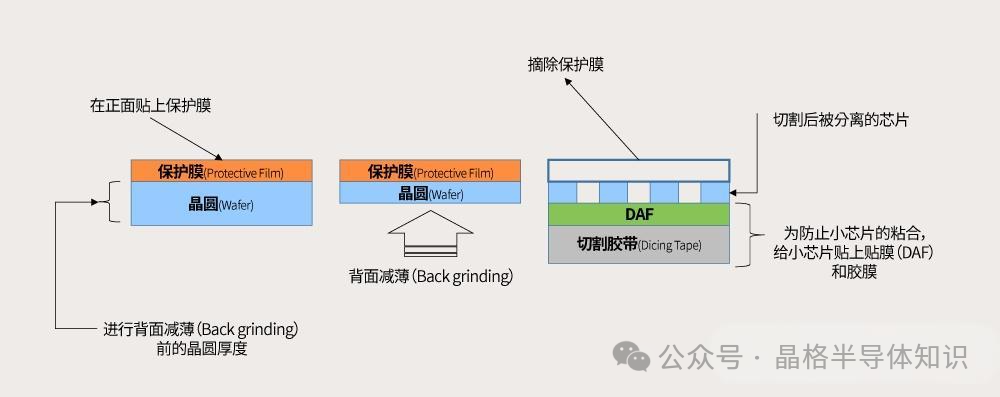
易于后續處理在晶圓切割完成后,通過照射特定波長和強度的紫外線,可以使 UV 膠帶的粘性迅速降低甚至完全失去粘性,從而能夠輕松地將切割后的芯片從膠帶上分離下來,方便進行芯片的后續封裝、測試等工藝流程,而且這種分離過程對芯片的損傷風險極小。
-
芯片
+關注
關注
459文章
52148瀏覽量
436008 -
晶圓
+關注
關注
52文章
5113瀏覽量
129157 -
UV
+關注
關注
0文章
71瀏覽量
2915
原文標題:晶圓劃片為什么用UV膠帶?
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 晶圓劃片為什么用UV膠帶
晶圓劃片為什么用UV膠帶


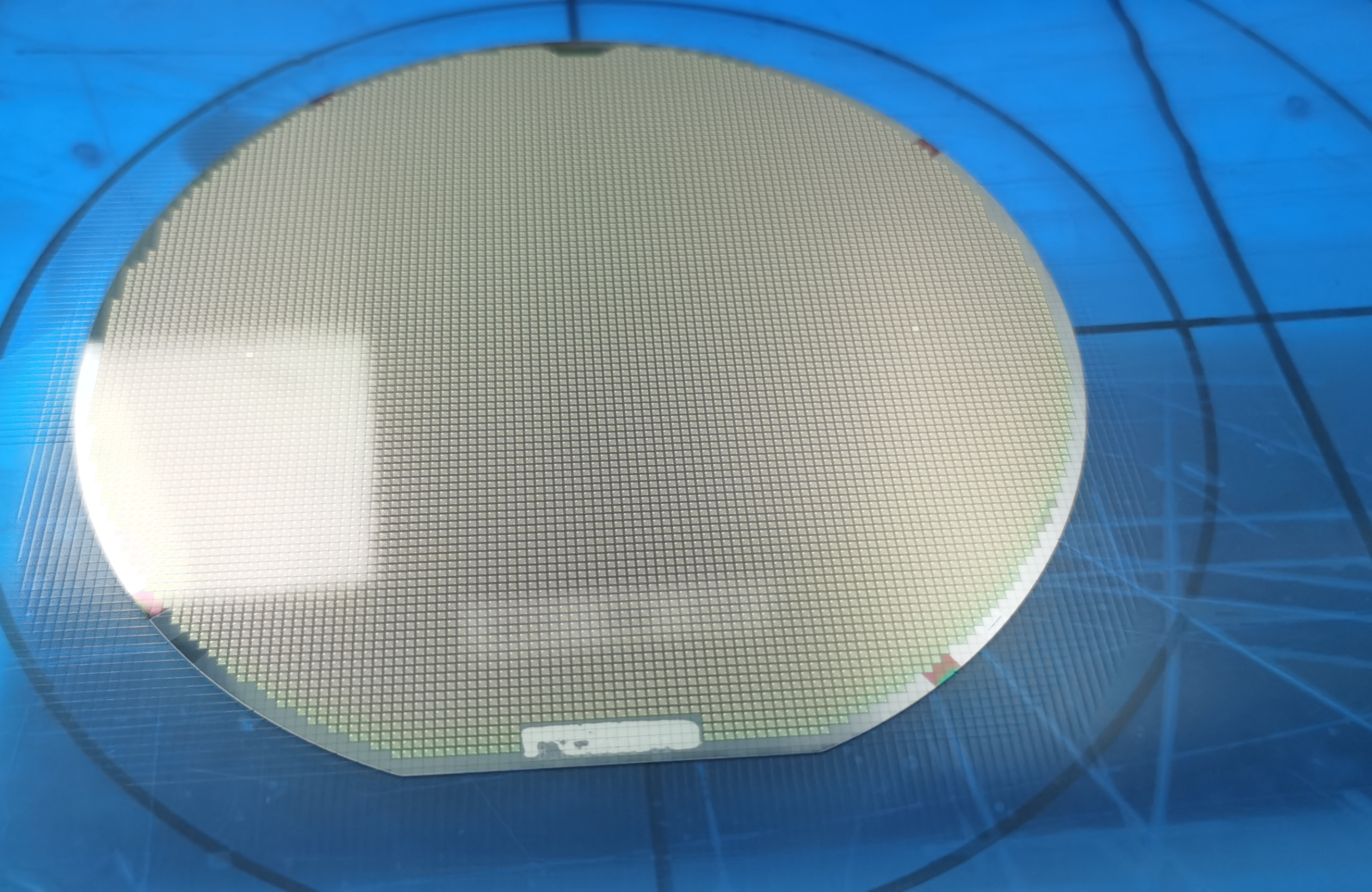
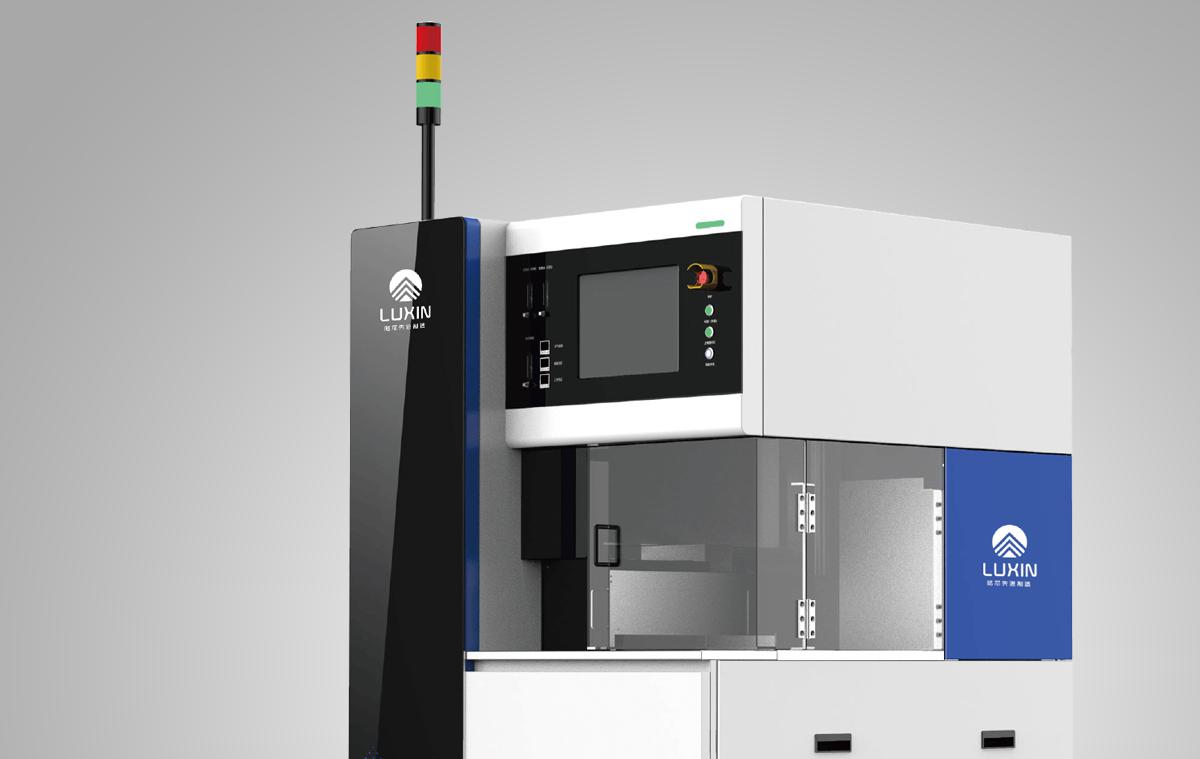














評論