除了5nm、4nm、3nm、2nm工藝進展和規劃,臺積電近日還公布了不少新的芯片封裝技術,畢竟隨著高性能計算需求的與日俱增、半導體工藝的日益復雜,單靠升級制程工藝已經不能解決所有問題。

臺積電的CoWoS-S晶圓級封裝技術已經使用了很多年,大大突破了光刻掩膜尺寸的限制,芯片越做越大,內部封裝的小芯片也越來越多。
2016年的時候,臺積電做到了1.5倍于掩模尺寸的規模,單芯片內部可封裝4顆HBM高帶寬內存芯片,去年達成2x尺寸、6顆HBM,并計劃明年實現3x尺寸、8顆HBM。
根據臺積電最新公布的規劃,2023年的時候,他們將把芯片做到4倍于掩模尺寸的程度,內部可以封裝多達12顆HBM,再加上主芯片就有13顆,而總面積估計可達驚人的3200平方毫米。
作為對比,NVIDIA安培架構的GA100核心面積為826平方毫米,7nm工藝,540億晶體管,也不過它的大約四分之一。
HBM技術發展迅速,雖然還不確定2023年會是什么樣子,但無論容量還是帶寬都將超越很多人的想象,上百GB、TB/s應該都不是事兒。
目前最先進的三星HBM2e已經做到單顆12層堆疊,數據傳輸率3200MT/s,帶寬至少4.92TB/s。
-
芯片
+關注
關注
460文章
52510瀏覽量
440855 -
臺積電
+關注
關注
44文章
5755瀏覽量
169793 -
HBM
+關注
關注
2文章
412瀏覽量
15240
發布評論請先 登錄
美國芯片“卡脖子”真相:臺積電美廠芯片竟要運回臺灣封裝?
臺積電2025年起調整工藝定價策略
消息稱臺積電完成CPO與先進封裝技術整合,預計明年有望送樣
臺積電推出“超大版”CoWoS封裝,達9個掩模尺寸
OpenAI攜手博通、臺積電打造內部芯片
三星電子或2026年將HBM4基底技術生產外包給臺積電
GPU集成12顆HBM4,臺積電CoWoS-L、CoW-SoW技術演進
三星與臺積電合作開發無緩沖HBM4 AI芯片
三星攜手臺積電,共同研發無緩沖HBM4 AI芯片技術
臺積電封裝,新規劃
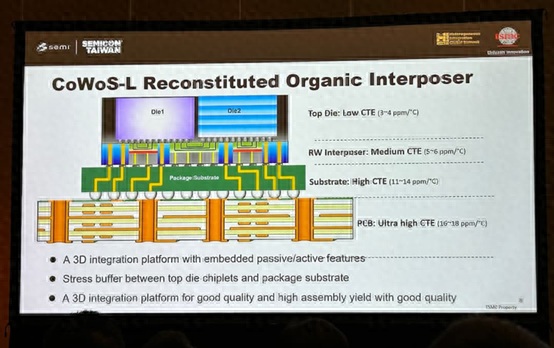





 臺積電將在2023年完成3200mm2芯片,內部封裝12顆HBM
臺積電將在2023年完成3200mm2芯片,內部封裝12顆HBM












評論