來源:半導(dǎo)體芯聞綜合
臺積電高效能封裝整合處處長侯上勇3 日在Semicon Taiwan 2024 中舉行專題演講,表示被視為是三種CoWoS 產(chǎn)品中,能滿足所有條件的最佳解決方案,因此會從CoWoS-S 逐步轉(zhuǎn)移至CoWoS -L,并稱CoWoS-L 是未來路線圖要角。
侯上勇指出,臺積電過去的三場演講,于2012 年發(fā)表3D-IC 模組、TSV、微凸塊(micro bond)和臨時載板制程;2016 年第二次講座,重點(diǎn)是HBM 邏輯整合;2020 年第三場則確定矽中介層可擴(kuò)展三倍光罩尺寸;現(xiàn)在則是第四個講座的最佳時機(jī)。
侯上勇認(rèn)為,由于頂部芯片(Top Die)成本非常高,CoWoS-L 是比CoWoS-R、CoWoS-S 更能滿足所有條件的最佳解,且因?yàn)榫哂徐`活性,可在其中介層實(shí)現(xiàn)異質(zhì)整合,會有其專精的尺寸與功能。
他提到,CoWoS-L 可相容于各式各樣的高效能頂級芯片,例如先進(jìn)邏輯、SOIC 和高頻寬記憶體。
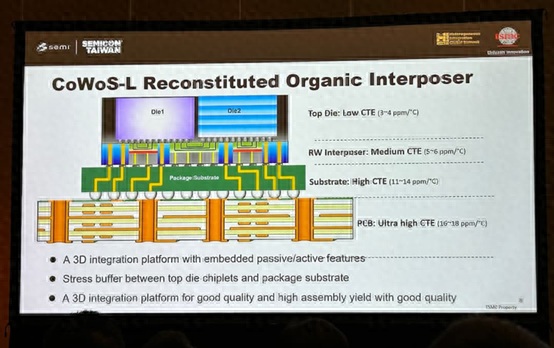
此外,臺積電也根據(jù)整體系統(tǒng)散熱方案開發(fā)各種散熱解決方案,而共同封裝光學(xué)(CPO)開發(fā)工作也在進(jìn)行中。侯上勇指出,在CoWoS 封裝中使用光學(xué)引擎(COUPE)的CPO,將使每瓦效能達(dá)到新里程碑。他也提到SOW(System-on-Wafer)技術(shù),表示過去已經(jīng)用于特斯拉,公司也在幫Cerebras 代工的wafer level chip。

臺積電CoW-SoW 預(yù)計(jì)2027年量產(chǎn)
隨著IC設(shè)計(jì)業(yè)者透過增加芯片尺寸提高處理能力,考驗(yàn)芯片制造實(shí)力。輝達(dá)AI芯片Blackwell,被CEO黃仁勛譽(yù)為「非常非常大的GPU」,而確實(shí)也是目前業(yè)界面積最大的GPU,由兩顆Blackwell芯片拼接而成,并採用臺積電4納米制程,擁有2,080億個電晶體,然而難免遇到封裝方式過于復(fù)雜之問題;臺灣坐擁全球最先進(jìn)芯片制造,未來有望成為AI重要硅島。
CoWoS-L封裝技術(shù),使用LSI(本地硅互連)橋接RDL(硅中介層)連接晶粒,傳輸速度可達(dá)10/TBs左右;不過封裝步驟由于橋接放置精度要求極高,稍有缺陷都可能導(dǎo)致價值4萬美元的芯片報廢,從而影響良率及獲利。
法人透露,由于GPU晶粒、LSI橋接、RDL中介層和主基板之間的熱膨脹系數(shù)(CTE)相異,導(dǎo)致芯片翹曲、系統(tǒng)故障。為提升良率,輝達(dá)重新設(shè)計(jì)GPU芯片頂部金屬層和凸點(diǎn)。不只是AI芯片RTO(重新流片)修改設(shè)計(jì),據(jù)供應(yīng)鏈透露,準(zhǔn)備發(fā)布之50系列的顯卡也需要RTO,上市時間較原本遞延。
芯片設(shè)計(jì)問題將不會只是輝達(dá)所獨(dú)有。供應(yīng)鏈透露,這類問題只會越來越多,不過為了消除缺陷或?yàn)樘岣吡悸识兏酒O(shè)計(jì)于業(yè)內(nèi)相當(dāng)常見。AMD執(zhí)行長蘇姿豐曾透露,隨著芯片尺寸不斷擴(kuò)大,制造復(fù)雜度將不可避免地增加。次世代芯片需要在效能和功耗方面取得突破,才能滿足AI數(shù)據(jù)中心對算力的巨大需求。
以開發(fā)全球最大AI芯片的Cerebras指出,多芯片組合技術(shù)難度將呈現(xiàn)指數(shù)級成長,強(qiáng)調(diào)「一整片晶圓就是一個處理器」,Cerebras的Wafer-Scale Engine(WSE)系列即採用AI領(lǐng)域知名的「晶圓級處理器」。依照臺積電一直在發(fā)展晶圓級系統(tǒng)整合技術(shù) InFO-SoW(System-on-Wafer),Dojo超級電腦訓(xùn)練區(qū)塊(Training Tile)就是基于臺積電InFO-SoW并已量產(chǎn)的首款解決方案。
因應(yīng)大芯片趨勢、及AI負(fù)載需要更多HBM,臺積電計(jì)劃結(jié)合InFO-SoW和SoIC為CoW-SoW,將記憶體或邏輯芯片堆迭于晶圓上,并預(yù)計(jì)在2027年量產(chǎn)。可預(yù)見的未來,將看到更多在整片晶圓上迭迭樂的巨無霸AI芯片出現(xiàn)。
臺積電直言,硅光大有可為
臺灣半導(dǎo)體制造公司和全球頂尖芯片設(shè)計(jì)商及供應(yīng)商正在加緊開發(fā)下一代硅光子解決方案,目標(biāo)是在未來三到五年內(nèi)使該技術(shù)投入生產(chǎn)。
他們的努力正值整個行業(yè)努力解決人工智能計(jì)算繁榮所需的大量能源和更快的數(shù)據(jù)傳輸速度之際。硅光子學(xué)將硅芯片與光學(xué)技術(shù)相結(jié)合,有望在這兩個方面取得進(jìn)步。
臺積電集成互連與封裝副總裁 KC Hsu 表示,硅光子市場尚處于起步階段,但從 2023 年開始將以 40% 的年復(fù)合增長率增長,到 2028 年將達(dá)到 5 億美元。Hsu 周二在 SEMICON 臺灣貿(mào)易展覽會前的一個技術(shù)論壇上發(fā)表了講話。
Hsu 表示:“增長的驅(qū)動力是高數(shù)據(jù)速率模塊的需求,用于提高光纖網(wǎng)絡(luò)容量,尤其是可插拔和共封裝光學(xué)器件 (CPO)。我們認(rèn)為 CPO 器件將成為未來五年內(nèi)高性能計(jì)算的重要平臺。”
但許在活動間隙對《日經(jīng)亞洲》表示,目前還很難確定量產(chǎn)時間表。他表示,這種尖端技術(shù)的商業(yè)化和大規(guī)模產(chǎn)出取決于客戶的支持和訂單。
共封裝光學(xué)器件是設(shè)計(jì)并直接集成到芯片封裝中的微型光學(xué)系統(tǒng)。與當(dāng)前數(shù)據(jù)中心建筑物中外部連接到人工智能服務(wù)器系統(tǒng)的“可插拔”解決方案相比,這是一種更先進(jìn)、更集成的方法。
Marvell 光學(xué)和云連接高級副總裁兼首席技術(shù)官 Radha Nagarajan 向《日經(jīng)新聞》表示,與目前的可插拔數(shù)據(jù)傳輸解決方案相比,采用共封裝光學(xué)元件可以“節(jié)省 30% 以上的功耗”。他表示,預(yù)計(jì)未來幾年 CPO 解決方案的部署將更加廣泛。
“目前已經(jīng)有一些 [CPO] 部署……但數(shù)量非常少,”Nagarajan 說道。“兩到三年后,你會看到數(shù)量回升。”
他補(bǔ)充說,應(yīng)用的瓶頸主要在于在芯片層面生產(chǎn)這種新型光學(xué)引擎,以及部署能夠容納它們的人工智能計(jì)算系統(tǒng)。這涉及重新設(shè)計(jì)人工智能芯片,將光學(xué)互連作為其結(jié)構(gòu)的內(nèi)部部分。
芯片材料供應(yīng)商 Soitec 業(yè)務(wù)部總經(jīng)理 Rachid Taibi 表示,Meta 和微軟等大型數(shù)據(jù)中心公司是支持 CPO 技術(shù)開發(fā)的公司之一,因?yàn)樗哂械凸牡膬?yōu)勢。
業(yè)界將硅光子技術(shù)視為實(shí)現(xiàn)人工智能、數(shù)據(jù)通信、6G 和量子計(jì)算等廣泛應(yīng)用的關(guān)鍵技術(shù)。與傳統(tǒng)數(shù)據(jù)傳輸技術(shù)相比,光傳輸更節(jié)能、延遲更低,這些特性有助于解決人工智能數(shù)據(jù)中心日益增長的熱量和能耗問題。
臺積電的許志強(qiáng)表示,將該技術(shù)從外部可插拔解決方案縮小到芯片封裝級別,可以實(shí)現(xiàn)更快的數(shù)據(jù)傳輸,并且每一代帶寬都可能翻倍。
然而,采用這項(xiàng)技術(shù)將需要整個供應(yīng)鏈中更多參與者的支持。
許世友在 SEMI 硅光子產(chǎn)業(yè)聯(lián)盟啟動儀式后表示:“硅光子生態(tài)系統(tǒng)仍處于早期階段,需要不斷發(fā)展。”
他說,構(gòu)建該技術(shù)的生態(tài)系統(tǒng)需要整個供應(yīng)鏈上的公司參與,從設(shè)計(jì)軟件供應(yīng)商新思科技(Synopsys)和楷登電子(Cadence Design Systems)、芯片開發(fā)商英偉達(dá)(Nvidia)和超威半導(dǎo)體(Advanced Micro Devices)等上游企業(yè),一直到人工智能服務(wù)器制造商富士康和廣達(dá)電腦等下游公司。
該新產(chǎn)業(yè)聯(lián)盟的成員包括臺積電、富士康、廣達(dá)電腦等 30 多家供應(yīng)商,以及全球最大的芯片封裝和測試供應(yīng)商日月光科技控股和領(lǐng)先的連接器供應(yīng)商 Bizlink。
【近期會議】
10月30-31日,由寬禁帶半導(dǎo)體國家工程研究中心主辦的“化合物半導(dǎo)體先進(jìn)技術(shù)及應(yīng)用大會”將首次與大家在江蘇·常州相見,邀您齊聚常州新城希爾頓酒店,解耦產(chǎn)業(yè)鏈?zhǔn)袌霾季郑ttps://w.lwc.cn/s/uueAru
11月28-29日,“第二屆半導(dǎo)體先進(jìn)封測產(chǎn)業(yè)技術(shù)創(chuàng)新大會”將再次與各位相見于廈門,秉承“延續(xù)去年,創(chuàng)新今年”的思想,仍將由云天半導(dǎo)體與廈門大學(xué)聯(lián)合主辦,雅時國際商訊承辦,邀您齊聚廈門·海滄融信華邑酒店共探行業(yè)發(fā)展!誠邀您報名參會:https://w.lwc.cn/s/n6FFne
聲明:本網(wǎng)站部分文章轉(zhuǎn)載自網(wǎng)絡(luò),轉(zhuǎn)發(fā)僅為更大范圍傳播。 轉(zhuǎn)載文章版權(quán)歸原作者所有,如有異議,請聯(lián)系我們修改或刪除。聯(lián)系郵箱:[email protected], 電話:0755-25988573
審核編輯 黃宇
-
臺積電
+關(guān)注
關(guān)注
44文章
5740瀏覽量
168965 -
封裝
+關(guān)注
關(guān)注
128文章
8509瀏覽量
144798
發(fā)布評論請先 登錄
臺積電最大先進(jìn)封裝廠AP8進(jìn)機(jī)
AMD或首采臺積電COUPE封裝技術(shù)
臺積電擴(kuò)大先進(jìn)封裝設(shè)施,南科等地將增建新廠
臺積電2025年起調(diào)整工藝定價策略
臺積電CoWoS封裝A1技術(shù)介紹






 臺積電封裝,新規(guī)劃
臺積電封裝,新規(guī)劃










評論