電子發燒友網報道(文/黃晶晶)日前消息,臺積電計劃于2027年量產CoW-SoW(晶圓上系統)封裝技術,該技術是將InFO-SoW(集成扇出晶圓上系統)與SoIC(集成芯片系統)結合,把存儲器和邏輯芯片堆疊在晶圓上。這一技術的推進是為了應對更強大的人工智能芯片以及AI趨勢下集成更多HBM存儲芯片的需求。
臺積電的InFO-SoW已經用于Cerebras AI芯片、Tesla Dojo的處理器等上面。其中,Cerebras Systems打造的超大AI芯片,采用互連的方法將所有內核放在同一塊硅晶圓上,臺積電曾表示其扇出型封裝技術使芯片厚度減少20%,成本降低30%,同時互連功耗降低15%。也就是說數據移動快速且低功耗。而特斯拉Dojo超算系統集成25個D1芯片的訓練模塊,也是通過臺積電的InFO_SoW整合扇出技術來實現的。
而InFO-SoW主要還是以一種制造工藝進行生產,難以進行不同工藝Die的集成。CoW-SoW的出現能夠更好地整合邏輯芯片和存儲芯片的集成,并獲取更高的互聯帶寬。據臺積電介紹,CoW-SoW技術的面積可比當前光罩極限大40倍,并且可以將HBM容量擴展60倍。這將使人工智能和大型數據中心的巨型芯片的開發成為可能。
2024年6月黃仁勛宣布下一代數據中心GPU架構平臺Rubin將集成 HBM4 內存,Rubin GPU 和Rubin Ultra GPU預計分別于2026年和2027年發布。根據曝料,Rubin架構首款產品為R100,采用臺積電3nm EUV制造工藝,四重曝光技術,CoWoS-L封裝,預計2025年第四季度投產。Rubin GPU將配備8個HBM4芯片、 Rubin Ultra GPU 將集成12顆HBM4芯片。這也是英偉達首次在其AI芯片中使用12顆HBM 芯片。
這里的CoWoS-L是CoWoS提供三種不同的轉接板技術之一,是CoWoS未來發展的關鍵技術。根據臺積電的規劃,其將于2026年推出,可將中介層尺寸拓展至光罩極限的5.5倍,可支持12個HBM內存堆棧,也就是單一封裝中整合更多計算和存儲資源,進一步滿足AI性能的需求。
考慮到臺積電CoW-SoW技術計劃于2027年開始量產,外界認為有可能會被英偉達的Rubin Ultra采用。
另據早前的報道,SK 海力士希望將HBM4通過3D堆疊的方式直接集成在芯片上。外媒認為,Nvidia和SK海力士很可能會共同設計這種集成芯片,并借助臺積電進行代工。通過臺積電的晶圓鍵合技術將SK海力士的HBM4芯片直接堆疊到邏輯芯片上,HBM無需中介層。
市場調研機構Yole預測,先進封裝市場在2021-2027年間復合增長率將達到9.81%,到2027年市場規模將達到591億美元。此外,2.5D/3D封裝技術將實現顯著增長,預計其復合增長率將達到13.73%,到2027年2.5D/3D封裝市場規模預計將達180億美元。
誠然,AI性能的不斷提升需要依靠算力、存力和運力的綜合能力,單純的依靠先進制程來提升算力已不足夠。尤其是將大AI芯片與更多存儲更近距離的集成是AI性能不斷突破的關鍵,先進封裝對于AI芯片的優化起到越來越重要的作用。
-
臺積電
+關注
關注
44文章
5740瀏覽量
168944 -
gpu
+關注
關注
28文章
4910瀏覽量
130654 -
CoWoS
+關注
關注
0文章
154瀏覽量
10958 -
HBM
+關注
關注
1文章
408瀏覽量
15109 -
HBM4
+關注
關注
0文章
53瀏覽量
215
發布評論請先 登錄
HBM3E量產后,第六代HBM4要來了!






 GPU集成12顆HBM4,臺積電CoWoS-L、CoW-SoW技術演進
GPU集成12顆HBM4,臺積電CoWoS-L、CoW-SoW技術演進

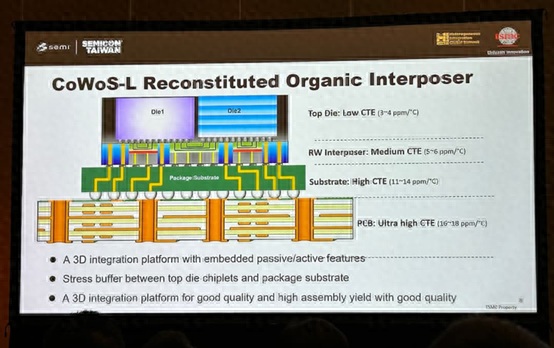










評論