半導體測量設備主要用于監測晶圓上膜厚、線寬、臺階高度、電阻率等工藝參數,實現器件各項參數的準確控制,進而保障器件的整體性能。橢偏儀主要用于薄膜工藝監測,基本原理為利用偏振光在薄膜上、下表面的反射,通過菲涅爾公式得到薄膜參數與偏振態的關系,計算薄膜的折射率和厚度。
Flexfilm費曼儀器作為薄膜測量技術革新者,致力于為全球工業智造提供精準測量解決方案,公司自主研發的全光譜橢偏儀提供高準確度、高速度和高穩定性的測量方案,保障薄膜沉積環節的量值統一,支撐半導體器件性能的精準控制,確保半導體制造的質量和效率。

橢偏儀測量原理
1
橢偏儀校準
flexfilm
用于校準橢偏儀的標準器為膜厚樣板,采用氧化工藝制備而成。薄膜氧化的過程是硅與水蒸氣、氧氣等氧化劑在高溫條件下化學反應產生二氧化硅。氧化過程中 , 氧和硅的價電子重新分配,形成 Si-O共價鍵。由于硅的原子密度和二氧化硅的分子密度不同,氧化后硅和二氧化硅的分界面會下降。隨著氧化薄膜的變厚,會形成一層致密層,氧化的速率會慢慢下降,符合迪爾 - 格羅夫的氧化動力學模型。
通常情況下,半導體工藝中氧化薄膜的厚度控制在2μm以內。如果需要制備更厚的氧化薄膜,可以選擇化學氣相沉積等方案。氧化過程在氧化爐中進行,需要嚴格控制溫度、氧化時間、濕度等條件。研制的 2~1 000 nm 標準樣片。
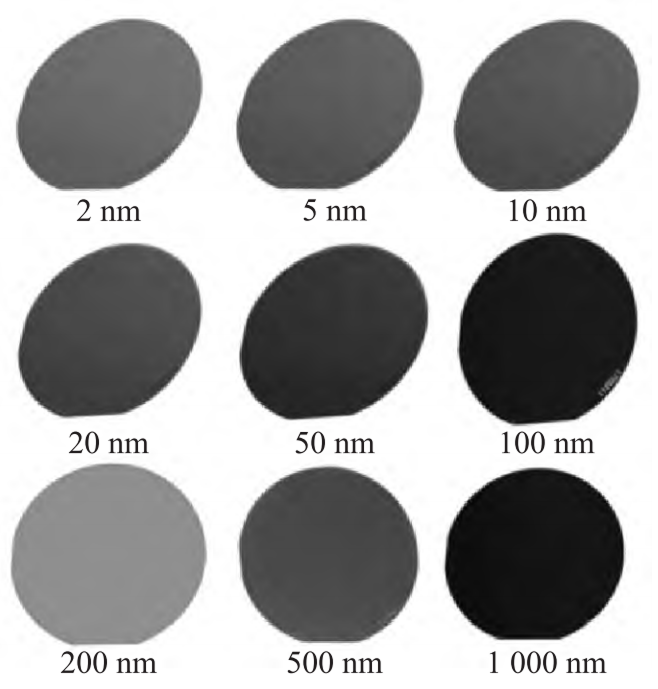
研制的 2~1 000 nm 膜厚標準樣片
2
橢偏儀的測量準確度
flexfilm
通常采用 X 射線光電子光譜儀(XPS)和光譜型橢偏儀等作為膜厚樣板的定值裝置。橢偏儀的校準依據JJG(軍工)14—2011《光學薄膜折射率和厚度測試儀》檢定規程,涉及的計量參數包括波長、入射角、偏振角、相位差、折射率以及膜厚等,其中主要計量參數是膜厚和折射率。通過橢偏儀對膜厚標準樣片中心的待測點重復測量六次,取平均值為測量結果,與標準值比較評價橢偏儀的測量準確度。
橢偏儀校準數據
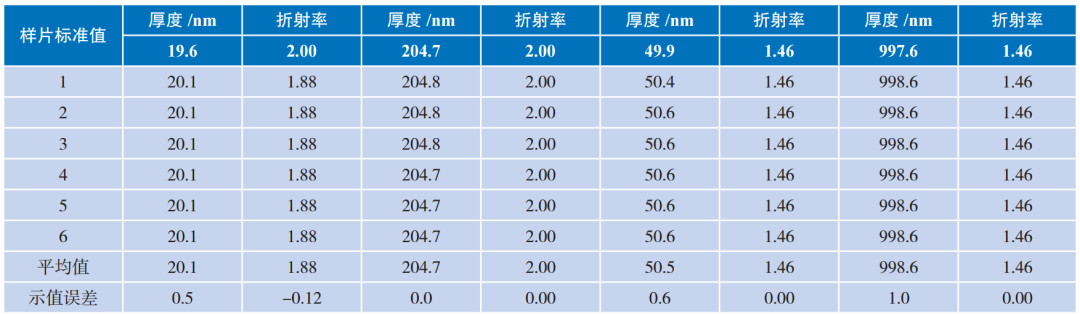
橢偏儀通過精準解析納米級膜厚與折射率,成為半導體薄膜沉積工藝不可或缺的監控工具。其計量數據不僅直接優化沉積參數,更支撐半導體量值溯源體系的核心決策——基于膜厚/折射率漂移趨勢,動態制定設備計量周期與應急響應機制,最終保障晶圓制造中薄膜特性的全局可控性。
Flexfilm全光譜橢偏儀
flexfilm

全光譜橢偏儀擁有高靈敏度探測單元和光譜橢偏儀分析軟件,專門用于測量和分析光伏領域中單層或多層納米薄膜的層構參數(如厚度)和物理參數(如折射率n、消光系數k)
- 先進的旋轉補償器測量技術:無測量死角問題。
- 粗糙絨面納米薄膜的高靈敏測量:先進的光能量增強技術,高信噪比的探測技術。
- 秒級的全光譜測量速度:全光譜測量典型5-10秒。
- 原子層量級的檢測靈敏度:測量精度可達0.05nm。
Flexfilm全光譜橢偏儀收集的數據可以用于分析半導體薄膜工藝中的問題,發現膜層厚度不符合要求后,可以調整沉積或刻蝕的時間和條件解決問題。Flexfilm費曼儀器的薄膜厚度測量技術貫穿于材料研發、生產監控到終端應用的全流程,尤其在半導體、新能源、汽車工業、醫療、航空航天等高精度領域不可或缺。
原文參考:《典型半導體工藝測量設備計量技術》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
半導體
+關注
關注
335文章
29024瀏覽量
239824 -
監測
+關注
關注
2文章
3998瀏覽量
45713 -
測量
+關注
關注
10文章
5286瀏覽量
113766
發布評論請先 登錄
VirtualLab Fusion應用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
全光譜橢偏儀測量:金屬/半導體TMDs薄膜光學常數與高折射率特性

薄膜厚度測量技術的綜述:從光譜反射法(SR)到光譜橢偏儀(SE)






 橢偏儀在半導體薄膜工藝中的應用:膜厚與折射率的測量原理和校準方法
橢偏儀在半導體薄膜工藝中的應用:膜厚與折射率的測量原理和校準方法

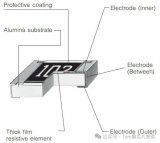













評論