在半導體芯片制造過程中,臺階結構的精確測量至關重要,通常采用白光干涉儀或步進儀等非接觸式測量設備進行監控。然而,SiO?/Si臺階高度標準在測量中存在的問題顯著影響了測量精度。傳統標準的上表面(SiO?)和下表面(Si)的折射率(n)和消光系數(k)差異導致了反射光的干涉相消現象,進而影響白光干涉儀的測量結果。為解決這一問題,本研究結合半導體濺射工藝,提出在臺階標準表面濺射一層金屬鉻(Cr)。通過光學理論分析,探討材料層對測量的影響,并采用Flexfilm探針式臺階儀與白光干涉儀進行對比測試,以驗證優化工藝的有效性。
1
測量偏差的理論分析
flexfilm
- 白光干涉儀的測量原理
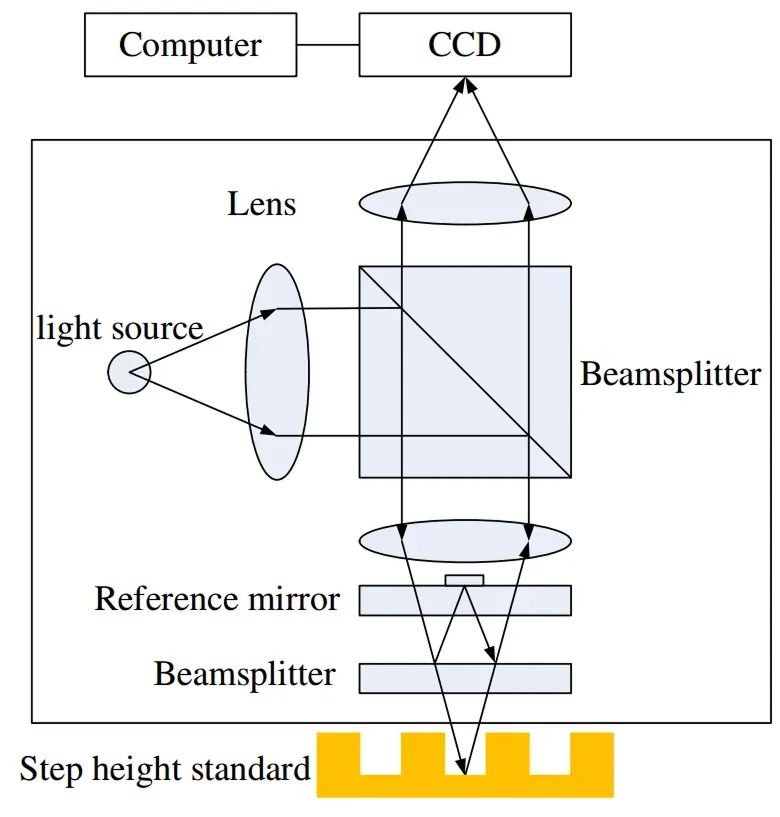
白光干涉儀的測量原理
白光干涉儀基于光的干涉效應測量臺階高度,如圖所示。光源發出的白光經分束器分成兩束,一束從參考鏡反射,另一束從被測表面反射。兩束光重新結合后形成干涉條紋,并通過CCD記錄,最終計算臺階高度。干涉條紋的可見度(M)由兩束光的強度比決定: 式中,I?, I? 為兩束光強度,Δ為光程差,λ為波長。
式中,I?, I? 為兩束光強度,Δ為光程差,λ為波長。
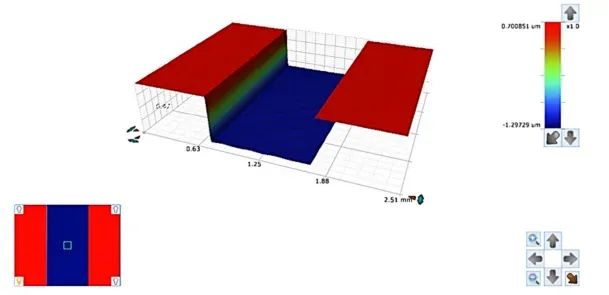
白光干涉儀掃描的臺階結構
2
測量誤差來源分析
flexfilm
傳統SiO?/Si臺階結構由于上下表面材料不同,導致反射率和相位差變化,影響干涉條紋的精確提取。根據菲涅耳反射理論,當光從一種介質進入另一種介質時,反射率(R)可表示為:

其中,n為折射率,k為消光系數。由于SiO?(n≈1.46)與Si(n≈3.88)的光學參數差異顯著,使得反射光強度變化,導致干涉儀測量偏差。

臺階高度標準件測試結果對比
3
臺階標準制備工藝優化
flexfilm
- 標準制備流程
傳統的SiO?/Si臺階制備工藝包括:1.熱氧化(SiO?層生長)2.旋涂光刻膠3.曝光與顯影(1:1掩膜接觸式光刻)4. 干法/濕法蝕刻(優化臺階結構)5.去膠(H?SO?/H?O?混合清洗)
- 磁控濺射金屬層改進
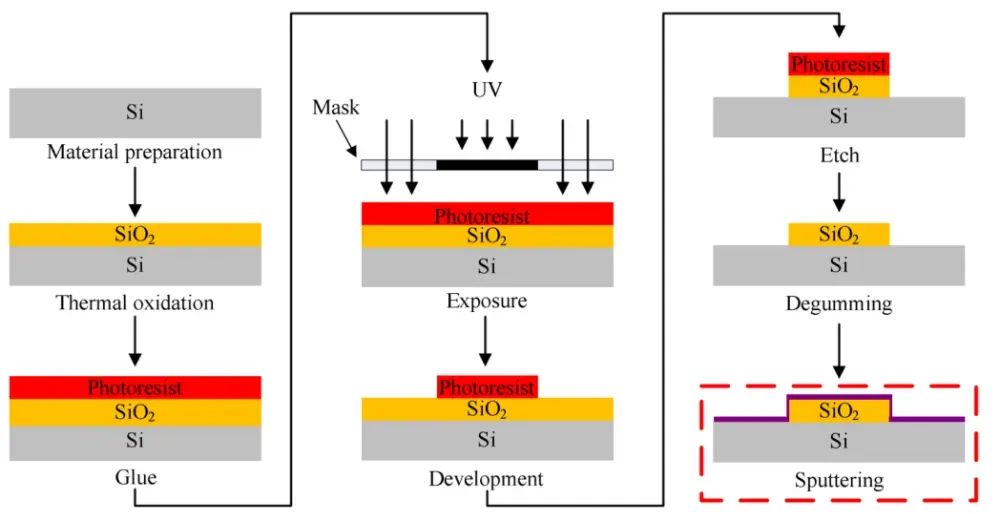
[標準件] 制備工藝的改進
為解決光學參數差異問題,本研究在去膠后增加一步Cr濺射工藝。Cr具有高折射率(n≈3.18)、硬度和耐腐蝕性,可有效覆蓋SiO?/Si表面,使上下表面光學參數均一化。采用磁控濺射技術,確保金屬層厚度均勻。
- 改進后臺階標準的實驗驗證
制備不同標稱高度(20–1000 nm)的臺階標準,采用兩種方法測量:臺階儀(基準測量):接觸式測量,激光干涉儀校準,ABay誤差補償。白光干涉儀(非接觸式測量):比較兩種方法的數據,分析誤差大小。

實驗數據表明,濺射Cr層后的臺階標準測量誤差<1%,驗證了工藝優化的有效性。本研究通過濺射金屬鉻(Cr)層于SiO?/Si臺階高度標準表面,成功解決了白光干涉儀的測量偏差問題,顯著提升精度至1%以內。實驗表明,該方案工藝兼容半導體制造流程(熱氧化/蝕刻后添加濺鍍),有效消除了上下表面光學參數(n和k)差異導致的誤差,適用于20–1000 nm量程的計量需求。
Flexfilm探針式臺階儀
flexfilm

在半導體、光伏、LED、MEMS器件、材料等領域,表面臺階高度、膜厚的準確測量具有十分重要的價值,尤其是臺階高度是一個重要的參數,對各種薄膜臺階參數的精確、快速測定和控制,是保證材料質量、提高生產效率的重要手段。
- 配備500W像素高分辨率彩色攝像機
- 亞埃級分辨率,臺階高度重復性1nm
- 360°旋轉θ平臺結合Z軸升降平臺
- 超微力恒力傳感器保證無接觸損傷精準測量
通過使用高精度的Flexfilm探針式臺階儀作為比對標尺,對開發的標稱范圍20~1000 nm的帶鉻鍍層臺階標準件高度進行了嚴格評價。實驗數據清晰表明,鍍層成功將白光干涉儀的測量相對誤差抑制在±0.83%以內(平均值絕對值<1%),相比未鍍層的“裸”SiO?/Si標準件精度提升顯著。此方案為半導體精密計量提供了可靠工具,具有潛力在更廣泛的光學測量環境中推廣應用。原文出處:《Effect analysis of surface metal layer on step height standard》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
半導體
+關注
關注
335文章
28963瀏覽量
238758 -
測量
+關注
關注
10文章
5275瀏覽量
113619
發布評論請先 登錄
晶圓表面形貌及臺階高度測量方法

白光干涉儀測量臺階高度有哪些優勢

白光干涉儀測量臺階高度有哪些優勢
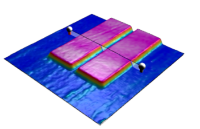





 臺階高度的測量標準丨在臺階儀校準下半導體金屬鍍層實現測量誤差<1%
臺階高度的測量標準丨在臺階儀校準下半導體金屬鍍層實現測量誤差<1%

















評論