ICP(Inductively Coupled Plasma,電感耦合等離子體)刻蝕技術(shù)是半導體制造中的一種關(guān)鍵干法刻蝕工藝,廣泛應用于先進集成電路、MEMS器件和光電子器件的加工。以下是關(guān)于ICP刻蝕技術(shù)的詳細介紹:
1. ICP刻蝕的基本原理
ICP刻蝕通過電感耦合方式產(chǎn)生高密度等離子體,利用物理和化學作用去除襯底材料。其核心過程包括:
等離子體生成:通過射頻(RF)線圈在真空腔體內(nèi)產(chǎn)生強電場,電離氣體(如CF?、SF?、Cl?等)形成高濃度的等離子體。
活性粒子轟擊:等離子體中的離子和自由基與襯底表面發(fā)生化學反應(如氟基氣體蝕硅生成SiF?),同時離子物理轟擊增強刻蝕方向性。
副產(chǎn)物排出:反應生成的揮發(fā)性物質(zhì)(如SiF?、CO?等)由真空系統(tǒng)抽離腔體。
2. ICP刻蝕設(shè)備的核心結(jié)構(gòu)
ICP設(shè)備主要由以下部分組成:
真空腔體:容納晶圓和等離子體反應區(qū)域,通常由耐蝕材料(如鋁或石英)制成。
射頻(RF)源:
ICP線圈(通常為13.56 MHz):產(chǎn)生電感耦合等離子體。
偏壓電極(通常為低頻RF或直流):控制離子轟擊能量和方向性。
氣體分配系統(tǒng):精確調(diào)節(jié)蝕刻氣體(如SF?、Cl?)和惰性載氣(如Ar)的流量。
溫度控制系統(tǒng):維持晶圓溫度穩(wěn)定,避免過熱損傷。
3. ICP刻蝕的關(guān)鍵特點
高深寬比:通過調(diào)控離子轟擊能量和化學腐蝕速率,實現(xiàn)深孔、窄縫等高深寬比結(jié)構(gòu)的刻蝕(如TSV、FinFET鰭片)。
各向異性:離子垂直轟擊襯底,側(cè)向腐蝕極小,圖形邊緣陡峭。
高精度控制:可獨立調(diào)節(jié)等離子體密度、離子能量、氣體成分等參數(shù),適應不同材料和結(jié)構(gòu)需求。
選擇性刻蝕:通過選擇合適的氣體和工藝參數(shù),優(yōu)先蝕刻目標材料(如硅、金屬),保護掩膜層(如光刻膠或硬質(zhì)掩膜)。
4. ICP刻蝕的主要應用領(lǐng)域
集成電路制造:
晶體管結(jié)構(gòu)(如多晶硅柵極、源漏極)。
金屬互連層的通孔、溝槽刻蝕。
三維集成中的穿透硅通孔(TSV)。
MEMS器件:
硅基懸空結(jié)構(gòu)(如加速度計、陀螺儀的空氣懸架)。
深槽刻蝕(如微流體通道、腔體)。
光電子器件:
Ⅲ-Ⅴ族化合物(如GaAs、InP)的圖形化。
5. ICP刻蝕的工藝參數(shù)與調(diào)控
氣體類型與流量:
氟基氣體(如SF?、CF?):用于硅或金屬的化學腐蝕。
氯基氣體(如Cl?、BCl?):常用于氧化物或金屬刻蝕。
惰性氣體(如Ar):調(diào)節(jié)離子轟擊強度。
射頻功率:
ICP功率:影響等離子體密度和反應速率。
偏壓功率:控制離子轟擊能量和方向性。
溫度與壓力:低溫利于減少熱損傷,低氣壓可提升等離子體均勻性。
刻蝕時間:決定刻蝕深度,需與停止層或自動檢測結(jié)合防止過刻。
審核編輯 黃宇
-
ICP
+關(guān)注
關(guān)注
0文章
75瀏覽量
13142 -
刻蝕
+關(guān)注
關(guān)注
2文章
202瀏覽量
13327
發(fā)布評論請先 登錄
一文詳解濕法刻蝕工藝

半導體boe刻蝕技術(shù)介紹
半導體制造關(guān)鍵工藝:濕法刻蝕設(shè)備技術(shù)解析

最全最詳盡的半導體制造技術(shù)資料,涵蓋晶圓工藝到后端封測
中微公司ICP雙反應臺刻蝕機Primo Twin-Star取得新突破

芯片制造中的淺溝道隔離工藝技術(shù)
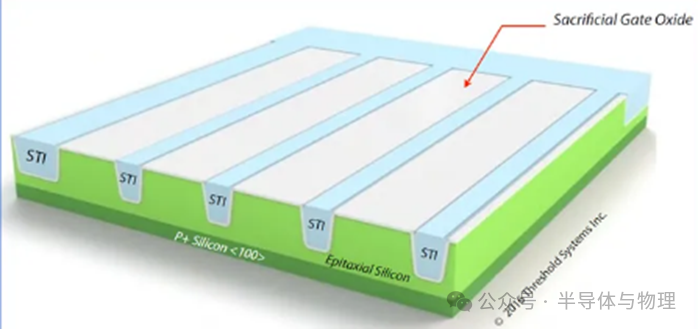
ALD和ALE核心工藝技術(shù)對比
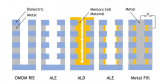
深入剖析半導體濕法刻蝕過程中殘留物形成的機理
半導體濕法刻蝕殘留物的原理
半導體濕法和干法刻蝕
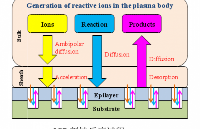
半導體濕法刻蝕設(shè)備加熱器的作用
半導體芯片制造技術(shù)之干法刻蝕工藝詳解
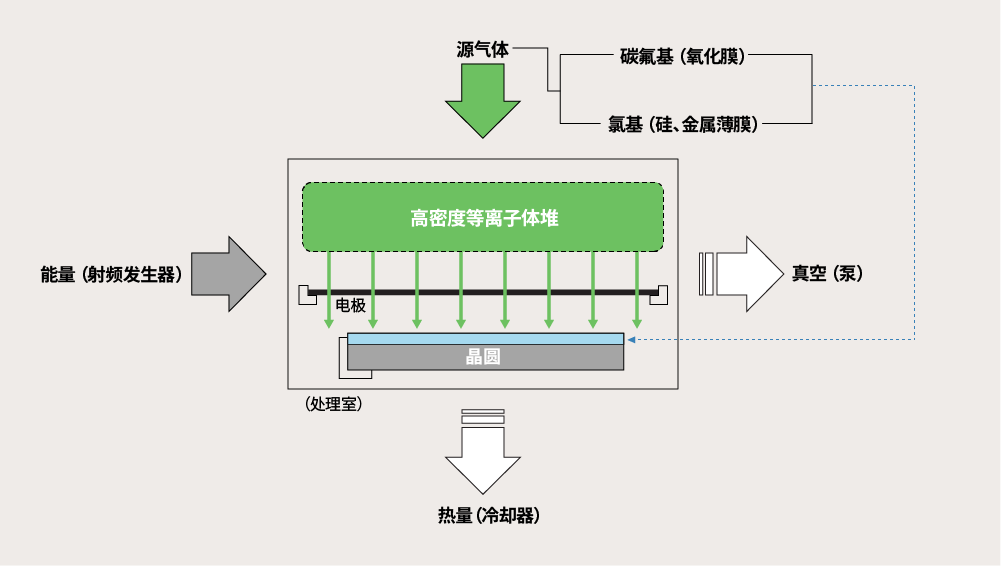





 半導體刻蝕工藝技術(shù)-icp介紹
半導體刻蝕工藝技術(shù)-icp介紹













評論