來源:國芯制造
一、氮化硅(SiNx)基礎認知
在芯片制造這一復雜且精妙的領域中,氮化硅(SiNx)占據著極為重要的地位,絕大多數芯片的生產都離不開它的參與。從其構成來看,氮化硅屬于無機化合物,由硅元素與氮元素共同組成。這種看似普通的元素組合,卻蘊含著諸多獨特的性質,在芯片制造流程里發揮著不可替代的作用 。
二、氮化硅(SiNx)化學式深度剖析
(一)氮元素價態的多樣性
氮元素因其特殊的電子結構,擁有豐富多樣的價態表現。其原子核外具備 5 個價電子,這使得氮原子在與其他元素相互作用時,能夠通過不同方式共享電子,進而展現出多種價態。在常見的化合物中,氮元素最穩定的價態呈現為 -3 價,像我們熟知的氨(NH?)以及氮化鎵(GaN)等物質便是如此。然而,氮元素并非局限于此,在特定條件下,它能夠失去電子,從而呈現出正價態,例如在硝酸(HNO?)中,氮元素便呈現出 +5 價態。此外,氮元素還能形成處于 -3 價與 +5 價之間的其他價態,諸如亞硝酸(HNO?)中的 +3 價態,在部分有機化合物里出現的 +1 價和 +2 價態。

(二)氮化硅材料的獨特性質
氮化硅通常以 SiNx 來表示。它屬于一種非晶態材料,其各項性質緊密依賴于氮和硅之間的比例關系,也就是 x 的值。只要 x 的值發生改變,氮化硅的物理性質以及化學性質也會隨之產生相應的變化。實際上,氮化硅存在著多種不同的形式,包括但不限于 Si?N?、Si?N?以及 SiN 等。其中,Si?N?屬于晶態材料,這意味著在該物質中硅和氮的比例是固定不變的。當 x 的值恰好等于 4/3 時,SiNx 就等同于 Si?N?。但回歸到實際的生產應用中,SiNx 大多呈現出非定比的狀態,其硅和氮的比例可以通過化學氣相沉積(CVD)過程中的相關參數進行調控來實現靈活改變 。Si?N?有高的介電常數(即k值為6.9,CVD淀積的SiO?,k值為 3.9),因而不能作為ILD and IMD絕緣介質,它會導致導體之間大的電容。
三、SiNx 在芯片制造中的核心作用
(一)卓越的絕緣與隔離性能
氮化硅(SiNx)展現出極為出色的絕緣性能,其電阻率能夠高達 101? Ω?cm,相較于一些常見的絕緣材料,例如氧化硅(SiO?),有著顯著的優勢。在芯片內部,氮化硅層還承擔著關鍵的雜質擴散阻擋任務,它能夠有效地阻止硼、磷等摻雜物質通過擴散的方式改變器件原本的特性,同時也能夠防止金屬離子等的擴散,從而避免出現短路等嚴重影響芯片性能的故障問題 。
(二)優異的熱穩定性
氮化硅擁有極佳的熱穩定性,這一特性主要源于其特殊的化學性質以及晶體結構。在氮化硅的晶體結構當中,每一個硅原子都會與四個氮原子以四面體的形式緊密結合在一起,同樣地,每一個氮原子也會與四個硅原子以四面體的形式相互連接。這樣獨特的結構設計,使得氮化硅的晶體格架具備極高的穩定性,在面臨溫度變化時,不易發生形變。基于此,在制造高電子遷移率晶體管的過程中,氮化硅常常被選作柵極絕緣層,以確保晶體管在復雜的工作環境下能夠穩定運行 。

四、SiNx 相對 SiO?的顯著優勢
與傳統的氧化硅(SiO?)相比,氮化硅(SiNx)在多個方面展現出明顯的優勢。首先,在熱穩定性方面,SiNx 表現更為出色,能夠在更為嚴苛的溫度條件下保持自身性能的穩定。其次,從硬度層面來看,SiNx 更硬,這使得其在應對外界物理沖擊時具備更強的抵抗能力。此外,在刻蝕工藝中,SiNx 相較于 SiO?更難被刻蝕,這種特性在一些對芯片結構精度要求極高的制造環節中,具有重要的應用價值 。
五、氮化硅薄膜的制備方法及用途解析
(一)制備方法
LPCVD 氮化硅工藝:低壓化學氣相沉積(LPCVD)工藝在進行氮化硅薄膜制備時,需要處于高溫環境之中,一般溫度范圍設定在 700 - 800°C 之間。通過這種工藝制備出來的氮化硅薄膜,具有結構致密的特點,相應地,其具備較高的耐腐蝕性以及硬度,在掩膜性能方面表現尤為優異,特別適用于作為在堿性溶液刻蝕硅材料過程中的掩膜層 。

PECVD 氮化硅工藝:與 LPCVD 工藝相比,等離子體增強化學氣相沉積(PECVD)工藝具有顯著的溫度優勢,它能夠在相對較低的溫度條件下,也就是低于 400°C 時進行氮化硅薄膜的沉積工作。這一特性使得 PECVD 工藝能夠在與底層器件結構相兼容的工作溫度區間內完成氮化硅薄膜的沉積操作。雖然 PECVD 制備的氮化硅薄膜在致密程度上相對 LPCVD 薄膜稍顯遜色,但其具備更高的工藝靈活性,并且制備成本也更低 。PECVD Si?N?膜不同于化學計量配比,有時候寫或SixNyHz。這個分子式點明了它的組成是非化學計量配比的,其中H的含量一般為9%~30%。下表比較了LPCVD和PECVD 氮化硅的性質

通常情況下PECVD 氮化硅會增加膜的壓應力,原因是淀積過程中的離子轟擊會破壞 Si-N 或 Si-H鍵。這個就涉及主流的應變硅技術啦!
(二)用途
掩蔽膜用途:在實際應用中,掩蔽膜通常會采用 LPCVD 工藝進行沉積。這主要是因為通過 LPCVD 制備的氮化硅薄膜具有極為優異的阻水性能。在熱氧化過程中,氮化硅掩蔽展現出了獨特的適用性,由于氧氣很難透過氮化硅進行擴散,從而能夠對被保護區域起到良好的遮蔽作用 。同時還可以作為離子注入的阻擋層,因為氮化硅薄膜非常致密,可以阻擋離子的擴散,從而應用在MOS的側墻工藝當中。
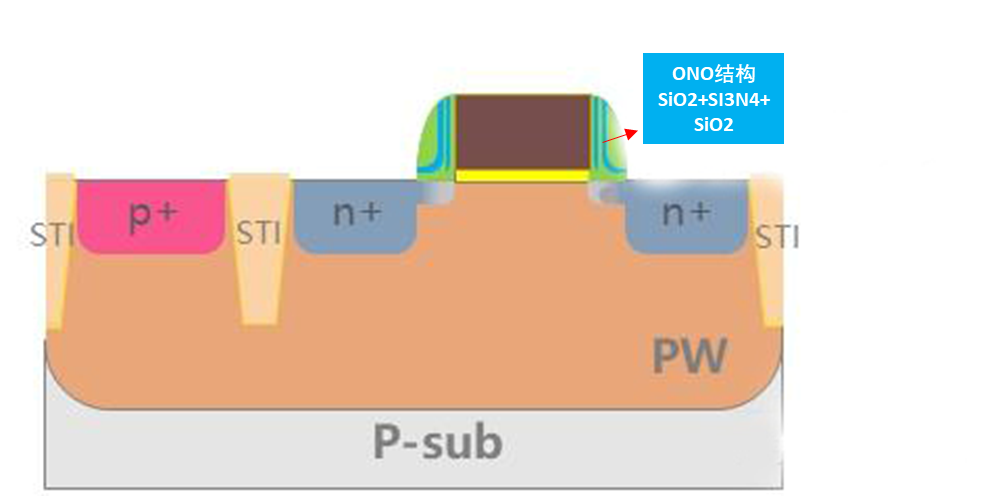
鈍化層用途:當氮化硅薄膜作為鈍化層來使用時,展現出了眾多令人滿意的特性。PECVD 方法允許在與底層器件結構工作溫度相兼容的條件下進行薄膜沉積。該薄膜對于水分以及鈉離子等關鍵的環境污染物具有很強的抵御能力,幾乎不會受到它們的影響。而且,通過對 PECVD 工藝條件進行合理調整,還能夠靈活地調控薄膜內部的固有應力,以此來有效消除薄膜可能出現的分層或者開裂風險 。
-
材料
+關注
關注
3文章
1320瀏覽量
27721 -
芯片制造
+關注
關注
10文章
676瀏覽量
29517 -
氮化硅
+關注
關注
0文章
80瀏覽量
466
原文標題:綜述氮化硅薄膜在先進芯片制程中的應用
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
氮化硅LPCVD工藝及快速加熱工藝(RTP)系統詳解
氮化硅陶瓷基板助力新能源汽車市場
氮化硅基板應用——新能源汽車核心IGBT
一種采用氮化硅襯底制造集成光子電路(光子芯片)技術
鍺對氮化硅中紅外集成光子學的波導
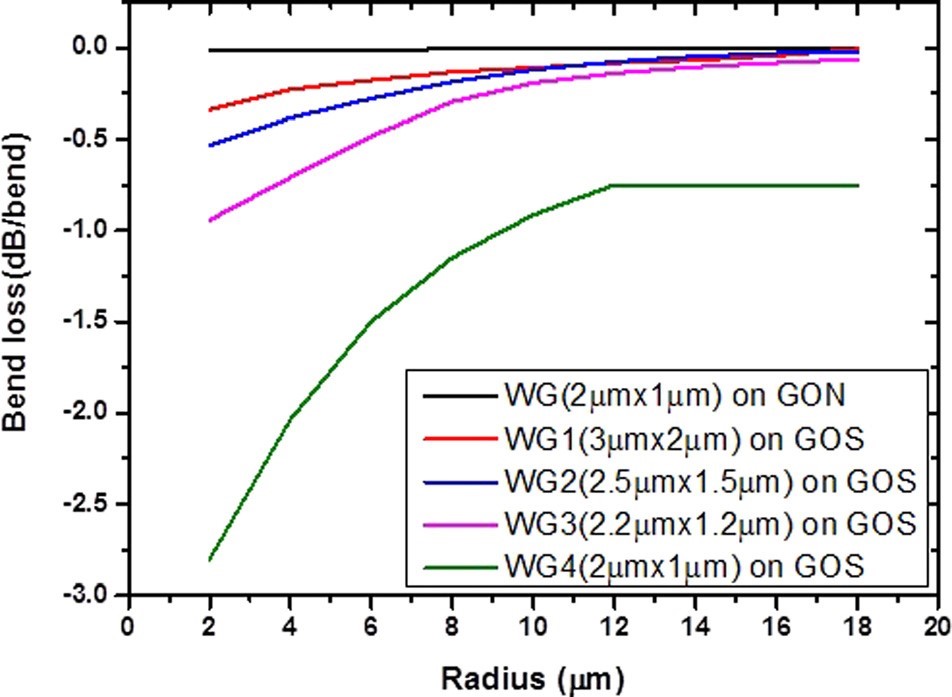
氮化硅陶瓷基板的5大應用你知道嗎?
氮化硅陶瓷基板的市場優勢和未來前景
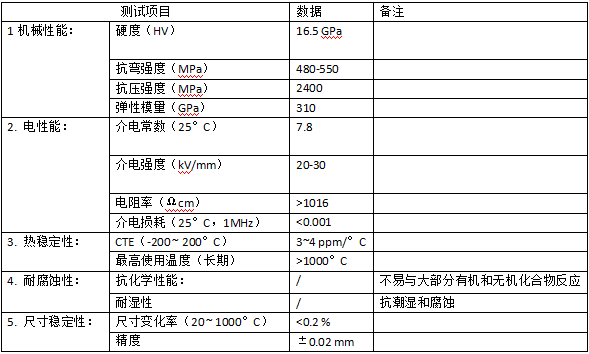
氮化硅陶瓷在四大領域的研究及應用進展

氮化硅是半導體材料嗎 氮化硅的性能及用途
沉積氮化硅薄膜的重要制備工藝——PECVD鍍膜

氮化硅薄膜制備方法及用途

氮化硅薄膜的特性及制備方法






 氮化硅在芯片制造中的核心作用
氮化硅在芯片制造中的核心作用












評論