什么是芯片底部填充膠,它有什么特點?
芯片底部填充膠是一種用于電子封裝的膠水,主要用于底部填充bga芯片電子組件,以增強組件的可靠性和穩(wěn)定性。它通常是一種環(huán)氧樹脂,具有良好的粘接性和耐熱性。
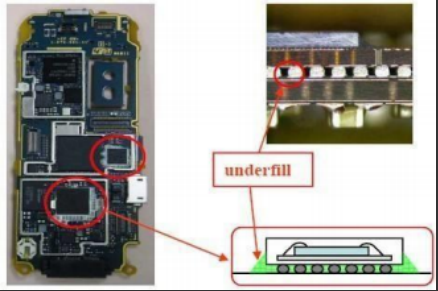
底部填充膠的特點主要有以下幾點:
1,良好的粘接性:底部填充膠能夠很好地粘接各種材料,包括金屬、陶瓷和塑料等。
2,耐熱性:底部填充膠具有良好的耐熱性,可以在高溫環(huán)境下保持穩(wěn)定。
3,高強度:底部填充膠固化后具有高強度,能夠承受較大的機械應(yīng)力。
4,耐腐蝕性:底部填充膠具有良好的耐腐蝕性,能夠抵抗各種化學(xué)物質(zhì)的侵蝕。
5,低收縮性:底部填充膠在固化過程中收縮性低,能夠減少因收縮引起的應(yīng)力。
6,易于操作:底部填充膠可以通過自動設(shè)備進行精確控制和操作,提高生產(chǎn)效率。
總的來說,芯片底部填充膠是一種高性能的膠粘劑,主要用于電子封裝領(lǐng)域,提高電子產(chǎn)品的可靠性和穩(wěn)定性。
-
芯片
+關(guān)注
關(guān)注
459文章
52162瀏覽量
436078 -
電子封裝
+關(guān)注
關(guān)注
0文章
83瀏覽量
11064
發(fā)布評論請先 登錄
蘋果手機應(yīng)用到底部填充膠的關(guān)鍵部位有哪些?

漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利

漢思新材料HS711板卡級芯片底部填充封裝膠

漢思新材料:車規(guī)級芯片底部填充膠守護你的智能汽車

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程

芯片底部填充工藝流程有哪些?

底部填充工藝在倒裝芯片上的應(yīng)用






 什么是芯片底部填充膠,它有什么特點?
什么是芯片底部填充膠,它有什么特點?

















評論