共讀好書
翟培卓,洪根深,王印權(quán),李守委,陳鵬,邵文韜,柏鑫鑫
(中國(guó)電子科技集團(tuán)公司第五十八研究所)
摘要:
倒裝焊封裝過(guò)程中,底部填充膠的流動(dòng)性決定了填充效率,進(jìn)而影響生產(chǎn)效率及成本。通過(guò)對(duì)比接觸角和底部填充膠流動(dòng)時(shí)間,研究了等離子清洗及點(diǎn)膠軌跡對(duì)底部填充膠流動(dòng)性的影響。結(jié)果表明:經(jīng)微波等離子清洗后,水及底部填充膠在陶瓷基板表面的浸潤(rùn)性均有所提高;微波等離子清洗還能促進(jìn)底部填充膠在芯片和陶瓷基板之間的流動(dòng)。I形點(diǎn)膠軌跡對(duì)應(yīng)的流動(dòng)時(shí)間最長(zhǎng),而U形點(diǎn)膠軌跡的流動(dòng)時(shí)間最短。因此適當(dāng)增加點(diǎn)膠軌跡的總長(zhǎng)度,可以有效提高底部填充膠的填充效率。
0引言
倒裝焊封裝技術(shù)以倒裝芯片的凸點(diǎn)作為連接媒介,采用回流焊、熱壓焊等實(shí)現(xiàn)芯片與基板的電路互連,是高速、高密度的主流封裝技術(shù)之一[1-2]。在倒裝焊封裝過(guò)程中,由于芯片與基板的熱膨脹系數(shù)不匹配,在溫度變化時(shí)會(huì)出現(xiàn)較大的熱應(yīng)力,所以往往需要在芯片與基板之間填充底部填充膠來(lái)起到加固的作用[3]。
底部填充的方式一般分為兩種:流動(dòng)底部填充和非流動(dòng)底部填充[4-5]。前者是在凸點(diǎn)回流后將底部填充膠注到芯片邊緣,借助液體的毛細(xì)作用將芯片與基板之間填滿;而后者是先將底部填充膠涂在基板表面適當(dāng)位置,再安裝倒裝芯片。由于流動(dòng)底部填充對(duì)于設(shè)備的要求不高且操作簡(jiǎn)單,被廣泛應(yīng)用于倒裝焊封裝。
等離子清洗是半導(dǎo)體行業(yè)中常用的表面處理手段,進(jìn)行等離子清洗可直接改變基板表面狀態(tài),進(jìn)而影響底部填充膠的流動(dòng)性[6]。同時(shí),不同點(diǎn)膠軌跡會(huì)影響底部填充膠注入位置的初始條件,從而也會(huì)對(duì)底部填充膠在芯片底部的流動(dòng)性造成影響[7-8]。底部填充膠在基板上的流動(dòng)性決定了填充效率,進(jìn)而關(guān)系到工程生產(chǎn)效率及成本。因此,研究等離子清洗及點(diǎn)膠軌跡對(duì)底部填充膠流動(dòng)性的影響具有重要意義。
1實(shí)驗(yàn)材料及方法
1. 1實(shí)驗(yàn)材料
選用Al2O3陶瓷基板,實(shí)驗(yàn)前基板表面不經(jīng)任何處理,保持原始素面;陶瓷基板存儲(chǔ)環(huán)境溫度為20~26 ℃,存儲(chǔ)環(huán)境濕度為40%~60%。選用的底部填充膠在25℃下黏度為50 Pa·s,填充料為SiO2顆粒,填充顆粒尺寸為2~10 μm,填充顆粒質(zhì)量分?jǐn)?shù)為60%,在-40 ℃下存儲(chǔ)。
1. 2實(shí)驗(yàn)方法
首先采用回流焊的方式,將倒裝芯片貼裝在基板焊盤區(qū)(圖1)。倒裝芯片尺寸為10. 3 mm ×10. 3 mm×0. 5 mm,對(duì)應(yīng)的凸點(diǎn)直徑為160 μm,節(jié)距250 μm,凸點(diǎn)總數(shù)為1 296個(gè)。首個(gè)樣品經(jīng)破壞性拉脫芯片實(shí)驗(yàn)后,在顯微鏡下觀察確認(rèn):采用離心清洗機(jī)在轉(zhuǎn)速800 r /min、水溫50 ℃下清洗20min,可以洗凈殘留助焊劑。后續(xù)樣品均采用上述參數(shù)進(jìn)行助焊劑清洗。
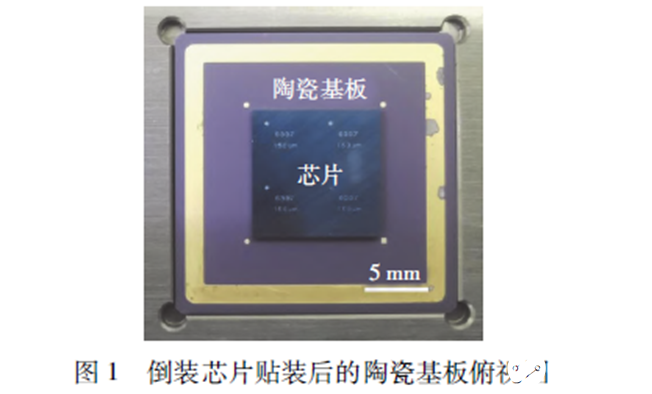
然后將陶瓷基板分為兩組:一組不經(jīng)任何表面處理,保持原始素面;另一組進(jìn)行微波等離子清洗。微波等離子清洗的功率為800 W,先用O2清洗5 min,再用體積分?jǐn)?shù)為90%N2+10%H2的混合氣清洗5 min,氣體流量均為300 mL/min。接著對(duì)兩組基板樣品用接觸角測(cè)量?jī)x分別測(cè)量水和底部填充膠對(duì)應(yīng)的接觸角,并采用I形、L形和U形3種軌跡在芯片邊緣位置進(jìn)行點(diǎn)膠實(shí)驗(yàn),每項(xiàng)實(shí)驗(yàn)均采用3個(gè)樣品,記錄底部填充膠填滿芯片底部所用的流動(dòng)時(shí)間。
I形、L形和U形3種點(diǎn)膠軌跡均一次性完成,點(diǎn)膠量為19 mg。基于工程經(jīng)驗(yàn),為了緩解底部填充膠在芯片邊緣填充速度過(guò)快的現(xiàn)象以實(shí)現(xiàn)較好的底部填充效果,3種軌跡頭尾分別空出單邊長(zhǎng)度的10%、20%和40%,如圖2所示。在點(diǎn)膠過(guò)程中,底部填充加熱平臺(tái)溫度保持在110 ℃。
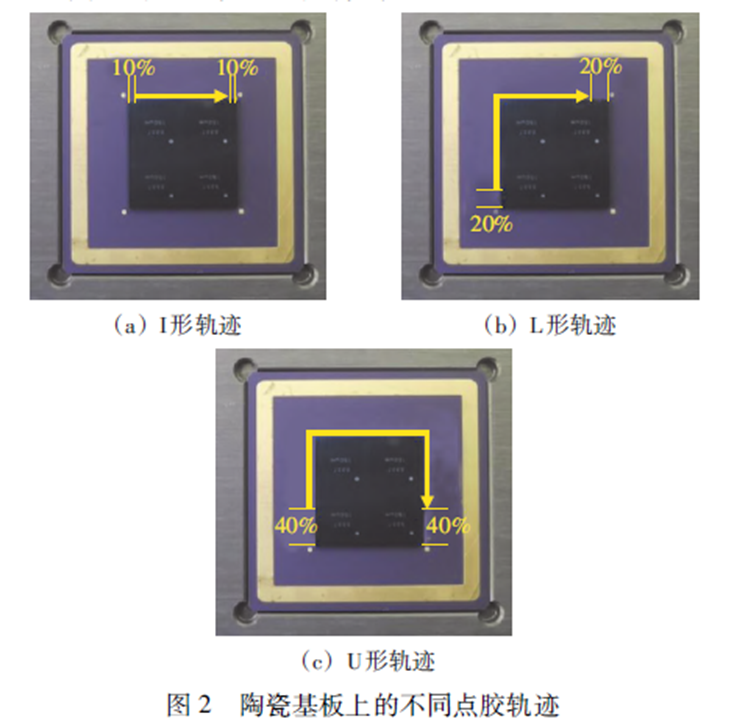
2分析與討論
2. 1等離子清洗對(duì)陶瓷基板浸潤(rùn)性的影響
為了確認(rèn)不同表面處理的陶瓷基板表面的浸潤(rùn)性,分別對(duì)未經(jīng)等離子清洗和等離子清洗后的陶瓷基板進(jìn)行接觸角測(cè)量實(shí)驗(yàn)。圖3所示分別為未經(jīng)等離子清洗和等離子清洗后,水和底部填充膠在陶瓷基板表面接觸瞬間的接觸角照片。可以看出未經(jīng)等離子清洗時(shí),水和底部填充膠在陶瓷基板表面的接觸角分別為81. 1°和45. 8°;在等離子清洗后,水和底部填充膠在陶瓷基板表面的接觸角均有所減小,分別變?yōu)?6. 8°和21. 1°。這一方面是由于經(jīng)等離子清洗后陶瓷基板表面的親水基增多、憎水基減少,另一方面是由于等離子清洗在一定程度上減少了陶瓷表面的殘留污染物,最終提高了水和底部填充膠在陶瓷表面的浸潤(rùn)性[9-10]。
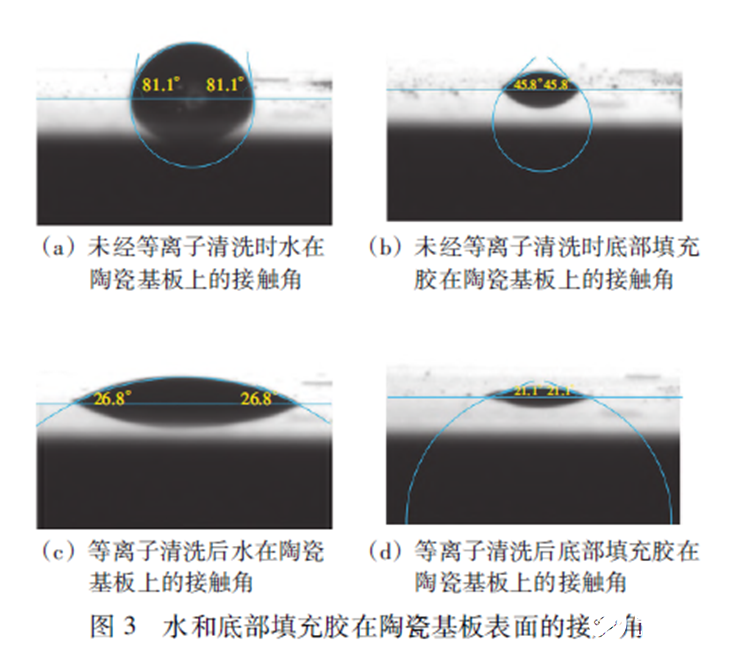
2. 2底部填充膠的流動(dòng)性對(duì)比
經(jīng)實(shí)驗(yàn)測(cè)得,在采用I形、L形和U形點(diǎn)膠軌跡情況下,未經(jīng)等離子清洗時(shí)的底部填充膠平均流動(dòng)時(shí)間分別為23、21和18 s;而在等離子清洗后分別為21、16和14 s。
可見(jiàn),陶瓷基板經(jīng)等離子清洗之后,不論是I形、L形還是U形點(diǎn)膠軌跡,底部填充膠的流動(dòng)時(shí)間明顯減少。另外,I形點(diǎn)膠軌跡對(duì)應(yīng)的流動(dòng)時(shí)間最長(zhǎng),L形軌跡的流動(dòng)時(shí)間稍短,而U形點(diǎn)膠軌跡的流動(dòng)時(shí)間最短。對(duì)于等離子清洗之后的陶瓷基板,L形軌跡和U形軌跡比I形軌跡的流動(dòng)時(shí)間分別縮短了23%和33%。換算成單位小時(shí)產(chǎn)能,L形軌跡和U形軌跡對(duì)應(yīng)的填充效率相比于I形軌跡分別提高了31%和50%。
底部填充膠主要依靠毛細(xì)作用深入到芯片與基板之間的縫隙處。若采用Washburn模型[11],假設(shè)底部填充膠為不可壓縮的牛頓流體,且底部填充膠在芯片和基板之間的流動(dòng)為穩(wěn)定的二維層流流動(dòng),那么底部填充膠的流動(dòng)可以等效為芯片與基板間的壓力差Vp的作用[12],即

式中: σ為底部填充膠前端與空氣的表面張力; θ為底部填充膠與基板形成的接觸角; h為芯片與基板間的縫隙寬度。
由圖3可知等離子清洗可減小底部填充膠在陶瓷基板上的接觸角,所以等離子清洗之后可以獲得更大的壓力差,即底部填充膠獲得的推力變大,從而促進(jìn)底部填充膠在芯片底部的流動(dòng),在同樣點(diǎn)膠軌跡下減少流動(dòng)時(shí)間。而基板在未經(jīng)等離子清洗時(shí)和等離子清洗后的不同點(diǎn)膠軌跡的流淌效果如圖4所示。

從圖4中可以看出,在陶瓷基板進(jìn)行等離子清洗之后,無(wú)論何種點(diǎn)膠軌跡,底部填充膠在陶瓷基板上的擴(kuò)散寬度均偏大,這也是由于等離子清洗可減小底部填充膠在陶瓷基板上的接觸角導(dǎo)致。此外,從點(diǎn)膠軌跡的總長(zhǎng)度上看,U形軌跡最長(zhǎng),其次是L形軌跡,最短的是I形軌跡。軌跡總長(zhǎng)度越長(zhǎng),相當(dāng)于增大了底部填充膠的入口,在相同的壓力差下可以更快地流滿芯片底部,所以U形軌跡的流動(dòng)時(shí)間最短。
2. 3超聲掃描結(jié)果對(duì)比
為了檢驗(yàn)底部填充膠的填充效果,對(duì)基板在未經(jīng)等離子清洗和等離子清洗后的不同點(diǎn)膠軌跡的芯片進(jìn)行了超聲掃描檢測(cè)。超聲掃描采用反射模式( C掃描模式),對(duì)芯片附近的底部填充層進(jìn)行逐行掃描,得到超聲掃描照片如圖5所示。從圖5中可以看出,對(duì)于本文所采用的芯片,無(wú)論是否進(jìn)行了等離子清洗,采用I形、L形和U形點(diǎn)膠軌跡的底部填充膠與芯片或陶瓷基板均未發(fā)生分層和孔洞缺陷。
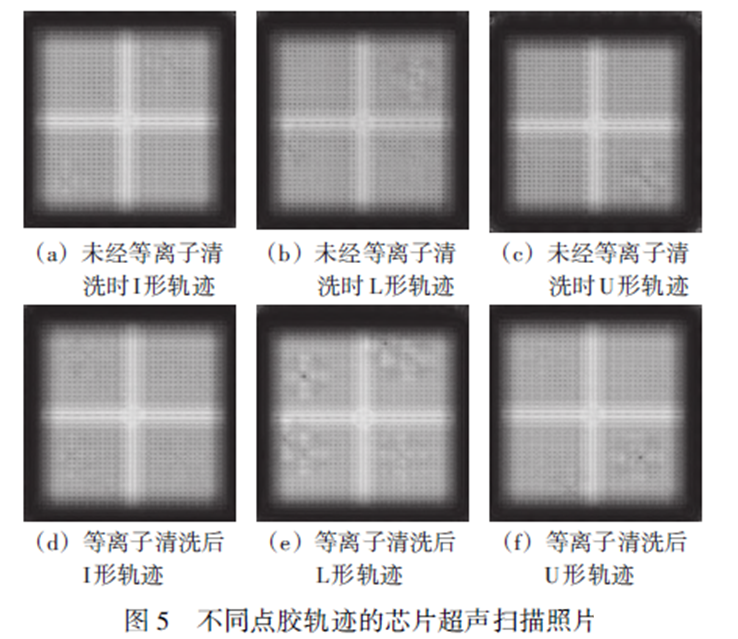
3結(jié)論
陶瓷基板經(jīng)微波等離子清洗后,水及底部填充膠在其表面的接觸角均有減小,浸潤(rùn)性均有所提高。從而,微波等離子清洗可以促進(jìn)底部填充膠在芯片和陶瓷基板之間的流動(dòng),減少流動(dòng)時(shí)間。另外,I形點(diǎn)膠軌跡對(duì)應(yīng)的流動(dòng)時(shí)間最長(zhǎng),L形軌跡的流動(dòng)時(shí)間稍短,而U形點(diǎn)膠軌跡的流動(dòng)時(shí)間最短。適當(dāng)增加點(diǎn)膠軌跡的總長(zhǎng)度,可以有效減少底部填充膠的流動(dòng)時(shí)間,提高填充效率,從而提升工程生產(chǎn)效率并降低生產(chǎn)成本。
審核編輯 黃宇
-
等離子
+關(guān)注
關(guān)注
2文章
237瀏覽量
30689 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
106瀏覽量
16603 -
陶瓷基板
+關(guān)注
關(guān)注
5文章
244瀏覽量
11837
發(fā)布評(píng)論請(qǐng)先 登錄
漢思新材料:底部填充膠二次回爐的注意事項(xiàng)

蘋果手機(jī)應(yīng)用到底部填充膠的關(guān)鍵部位有哪些?

漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利

芯片底部填充膠填充不飽滿或滲透困難原因分析及解決方案

漢思新材料:車規(guī)級(jí)芯片底部填充膠守護(hù)你的智能汽車

哪家底部填充膠廠家比較好?漢思底填膠優(yōu)勢(shì)有哪些?

先進(jìn)封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

電路板元件保護(hù)用膠

芯片封裝膠underfill底部填充膠點(diǎn)膠工藝基本操作流程

芯片底部填充工藝流程有哪些?






 等離子清洗及點(diǎn)膠軌跡對(duì)底部填充膠流動(dòng)性的影響
等離子清洗及點(diǎn)膠軌跡對(duì)底部填充膠流動(dòng)性的影響




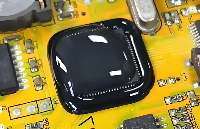











評(píng)論