底部填充工藝在倒裝芯片(Flip Chip)上的應用是一種重要的封裝技術,旨在提高封裝的可靠性和延長電子產(chǎn)品的使用壽命。以下是該工藝的主要應用和優(yōu)勢:
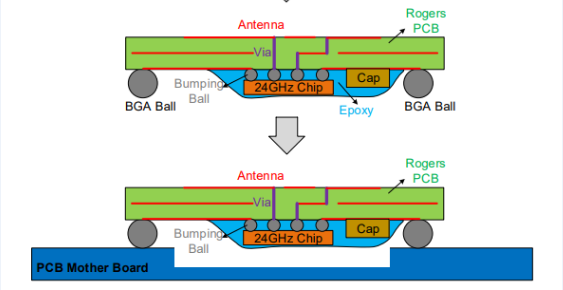
增強可靠性:倒裝芯片封裝中的焊點(常為金錫合金或鉛錫合金)在熱循環(huán)過程中承受巨大應力,容易導致疲勞和失效。底部填充材料(通常是高粘度環(huán)氧樹脂,含有大量SiO2填充物)填充芯片與基板間的空隙,形成剛性支撐結構,有效分散應力,增強封裝的機械強度和熱穩(wěn)定性。
改善熱性能:底部填充材料具有一定的熱傳導性,幫助芯片產(chǎn)生的熱量快速傳遞至基板,再散發(fā)到外部,從而降低工作溫度,提升電子設備的長期可靠性和性能。
防潮保護:填充材料能防止水分滲透到芯片下方,減少濕氣引起的焊點腐蝕或爆裂,尤其是在高溫處理如回流焊過程中,避免“爆米花”效應,即水分在高溫下迅速蒸發(fā)導致的內(nèi)部壓力增大和破裂。
提升抗沖擊能力:在受到跌落、振動等外力時,底部填充增加了封裝結構的韌性,減少內(nèi)部損傷,保護芯片免受物理沖擊。
應力重分配:通過底部填充,焊點上的熱應力在芯片、填充物、基板及所有焊點間重新分配,避免應力集中在芯片邊緣的外圍焊點上,顯著降低焊點的應變水平,從而提高焊點的疲勞壽命,據(jù)實踐證明,這可以將焊點的疲勞壽命提高10至100倍。
底部填充工藝流程通常包括:
點膠:在芯片與基板之間預設位置精確施加底部填充材料,此步驟要求極高精度,以避免污染其他元件。
毛細管效應填充:利用膠水的流動性和毛細作用自動填充芯片底部空間。
固化:加熱促使底部填充材料固化,形成穩(wěn)定的封裝結構。
檢查與測試:
固化完成后,進行光學或X射線檢查,以驗證底部填充是否均勻、完全,以及是否存在氣泡或其他缺陷。隨后,還需進行電氣性能測試,確保封裝后的芯片功能正常。
底部填充材料的選擇:
底部填充材料的選擇需綜合考慮流動性、固化特性、熱膨脹系數(shù)、熱導率、介電性能等因素。隨著芯片尺寸的縮小和集成度的提高,對底部填充材料提出了更高要求,如更低的固化溫度、更快的固化速度、更好的流動性和更優(yōu)的熱管理能力。
底部填充工藝在倒裝芯片封裝中的應用顯著提升了封裝的性能、可靠性和壽命。通過增強焊點的可靠性、改善熱性能、提供防潮保護和提升抗沖擊能力,底部填充工藝成為現(xiàn)代電子封裝技術中不可或缺的一部分。隨著技術的不斷進步,底部填充工藝將持續(xù)演進,以滿足日益增長的高性能、小型化和多功能電子設備的需求。這種工藝是現(xiàn)代半導體封裝技術的關鍵組成部分,尤其適用于高性能、高密度和高可靠性要求的電子產(chǎn)品中。
-
芯片
+關注
關注
459文章
52145瀏覽量
435993 -
芯片封裝
+關注
關注
11文章
571瀏覽量
31236 -
倒裝芯片
+關注
關注
1文章
102瀏覽量
16520 -
底部填充劑
+關注
關注
0文章
8瀏覽量
5479
發(fā)布評論請先 登錄
什么是芯片封裝?倒裝芯片(FC)底部填充的原因
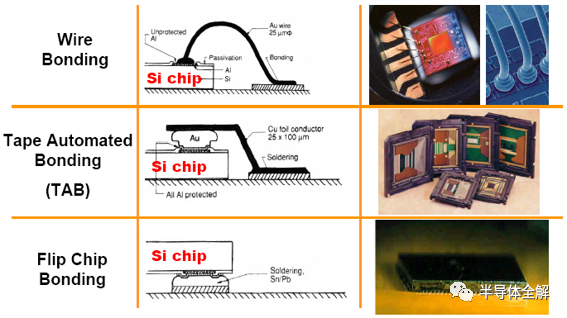
倒裝晶片底部填充后的檢查
倒裝晶片為什么需要底部填充
SMT倒裝芯片的非流動型底部填充劑工藝
漢思新材料研發(fā)生產(chǎn)半導體 Flip chip 倒裝芯片封裝用底部填充材料

底部填充膠的返修工藝步驟有哪些?如何返修BGA芯片?






 底部填充工藝在倒裝芯片上的應用
底部填充工藝在倒裝芯片上的應用















評論