射頻前端(RFFE,Radio Frequency Front-End)模組國內(nèi)外手機(jī)終端中廣泛應(yīng)用。它將功率放大器(PA,Power Amplifier)、開關(guān)(Switch)、低噪聲放大器LNA(Low Noise Amplifier)、濾波器(Filter)、無源器件等集成為一個(gè)模組,從而提高性能,并減小封裝體積。然而,受限于國外專利以及設(shè)計(jì)水平等因素,國產(chǎn)濾波器的份額相當(dāng)?shù)汀T谀K集成化的趨勢下,國內(nèi)射頻巨頭在布局和生產(chǎn)濾波器。聲學(xué)濾波器可分為聲表面濾波器和體聲波濾波器,其中聲表面濾波器可根據(jù)適用的頻率細(xì)分為SAW、TC-SAW和IHP-SAW。體聲波濾波器適用于較高的頻段,可細(xì)分為BAW、FBAR、XBAR等。無論是SAW(Surface Acoustic Wave filter)還是BAW(Bulk Acoustic Wave Filter),均是在晶圓級封測后以倒裝芯片的工藝貼裝在模組上。在晶圓級封裝工藝中,Bump制造是相當(dāng)重要的一道工序,因此本文將淺談濾波器晶圓級封裝(Wafer Level package)中Bump制造的關(guān)鍵點(diǎn)。
當(dāng)前業(yè)內(nèi)常見的幾種SAW filter Wafer Bumping工藝如下:
1.通過打線工藝在晶圓的UBM(Under Bump Metal)上植金球。
2.通過鋼網(wǎng)印刷工藝在UBM上印刷錫膏,再經(jīng)過回流焊成球。
3.先在晶圓的UBM上印刷助焊劑,將錫球放到UBM上,再經(jīng)過回流焊完成植球。
本文重點(diǎn)介紹第二種工藝。通過對印刷錫膏方案的剖析發(fā)現(xiàn),在Bumping工藝中Bump的高度和共面度(同一顆芯片上Bump高度最大值最小值之差,差值越低越好)是最重要的關(guān)鍵指標(biāo)(如圖1.1、圖1.2)。下面從鋼網(wǎng)的工藝和設(shè)計(jì)、錫膏的特性等方面進(jìn)行分析。
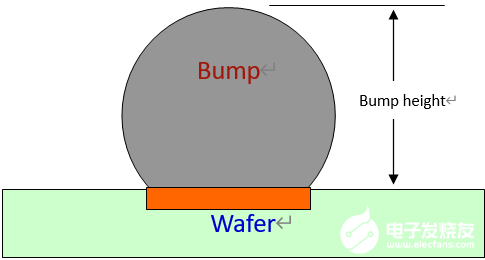
圖1.1 球高
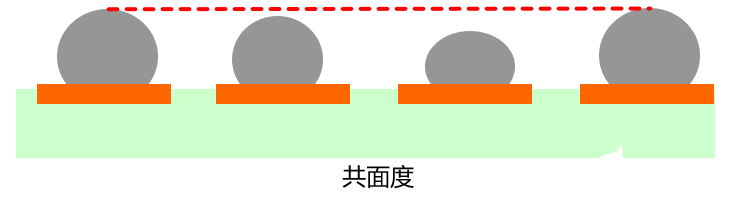
圖1.2 共面度
鋼網(wǎng)印刷
鋼網(wǎng)印刷的目的是使錫膏材料通過特定的圖案孔沉積到正確的位置上。首先,將錫膏放到鋼網(wǎng)上,再用刮刀使其通過鋼網(wǎng)開孔沉積到焊盤上。鋼網(wǎng)與晶圓之間的距離(印刷間隙)、印刷角度、壓力、速度和膏體的流變特性是確保錫膏印刷的關(guān)鍵參數(shù)。一旦鋼網(wǎng)開孔被膏體填滿,脫模后膏體留在每個(gè)焊盤上,沉積在焊盤上的體積取決于鋼網(wǎng)的孔距和孔壁的質(zhì)量、焊盤的表面特性和膏體的流變性能。
鋼網(wǎng)的加工工藝與開孔設(shè)計(jì)
鋼網(wǎng)孔壁質(zhì)量、尺寸一致性、定位精度和鋼網(wǎng)生產(chǎn)成本是鋼網(wǎng)生產(chǎn)工藝的選擇標(biāo)準(zhǔn)。考慮到帶有Bump的濾波器是以倒裝芯片的工藝應(yīng)用在前端射頻模組里,其特點(diǎn)是Bump的尺寸小(bump高度在50~100μm之間)、間距小、對Bump高度的一致性要求高(共面度在10μm以內(nèi))。為了滿足以上要求,業(yè)內(nèi)最常選用的是納米涂層鋼網(wǎng)和電鑄鋼網(wǎng)。
納米涂層鋼網(wǎng)的工藝是:在激光切割的基礎(chǔ)上對鋼網(wǎng)進(jìn)行清洗,然后在鋼網(wǎng)內(nèi)壁進(jìn)行打磨拋光以降低粗糙度,最后涂覆納米涂層。納米涂層使接觸角顯著增加,從而降低鋼網(wǎng)材料的表面能,有利于錫膏脫模。
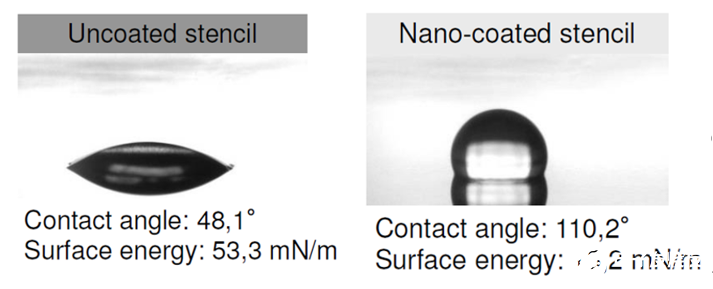
圖2.1 無納米涂層 圖2.2 納米涂層
Source: Laser Job
電鑄鋼網(wǎng)的制作方法是:先在導(dǎo)電基板上用光刻技術(shù)制備模板,然后在阻膠膜周圍進(jìn)行直流電鑄,最后從光刻膠孔上剝離。電鑄鋼網(wǎng)的質(zhì)量和印刷性能取決于光刻膠的靈敏度、所用光刻工具的類型、導(dǎo)電基材的光學(xué)性能和電鑄工藝。電鑄鋼網(wǎng)的開孔內(nèi)壁非常光滑(如圖3所示),其印刷脫模的表現(xiàn)也最好最穩(wěn)定。
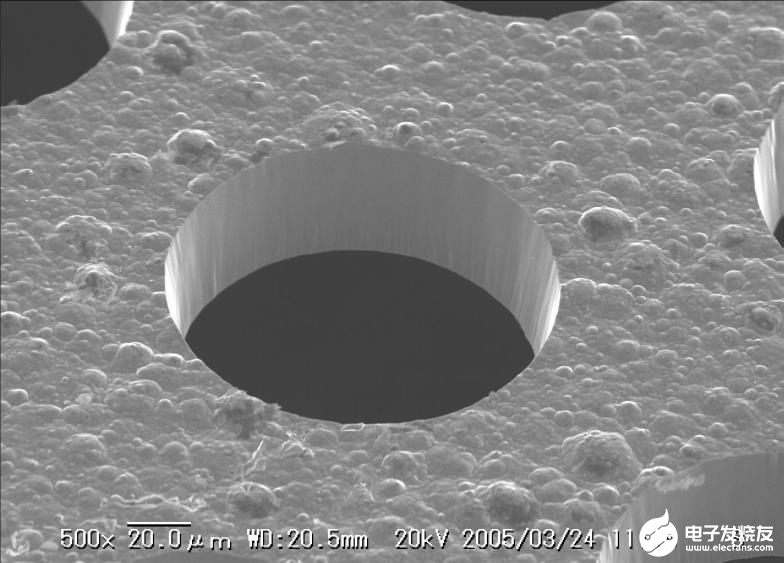
圖3 電鑄鋼網(wǎng)孔壁
Source: Bon Mark
小結(jié),納米涂層鋼網(wǎng)的印刷表現(xiàn)略遜于電鑄鋼網(wǎng),其涂層在批量生產(chǎn)一段時(shí)間后可能會(huì)脫落,但是納米涂層鋼網(wǎng)的價(jià)格遠(yuǎn)低于電鑄鋼網(wǎng);電鑄鋼網(wǎng)的側(cè)壁非常光滑,其印刷表現(xiàn)最好,是超細(xì)間距應(yīng)用的最佳選擇,但電鑄鋼網(wǎng)的價(jià)格相當(dāng)昂貴。鋼網(wǎng)的選擇取決于客戶對產(chǎn)品特性和成本的綜合考量。
開孔面積比
由于CTE不匹配會(huì)影響封裝的可靠性,符合高度要求的Bump在這方面會(huì)起到積極的作用。這就要求鋼網(wǎng)印刷過程可靠地沉積穩(wěn)定的錫膏量,以產(chǎn)生堅(jiān)固的互連。錫膏從鋼網(wǎng)孔的釋放是由錫膏在鋼網(wǎng)孔側(cè)壁和晶圓焊盤之間的相互作用決定的。據(jù)文獻(xiàn)記載,為了從鋼網(wǎng)印刷中獲得良好的膏體釋放效率,模板開孔面積比 [開孔面積比=開口面積/孔壁面積] 應(yīng)大于0.66。該比率限制了給定孔徑大小的模板厚度,并要求使用更薄的模板來印刷更細(xì)的間距。隨著鋼網(wǎng)制作工藝的提升,鋼網(wǎng)開孔的面積比可以適當(dāng)降低,如下圖4所示。
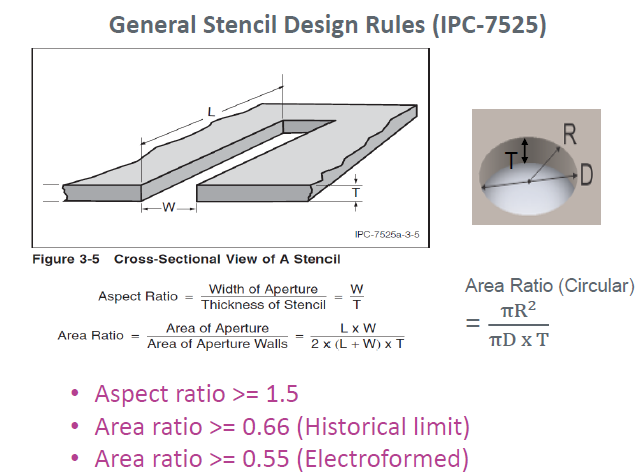
圖4 鋼網(wǎng)開孔規(guī)則
錫膏
錫膏是由焊粉和助焊劑均勻混合而成的膏體,其中錫球的形狀、顆粒大小、尺寸分布、氧化程度以及助焊劑載體的流變性能和配方體系,都對錫膏的印刷和回流性能起著重要作用。細(xì)間距印刷用的焊粉一直是賀利氏電子的優(yōu)勢,因?yàn)閃elco? technology(一種在油介質(zhì)中分散熔融合金的制造技術(shù))利用兩種不同介質(zhì)的表面張力存在差異的原理,用工藝配方控制粉末尺寸范圍,摒棄了傳統(tǒng)的網(wǎng)篩工序,避免了粉末顆粒因網(wǎng)篩而導(dǎo)致的形變(表面積變大)。再者,粉末在油介質(zhì)中得到充分保護(hù),減少了粉末表面的氧化。Welco?焊粉搭配賀利氏獨(dú)特的助焊劑配方體系,使印刷錫膏的轉(zhuǎn)化率能夠得到保證。
圖5 Welco 焊粉 SEM 圖片
當(dāng)前市場上SAW/BAW濾波器的應(yīng)用中常見的Bump高度為50-100μm,結(jié)合單個(gè)芯片的layout,即相鄰bump的最小間距,以及相鄰芯片的bump的最小間距,6號(hào)粉和7號(hào)粉錫膏是匹配的選擇。粒徑的定義是基于IPC的標(biāo)準(zhǔn)(如圖6),即6號(hào)粉有80%的焊粉粒徑分布在5-15μm的區(qū)間。
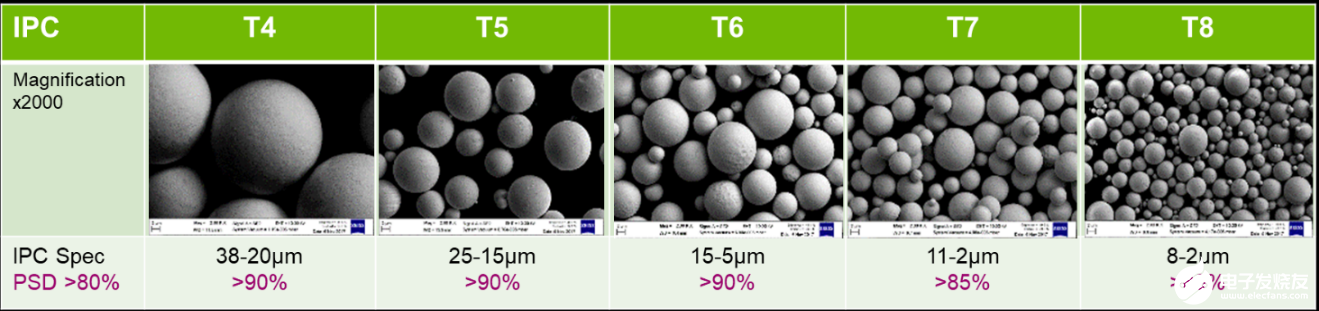
圖6 IPC粒徑規(guī)格
選擇合適粒徑的錫膏非常重要,助焊劑體系的選擇也是非常關(guān)鍵。因?yàn)橐恍㏒AW 的IDT 位置是裸露的,焊錫膏或助焊劑的飛濺都有可能影響IDT 的信號(hào)和聲波之間的轉(zhuǎn)換。對此,賀利氏開發(fā)的AP5112和AP520系列產(chǎn)品在開發(fā)時(shí)均在飛濺方面做了深入的研究,從而盡可能避免飛濺問題。Bump 中空洞的表現(xiàn)也是非常重要的質(zhì)量指標(biāo),尤其是在模組中經(jīng)過多次回流焊之后。
案例分享
應(yīng)用:SAW filter
6 inch 鉭酸鋰晶圓(印刷測試以銅板代替鉭酸鋰晶圓)
Bump 高度=72±8μm;共面度<10μm
鋼網(wǎng)開孔尺寸:130*140*50μm
錫膏:AP5112 SAC305 T6
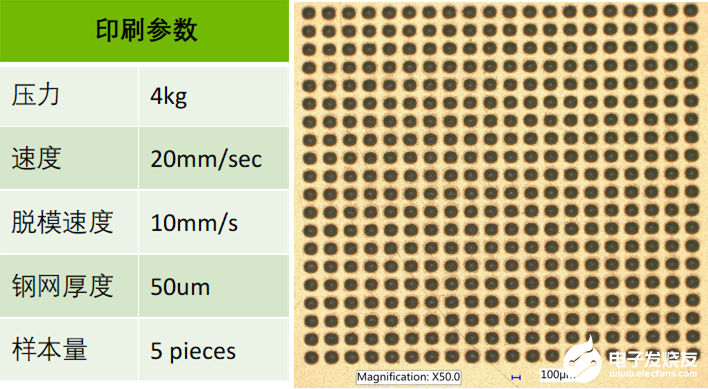
圖7 印刷后
印刷穩(wěn)定性是影響bump高度一致性的關(guān)鍵因素。印刷窗口的定義通常受印刷設(shè)備的能力、鋼網(wǎng)的加工工藝、產(chǎn)品設(shè)計(jì)等因素的影響,通常通過實(shí)驗(yàn)驗(yàn)證獲得。如圖7所示,6號(hào)粉錫膏的連續(xù)印刷表現(xiàn)優(yōu)異,沒有發(fā)現(xiàn)連錫和大小點(diǎn)的問題。Bump的高度數(shù)據(jù)能夠更好地說明。
在回流焊過程中,已印刷在UBM區(qū)域的錫膏逐步熔化,助焊劑流至焊錫四周,而焊料熔化后回流到UBM上并在界面之間形成金屬間化合物(Intermetallic layer),冷卻后形成一定高度的Bump。Bump的平均高度非常靠近目標(biāo)值,且標(biāo)準(zhǔn)差相對較小,如圖8、圖9所示。

圖8 Bump高度數(shù)據(jù)

圖9 Bump高度標(biāo)準(zhǔn)差
Bump 高度的指標(biāo)非常關(guān)鍵,Bump中的空洞也至關(guān)重要。在SAW filter上面的結(jié)果顯示,賀利氏的6號(hào)粉和7號(hào)粉具有良好的表現(xiàn),如圖10所示。

圖10 Bump void 數(shù)據(jù)
晶圓級封裝最終會(huì)以芯片級應(yīng)用到系統(tǒng)封裝,即以倒裝芯片的工藝集成到模組里。在此過程中會(huì)經(jīng)歷多次回流焊工藝,那么回流焊之后bump內(nèi)部的空洞會(huì)發(fā)生怎樣的變化?對此,我們測試了3次回流焊之后bump內(nèi)部空洞的變化,結(jié)果如圖11所示。
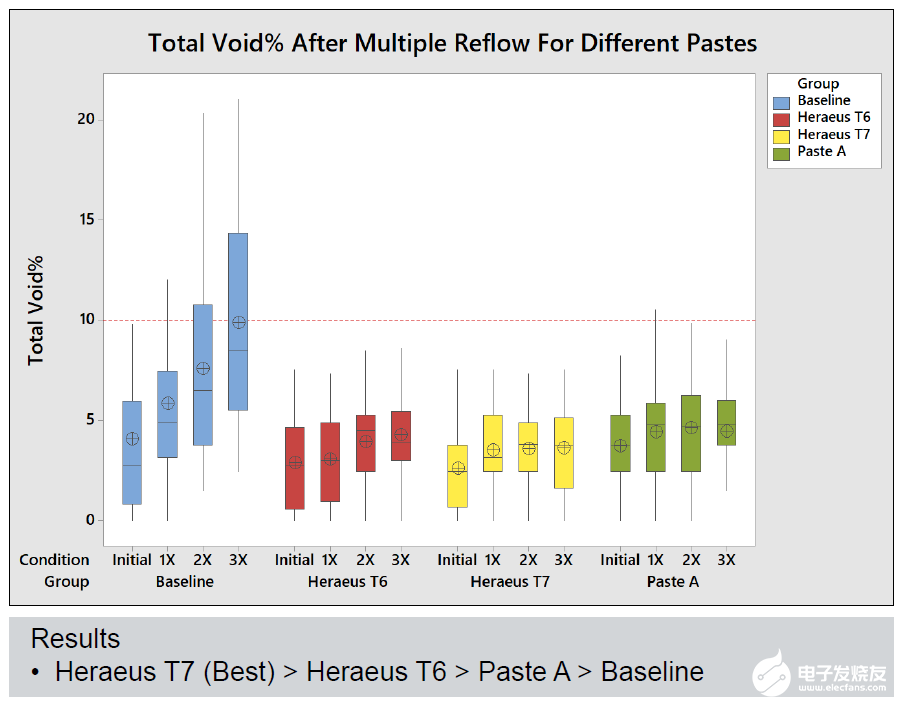
圖11 多次回流焊后空洞變化的數(shù)據(jù)
賀利氏的6號(hào)和7號(hào)粉錫膏對應(yīng)的Bump,在經(jīng)過3次回流焊之后仍然能夠保持在比較好的水平。
總結(jié),本文簡單闡述了晶圓級封裝的關(guān)鍵技術(shù)點(diǎn)。賀利氏Welco焊粉和獨(dú)有的助焊劑配方體系能夠匹配SAW、BAW 等濾波器的晶圓封裝需求。更深層次的技術(shù)細(xì)節(jié),如Bump高度的設(shè)計(jì)和球高與錫膏量的關(guān)系,敬請期待下一篇文章。不論是晶圓級封裝還是先進(jìn)封裝賀利氏都能提供成熟的解決方案。
-
晶圓
+關(guān)注
關(guān)注
52文章
5117瀏覽量
129159 -
封裝
+關(guān)注
關(guān)注
128文章
8479瀏覽量
144773 -
射頻前端
+關(guān)注
關(guān)注
5文章
257瀏覽量
24669
發(fā)布評論請先 登錄
晶圓級WLP封裝植球機(jī)關(guān)鍵技術(shù)研究及應(yīng)用
HRP晶圓級先進(jìn)封裝替代傳統(tǒng)封裝技術(shù)研究(HRP晶圓級先進(jìn)封裝芯片)

什么是晶圓級封裝?
晶圓級封裝產(chǎn)業(yè)(WLP),晶圓級封裝產(chǎn)業(yè)(WLP)是什么意思
晶圓級芯片封裝技術(shù)上市公司有哪些 晶圓級封裝與普通封裝區(qū)別在哪
深入探索:晶圓級封裝Bump工藝的關(guān)鍵點(diǎn)






 晶圓級封裝的關(guān)鍵技術(shù)點(diǎn)
晶圓級封裝的關(guān)鍵技術(shù)點(diǎn)













評論