IC芯片四角邦定加固膠水為底部填充膠,芯片封裝膠水是對芯片引腳四周包封達到保護芯片和加固補強的作用。
底部填充膠是通過自然流動低溫快速固化的一種環氧樹脂膠粘劑,也可以用于芯片四周圍堰上,圍堰填充膠水和一般的底部填充相比,粘度上面會有一定的區別,所以芯片封裝需要分清楚是底部填充加固還是四周圍堰保護芯片。底部填充加固具有更好的緩震性能,而四周包封可以起到保護芯片或者焊點的作用,防止焊點氧化。芯片四角邦定膠和底部填充圍堰膠是一樣的作用,都是為了保護芯片以及焊點的作用。
IC芯片四角邦定加固的環氧膠水應用案例如下:
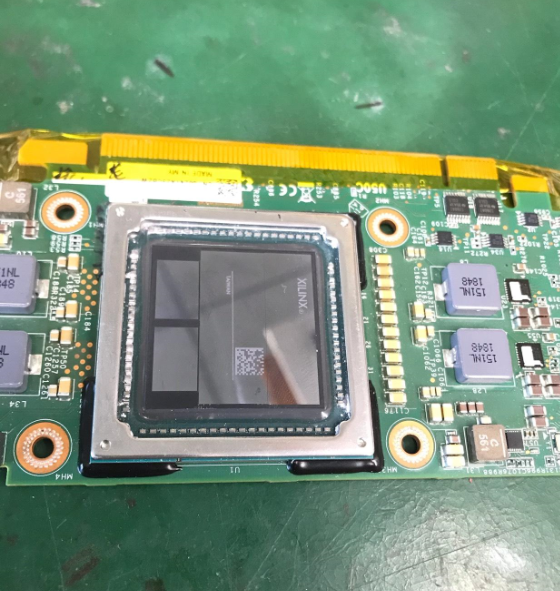 漢思新材料-IC芯片四角邦定加固的環氧膠水應用方案
漢思新材料-IC芯片四角邦定加固的環氧膠水應用方案IC芯片四角邦定加固的環氧膠水應用案例由漢思新材料提供
客戶產品:通訊計算卡
用膠部位:通訊計算卡BGA四角填充加固
芯片尺寸 :5050mm錫球高度:3.71mm錫球間距1.00mm錫球數量:2000顆 錫球大小0.25mm
用膠目的:粘接、固定,抗震動,芯片四角邦定加固。
施膠工藝:簡易型點膠機
固化方式:接受150度 7~8分加熱固化
顏色:無要求
換膠原因:新項目研發。
客戶用膠要求:
a.主芯片較大與板之間的應力,緩解外應力
b.主芯片持續性工作溫度100度,要求緩解熱應力,耐高溫沖擊
c. 要求膠水可返修和粘接力強
漢思新材料推薦用膠:
經過漢思工作人員和客戶溝通對接,推薦底部填充膠HS710給客戶測試。
-
芯片
+關注
關注
459文章
52165瀏覽量
436086 -
材料
+關注
關注
3文章
1320瀏覽量
27721
發布評論請先 登錄
粘接聚酰亞胺PI膜除了使用PI膜專用UV膠粘接,還可以使用熱固化環氧膠來解決!

漢思新材料:創新指紋模組用膠方案,引領智能終端安全新高度

一文講清芯片封裝中的塑封材料:環氧塑封料(EMC)成分與作用
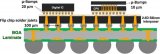
芯片環氧膠可以提供一定的耐鹽霧耐腐蝕效果






 漢思新材料-IC芯片四角邦定加固的環氧膠水應用方案
漢思新材料-IC芯片四角邦定加固的環氧膠水應用方案




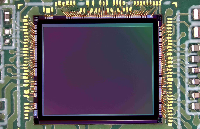












評論