在過去四十年間,刀片(blade)與劃片(dicing)系統不斷改進以應對工藝的挑戰,滿足不同類型材料切割的要求。行業不斷研究刀片、切割工藝參數等對切割品質的影響,使切割能夠滿足日新月異的晶圓材質變化。
劃片機制(The Dicing Mechanism)

硅晶圓劃片工藝是“后端”封裝制程工藝中的第一步。該工藝將晶圓分成獨立帶有電氣性能的芯片,用于隨后的芯片粘合(die bonding)、引線焊接(wire bonding)和測試。劃片機空氣靜壓主軸以每分鐘30000~60000rpm的速度(83~175m/sec的線性速度)轉動刀片。該刀片由嵌入電鍍鎳矩陣結合劑中的研磨金剛石制成。
在晶圓切割過程中,刀片碾碎基礎材料,同時去掉所產生的碎屑,冷卻水(通常是去離子水)用于冷卻刀片并改善切割品質,通過幫助去掉碎屑而延長刀片壽命。
關鍵工藝參數
晶圓切割追求生產效率和合格率最大化,同時投入的成本最小。但是,面臨的挑戰是,生產效率增加往往導致合格率降低,反之亦然。隨著進給速度增加,切割品質會下降,同時也影響刀片壽命。
晶圓切割經常遇到較窄的切割槽,要求設備能將每一次切割都精準放在切割槽中心幾微米范圍內。這不僅需要非常高的設備精度,更需要一款高精度超薄劃片刀。
可是,越薄的刀片(比如:10μm)越脆弱,更容易過早破裂和磨損,導致其壽命和工藝穩定性較之稍厚的刀片差。對于50~76μm切割槽的刀片一般推薦刀片厚度應該是20~30μm。
崩邊(Chipping)
正崩(TSC, top-side chipping),發生在晶圓的表面,當劃片刀接近晶圓的有源區域時,主要依靠主軸轉速、金剛石粒度、金剛石濃度、冷卻水流量和進給速度等因素控制。
背崩(BSC, back-side chipping),發生在晶圓的背面,當不規則微小裂紋從晶圓的背面擴散開并匯合到一起時,這些微小裂紋足夠長而引起較大顆粒從切口掉出,背崩就會影響到產品合格率。通常,切割硅晶圓的質量判定標準是:如果背面崩缺尺寸在10μm以下,忽略不計;當尺寸大于25μm時,可以看作是潛在的受損;一般,50μm以內的平均大小在可接受范圍內,具體要求可示晶圓的厚度來定。
可以用來控制崩邊的的方法和技術,主要是優化刀片,以及優化工藝參數。
刀片優化(Blade Optimization)
除了尺寸,有三個關鍵元素決定刀片特性:金剛石(磨料)尺寸、金剛石含量和粘結劑的類型。這些元素的結合效果決定刀片的壽命和切割品質(TSC與BSC)。改變任何一個參數都將直接影響刀片性能。
為一個既定的劃片工藝選擇最佳刀片,要求在刀片壽命與切割品質之間作出平衡。高壽命,品質降低;高品質,壽命降低。劃片刀所用金剛石越細,對工藝參數的變化越敏感。
其它因素,諸如進給速度和主軸轉速,也可能影響刀片選擇。切割參數對材料去除率有直接影響,它反過來會影響刀片的性能和工藝效率。刀片廠家(例如:深圳西斯特)會對這些規律做深入研究,以應對市場諸多材料精密劃切過程中面臨的多樣需求。
為了選擇一款合適的刀片,重要的還是要理解刀片外表硬度的影響,刀片外表硬度通常叫做基體硬度。基體硬度通過金剛石尺寸、濃度和粘合物硬度來決定。通常,較細的磨料尺寸、較高的金剛石濃度和較硬的粘合物將得到相對增加的基體硬度。通常建議,與其它因素綜合考慮,較硬的材料需要較軟的(基體)刀片來切,反之亦然。例如,砷化鎵(GaAs)晶圓一般要求較細的金剛砂尺寸(較硬的刀片),而鉭酸鋰(LiTaO3)晶圓最適合用較粗的金剛砂尺寸和較低的金剛石濃度(較軟的刀片)。
結語
總而言之,劃片工藝變得越來越精良且要求高。切割跡道變得越來越窄,且跡道內可能充滿測試用的衰耗器(test pad),并且刀片可能還需要切割由不同材料制成的各種涂敷層。在這些條件下達到最大的劃片工藝合格率和生產率,要求有精準選刀能力與先進工藝控制能力。
-
晶圓
+關注
關注
52文章
5123瀏覽量
129168
發布評論請先 登錄
晶圓減薄工藝分為哪幾步
MICRO OLED 金屬陽極像素制作工藝對晶圓 TTV 厚度的影響機制及測量優化






 晶圓切割追求刀片與工藝的雙重優化
晶圓切割追求刀片與工藝的雙重優化





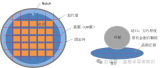













評論