技術(shù)概述
聚焦離子束與掃描電鏡聯(lián)用系統(tǒng)(FIB-SEM)是一種融合高分辨率成像與微納加工能力的前沿設(shè)備,主要由掃描電鏡(SEM)、聚焦離子束(FIB)和氣體注入系統(tǒng)(GIS)構(gòu)成。聚焦離子束系統(tǒng)利用靜電透鏡將離子束聚焦至極小尺寸,最小束斑直徑可小于10納米,是一種高精度的顯微加工工具。當(dāng)前商用系統(tǒng)中,離子源種類豐富,涵蓋鎵(Ga)、氙(Xe)、氦(He)等。
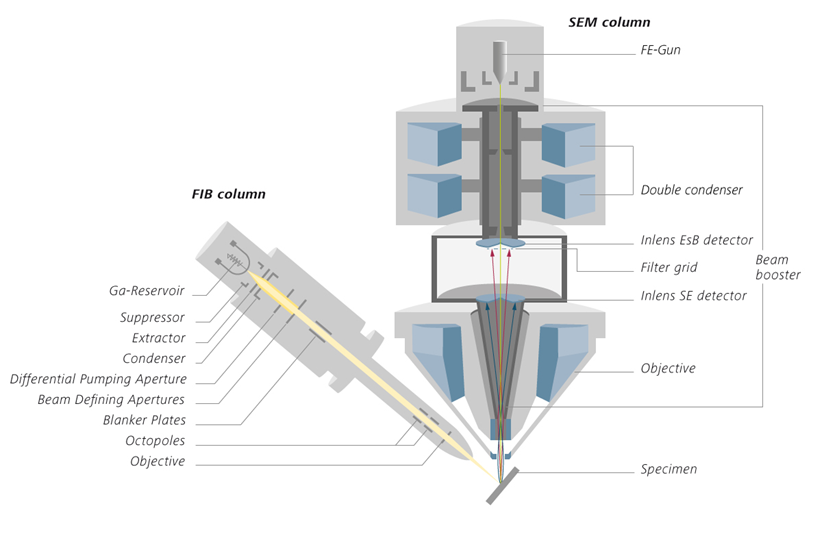
在系統(tǒng)設(shè)計(jì)上,電子束鏡筒與離子束鏡筒之間存在固定夾角,不同廠商設(shè)備角度略有不同,F(xiàn)IB加工時(shí),需將樣品傾轉(zhuǎn)至相應(yīng)角度,使加工面正對離子束。
掃描電鏡主要負(fù)責(zé)高分辨率成像,結(jié)合能譜儀可進(jìn)行元素分析,還能用于特定材料的電子束曝光;而FIB的核心功能是微納加工,可用于透射電鏡(TEM)、三維原子探針(APT)等樣品的制備,也可用于離子束成像,因其具有更明顯的離子通道襯度,可用于飛行時(shí)間二次離子質(zhì)譜(TOFSIMS)分析等。GIS系統(tǒng)則主要用于FIB加工前沉積保護(hù)層,以及半導(dǎo)體刻蝕和線路修復(fù)等。
離子源的分類與特點(diǎn)
1.液態(tài)金屬離子源
液態(tài)金屬離子源如鎵(Ga)、鈹(Be)、鈀(Pd)等,發(fā)射溫度低,壽命較長,應(yīng)用最為廣泛。其原理是利用液態(tài)金屬在強(qiáng)電場作用下產(chǎn)生場致離子發(fā)射形成離子源。鎵(Ga)作為目前使用最普遍的液態(tài)金屬離子源,具有諸多顯著優(yōu)點(diǎn)。其熔點(diǎn)低,容易成為液態(tài),高溫下不易發(fā)生相互擴(kuò)散;表面自由能低,容易浸潤鎢針尖端;加工精度較高,對樣品的損傷相對較小;液態(tài)下不易揮發(fā),有較長的使用壽命。
2.氣體場發(fā)射離子源
氣體場發(fā)射離子源如氦(He)、氖(Ne)等,亮度更高、束斑更小,但發(fā)射穩(wěn)定性略差,壽命較短。
3.等離子體離子源
等離子體離子源如氙(Xe)、氬(Ar)、氧(O)等,電流更大,可進(jìn)行高通量切割,適合大體積表征,尤其適合加工對離子束輻照敏感的材料,但價(jià)格較昂貴。
FIB的核心功能

1.切割功能
切割功能源于聚焦離子束的高能量,可通過轟擊改變樣品表面形狀,結(jié)合掃描電鏡可實(shí)現(xiàn)定點(diǎn)、定位取樣,適用于微納圖案加工以及TEM和APT樣品的制備。
2.沉積或增強(qiáng)刻蝕功能
沉積或增強(qiáng)刻蝕功能利用FIB將GIS中的氣體分子沉積或作用在樣品表面,可用于表面Pt保護(hù)、半導(dǎo)體線路修復(fù)及故障診斷剖析等。
3.成像功能
成像功能借助掃描電鏡的探測器,離子束可用于觀察表面形貌,尤其對于金屬,二次離子的通道效應(yīng)更明顯,晶粒取向更易區(qū)分,同時(shí)二次離子還能進(jìn)行微區(qū)元素分析,適用于表征同位素的分布。
FIB-TEM樣品制備難點(diǎn)與解決方案
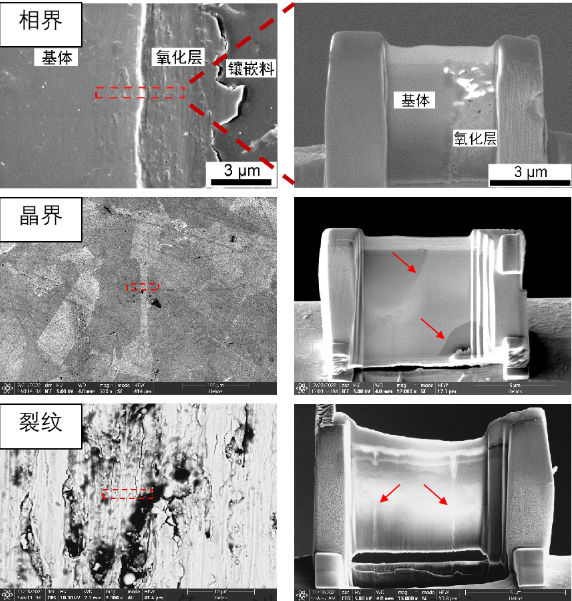
1.相界樣品
相界樣品由于相界兩邊材料及成分差異大,Ga離子減薄時(shí)速率有差別,需調(diào)控減薄方式,如分區(qū)域減薄,對難減薄的相增加減薄次數(shù),使樣品整體厚度趨于均勻一致。
2.晶界樣品
晶界樣品需將晶界留在減薄區(qū)域,要預(yù)挖坑確認(rèn)晶界走向,才能減薄得到含有晶界的TEM樣品。
3.裂紋樣品
裂紋樣品與晶界樣品類似,需將裂紋留在減薄區(qū)域,選擇裂紋時(shí)要初步篩選,減薄時(shí)必須控制角度、電壓電流等,因?yàn)榱鸭y是缺陷,控制不當(dāng)會(huì)迅速擴(kuò)大,難以得到質(zhì)量較好的TEM樣品。
4.粉末樣品
對于粉末樣品,獲得全截面的TEM樣品較為困難。需選擇合適的支撐物,表面平整且有一定靜電吸附能力;解決粉末顆粒的固定問題,采用Pt沉積固定,從多角度、多位置沉積,形成Pt包裹層,后續(xù)根據(jù)需要適時(shí)補(bǔ)焊Pt,保證固定牢固性,提高減薄成功率。
FIB在工業(yè)領(lǐng)域的應(yīng)用案例
1.金屬材料工業(yè)
在金屬材料工業(yè)中,企業(yè)常面臨表面異物、缺陷等問題。例如,某金屬表面出現(xiàn)大量凸起異物,需查明原因。利用FIB深度剖析,從表層到基體得到顯微組織,發(fā)現(xiàn)基材層表面平整無缺陷,但第一層鍍層存在向外凸起、向內(nèi)少量嵌入基材且有明顯缺陷等問題,外凸導(dǎo)致第二次涂鍍表面形態(tài)異常。實(shí)驗(yàn)準(zhǔn)確指出了異物產(chǎn)生的位置,為客戶改進(jìn)工藝提供了很大幫助。
2.有機(jī)材料領(lǐng)域
在有機(jī)材料領(lǐng)域,對于非表面的缺陷鑒定,F(xiàn)IB也能提供解決方案。如某有機(jī)半透明膜在光學(xué)顯微鏡下隱約發(fā)現(xiàn)異常點(diǎn),但表面肉眼不可見,深度未知。先利用微分干涉功能初步確定異常點(diǎn)在二維平面的相對位置,再結(jié)合FIB進(jìn)行深度方向剖析。實(shí)驗(yàn)難點(diǎn)在于異常點(diǎn)唯一,F(xiàn)IB切割不可逆,需嚴(yán)格計(jì)算開槽位置、控制加工速度和深度,邊切邊看,切到異常點(diǎn)立即停止。通過合理方案,成功確定了異常點(diǎn)的位置和異物成分。
3.半導(dǎo)體行業(yè)
在半導(dǎo)體行業(yè),F(xiàn)IB應(yīng)用頻繁,是物理表征和失效分析的重要手段。例如,用FIB判別激光切割對晶圓芯片的損傷層影響。這種實(shí)驗(yàn)?zāi)康男詮?qiáng),時(shí)效性要求高,需設(shè)置合適參數(shù)快速得到可觀測面,進(jìn)行特定位置的尺寸測量。
-
fib
+關(guān)注
關(guān)注
1文章
91瀏覽量
11332 -
離子束
+關(guān)注
關(guān)注
0文章
82瀏覽量
7723 -
掃描電鏡
+關(guān)注
關(guān)注
0文章
109瀏覽量
9324
發(fā)布評論請先 登錄
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應(yīng)用介紹
聚焦離子束技術(shù)介紹
聚焦離子束掃描電鏡(FIB-SEM)技術(shù)原理、樣品制備要點(diǎn)及常見問題解答

聚焦離子束系統(tǒng)的結(jié)構(gòu)、工作原理及聚焦離子束雙束系統(tǒng)
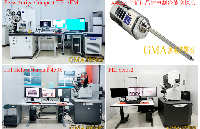
聚焦離子束(FIB)技術(shù)原理和應(yīng)用

雙束聚焦離子束-掃描電鏡(FIB):TEM樣品制備

聚焦離子束掃描電鏡雙束系統(tǒng)(FIB-SEM)
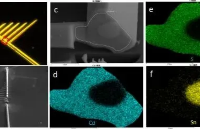
聚焦離子束技術(shù)在納米加工中的應(yīng)用與特性
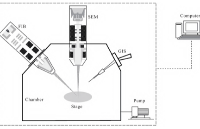
一文了解聚焦離子束(FIB)技術(shù)及聯(lián)用技術(shù)
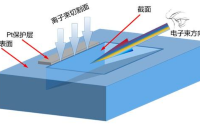





 聚焦離子束與掃描電鏡聯(lián)用技術(shù)
聚焦離子束與掃描電鏡聯(lián)用技術(shù)


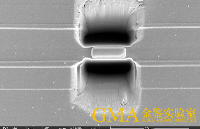










評論