日前,華為技術有限公司公布一項全新專利,命名為“封裝結構及其制造方法、板級架構以及電子設備”,專利公開編號為CN117577594A,申請日期為2022年8月。
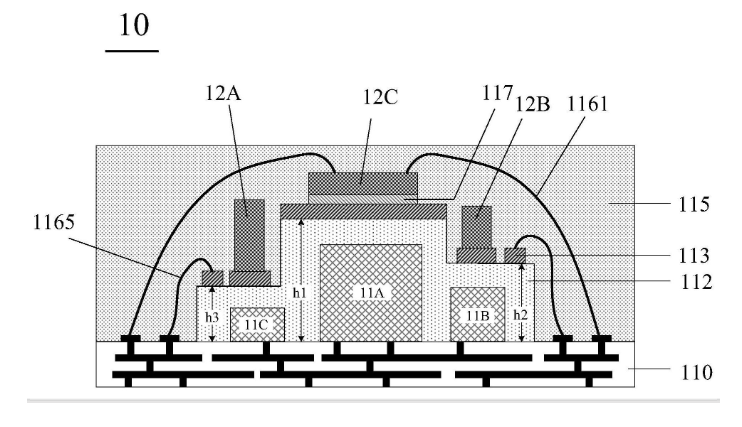
據悉,該新型專利涉及封裝結構設計、制造流程、板級架構以及相應的電子設備等多方面內容。具體而言,創新性的封裝結構由基板、多種不同功能的元器件、第一和第二塑封層以及金屬布線層組成。巧妙地將基板上方的第一塑封層依照元器件的高度進行規劃,極大地節省了高度方向的使用空間,進一步提升了封裝結構的堆疊密度;此外在第一塑封層頂部還設置有金屬布線層,用以配合第二塑封層將元器件穩固地安裝并實現基板間的電氣連通。相較于傳統的封裝結構,新發明在此基礎上減少了一塊基板的使用量,有效地降低了生產成本。同時,由于第二元器件直接被安裝在第一金屬布線層上,從而使整個裝置具備顯著的散熱功效。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
元器件
+關注
關注
113文章
4807瀏覽量
94319 -
電子設備
+關注
關注
2文章
2871瀏覽量
54517 -
專利
+關注
關注
3文章
591瀏覽量
39672 -
華為技術
+關注
關注
0文章
40瀏覽量
7331
發布評論請先 登錄
相關推薦
熱點推薦
系統級封裝電磁屏蔽技術介紹
多年來,USI環旭電子始終致力于創新制程技術的研發,為穿戴式電子設備中的系統級封裝(SiP)實現高集成度及高性能的解決方案。其中,電磁屏蔽性能的持續優化與提升,可謂是 SiP 技術發展

簽約頂級封裝廠,普萊信巨量轉移技術掀起晶圓級封裝和板級封裝的技術革命
經過半年的測試,普萊信智能和某頂級封裝廠就其巨量轉移式板級封裝設備(FOPLP)設備XBonder Pro達成戰略合作協議,這將是巨量轉移技

華為公布AI模型訓練與車輛控制專利
近日,華為技術有限公司在技術創新領域再次邁出重要一步,其申請的“模型的訓練方法、車輛的控制方法及相關裝置”專利于2月18日正式公布。這一
半導體封裝的主要類型和制造方法
半導體封裝是半導體器件制造過程中的一個重要環節,旨在保護芯片免受外界環境的影響,同時實現芯片與外部電路的連接。隨著半導體技術的不斷發展,封裝技術也在不斷革新,以滿足電子設備小型化、高性能、低成本和環保的需求。本文將詳細介紹半導體

封裝工藝簡介及元器件級封裝設備有哪些
? 本文介紹了封裝工藝簡介及元器件級封裝設備有哪些。 概述 電子產品制造流程涵蓋半導體元件制造及整機系統集成,以晶圓切割成芯片為分界,大致分為前期工序與后期工序,如圖所示。后期工序主要

電源技術對電子設備的影響
電源技術對電子設備的影響深遠且重要,主要體現在以下幾個方面: 一、提供穩定電能 電源技術是電子設備正常運行的基礎,它負責為設備提供穩定和適當的電能。這種穩定的電能供應是確保電子設備能夠
長電科技申請電感封裝結構專利
近日,江蘇長電科技股份有限公司在電感封裝技術領域取得重要突破,向國家知識產權局提交了一項名為“一種電感封裝結構、相應的制備方法及封裝板





 華為公布封裝結構、封裝方法、板級架構及電子設備專利
華為公布封裝結構、封裝方法、板級架構及電子設備專利














評論