本文介紹了封裝工藝簡介及元器件級封裝設(shè)備有哪些。
概述
電子產(chǎn)品制造流程涵蓋半導(dǎo)體元件制造及整機(jī)系統(tǒng)集成,以晶圓切割成芯片為分界,大致分為前期工序與后期工序,如圖所示。后期工序主要包含芯片封裝與組件裝配兩大環(huán)節(jié)。

封裝與裝配過程可細(xì)分為四個層級:芯片級封裝(0級)、元件級封裝(1級)、板卡級裝配(2級)以及系統(tǒng)整機(jī)裝配(3級)。通常,0級與1級封裝被歸類為電子封裝范疇,而2級與3級則屬于電子裝配領(lǐng)域。電子封裝旨在妥善安放、固定、密封芯片,提供保護(hù)并優(yōu)化其電熱性能,通過導(dǎo)線、凸點等方式將芯片內(nèi)部電路與外部封裝殼的引腳相連,或?qū)崿F(xiàn)多個芯片間的高效、可靠互聯(lián)。自20世紀(jì)50年代以來,電子封裝技術(shù)經(jīng)歷了從晶體管封裝(TO封裝)、雙列直插式封裝(DIP)、小型封裝(SOP)、四方扁平封裝(QFP)、引腳網(wǎng)格陣列封裝(PGA)、球柵陣列封裝(BGA)、多芯片封裝(MCP)至系統(tǒng)級封裝(SiP)的演變。隨著集成電路技術(shù)的不斷進(jìn)步,其性能指標(biāo)日益提升,芯片與封裝面積比趨近于1,適用性與耐熱性顯著增強(qiáng),引腳數(shù)量增加,間距縮小,重量減輕,可靠性及易用性均得到顯著提高。
在2級裝配階段,這些引腳通過印刷電路板(PCB)上的線路與其他元件建立連接,此過程主要運用了通孔插裝(THT)與表面貼裝技術(shù)(SMT)。鑒于SMT的顯著優(yōu)勢,它已成為當(dāng)前電子制造業(yè)的主流技術(shù)。先進(jìn)的電子封裝技術(shù)正朝著系統(tǒng)設(shè)計的綜合化方向發(fā)展,各封裝階段由分散獨立轉(zhuǎn)向集中統(tǒng)一,由單純的生產(chǎn)制造向設(shè)計主導(dǎo)型轉(zhuǎn)變,即3級封裝正逐步融合為一個整體。
集成電路的芯片制造與封裝技術(shù)水平與其相關(guān)設(shè)備的性能緊密相連,先進(jìn)的設(shè)備是打造高端芯片與封裝技術(shù)的基石。在芯片與封裝的生產(chǎn)流程中,設(shè)備、工藝、材料以及環(huán)境這四大關(guān)鍵因素相互依存、相互促進(jìn),共同推動著技術(shù)的發(fā)展。因此,要推動芯片與封裝技術(shù)的進(jìn)步,設(shè)備的發(fā)展必須走在前列。許多在此領(lǐng)域較為領(lǐng)先的國家均投入巨資致力于相關(guān)設(shè)備的研發(fā),這正是對這一關(guān)系的深刻認(rèn)識。
電子封裝工藝設(shè)備特指在電子產(chǎn)品研發(fā)、制造及封裝過程中,專門用于基板制備、元器件封裝、板級組裝、整機(jī)系統(tǒng)集成、工藝環(huán)境控制、生產(chǎn)過程監(jiān)測以及產(chǎn)品質(zhì)量保障的設(shè)備。在電子封裝工藝設(shè)備領(lǐng)域,有如下三個方面尤為基礎(chǔ)且規(guī)模龐大,它們與工藝結(jié)合最為緊密,對封裝性能的影響也最為顯著:
1.在0級封裝階段,為了執(zhí)行晶圓的測試、減薄及切割作業(yè),主要依賴的封裝設(shè)備包括晶圓探針測試臺、晶圓研磨減薄機(jī)、砂輪切割機(jī)以及激光劃片機(jī)等。
2.進(jìn)入1級封裝階段,為實現(xiàn)芯片的互聯(lián)與封裝,關(guān)鍵設(shè)備涵蓋粘片機(jī)、金絲球焊機(jī)(引線鍵合)、塑封機(jī)、切筋成型機(jī)、倒裝機(jī)、激光打標(biāo)機(jī)以及引線電鍍機(jī)等。此外,針對圓片級芯片尺寸封裝(WLCSP)技術(shù),還需使用圓片凸點制作設(shè)備、植球設(shè)備、金屬沉積裝置(用于圓片級封裝)及光刻機(jī)等。
3.在板卡級,即2級組裝階段,為滿足PCB組裝需求,主要設(shè)備有焊錫膏涂布機(jī)、精密絲網(wǎng)印刷裝置、點膠作業(yè)機(jī)、自動貼片機(jī)、回流焊接爐、波峰焊接機(jī)、清洗設(shè)備以及自動視覺檢測系統(tǒng)。同時,為制備電路組裝所需的基板,所需的主要基板工藝設(shè)備包括真空層壓成型機(jī)、精密鉆孔設(shè)備、電鍍通孔系統(tǒng)、涂膠裝置、刻蝕機(jī)、顯影機(jī)、光刻機(jī)、再次的絲網(wǎng)印刷機(jī)(用于不同工序)、電鍍銅生產(chǎn)線、自動光學(xué)檢測系統(tǒng)與打標(biāo)機(jī)等。
隨著技術(shù)迭代,傳統(tǒng)插裝式封裝(如DIP)的市場份額逐漸縮小,而倒裝芯片封裝、扇出型封裝、圓片級封裝(WLP)、系統(tǒng)級封裝(SiP)以及三維(3D)封裝等先進(jìn)封裝技術(shù)正成為行業(yè)主流。相應(yīng)地,先進(jìn)封裝設(shè)備也在持續(xù)推出與升級,例如用于超薄晶圓加工的臨時鍵合與去鍵合設(shè)備、晶圓直接鍵合機(jī)等。
粘片機(jī)
芯片粘貼是將集成電路芯片穩(wěn)固地安裝到封裝基板或外殼上的過程,這一步驟主要依賴于粘片機(jī)這一專業(yè)設(shè)備。在晶圓生產(chǎn)線階段,芯片會先經(jīng)過片上測試,有缺陷的芯片會被標(biāo)記,以便后續(xù)封裝時能夠識別并排除。封裝工藝的首要步驟是將晶圓上的芯片分割成單個單元。隨后,這些單獨的芯片會通過粘片工藝被精確地安置在引線框架或芯片載體上。
粘片過程中所使用的粘合材料多樣,包括但不限于金屬焊料和導(dǎo)電環(huán)氧樹脂。粘片機(jī),亦稱芯片鍵合機(jī)、裝片機(jī)或固晶設(shè)備,其核心構(gòu)成包括承載平臺、點膠裝置、鍵合執(zhí)行頭、視覺定位系統(tǒng)、物料轉(zhuǎn)運系統(tǒng)以及上下機(jī)箱和基座等組件,如圖所示。鍵合執(zhí)行頭負(fù)責(zé)芯片的拾取與放置,是粘片工藝中的核心部件。它協(xié)同承載平臺,從藍(lán)膜上精確抓取芯片,并與物料搬運系統(tǒng)配合,將芯片準(zhǔn)確無誤地放置于已涂覆粘合劑的封裝基底上。
隨后,對芯片施加均勻壓力,確保芯片與封裝基底間形成厚度一致的粘合劑層。
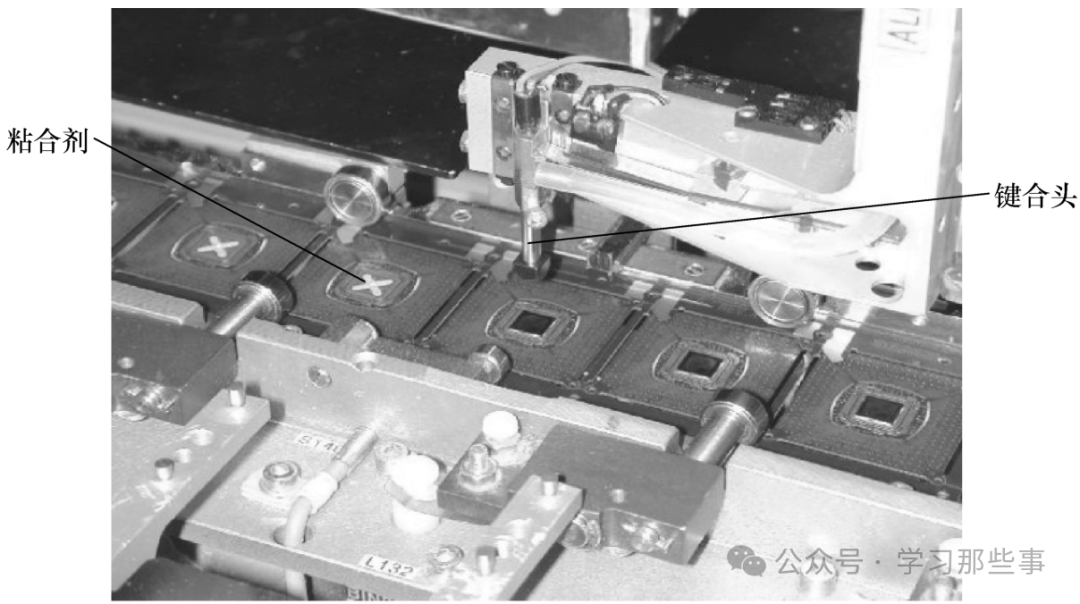
粘片機(jī)內(nèi)部結(jié)構(gòu)圖
在承載臺與物料轉(zhuǎn)運系統(tǒng)的驅(qū)動裝置上,均裝備了一套視覺定位裝置,用以精確鎖定芯片與封裝基板的位置,并將芯片的精確坐標(biāo)信息傳遞給運動調(diào)控模塊,從而即時調(diào)整控制參數(shù),確保貼片作業(yè)順利進(jìn)行。物料轉(zhuǎn)運系統(tǒng)承擔(dān)著貼片工藝中物料條的全自動化管理任務(wù),這包括上料、輸送/夾持、下料等一系列流程。作為貼片機(jī)的核心構(gòu)成,芯片傳輸機(jī)構(gòu)需兼具緊湊與精密的設(shè)計特點。鑒于圓片的移動遵循x-y平面的柵格掃描軌跡,因此,圓片/芯片供給系統(tǒng)的核心組件為x-y位移臺。在實施貼片作業(yè)時,圓片的移動步長需與相鄰芯片間距相協(xié)調(diào),同時,x-y位移臺的行程需超出圓片直徑,以保證圓片上的任意芯片都能被頂針托起并移送至吸嘴下方。當(dāng)前,主流的圓片直徑標(biāo)準(zhǔn)包括150mm、200mm及300mm,其中,300mm規(guī)格在國際市場上占據(jù)主導(dǎo)地位。粘片機(jī)的關(guān)鍵技術(shù)領(lǐng)域涉及整機(jī)運動調(diào)控、芯片的高速且高精度的拾取與放置,以及圖像辨識技術(shù)。針對芯片拾取與放置機(jī)構(gòu),高速性與高精度是其設(shè)計的兩大關(guān)鍵要素。
引線鍵合機(jī)
引線鍵合技術(shù)是一種利用導(dǎo)電引線將封裝內(nèi)部的芯片焊接區(qū)與外部引腳相連接的工藝,它在確保集成電路具備所需的電氣、光學(xué)、熱學(xué)和機(jī)械性能方面起著至關(guān)重要的作用。因其實現(xiàn)方式靈活多變、成本效益高以及兼容多種封裝形式,引線鍵合在封裝連接技術(shù)中占據(jù)核心地位。為了實現(xiàn)多樣化的線弧形態(tài),以適應(yīng)不同的封裝需求,引線接合技術(shù)通過陶瓷細(xì)管引導(dǎo)金屬引線在三維空間內(nèi)執(zhí)行復(fù)雜的高速運動,將已經(jīng)固定在引線框架上的芯片內(nèi)部連接點與引線框架上的外部引腳進(jìn)行物理連接,如圖所示。
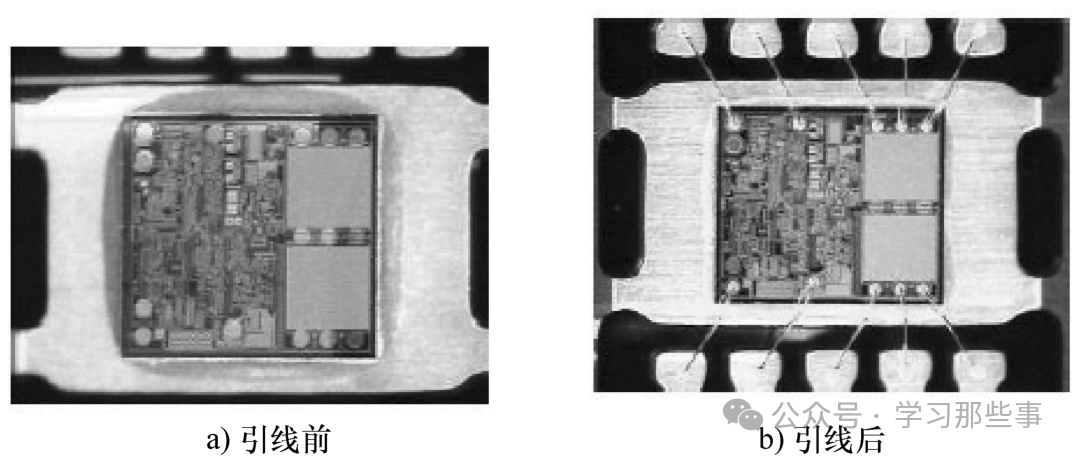
引線示意圖
在半導(dǎo)體封裝生產(chǎn)流程中,引線鍵合機(jī)也被稱為壓焊機(jī)、球焊機(jī)、邦定機(jī)或焊絲機(jī)。根據(jù)在引線末端工藝中使用的能量類型,主要有三種基本的引線鍵合方法:熱壓鍵合、超聲鍵合、熱超聲金球焊接。
熱壓鍵合技術(shù):此過程涉及將熱能及壓力施加至芯片焊接點及引線框架內(nèi)電極上,旨在實現(xiàn)金屬引線的牢固連接。操作中,一個特制的毛細(xì)管刀具被用來精確放置引線至預(yù)熱后的芯片焊接點,并施加必要的壓力。熱與力的協(xié)同作用,促進(jìn)了金引線與鋁焊接點間的楔形鍵合。隨后,該刀具移至引線框架內(nèi)的電極位置,同時引入新的引線,以相同機(jī)制再次形成楔形鍵合。此鍵合步驟循環(huán)進(jìn)行,直至所有芯片焊接點均與對應(yīng)的引線框架內(nèi)部電極成功連接。

熱壓鍵合
超聲鍵合技術(shù):此技術(shù)依賴于超聲波能量與機(jī)械壓力,實現(xiàn)引線至焊接點的楔形緊固連接,適用于同質(zhì)或異質(zhì)金屬材料的結(jié)合,諸如鋁-鋁或金-鋁連接。引線借助類似熱壓焊接中的毛細(xì)管引導(dǎo)部件底部的通道,精準(zhǔn)定位至芯片焊接點上方。隨后,引導(dǎo)部件尖端施加壓力并快速振動,振動頻率通常在60kHz至100kHz范圍內(nèi),以促進(jìn)冶金結(jié)合的形成,此過程無需基座加熱。一旦焊接完成,工具轉(zhuǎn)移至引線框架內(nèi)的電極焊接點,完成焊接并剪斷引線。該流程循環(huán)執(zhí)行,直至所有芯片焊接點均與相鄰引線框架電極通過引線牢固連接。

超聲鍵合步驟
熱超聲金球焊接技術(shù):這是一種融合超聲波振動、熱能及機(jī)械壓力實現(xiàn)焊接的方法,特色在于金球的形成與焊接。基座保持約150℃恒溫。采用碳化鎢或陶瓷材質(zhì)的毛細(xì)管引導(dǎo)部件,通過中心通道垂直供給細(xì)金絲。金絲末端經(jīng)火焰預(yù)熱或電容放電加熱至熔化,于針尖凝結(jié)成金球。焊接時,超聲波能量與壓力共同作用,促使金球與鋁焊接點間發(fā)生冶金結(jié)合。金球焊接步驟結(jié)束后,焊接裝置移至基座內(nèi)部電極焊接點,執(zhí)行熱壓楔形焊接,隨后剪斷引線并移至下一個芯片焊接點。此金球焊接與楔形焊接序列對精確控制焊接點與內(nèi)部電極間引線連接的尺寸至關(guān)重要,尤其對于輕薄集成電路而言。

熱超聲金球焊接步驟
為評估引線焊接質(zhì)量,采用引線拉力測試(見下圖),通過測量單個焊接點的抗拉強(qiáng)度來確定失效位置,例如焊接根部(引線與焊接點結(jié)合界面)。這些量化數(shù)據(jù)可通過統(tǒng)計過程控制手段進(jìn)行監(jiān)測,以分析工藝穩(wěn)定性及趨勢變化。
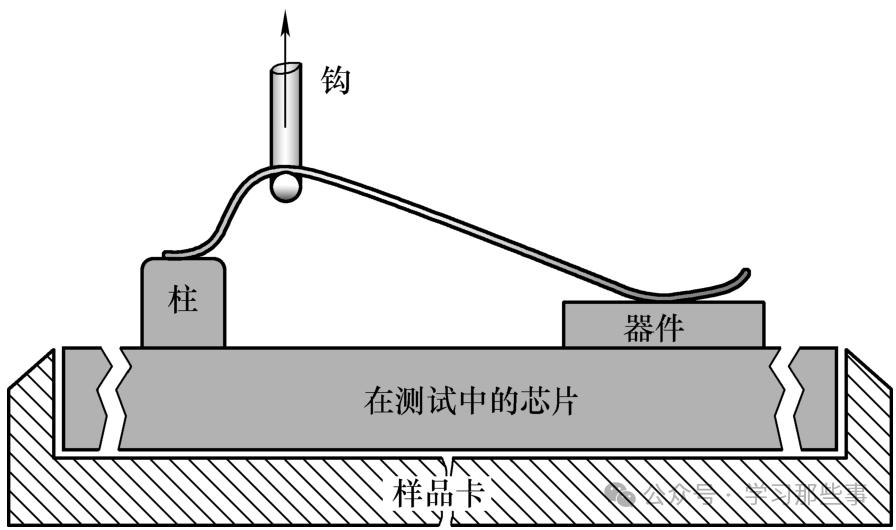
引線鍵合拉力試驗
-
元器件
+關(guān)注
關(guān)注
113文章
4807瀏覽量
94296 -
封裝
+關(guān)注
關(guān)注
128文章
8474瀏覽量
144762
原文標(biāo)題:封裝工藝簡介及元器件級封裝設(shè)備
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
器件高密度BGA封裝設(shè)計
MEMS器件的封裝級設(shè)計
晶圓凸起封裝工藝技術(shù)簡介
招聘封裝工程師
【PCB封裝工藝】低溫低壓注塑
招聘人才 封裝工藝工程師
BGA的封裝工藝流程基本知識簡介
透明封裝工藝簡介
功率模塊封裝工藝






 封裝工藝簡介及元器件級封裝設(shè)備有哪些
封裝工藝簡介及元器件級封裝設(shè)備有哪些










評論