引言
通過有效控制AlN薄膜與Si襯底之間的界面反應(yīng),利用脈沖激光沉積(PLD)在Si襯底上生長高質(zhì)量的AlN外延薄膜。英思特對PLD生長的AlN/Si異質(zhì)界面的表面形貌、晶體質(zhì)量和界面性能進行了系統(tǒng)研究。
我們研究發(fā)現(xiàn),高溫生長過程中形成非晶SiAlN界面層,這是由于高溫生長過程中燒蝕AlN靶材時,襯底擴散的Si原子與脈沖激光產(chǎn)生的AlN等離子體之間發(fā)生了嚴重的界面反應(yīng)所致。相反,通過在合適的生長溫度下有效控制界面反應(yīng),可以實現(xiàn)突變且尖銳的AlN/Si異質(zhì)界面。
因此英思特提出了通過PLD將界面層從非晶SiAlN層演變?yōu)橥蛔兦壹怃J的AlN/Si異質(zhì)界面的機制。通過PLD生長的AlN薄膜獲得突變界面和平坦表面的工作對于高質(zhì)量AlN基器件在Si襯底上的應(yīng)用至關(guān)重要。
實驗與討論
使用H2SO4:H2O2:H2O(3:1:1)和緩沖氧化物蝕刻(BOE)HF(20:1)清潔收到的2英寸 Si(111) 基板以獲得無氧化物且氫封端的Si表面。隨后,將清潔后的Si(111)襯底在背景壓力為1.0×10-8 Torr的超高真空(UHV)負載鎖中脫氣,然后?轉(zhuǎn)移到背景壓力為1.0×10-8Torr的生長室中。在外延生長之前,脫氣后的Si(111)襯底在850℃下進行60分鐘的退火,以去除殘留的表面污染物,并為后續(xù)沉積獲得原子級平坦的Si(111)表面。
在外延生長過程中,我們通過KrF準分子激光(λ= 248 nm,t= 20ns)燒蝕高純度 AlN (4N)靶材,生長出厚度范圍為~6–300nm的AlN薄膜。采用PLD法在Si(111)襯底上生長AlN薄膜示意圖如圖1所示。
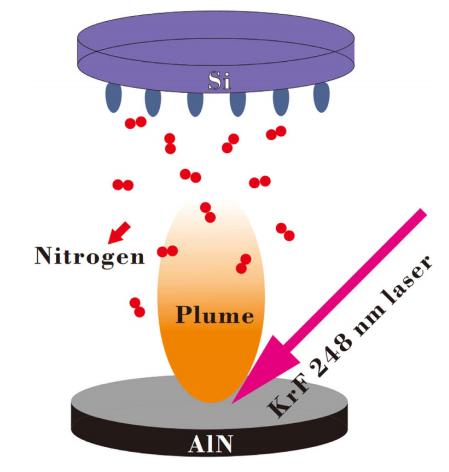 圖1:通過PLD在Si(111)襯底上的AlN薄膜的外延生長示意圖
圖1:通過PLD在Si(111)襯底上的AlN薄膜的外延生長示意圖
英思特采用RHEED測量來監(jiān)測整個過程的生長過程。圖2顯示了在750℃下Si襯底上生長的AlN薄膜的照片,顯示了在不同生長溫度下生長的 AlN 薄膜的RHEED圖案。很明顯,在850℃退火60分鐘后,可以在Si方向上識別出尖銳的條紋圖案,這與退火工藝之前形成鮮明對比。隨后,我們在退火后的Si襯底上生長AlN膜。在 850℃高溫下生長約6nm厚的薄膜后,實驗發(fā)現(xiàn)幾乎無法識別 RHEED 圖案,這表明發(fā)現(xiàn)了非常差的薄膜。這意味著生長出了表面相對粗糙的單晶AlN薄膜。如果在低溫(800-700℃)下生長AlN薄膜,也可以獲得單晶AlN薄膜。

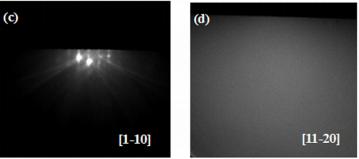
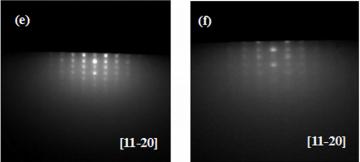
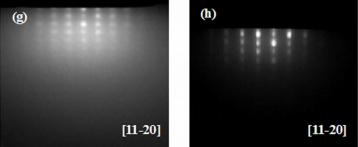 圖2
圖2
生長溫度對 AlN 薄膜的結(jié)晶質(zhì)量有重大影響。晶體生長溫度的變化趨勢與表面形貌的變化趨勢非常一致。
結(jié)論
根據(jù)實驗英思特提出了通過PLD將界面層從非晶SiAlN和層演化為突變且尖銳的 AlN/Si異質(zhì)界面的機制。這項通過PLD生長的AlN薄膜獲得突變界面和平坦表面的工作對于高質(zhì)量AlN基器件在Si襯底上的應(yīng)用具有重要意義。因此英思特提出了通過PLD將界面層從非晶SiAlN和層演化為突變且尖銳的AlN/Si異質(zhì)界面的機制
審核編輯 黃宇
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28585瀏覽量
232442 -
激光
+關(guān)注
關(guān)注
20文章
3418瀏覽量
65785 -
蝕刻
+關(guān)注
關(guān)注
10文章
424瀏覽量
15934
發(fā)布評論請先 登錄
詳解原子層沉積薄膜制備技術(shù)

連續(xù)激光器與脈沖激光器:有什么區(qū)別?

質(zhì)量流量控制器在薄膜沉積工藝中的應(yīng)用
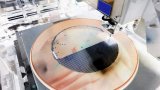
LPCVD氮化硅薄膜生長的機理

碳化硅薄膜沉積技術(shù)介紹
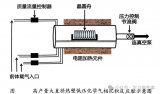
SiGe外延工藝及其在外延生長、應(yīng)變硅應(yīng)用及GAA結(jié)構(gòu)中的作用

脈沖激光焊和連續(xù)激光焊怎么選?
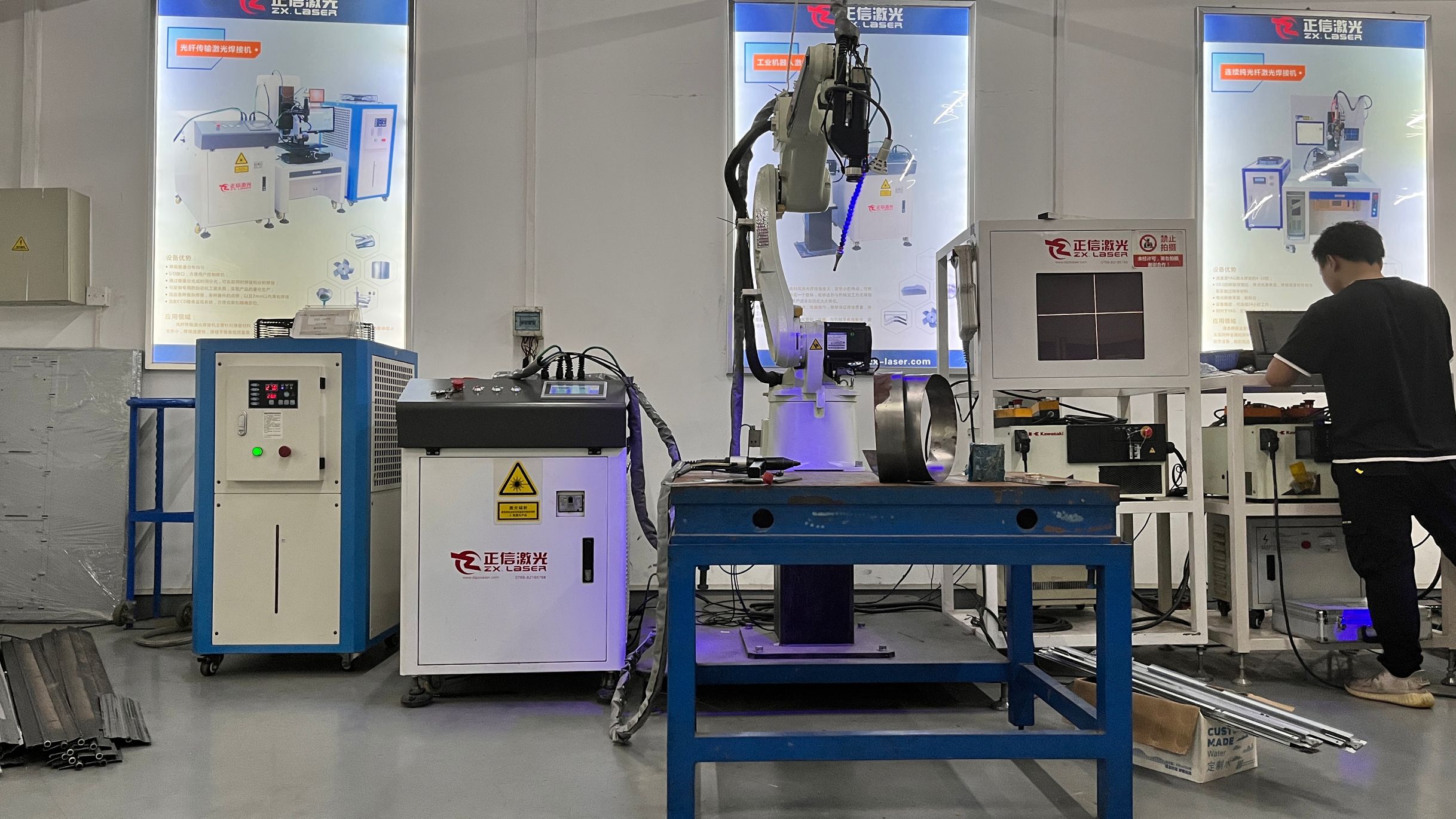
超短脈沖激光輔助碳化硅晶圓切片

如何用AWG實現(xiàn)脈沖激光輸出

SOLMATES:準分子激光器推進脈沖激光沉積

帶你了解脈沖激光清洗機排名盤點






 Si(111)襯底上脈沖激光沉積AlN外延薄膜的界面反應(yīng)控制及其機理
Si(111)襯底上脈沖激光沉積AlN外延薄膜的界面反應(yīng)控制及其機理










評論