華為技術有限公司最近增加了多項專利信息,其中一項專利名稱為“一種芯片封裝以及芯片封裝的制備方法”,公開號碼為cn116547791a。
根據專利摘要,這次申請有助于芯片性能的提高。芯片包包括基板、該裸芯片、第一保護結構及屏蔽結構;該裸芯片、第一保護結構和屏蔽結構都設置在基板的第一表面。該包裹第一保護結構,芯片側面堵塞的包裹,不僅第一保護結構背離該裸芯片的半導體表面,還有芯片第一表面1,保護結構的第一表面及其結構阻擋的第一表面,其中該裸芯片的第一表面為該裸芯片背離該基板的表面,該第一保護結構的第一表面為該第一保護結構背離該基板的表面,該阻隔結構的第一表面為該阻隔結構背離該基板的表面。
據了解,截至2022年底,華為擁有有效授權專利超過12萬項,主要分布在中國、歐洲、美洲、亞太、中東、非洲。華為在中國和歐洲分別擁有4萬多項專利,在美國擁有22000多項專利。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
459文章
52174瀏覽量
436135 -
華為
+關注
關注
216文章
35026瀏覽量
255055 -
結構
+關注
關注
1文章
117瀏覽量
21900 -
基板
+關注
關注
2文章
298瀏覽量
23425
發布評論請先 登錄
相關推薦
熱點推薦
超聲波焊接有利于解決固態電池的枝晶問題
://www.huisheng-sonic.com/news_details.html?newsid=3005237&_t=1739594692
超聲波焊接有利于解決固態電池的枝晶問題
超聲波輥焊
發表于 02-15 15:08
順絡貼片電感的微型化封裝是否會影響性能?
顯著減小了電感的尺寸,特別適用于空間受限的便攜式電子設備,如智能手機、平板電腦等。 提高集成度: ?更小的封裝尺寸允許在PCB上集成更多的元器件,提高電路板的集成度和功能性。 降低重量: ?微型化



蘋果公開新專利:可折疊設備鉸鏈
蘋果公司近日公開了一項嶄新的鉸鏈設計專利。該專利詳盡地闡述了一種由多個相互連接的指狀部件和摩擦離合器構成的機制,其核心的創新之處在于運用新月形凹槽將旋轉軸移至連桿的外部。另外,專利的草

BGA芯片在汽車電子中的應用
:BGA芯片可以容納更多的引腳,適合高性能和高密度的集成電路。 高性能 :由于引腳分布在芯片底部,信號傳輸路徑更短,有利于

淺談英特爾在先進封裝領域的探索
隨著工藝節點的進步,英特爾也在不斷推進下一代封裝技術的發展。對高性能硅需求與工藝節點開發相結合,創造了一種新的方案,即處理器不再是單片硅,而是依賴于多個較小(且可能優化過)的芯粒或芯片,通過一種
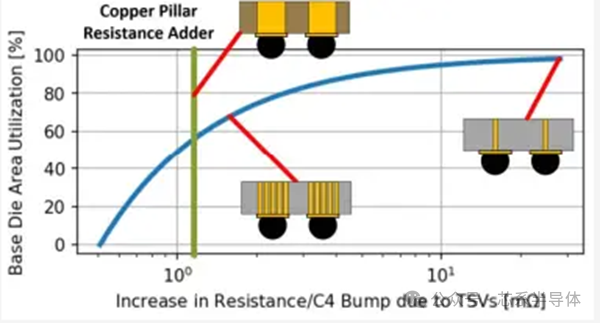


芯片開封decap簡介及芯片開封在失效分析中應用案例分析
DECAP:即開封,業內也稱開蓋,開帽。是指將完整封裝的IC做局部腐蝕,使得IC可以暴露出來 ,同時保持芯片功能的完整無損,為下一步芯片失效分析實驗做準備,方便觀察或做其他測試。通過
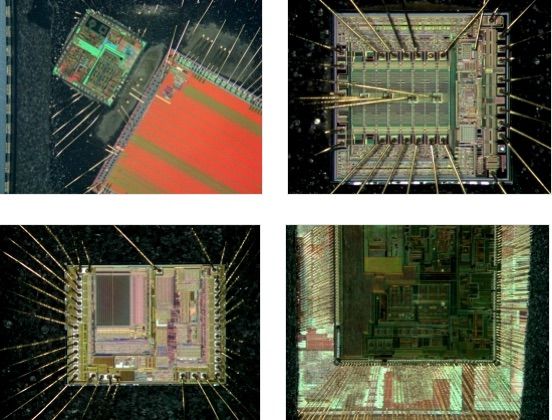





 華為公開封裝專利:有利于提高芯片性能
華為公開封裝專利:有利于提高芯片性能
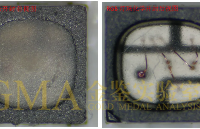











評論