通訊計算卡BGA四角填充加固膠應用案例由漢思新材料提供
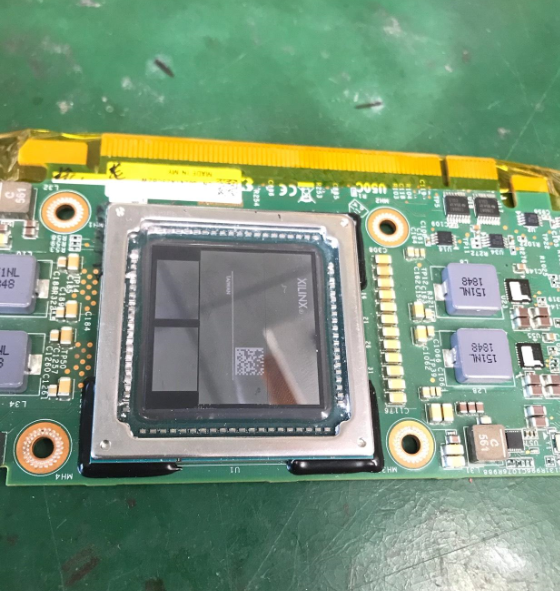
客戶產品:通訊計算卡
用膠部位:通訊計算卡BGA四角填充加固
芯片尺寸 :50*50mm 錫球高度:3.71mm 錫球間距:1.00mm 錫球數量:2000顆 錫球大小:0.25mm
用膠目的:粘接、固定,抗震動。
施膠工藝:簡易型點膠機
固化方式:接受150度7~8分加熱固化
顏色:無要求
換膠原因:新項目研發。
客戶用膠要求:
a.主芯片較大與板之間的應力,緩解外應力
b.主芯片持續性工作溫度100度,要求緩解熱應力,耐高溫沖擊
c.要求膠水可返修和超強粘接力
漢思新材料推薦用膠:
經過漢思工作人員和客戶詳細溝通對接,推薦底部填充膠HS710給客戶測試。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
459文章
52160瀏覽量
436070 -
BGA
+關注
關注
5文章
565瀏覽量
48137 -
計算卡
+關注
關注
0文章
16瀏覽量
3813
發布評論請先 登錄
相關推薦
熱點推薦
無人機控制板與遙控器板BGA芯片底部填充膠加固方案
無人機控制板與遙控器板BGA芯片底部填充膠加固方案方案提供方:漢思新材料無人機應用趨勢概覽隨著科技的飛速發展,無人機已廣泛應用于航拍、農業監測、物流配送、緊急救援等多個領域,成為現代生
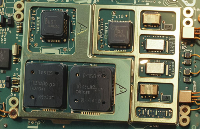
哪家底部填充膠廠家比較好?漢思底填膠優勢有哪些?
產品特性1.高可靠性與機械強度漢思底部填充膠采用單組份改性環氧樹脂配方,專為BGA、CSP和Flipchip設計。通過加熱固化,能填充芯片底部80%以上的空隙,顯著

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹
今天我們再詳細看看Underfill工藝中所用到的四種填充膠:CUF,NUF,WLUF和MUF。 倒裝芯片的底部填充工藝一般分為三種:毛細填充

人工智能機器人關節控制板BGA芯片底部填充用膠方案
人工智能機器人關節控制板BGA芯片底部填充用膠方案方案提供商:漢思新材料人工智能機器人的廣泛應用:隨著人工智能技術的飛速進步,機器人已不再是科幻電影中的幻想,而是日益融入我們的日常生活。在教育、醫療

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程
一、烘烤烘烤,主要是為了確保主板的干燥。實施底部填充膠之前,如果主板不干燥,容易在填充后有小氣泡產生,在最后的固化環節,氣泡就會發生爆炸,從而影響焊盤與PCB之間的粘結性,也有可能導致焊錫球與焊盤

等離子清洗及點膠軌跡對底部填充膠流動性的影響
共讀好書 翟培卓,洪根深,王印權,李守委,陳鵬,邵文韜,柏鑫鑫 (中國電子科技集團公司第五十八研究所) 摘要: 倒裝焊封裝過程中,底部填充膠的流動性決定了填充效率,進而影響生產效率及成本。通過對比






 通訊計算卡BGA四角填充加固膠應用案例
通訊計算卡BGA四角填充加固膠應用案例

















評論