光刻膠在做完后續(xù)成形工藝之后,PR就不需要了,而且還要去除的很干凈,減少多后續(xù)工藝的影響。
去除光刻膠的方法主要有干法和濕法,濕法是主流,但是對于一些ICP或者離子注入工藝后發(fā)生“硬化”的光刻膠,濕法就會出現(xiàn)去膠不干凈的情況。
因此就有了干法刻蝕去除光刻膠的技術(shù),從20世紀(jì)70年代末開始,干法工藝采用灰化Ashing來去除光刻膠。

灰化,簡單的理解就是用氧氣把光刻膠燃燒掉,光刻膠的基本成分是碳氫有機物,在射頻或微波作用下,氧氣電離成氧原子并與光刻膠發(fā)生化學(xué)反應(yīng),生成一氧化碳,二氧化碳和水等,再通過泵被真空抽走,完成光刻膠的去除。
在干法去除機中,等離子體由微波,射頻和UV臭氧源共同作用產(chǎn)生。
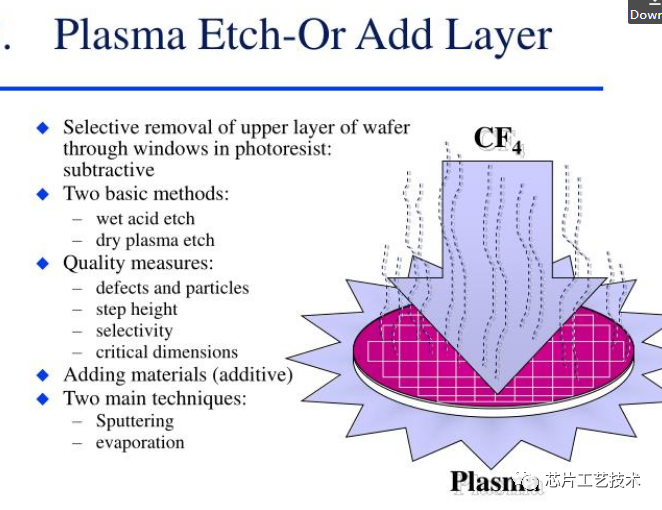
也有用CF4的。
工藝條件也和設(shè)備不同有關(guān),一般處理10min~20分鐘,根據(jù)產(chǎn)品特性而定,
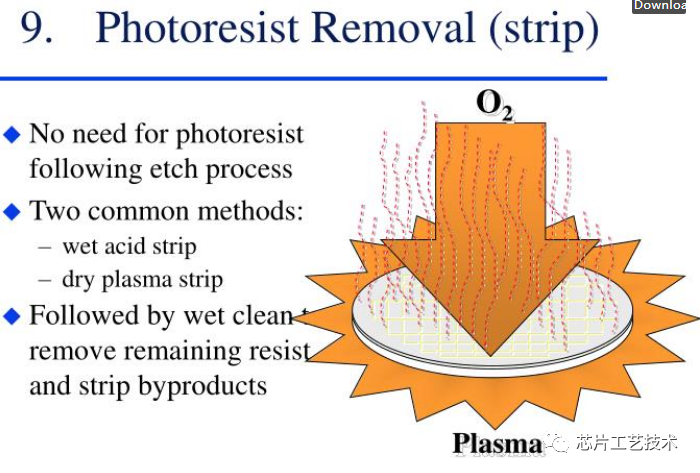
有時候也先用干法刻蝕去膠再用濕法去膠清洗。
但是有時候還是不能去除干凈,就只能用笨方法擦了,大家有什么好方法也可以互相交流。
審核編輯 :李倩
-
光刻膠
+關(guān)注
關(guān)注
10文章
327瀏覽量
30757 -
刻蝕
+關(guān)注
關(guān)注
2文章
202瀏覽量
13315
原文標(biāo)題:如何去除光刻膠
文章出處:【微信號:dingg6602,微信公眾號:芯片工藝技術(shù)】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
微流控中的烘膠技術(shù)
干法刻蝕時側(cè)壁為什么會彎曲
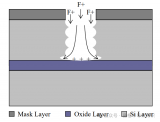
芯片制造中的濕法刻蝕和干法刻蝕

干法刻蝕側(cè)壁彎曲的原因及解決方法

晶圓表面溫度對干法刻蝕的影響

干法刻蝕工藝的不同參數(shù)
一文看懂光刻膠的堅膜工藝及物理特性和常見光刻膠
如何成功的烘烤微流控SU-8光刻膠?
導(dǎo)致光刻膠變色的原因有哪些?
光刻膠的硬烘烤技術(shù)

光刻膠后烘技術(shù)
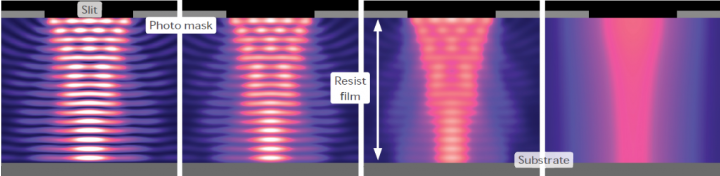





 干法刻蝕去除光刻膠的技術(shù)
干法刻蝕去除光刻膠的技術(shù)












評論