后烘是指(post exposure bake-PEB)是指在曝光之后的光刻膠膜的烘烤過(guò)程。由于光刻膠膜還未顯影,也就是說(shuō)還未閉合,PEB也可以在高于光刻膠軟化溫度的情況下進(jìn)行。前面的文章中我們?cè)谝话愎饪踢^(guò)程文章中簡(jiǎn)單介紹過(guò)后烘工藝但是比較簡(jiǎn)單,本文就以下一些應(yīng)用場(chǎng)景下介紹后烘的過(guò)程和作用。
化學(xué)放大正膠
機(jī)理
當(dāng)使用“正常”正膠時(shí),曝光完成后光反應(yīng)也就完成了,但是化學(xué)放大的光刻膠需要隨后的烘烤步驟。光反應(yīng)在曝光期間開(kāi)始并在后烘環(huán)節(jié)中完成。“化學(xué)放大”的過(guò)程發(fā)生在,曝光后反應(yīng)產(chǎn)物的催化下,并在烘烤中完成。這使得較厚的光刻膠可以使用較低的曝光劑量進(jìn)行曝光,且顯影速度快。
后烘條件
沒(méi)有進(jìn)過(guò)后烘(PEB)工藝的光刻膠將不能顯影或只能以極低的速度顯影。后烘所需的時(shí)間和溫度并不取決于光刻膠薄膜的厚度,而是取決于所使用的光刻膠的種類(lèi),通常在100-110℃的溫度下持續(xù)幾分鐘。
圖形反轉(zhuǎn)膠和交聯(lián)負(fù)膠機(jī)理
像AZ5214E這樣的圖形反轉(zhuǎn)膠在反轉(zhuǎn)工藝下需要在曝光后進(jìn)行后烘工藝,來(lái)實(shí)現(xiàn)圖形的反轉(zhuǎn),從而使曝光區(qū)域在顯影后流下來(lái)。
交聯(lián)型負(fù)膠電阻,如AZ5214負(fù)膠系列或AZ15nxt,需要在后烘環(huán)節(jié)來(lái)進(jìn)行交聯(lián),交聯(lián)反應(yīng)是在曝光過(guò)程中開(kāi)始的,被曝光區(qū)域結(jié)構(gòu)在顯影液中不被溶解而留下。
后烘條件
后烘所需的時(shí)間和溫度并不取決于光刻膠薄膜的厚度,而是取決于所使用的光刻膠種類(lèi),通常為110-130℃,持續(xù)幾分鐘。
圖形反轉(zhuǎn)膠的烘烤溫度越高,反轉(zhuǎn)膠的結(jié)構(gòu)在顯影過(guò)程中越穩(wěn)定,但反轉(zhuǎn)膠在前面未曝光區(qū)域在后續(xù)的范曝光過(guò)程中的感光性越差,顯影速度越慢。
負(fù)膠的后烘溫度越高,交聯(lián)程度越高,顯影后的結(jié)構(gòu)越穩(wěn)定。然而,隨著PEB溫度的升高,未暴露的光刻膠區(qū)域的熱交聯(lián)增加,因此更難顯影。需要注意的是,并不是所有的負(fù)膠都需要后烘工藝步驟,有些負(fù)膠在曝光過(guò)程中就能完成交聯(lián)反應(yīng),因而無(wú)需后烘。
高反射率襯底上的正膠機(jī)理
在高反射率襯底上的單色光源曝光應(yīng)用中,由于界面的反射,會(huì)在光刻膠內(nèi)部形成干涉,這種干涉會(huì)導(dǎo)致顯影時(shí)在光刻膠側(cè)壁形成波浪條紋結(jié)構(gòu),即駐波效應(yīng)。曝光后的后烘有助于光反應(yīng)產(chǎn)物的擴(kuò)散,如下圖1所示,因此隨后顯影過(guò)程中的光刻膠結(jié)構(gòu)具有更陡峭和更光滑的側(cè)壁。
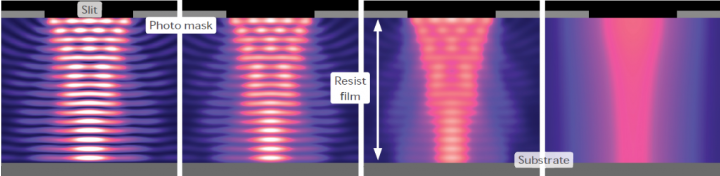
圖1 高反襯底上的光強(qiáng)分布以及后烘后的光反應(yīng)分布
后烘條件
所需的時(shí)間和溫度并不取決于光刻膠薄膜的厚度,而是取決于所使用的光刻膠種類(lèi),通常為110-120℃,持續(xù)幾分鐘。
免責(zé)聲明:文章來(lái)源汶顥 www.whchip.com 以傳播知識(shí)、有益學(xué)習(xí)和研究為宗旨。轉(zhuǎn)載僅供參考學(xué)習(xí)及傳遞有用信息,版權(quán)歸原作者所有,如侵犯權(quán)益,請(qǐng)聯(lián)系刪除。
審核編輯 黃宇
-
光刻膠
+關(guān)注
關(guān)注
10文章
339瀏覽量
30941
發(fā)布評(píng)論請(qǐng)先 登錄
國(guó)產(chǎn)光刻膠突圍,日企壟斷終松動(dòng)
針對(duì)晶圓上芯片工藝的光刻膠剝離方法及白光干涉儀在光刻圖形的測(cè)量

用于 ARRAY 制程工藝的低銅腐蝕光刻膠剝離液及白光干涉儀在光刻圖形的測(cè)量

減少光刻膠剝離工藝對(duì)器件性能影響的方法及白光干涉儀在光刻圖形的測(cè)量

光刻膠剝離液及其制備方法及白光干涉儀在光刻圖形的測(cè)量

光刻膠的類(lèi)型及特性

晶圓表面光刻膠的涂覆與刮邊工藝的研究
光刻膠成為半導(dǎo)體產(chǎn)業(yè)的關(guān)鍵材料
光刻膠的主要技術(shù)參數(shù)

一文解讀光刻膠的原理、應(yīng)用及市場(chǎng)前景展望






 光刻膠后烘技術(shù)
光刻膠后烘技術(shù)












評(píng)論