引言
在晶圓上芯片制造工藝中,光刻膠剝離是承上啟下的關(guān)鍵環(huán)節(jié),其效果直接影響芯片性能與良率。同時(shí),光刻圖形的精確測(cè)量是保障工藝精度的重要手段。本文將介紹適用于晶圓芯片工藝的光刻膠剝離方法,并探討白光干涉儀在光刻圖形測(cè)量中的應(yīng)用。
針對(duì)晶圓上芯片工藝的光刻膠剝離方法
濕法剝離
濕法剝離是晶圓芯片工藝中常用的光刻膠去除方式。通過將涂覆光刻膠的晶圓浸入含有特定化學(xué)成分的剝離液中,利用剝離液與光刻膠發(fā)生化學(xué)反應(yīng),使其溶解或溶脹,從而實(shí)現(xiàn)光刻膠從晶圓表面的脫離。對(duì)于不同類型的光刻膠,需針對(duì)性選擇剝離液配方,例如對(duì)于負(fù)性光刻膠,常采用含有有機(jī)溶劑(如 N - 甲基吡咯烷酮)和堿性物質(zhì)(如四甲基氫氧化銨)的混合溶液。在剝離過程中,嚴(yán)格控制溫度、時(shí)間和剝離液濃度等參數(shù),避免對(duì)晶圓表面及已形成的芯片結(jié)構(gòu)造成損傷 。
干法剝離
干法剝離主要依賴等離子體技術(shù),在真空反應(yīng)腔室內(nèi)進(jìn)行。向腔室中通入特定氣體(如氧氣、氟氣等),在射頻電場(chǎng)的作用下,氣體電離產(chǎn)生等離子體。等離子體中的活性粒子與光刻膠發(fā)生化學(xué)反應(yīng),將光刻膠分解為揮發(fā)性氣體,進(jìn)而實(shí)現(xiàn)去除目的。干法剝離具有刻蝕方向性好、對(duì)晶圓表面損傷小等優(yōu)點(diǎn),尤其適用于對(duì)精度要求極高的先進(jìn)晶圓芯片工藝,能夠有效避免濕法剝離可能帶來的殘留物問題 。
新興剝離技術(shù)
隨著芯片工藝不斷發(fā)展,新興剝離技術(shù)也逐漸應(yīng)用于晶圓制造。例如,激光剝離技術(shù)利用激光的高能量,選擇性地照射光刻膠,使其瞬間氣化或分解,實(shí)現(xiàn)快速剝離。該技術(shù)具有剝離速度快、精度高、對(duì)晶圓損傷小等特點(diǎn),可滿足先進(jìn)制程對(duì)光刻膠剝離的嚴(yán)苛要求;電化學(xué)剝離技術(shù)則通過在晶圓表面施加特定的電場(chǎng),促使光刻膠發(fā)生電化學(xué)反應(yīng),實(shí)現(xiàn)光刻膠的去除,在一些特殊材料晶圓的光刻膠剝離中展現(xiàn)出獨(dú)特優(yōu)勢(shì) 。
白光干涉儀在光刻圖形測(cè)量中的應(yīng)用
測(cè)量原理
白光干涉儀基于白光干涉原理,通過對(duì)比參考光束與晶圓光刻圖形表面反射光束的光程差,將光強(qiáng)分布轉(zhuǎn)化為表面高度信息。由于白光包含多種波長(zhǎng),僅在光程差為零的位置形成清晰干涉條紋,利用這一特性,可實(shí)現(xiàn)納米級(jí)精度的光刻圖形形貌測(cè)量,能夠精準(zhǔn)捕捉光刻圖形的微小結(jié)構(gòu)變化,為晶圓芯片工藝優(yōu)化提供關(guān)鍵數(shù)據(jù) 。
測(cè)量過程
將完成光刻工藝的晶圓樣品放置于白光干涉儀載物臺(tái)上,利用顯微鏡初步定位待測(cè)的光刻圖形區(qū)域。精確調(diào)節(jié)干涉儀的光路參數(shù),獲取清晰的干涉條紋圖像。通過專業(yè)軟件對(duì)干涉圖像進(jìn)行相位解包裹等處理,可精確計(jì)算出光刻圖形的深度、寬度、側(cè)壁角度等關(guān)鍵參數(shù),從而對(duì)光刻圖形質(zhì)量進(jìn)行評(píng)估 。
優(yōu)勢(shì)
白光干涉儀采用非接觸式測(cè)量,避免了對(duì)晶圓光刻圖形的物理損傷,適用于脆弱的先進(jìn)光刻結(jié)構(gòu)檢測(cè);具備快速測(cè)量能力,可實(shí)現(xiàn)對(duì)晶圓上大量光刻圖形的批量檢測(cè),滿足晶圓芯片生產(chǎn)線的高效檢測(cè)需求;其三維表面形貌可視化功能,能夠直觀呈現(xiàn)光刻圖形的質(zhì)量狀況,便于工程師及時(shí)發(fā)現(xiàn)光刻圖形缺陷,快速調(diào)整光刻工藝參數(shù) 。
TopMap Micro View白光干涉3D輪廓儀
一款可以“實(shí)時(shí)”動(dòng)態(tài)/靜態(tài) 微納級(jí)3D輪廓測(cè)量的白光干涉儀
1)一改傳統(tǒng)白光干涉操作復(fù)雜的問題,實(shí)現(xiàn)一鍵智能聚焦掃描,亞納米精度下實(shí)現(xiàn)卓越的重復(fù)性表現(xiàn)。
2)系統(tǒng)集成CST連續(xù)掃描技術(shù),Z向測(cè)量范圍高達(dá)100mm,不受物鏡放大倍率的影響的高精度垂直分辨率,為復(fù)雜形貌測(cè)量提供全面解決方案。
3)可搭載多普勒激光測(cè)振系統(tǒng),實(shí)現(xiàn)實(shí)現(xiàn)“動(dòng)態(tài)”3D輪廓測(cè)量。

實(shí)際案例

1,優(yōu)于1nm分辨率,輕松測(cè)量硅片表面粗糙度測(cè)量,Ra=0.7nm

2,毫米級(jí)視野,實(shí)現(xiàn)5nm-有機(jī)油膜厚度掃描
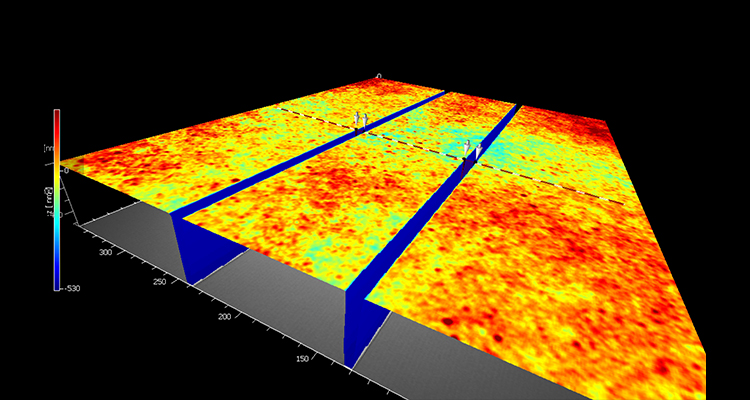
3,卓越的“高深寬比”測(cè)量能力,實(shí)現(xiàn)光刻圖形凹槽深度和開口寬度測(cè)量。
審核編輯 黃宇
-
晶圓
+關(guān)注
關(guān)注
53文章
5165瀏覽量
129796 -
干涉儀
+關(guān)注
關(guān)注
0文章
109瀏覽量
10408
發(fā)布評(píng)論請(qǐng)先 登錄
行業(yè)案例|膜厚儀應(yīng)用測(cè)量之光刻膠厚度測(cè)量

低含量 NMF 光刻膠剝離液和制備方法及白光干涉儀在光刻圖形的測(cè)量

光刻膠剝離液及其制備方法及白光干涉儀在光刻圖形的測(cè)量

Micro OLED 陽極像素定義層制備方法及白光干涉儀在光刻圖形的測(cè)量






 針對(duì)晶圓上芯片工藝的光刻膠剝離方法及白光干涉儀在光刻圖形的測(cè)量
針對(duì)晶圓上芯片工藝的光刻膠剝離方法及白光干涉儀在光刻圖形的測(cè)量












評(píng)論