文章來源:學習那些事
原文作者:小陳婆婆
光刻膠類型及特性光刻膠(Photoresist),又稱光致抗蝕劑,是芯片制造中光刻工藝的核心材料。其性能直接影響芯片制造的精度、效率和可靠性。本文介紹了光刻膠類型和光刻膠特性。
光刻膠類型
以下從成分、類型、性能要求及應用領域等方面,對光刻膠進行系統性闡述。
一、光刻膠的成分與基本功能
光刻膠是一種對光敏感的混合液體,主要由以下部分組成:
基體材料:通常為樹脂,構成光刻膠的基本骨架,決定其機械性能和化學穩定性。
感光化合物(PAC):控制光刻膠在曝光前后的溶解性變化。
正性光刻膠:PAC在曝光前抑制溶解,曝光后促進溶解。
負性光刻膠:PAC在曝光后引發交聯反應,使曝光區域不溶解。
溶劑:調節光刻膠的黏滯性,確保其在涂覆時保持液體狀態,并均勻成膜。
二、光刻膠的分類及特性
光刻膠分為正性和負性兩種,核心區別在于曝光后溶解性的變化:
正性光刻膠
原理:曝光區域PAC發生光化學反應,從抑制劑變為促進劑,使曝光部分溶于顯影液。
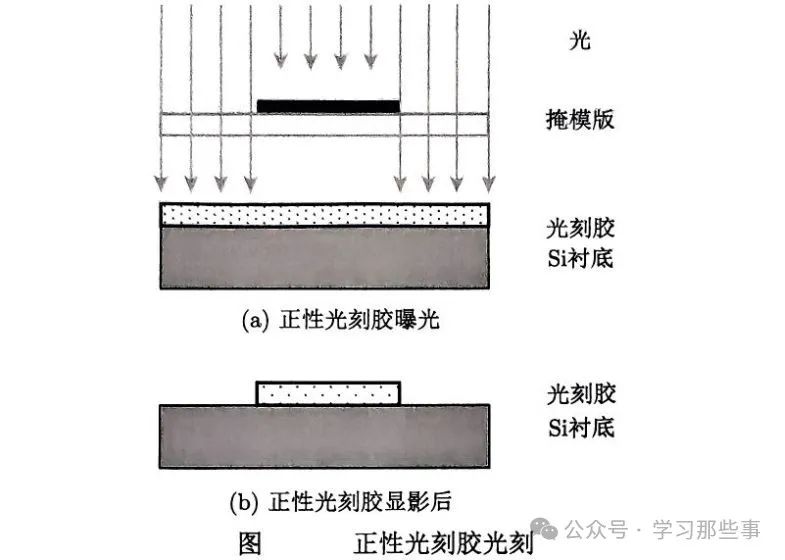
特點
高分辨率:曝光區域溶解后形成清晰邊緣,適合精細結構。
高對比度:曝光區與非曝光區溶解速率差異大,圖形保真度高。
主流應用:先進芯片制造(如邏輯電路、存儲器)、微機電系統(MEMS)。
2. 負性光刻膠
原理:曝光區域PAC引發交聯反應,形成不溶性網狀結構,未曝光部分溶解。
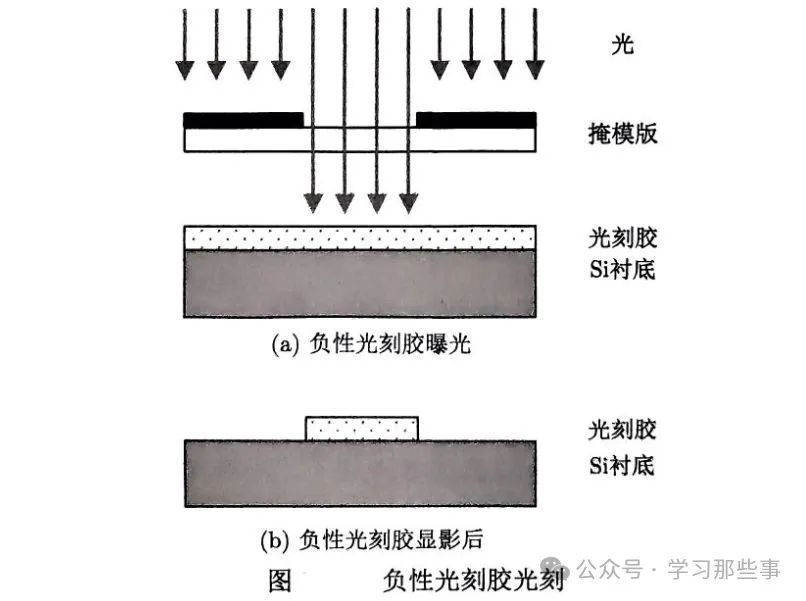
特點
抗蝕性強:交聯后結構致密,耐刻蝕能力優于正膠。
分辨率較低:交聯反應可能導致邊緣模糊,適用于對分辨率要求不高的厚膠工藝。
應用場景:厚膜光刻、特殊封裝工藝。
三、光刻膠的關鍵性能要求
光刻膠需滿足以下性能以確保工藝可靠性:
靈敏度高:低曝光劑量即可引發反應,提高生產效率。
分辨率高:支持微米級以下精細結構加工。
黏附性好:與襯底(如硅片、玻璃)緊密結合,避免脫膠。
致密無針孔:成膜均勻,防止刻蝕時底層被腐蝕。
圖形邊緣陡直:側壁接近垂直,避免“鋸齒效應”。
抗蝕性強:耐受刻蝕工藝中的化學或物理作用。
去膠容易:顯影后殘留少,便于后續工藝。
四、光刻膠的涂覆與加工流程
涂膠:通過旋涂或噴涂工藝,在襯底表面形成均勻膠膜。
曝光:利用特定波長光源通過掩膜版照射,引發光化學反應。
顯影:溶解可溶部分,形成所需圖形。
烘焙:固化膠膜,增強與襯底的黏附性。
刻蝕:以光刻膠為掩膜,轉移圖形至底層材料。
去膠:去除剩余光刻膠,完成工藝。
五、光刻膠靈敏度與對比度的深度解析
光刻膠的性能參數中,靈敏度和對比度是直接影響光刻工藝精度和效率的關鍵指標。
靈敏度:光刻膠的感光效率
定義:靈敏度是指使光刻膠發生光化學反應所需的單位面積能量,通常以毫焦耳每平方厘米(mJ/cm2)為單位。
物理意義:靈敏度值越小,表明光刻膠對光的反應越靈敏。在相同曝光量(光強×曝光時間)下,靈敏度高的光刻膠所需曝光時間更短,有助于提高生產效率。
公式關聯
靈敏度=光刻膠反應程度曝光量(mJ/cm2)
雖然無直接公式,但靈敏度低的工藝需要更高的曝光量或更長的曝光時間以達到相同反應效果。
2.對比度:光刻膠的分辨能力
定義:對比度是光刻膠區分掩模版上亮區(透光區)和暗區(遮光區)光強差別的能力,直接決定光刻圖形的保真度。
測量方法
在硅晶圓上涂覆正性光刻膠并測量初始厚度;
進行短時間均勻曝光,逐步增加曝光劑量(光強×時間);
測量顯影后光刻膠厚度,繪制厚度隨曝光劑量變化的對數曲線。

曲線中,伽馬(γ)為直線斜率,表征對比度;D?為不產生曝光效應的最大劑量;D???為完全去除光刻膠的最小劑量。
3.靈敏度與對比度的協同作用
靈敏度的影響:高靈敏度允許低曝光量實現充分反應,但可能犧牲分辨率(因快速擴散導致圖形模糊)。低靈敏度需更高曝光量,但可能提高圖形銳度。
對比度的優化:對比度越高,光刻膠區分光強差別的能力越強,圖形邊緣越陡直(接近理想垂直)。實際工藝中,對比度受光刻膠厚度、吸收系數(α)和光學特性(如折射率)影響。公式表明,對比度隨光刻膠厚度(TR)減小而增大,但需平衡臺階覆蓋性。
4.實際曝光中的尺寸偏差
正性光刻膠
理想情況:曝光區域完全溶解,邊緣陡直(圖a)。
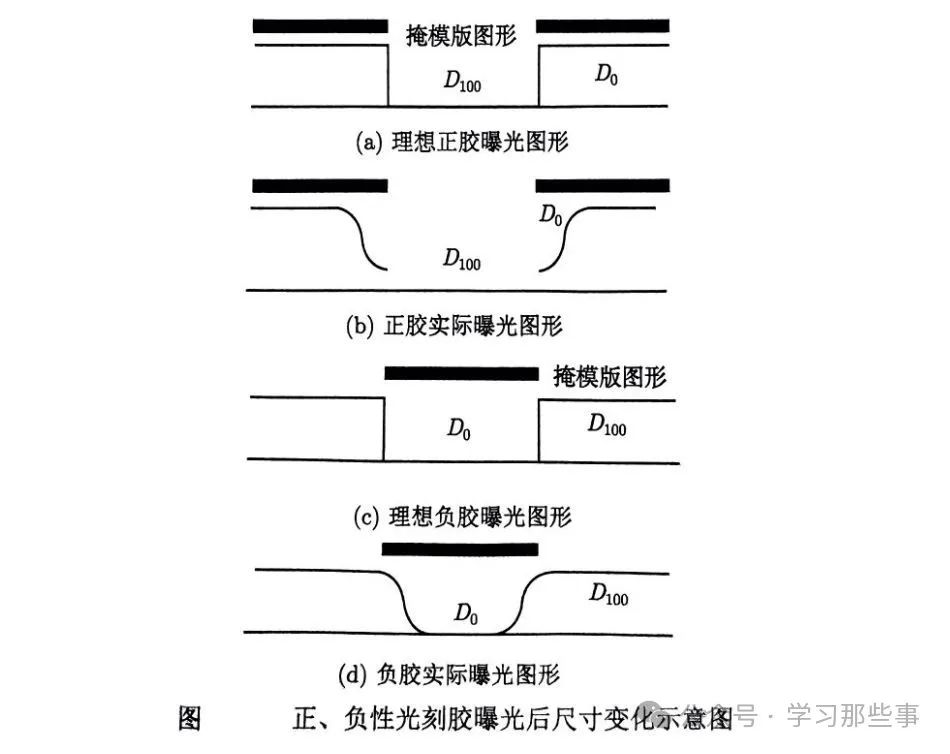
實際情況:邊緣劑量介于D?和D???之間,顯影后形成斜坡,導致圖形尺寸大于掩模版(圖b)。
負性光刻膠
理想情況:未曝光區域溶解,曝光區域保留,圖形反轉且邊緣陡直(圖c)。
實際情況:邊緣交聯不完全,顯影后圖形尺寸小于掩模版(圖d)。
六、光刻膠的應用領域與市場趨勢
應用領域
半導體:芯片制造中的關鍵材料,直接影響器件性能。
顯示面板:用于制備彩色濾光片、觸摸屏電極等。
PCB:線路板加工中的圖形轉移介質。
2. 市場與技術發展
技術趨勢:向短波長(如EUV)、高分辨率方向演進,滿足先進制程需求。
市場格局:全球主要由日本、韓國企業主導,中國本土企業逐步突破。
國產化挑戰:技術壁壘高,需攻克配方設計、原材料純度等難題。
光刻膠特性
一、DQN正膠的典型反應
DQN(Diazoquinone-Novolak)正性光刻膠由感光化合物(重氮醌,DQ)和基體材料(酚醛樹脂,Novolak)組成,適用于i線和g線曝光。
基體材料(酚醛樹脂)

酚醛樹脂是一種長鏈芳香烴聚合物,其基本環結構可重復5~200次。其單體為帶兩個甲基和一個羥基的芳香族環烴。酚醛樹脂易溶于含水溶液,通過添加溶劑(如二甲苯、醋酸)調節黏度,影響涂膠厚度。
感光化合物(重氮醌)

重氮醌作為抑制劑,可降低光刻膠在顯影液中的溶解速率至原來的十分之一。其分子結構中的氮原子(N?)化合鍵較弱,在紫外線作用下發生光化學反應:
氮分子脫離碳環:形成高活性碳位。
Wolff重組:環內碳原子移至環外,氧原子與之形成共價鍵,生成乙烯酮中間體。
水解反應:乙烯酮進一步與水反應,雙鍵斷裂,形成羧酸。
顯影過程
曝光后,羧酸與顯影液(如KOH或NaOH溶液)反應,生成水溶性胺(如苯胺)和鹽類,同時釋放氮氣,促進光刻膠溶解。未曝光區域因顯影液無法滲入而保留,形成與掩模版一致的圖形。
DQN正膠的優點:
高分辨率:未曝光區在顯影中幾乎不變,保持線寬和形狀。
抗蝕性強:酚醛樹脂耐受化學腐蝕,適合作為刻蝕掩模。
負性光刻膠的局限性
圖形變形:曝光后交聯導致顯影時線寬展寬,烘焙后收縮,易引發線條粘連。
尺寸限制:不適用于小于2.0 μm的圖形。
針孔問題:工藝控制不當易產生缺陷。
DQN正膠通過光化學反應實現高分辨率圖形轉移,而負性膠因交聯機制面臨變形和尺寸限制。CMTF作為分辨率指標,指導光刻膠選型與工藝優化。
二、光刻膠的光吸收特性與二級曝光效應
光刻膠的光吸收特性直接影響其曝光效率和圖形保真度。以下結合二級曝光效應及表面反射效應,深入了解光刻膠的曝光行為。
二級曝光效應(脫色效應)
定義:光刻膠在曝光過程中,光吸收系數隨曝光量增加而減小,稱為光化學吸收或脫色效應。
物理機制
光化學反應:曝光后,光刻膠中的感光化合物(如重氮醌)發生反應,生成半透明產物(如羧酸)。
吸收均勻化:頂層光刻膠透光性增強,使下層接收更多光強,實現更均勻的曝光。
優勢:提高垂直方向曝光均勻性,減少顯影后圖形邊緣斜坡。
2.表面反射效應與光刻膠保形性
表面反射效應:在凹凸不平的晶圓表面,光刻膠厚度變化導致曝光量分布不均,引起線寬偏差。
光刻膠保形性:黏性薄膜特性,光刻膠涂覆后無法完全復刻襯底表面形貌,而是形成平滑的膠膜;臺階頂部,膠膜厚度小于平面區域(因重力作用);臺階邊緣,膠膜厚度大于平面區域(因涂覆過程中的堆積效應)。
線寬變化:當臺階高度與膠膜厚度相當時,厚度差異顯著,導致曝光量分布不均。顯影后,臺階邊緣可能因過度曝光而線寬展寬,頂部可能因曝光不足而線寬變窄。
-
芯片制造
+關注
關注
10文章
673瀏覽量
29508 -
光刻膠
+關注
關注
10文章
328瀏覽量
30779 -
光刻工藝
+關注
關注
1文章
34瀏覽量
1942
原文標題:光刻膠類型及特性
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
Futurrex高端光刻膠
光刻膠殘留要怎么解決?
Microchem SU-8光刻膠 2000系列
光刻膠在集成電路制造中的應用
光刻膠板塊的大漲吸引了產業注意 ,國產光刻膠再遇發展良機?
光刻膠的原理和正負光刻膠的主要組分是什么
光刻膠黏度如何測量?光刻膠需要稀釋嗎?
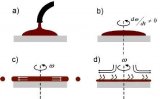





 光刻膠的類型及特性
光刻膠的類型及特性











評論