干法刻蝕中可以調節的工藝參數有哪些?各有什么作用?
1,溫度:晶圓表面溫度,溫度梯度
晶圓表面溫度:控制刻蝕表面的化學反應速率和產物的揮發性
溫度梯度:晶圓表面不同區域的溫度由于加熱器分布不均可能會有差異,導致局部區域刻蝕速率不同,從而影響刻蝕均勻性。
2,氣體:氣體化學組成,氣體比例,氣體流量
氣體化學組成:干法刻蝕的腔室中可以選擇的氣體多達20種,通過調整化學成分實現不同的刻蝕性能
氣體比例:不同氣體的分壓比可以改變選擇比和刻蝕形貌。
氣體流量:控制腔室內的反應氣體和刻蝕產物的停留時間,濃度等,從而影響刻蝕速率。
總射頻功率:決定了等離子體的能量水平,影響離子轟擊的強度。
多頻RF組合:通過調節低頻和高頻的配比,實現更優的刻蝕效果。高頻可以提高等離子體密度,低頻可以增強離子的方向性和能量。
4,脈沖:射頻功率脈沖,氣體脈沖
射頻功率脈沖:調節占空比和頻率,可以用來優化刻蝕速率和選擇比。
氣體脈沖:控制氣體流量的周期性變化,用于改善刻蝕均勻性。
5,其他:刻蝕時間,工藝腔壓力等
刻蝕時間:直接決定刻蝕深度
工藝腔壓力:控制等離子體的密度、化學反應速率和離子的轟擊能量。
-
脈沖
+關注
關注
20文章
901瀏覽量
96716 -
射頻功率
+關注
關注
0文章
43瀏覽量
13061 -
刻蝕
+關注
關注
2文章
202瀏覽量
13319
原文標題:干法刻蝕工藝參數匯總
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
干法刻蝕的概念、碳硅反應離子刻蝕以及ICP的應用

半導體濕法和干法刻蝕
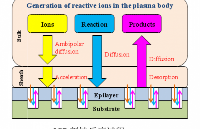
干法刻蝕時側壁為什么會彎曲
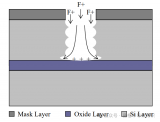
芯片制造中的濕法刻蝕和干法刻蝕

干法刻蝕側壁彎曲的原因及解決方法

晶圓表面溫度對干法刻蝕的影響

為什么干法刻蝕又叫低溫等離子體刻蝕

半導體干法刻蝕技術解析






 干法刻蝕工藝的不同參數
干法刻蝕工藝的不同參數





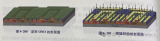
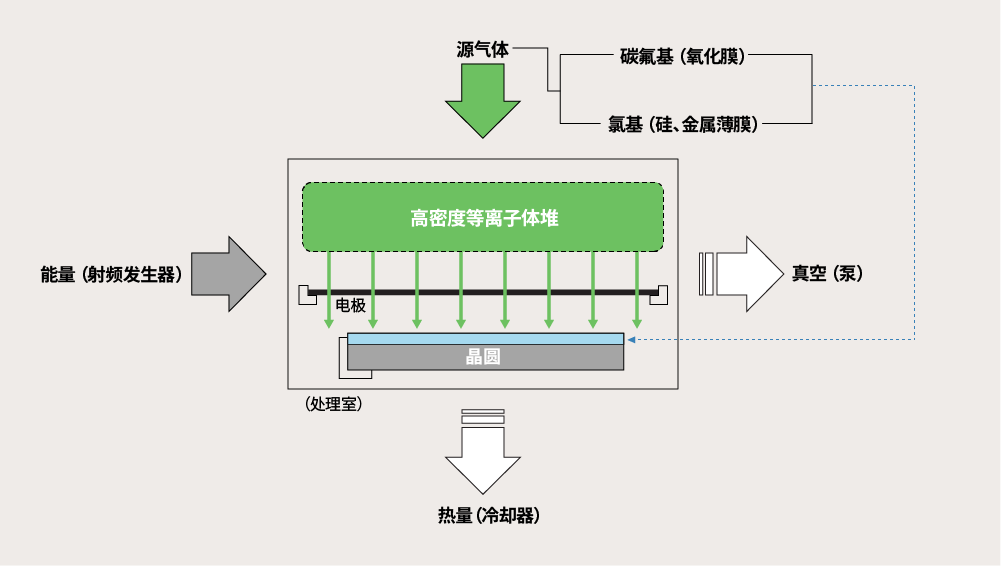










評論