半導(dǎo)體設(shè)備技術(shù)和工藝控制的不斷進(jìn)步,加上制造亞微米尺寸器件對(duì)襯底清潔度提出的更嚴(yán)格要求,重新引起了人們對(duì)汽相HF氧化物蝕刻技術(shù)的興趣,在文中描述了一種系統(tǒng)
我們?nèi)A林科納通過(guò)將氮?dú)馔ㄟ^(guò)HF水溶液引入HF蒸汽,為了最小化由于蒸發(fā)導(dǎo)致的源組成的變化,可以使用38.26重量% of的共沸混合物。
這項(xiàng)工作使用的反應(yīng)器的示意圖中,該反應(yīng)器由一個(gè)惰性碳化硅反應(yīng)室和兩個(gè)裝有適當(dāng)溶液的加熱蒸發(fā)器組成,電容器既不接受氧化后惰性環(huán)境,也不接受金屬化后形成氣體退火,
培養(yǎng)時(shí)間和蝕刻速率,用汽相HF氧化物蝕刻可以實(shí)現(xiàn)兩種不同的蝕刻選擇性模式,各種硅氧化物和氮化物的蝕刻速率列于表中,與含水HF的情況一樣,對(duì)于不同的硅氧化物,氣相等效物表現(xiàn)出不同的蝕刻速率,從而產(chǎn)生蝕刻選擇性,從熱生長(zhǎng)到沉積氧化物,以及從未摻雜到摻雜氧化物,蝕刻速率增加,盡管氮化硅的低蝕刻速率使其成為硅氧化物的合適蝕刻掩模,但應(yīng)該注意的是,氣相HF,像其含水對(duì)應(yīng)物一樣,產(chǎn)生各向同性蝕刻。
在蝕刻過(guò)程開(kāi)始時(shí),存在發(fā)生可忽略蝕刻的時(shí)間,該培養(yǎng)時(shí)間與在晶片表面形成薄水膜所需的時(shí)間有關(guān)。如圖所示,對(duì)于不同的氧化物,孵化時(shí)間是不同的,這產(chǎn)生了第二種蝕刻選擇性,在熱氧化物的培養(yǎng)時(shí)間內(nèi)的時(shí)間間隔8t中,PSG的非零蝕刻速率意味著PSG對(duì)熱氧化物的無(wú)限蝕刻選擇性,這種現(xiàn)象的一個(gè)具體應(yīng)用是從包含熱氧化物作為成分之一的電介質(zhì)材料的圖案化疊層中選擇性去除摻雜氧化物,通過(guò)執(zhí)行具有由抽空/解吸步驟分隔的幾個(gè)蝕刻循環(huán)的多步蝕刻工藝,無(wú)限選擇性的持續(xù)時(shí)間可以進(jìn)一步增加到8t以上。
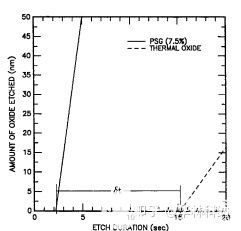
為了區(qū)分長(zhǎng)培養(yǎng)時(shí)間和短培養(yǎng)時(shí)間與可忽略蝕刻速率的可能組合,設(shè)計(jì)了連續(xù)多步蝕刻工藝來(lái)表征在減少的氮載氣流量下的熱氧化物蝕刻速率,結(jié)果總結(jié)在下圖,第一步包括用流速為15升/分鐘的氮?dú)廨d氣進(jìn)行10秒鐘的蝕刻,隨后的步驟是可變時(shí)間蝕刻,其中氮載氣的流量減少,同時(shí)通過(guò)注入額外量的純氮?dú)鈱⑼ㄟ^(guò)蝕刻室的總流量保持在15升/分鐘的恒定值,第一步導(dǎo)致濃縮膜的形成,因此,第二步的有效培養(yǎng)時(shí)間基本為零,在第一步和向第二步過(guò)渡期間,蝕刻的厚度略小于60納米,對(duì)于5升/分鐘的氮載氣流速,使用該技術(shù)測(cè)量的蝕刻速率為3.2納米/秒,而當(dāng)流速進(jìn)一步降低至1升/分鐘時(shí),基本上沒(méi)有觀察到蝕刻。

在較低流速下較長(zhǎng)的培養(yǎng)時(shí)間可以理解為H2O蒸汽分壓隨著載氣流速的降低而降低,對(duì)這種培養(yǎng)時(shí)間對(duì)H2O蒸汽分壓的依賴性的進(jìn)一步驗(yàn)證來(lái)自于對(duì)固定注射HF的觀察,培養(yǎng)時(shí)間隨著H2O蒸汽注射量的增加而減少,例如,當(dāng)10升/分鐘的氮?dú)饬鞅晦D(zhuǎn)移通過(guò)H~O蒸發(fā)器時(shí),熱氧化物蝕刻的培養(yǎng)時(shí)間下降到小于5s。
對(duì)于摻雜氧化物膜,蝕刻速率進(jìn)一步受到與膜致密化工藝相關(guān)的熱處理的影響,BPSG的固定持續(xù)時(shí)間蝕刻的結(jié)果在表中,除了在氮?dú)猸h(huán)境中于850℃退火20分鐘的薄膜外,致密化實(shí)際上導(dǎo)致了氧化物的更多蝕刻,這是由更快的蝕刻速率或保溫時(shí)間的減少引起的。未致密化膜和在850℃退火的膜的腐蝕速率是相當(dāng)?shù)模旅芑さ谋貢r(shí)間是沉積態(tài)膜的兩倍多一點(diǎn),對(duì)于相同的工藝參數(shù),PSG膜的腐蝕速率通常比BPSG膜的腐蝕速率高,而相應(yīng)的培養(yǎng)時(shí)間較短,例如,當(dāng)用5升/分鐘的氮?dú)廨d氣流速蝕刻PSG時(shí),蝕刻速率和培養(yǎng)時(shí)間分別為17.2納米/秒和4.7秒。
在這組實(shí)驗(yàn)中,使用H2O含量遠(yuǎn)大于共沸組合物的蒸汽混合物,第一個(gè)觀察結(jié)果是蝕刻速率遠(yuǎn)低于在具有相同HF分壓的共沸蒸汽中的蝕刻速率,蝕刻速率的下降直接源于濃縮膜中HF濃度的降低,這使得蝕刻動(dòng)力學(xué)對(duì)注入的少量HCl更加敏感,根據(jù)濃縮膜的pH值,可以給出觀察到的孵育時(shí)間和蝕刻速率對(duì)HCl的依賴性的可能解釋。
在沒(méi)有H~O稀釋的共沸蒸汽混合物的情況下,冷凝膜中高得多的HF濃度使得蝕刻速率和培養(yǎng)時(shí)間對(duì)注入少量HCl幾乎不敏感,在有和沒(méi)有(100 SCCM)HCl注入的情況下,蝕刻速率分別為3.2和3.3 nm/s,培養(yǎng)時(shí)間分別為15.0和15.4 s,對(duì)表面處理的依賴,除了蝕刻速率依賴于氧化膜的形成和摻雜方法之外,培養(yǎng)時(shí)間的存在還帶來(lái)了另一個(gè)工藝參數(shù),必須仔細(xì)研究其變化。
高顆粒密度有助于水在晶片表面的凝結(jié),從而有效地縮短了顆粒周?chē)鷧^(qū)域的培養(yǎng)時(shí)間,這種成核降低了蝕刻均勻性,并導(dǎo)致更高的有效蝕刻速率,在一些嚴(yán)重的情況下,在氣相HF處理的氧化物表面上可以觀察到顆粒成核的腐蝕斑點(diǎn),因此,為了達(dá)到可接受的工藝控制程度,氧化物表面必須保持相對(duì)無(wú)顆粒。
與典型的硅加工特別相關(guān)的表面處理的另一個(gè)例子是擴(kuò)展的,將氧化物暴露在熱磷酸中,通過(guò)在160℃下在磷酸中浸泡一小時(shí),培養(yǎng)時(shí)間沒(méi)有顯著,處理后蝕刻速率提高了約18%,蝕刻均勻性提高了略小于50%,較高的蝕刻速率可能與氧化物表面的輕微摻雜有關(guān),源自磷的非揮發(fā)性摻雜劑停留在氧化物的表面,通過(guò)降低濃縮膜的pH值而導(dǎo)致更高的蝕刻速率。
在NH~OH/H~OJH~O溶液中處理氧化物也對(duì)腐蝕特性有影響,在一個(gè)特定的蝕刻配置中,培養(yǎng)時(shí)間減少了3秒,蝕刻速率稍微降低,粒子性能-對(duì)于許多需要無(wú)自然氧化物的硅表面的工藝,通常在清洗程序的最后使用短時(shí)間的HF蝕刻來(lái)去除自然或化學(xué)氧化物,這種方法有許多缺點(diǎn),在HF處理之后的水沖洗和旋轉(zhuǎn)干燥步驟期間,發(fā)生了有限量的天然氧化物再生長(zhǎng),第二,一般認(rèn)為如果HF溶液中存在顆粒和重金屬,這些污染物很容易沉積在干凈的硅表面上,當(dāng)氣相HF用于蝕刻天然或化學(xué)氧化物時(shí),可以消除沖洗和干燥晶片的需要。
薄氧化物表征-使用具有12 nm柵極氧化物的LOCOS隔離MOS電容器研究了用氣相HF蝕刻代替含水HF蝕刻的電氣含義,電容器既不接受氧化后惰性環(huán)境退火,也不接受柵極形成氣體退火,在將晶片分成三份之前,對(duì)晶片進(jìn)行常規(guī)的預(yù)氧化清洗。
不同HF治療組,處理是含水(1%) HF、氣相I-IF和氣相HF,然后用水沖洗,在所有晶片上測(cè)量了相似的有效固定氧化物電荷密度和中間帶隙界面態(tài),圖中總結(jié)了斜坡電壓擊穿分布,觀察到從含水HF到氣相HF的改善趨勢(shì),并且氣相HF和水沖洗的組合獲得了最佳分布,隨著超過(guò)四倍的改善,時(shí)間相關(guān)的介電擊穿數(shù)據(jù)顯示了當(dāng)含水HF被氣相HF替代時(shí)最顯著的變化。
各種硅氧化物的氣相HF蝕刻已經(jīng)被廣泛表征,已經(jīng)開(kāi)發(fā)了基于不同氧化物的培養(yǎng)時(shí)間變化的新方法,用于實(shí)際應(yīng)用,例如在也包含熱氧化物的圖案化疊層中選擇性去除PSG,用氣相HF工藝代替?zhèn)鹘y(tǒng)的含水HF工藝,不僅可以獲得更好的清潔度,而且可以提高薄氧化物的耐電應(yīng)力性。
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28625瀏覽量
232848 -
晶片
+關(guān)注
關(guān)注
1文章
407瀏覽量
31938
發(fā)布評(píng)論請(qǐng)先 登錄
半導(dǎo)體清洗SC1工藝
半導(dǎo)體boe刻蝕技術(shù)介紹
spm清洗會(huì)把氮化硅去除嗎
晶圓擴(kuò)散清洗方法
碳化硅外延晶片硅面貼膜后的清洗方法

蘋(píng)果著手開(kāi)發(fā)新款MacBook Air,將采用氧化物TFT LCD
深入剖析半導(dǎo)體濕法刻蝕過(guò)程中殘留物形成的機(jī)理
8寸晶圓的清洗工藝有哪些
半導(dǎo)體濕法刻蝕殘留物的原理
芯片濕法刻蝕殘留物去除方法
金屬氧化物和柔性石墨烯MOS的區(qū)別

芯片制造中的濕法刻蝕和干法刻蝕

多晶氧化物中的晶界和異質(zhì)界面概念、形成機(jī)理以及如何表征

SiO2薄膜的刻蝕機(jī)理
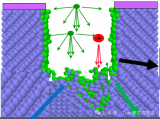
使用Keithley 4200-SCS半導(dǎo)體表征系統(tǒng)進(jìn)行氧化物可靠性測(cè)試






 蒸汽相氟化氫對(duì)晶片清洗和氧化物刻蝕的表征
蒸汽相氟化氫對(duì)晶片清洗和氧化物刻蝕的表征










評(píng)論