前言
氧化物完整性是一個(gè)重要的可靠性問(wèn)題,特別對(duì)于今天大規(guī)模集成電路的MOSFET器件, 其中氧化物厚度已經(jīng)縮放到幾個(gè)原子層。JEDEC 35標(biāo)準(zhǔn) (EIA/JE SD 35, Procedure for wafer-level Testing of Thin Dielectrics) 描述了通常用于監(jiān)測(cè)氧化物完整性的兩種晶圓級(jí)測(cè)試技術(shù):電壓斜坡 (V-Ramp)和電流斜坡 (J-Ramp )。這兩種技術(shù)都為氧化物評(píng)估提供了快速反饋。
用于監(jiān)測(cè)氧化物擊穿的儀器必須具備以下能力:
? 精確的電壓和電流施加及測(cè)量能力
? 精確的步長(zhǎng)時(shí)間控制
? 自動(dòng)化設(shè)備參數(shù)提取
? 先進(jìn)的數(shù)據(jù)分析技術(shù)
本應(yīng)用文檔描述了如何使用Keithley 4200-SCS半導(dǎo)體表征系統(tǒng)進(jìn)行氧化物可靠性測(cè)試。
電壓斜坡和電流斜坡測(cè)試技術(shù)
電壓斜坡測(cè)試采用線性電壓斜坡,電流斜坡測(cè)試采用不斷增加的對(duì)數(shù)電流斜坡,直到氧化物擊穿。電壓斜坡測(cè)試在低氧化物電壓下開(kāi)始,因此它能夠更好地檢測(cè)低電場(chǎng)故障,但在高電場(chǎng)下提供的分辨率較差。電流斜坡測(cè)試是不同的,它從一個(gè)相對(duì)較高的氧化物電壓開(kāi)始,所以它提供了較差的低電場(chǎng)分辨率,但在高電場(chǎng)下有更好的分辨率。這種分辨率的差異使得電壓斜坡測(cè)試經(jīng)常被用于確定較大的測(cè)試結(jié)構(gòu)故障,而電流斜坡試驗(yàn)通常用于較小的測(cè)試結(jié)構(gòu),其中氧化物失效模式預(yù)計(jì)是固有的。
V-Ramp試驗(yàn)程序
圖1說(shuō)明了電壓斜坡測(cè)試過(guò)程。該序列以一個(gè)預(yù)試開(kāi)始,以確定初始氧化物的完整性。在預(yù)試期間,施加恒定電壓(Vuse)并測(cè)量氧化物泄漏電流。如果氧化物被確定為“良好”,則對(duì)設(shè)備施加一個(gè)線性電壓斜坡,直到氧化物失效。
氧化物失效是通過(guò)預(yù)期值數(shù)十倍增加的電流或超過(guò)指定限流的氧化物電流來(lái)檢測(cè)。在Vuse上進(jìn)行的測(cè)試,用于確定被測(cè)試設(shè)備的最終狀態(tài)。提取的電壓斜坡測(cè)量參數(shù)包括:擊穿電壓(VBD)和擊穿電荷(QBD)。

圖1. 電壓斜坡測(cè)試流程圖
電流斜坡法測(cè)試流程
圖2是電流斜坡測(cè)試方法的過(guò)程。該過(guò)程從氧化物完整性的預(yù)試開(kāi)始。在這個(gè)預(yù)試中,施加恒定電流(通常為1μA),并測(cè)量氧化物的電壓。如果器件“良好”,則增加對(duì)數(shù)階躍電流,由Iporser = Iprev *F(其中 F<3.2)給出,直到氧化物失效。當(dāng)氧化物上施加的電壓從之前測(cè)量的電壓(Vprev)下降15%或以上,或超過(guò)電荷極限時(shí),就會(huì)檢測(cè)到氧化物故障。應(yīng)力后的恒定電流測(cè)試用于評(píng)估被測(cè)試設(shè)備的最終狀態(tài)。提取的電流斜坡氧化物擊穿參數(shù)包括擊穿電壓(VBD)和擊穿電荷(QBD)。

圖2. J-Ramp Flowchart
電壓斜坡法和電流斜坡法測(cè)試差異
在實(shí)施任何一種測(cè)試程序時(shí),都可能會(huì)出現(xiàn)潛在的測(cè)量困難。電壓或電流階躍時(shí)間必須均勻和精確,以準(zhǔn)確地確定QBD和VBD。在實(shí)踐中,由于與外部控制器計(jì)算機(jī)時(shí)鐘相關(guān)的分辨率和精度限制,這個(gè)步長(zhǎng)時(shí)間可能難以控制。此外,一些儀器效應(yīng),如范圍的變化,可能產(chǎn)生不可預(yù)測(cè)的步長(zhǎng)時(shí)間的變化。
使用Keithley 4200-SCS的電壓斜坡
和電流斜坡測(cè)試
4200電壓斜坡測(cè)試
4200-SCS內(nèi)置的測(cè)試序列器和交互式測(cè)試模塊(ITM)功能簡(jiǎn)化了電壓斜坡和電流斜坡測(cè)試算法的實(shí)現(xiàn)。圖3顯示了項(xiàng)目導(dǎo)航器窗口和電壓斜坡模塊定義選項(xiàng)卡中的電壓斜坡測(cè)試序列。“項(xiàng)目導(dǎo)航器”窗口顯示測(cè)試順序,從預(yù)測(cè)試開(kāi)始,然后是氧化物衰退的線性電壓斜坡(如V-Ramp模塊定義選項(xiàng)卡中的定義)。后測(cè)試確定了最終的設(shè)備狀態(tài)。
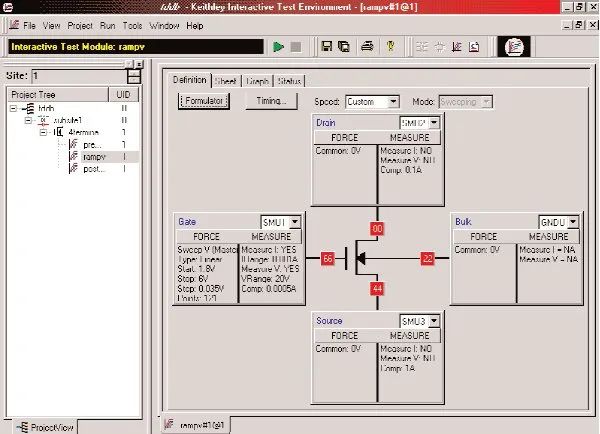
圖3. 電壓斜坡項(xiàng)目測(cè)試順序和測(cè)試定義
ITM定義選項(xiàng)卡便于指定源連接、施加信號(hào)、測(cè)量選項(xiàng)和設(shè)置時(shí)間信息。在圖3所示的電壓斜坡法測(cè)試中,柵極的源表(SMU1)被設(shè)置為從1.8V到6.0V的線性電壓掃描,電壓步長(zhǎng)為0.035V。電壓步長(zhǎng)基于JEDEC 35標(biāo)準(zhǔn)的0.1MV/cm最大電壓步長(zhǎng)高要求 (3.5nm氧化物厚度)。指定一個(gè)固定的電壓源和電流測(cè)量范圍可以最小化自動(dòng)定位對(duì)電壓階躍時(shí)間的影響。
線性電壓斜坡率在ITM時(shí)間設(shè)置對(duì)話框進(jìn)入屏幕中指定(圖4),通過(guò)點(diǎn)擊圖3中所示的timing按鈕打開(kāi)。通過(guò)選擇自定義速度選項(xiàng)和指定A/D Integration時(shí)間 (16.6ms),可以精確地控制SMU的測(cè)量時(shí)間。Sweep delay 是指測(cè)量前每一步的延遲。在這種情況下,選擇 sweep delay(83ms),使步長(zhǎng)時(shí)間為100ms(83 + 16.6),產(chǎn)生1MV/cm*s的電壓斜坡速率,這符合JEDEC 35標(biāo)準(zhǔn)的1MV/cm*的最大斜坡速率要求。0.2s的第一個(gè)點(diǎn)的建立穩(wěn)定時(shí)間,發(fā)生在第一個(gè)電壓步長(zhǎng)上,允許在電壓掃描開(kāi)始之前的電流穩(wěn)定。檢查ITMtimestamp啟用功能,以便在每個(gè)電壓步驟中保存精確的定時(shí)信息。該特性在確定QBD和驗(yàn)證步進(jìn)定時(shí)精度時(shí)非常有用。對(duì)該數(shù)據(jù)的分析顯示,電壓步長(zhǎng)時(shí)間平均為99.5ms(期望值為 99.6ms),標(biāo)準(zhǔn)差為 ± 為 0.062ms。

圖4. 電壓斜坡測(cè)量和定時(shí)控制
4200-ACS電壓斜坡數(shù)據(jù)分析
4200-SCS具有強(qiáng)大的高級(jí)數(shù)據(jù)分析能力,可以很容易地提取氧化物擊穿參數(shù)。通過(guò)單擊“definition”命令按鈕,從ITM定義選項(xiàng)卡激活此分析功能(參見(jiàn)圖3)。公式對(duì)話框輸入屏幕(未顯示)包含許多用于數(shù)據(jù)分析和提取的功能。公式從電壓斜坡測(cè)量的柵電流(IG)和柵電壓(VG)數(shù)據(jù)中自動(dòng)提取擊穿電流(IBD)、擊穿電壓(VBD)、擊穿電荷(QBD)和擊穿時(shí)間 (TBD):
QSUM = INTEG (TIME, IG)
FAILCURRENT = 0.5E-3
COLBD = COND (ABS(IG), ABS(0.98 * FAILCURRENT), 0, 1)
ROWBD = FINDD (COLBD, 1, FIRSTPOS(COLBD)) – 1
IBD = AT (IG, ROWBD)
VBD = AT (VG, ROWBD)
QBD = AT (QSUM, ROWBD)
TBD = AT (TIME, ROWBD)
QSUM方程使用積分(INTEG)公式函數(shù)得到氧化物電荷。氧化物失效電流在第二個(gè)方程中規(guī)定了失效電流。使用條件(COND)和Find Down(FINDD)函數(shù)的方程確定了4200-SCS模型內(nèi)置電子表格中行(ROWBD)的位置,該電子表格與微軟 Excel兼容。ROWBD在AT公式函數(shù)中提取IBD、VBD、QBD 和TBD。一旦被提取出來(lái),參數(shù)就可以自動(dòng)顯示在4200-SCS的圖形選項(xiàng)卡上。圖5顯示了典型的4200-SCS電壓斜坡數(shù)據(jù),并從3.5nm的氧化物中提取了擊穿參數(shù)。
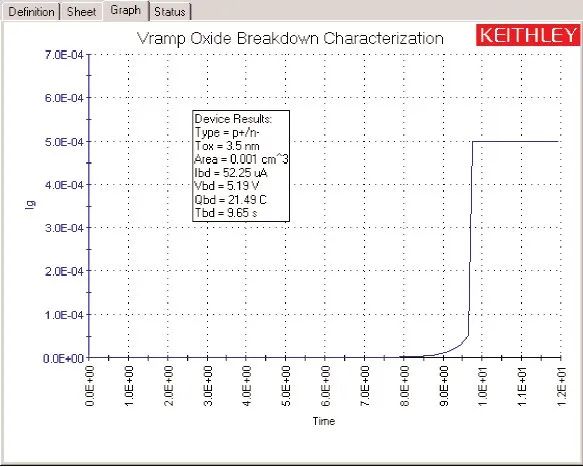
圖5. 典型的4200-SCS電壓斜坡測(cè)量結(jié)果
4201-SCS電流斜坡法測(cè)試
圖6顯示了在項(xiàng)目導(dǎo)航器窗口和電流斜坡測(cè)試模塊定義選項(xiàng)卡中的電流斜坡測(cè)試序列。電流斜坡測(cè)試序列首先在恒定電流下驗(yàn)證初始氧化物完整性,然后是對(duì)數(shù)電流斜坡到氧化物擊穿,最后確定了最終的器件狀態(tài)。

圖6. 電流斜坡法項(xiàng)目測(cè)試順序和測(cè)試定義
圖6中的ITM定義選項(xiàng)卡指定了電流斜坡法的測(cè)試條件。在這種情況下,柵極源表(SMU1)被指示施加從10nA到0.6mA 的對(duì)數(shù)電流掃描,其中電流掃描中的步數(shù)為 50(F =1.25)。指定一個(gè)固定的電壓測(cè)量范圍可以盡量減少自動(dòng)定位對(duì)步長(zhǎng)時(shí)間的影響。與電壓斜坡測(cè)試一樣,通過(guò)選擇ITM中的timing自定義速度選項(xiàng),并指定A/D integration時(shí)間、sweep delay、hold time和timestamp已啟用的特性,可以精確地控制SMU的步長(zhǎng)時(shí)間(參見(jiàn)圖4)。JEDEC標(biāo)準(zhǔn)35規(guī)定當(dāng)前斜坡率為110年/500毫秒。
4200-ACS電壓斜坡數(shù)據(jù)分析
與電壓斜坡法測(cè)試一樣,該公式器可以自動(dòng)提取電流斜坡氧化物擊穿參數(shù)(IBD、VBD、QBD和TBD)。這些方程是:
QSUM = INTEG (TIME, IG)
FAILRATIO = 0.85
RATIO = DELTA (VG)/(VG-DELTA(VG))
COLBD = COND (RATIO, FAILRATIO - 1, 0, 1)
ROWBD = FINDD (COLBD, 1, FIRSTPOS(COLBD)) – 1
IBD = AT (IG, ROWBD)
VBD = AT (VG, ROWBD)
QBD = AT (QSUM, ROWBD)
TBD = AT (TIME, ROWBD)
QSUM方程決定了氧化物的電荷。第二個(gè)方程指定了氧化物故障比,它對(duì)應(yīng)于測(cè)量的氧化物電壓下降 15%。比值方程決定了最近測(cè)量的VG與之前測(cè)量值的比值。接下來(lái)的兩個(gè)方程使用COND和FINDD公式函數(shù)來(lái)確定分解數(shù)據(jù)(ROWBD) 的行位置。最后四個(gè)方程使用AT公式函數(shù)自動(dòng)提取擊穿參數(shù)(IBD、VBD、QBD和TBD)。圖7顯示了典型的模型4200-SCS電流斜坡數(shù)據(jù)和提取的3.5nm氧化物的擊穿參數(shù)。
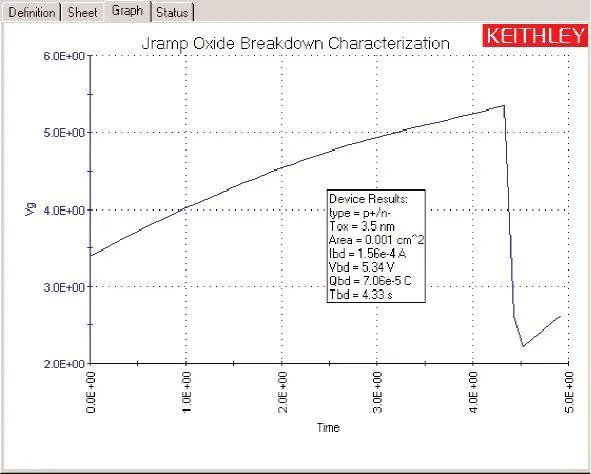
圖7. 典型的4200-SCSJ形斜坡測(cè)量結(jié)果
氧化物缺陷與超薄氧化物的表征
氧化物缺陷會(huì)在低電場(chǎng)下產(chǎn)生過(guò)多的隧穿電流。此外,超薄氧化物(<6nm)在低電場(chǎng)下表現(xiàn)出大量的直接隧穿氧化物電流。為了研究這些影響,有必要監(jiān)測(cè) fA 范圍內(nèi)的氧化物電流,這使得4200-SCS成為這種應(yīng)用的測(cè)試儀器。圖8顯示了在3.5nm氧化物上獲得的4200- SCS電壓掃描數(shù)據(jù),這是使用SMU Quiet ITM定時(shí)設(shè)置和自量程測(cè)量選項(xiàng)獲得的。這些結(jié)果表明,4200-SCS具有良好的低電流測(cè)量靈敏度。

圖8. 典型的4200-SCS I-V測(cè)量結(jié)果
結(jié)論
4200-SCS的快速、靈活和易于使用的測(cè)試環(huán)境提供了一個(gè)理想的方法來(lái)描述氧化物的可靠性。它內(nèi)置的軟件工具,如項(xiàng)目導(dǎo)航器、公式編輯器和與excel兼容的數(shù)據(jù)格式,極大地簡(jiǎn)化了創(chuàng)建測(cè)試序列和分析結(jié)果。自定義SMU定時(shí)控制和先進(jìn)的源測(cè)量單元技術(shù)為測(cè)量靈敏度、精度和控制設(shè)定了一個(gè)新的行業(yè)標(biāo)準(zhǔn)。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28588瀏覽量
232472 -
氧化物
+關(guān)注
關(guān)注
0文章
23瀏覽量
8231 -
Keithley
+關(guān)注
關(guān)注
1文章
30瀏覽量
11770 -
可靠性測(cè)試
+關(guān)注
關(guān)注
1文章
110瀏覽量
14446
原文標(biāo)題:應(yīng)用文檔 | 使用電壓斜坡和電流斜坡技術(shù)評(píng)估氧化物可靠性
文章出處:【微信號(hào):泰克科技,微信公眾號(hào):泰克科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
提供半導(dǎo)體工藝可靠性測(cè)試-WLR晶圓可靠性測(cè)試
GaN可靠性的測(cè)試
氧化物半導(dǎo)體甲烷敏感元件詳解
如何實(shí)現(xiàn)高可靠性電源的半導(dǎo)體解決方案
Keithley 4200-SCS 長(zhǎng)期 現(xiàn)金回收
SiC MOSFET FIT率和柵極氧化物可靠性的關(guān)系
基于氧化物半導(dǎo)體的CMOS電路有望實(shí)現(xiàn)
薄膜氧化物半導(dǎo)體評(píng)估系統(tǒng)的系統(tǒng)概述
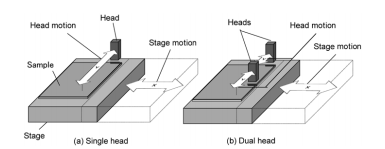
維修4200-SCS吉時(shí)利半導(dǎo)體特性分析儀無(wú)法開(kāi)機(jī)最新案例

8.2.11 氧化層可靠性∈《碳化硅技術(shù)基本原理——生長(zhǎng)、表征、器件和應(yīng)用》

Keithley 吉時(shí)利 4200A-SCS材料和半導(dǎo)體參數(shù)分析儀

半導(dǎo)體可靠性測(cè)試項(xiàng)目有哪些
吉時(shí)利keithley4200A-SCS 半導(dǎo)體參數(shù)分析儀
半導(dǎo)體測(cè)試可靠性測(cè)試設(shè)備






 使用Keithley 4200-SCS半導(dǎo)體表征系統(tǒng)進(jìn)行氧化物可靠性測(cè)試
使用Keithley 4200-SCS半導(dǎo)體表征系統(tǒng)進(jìn)行氧化物可靠性測(cè)試










評(píng)論