完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
濕法蝕刻工藝的原理是利用化學溶液將固體材料轉化為liquid化合物。由于采用了高選擇性化學物質可以非常精確地適用于每一部電影。對于大多數解決方案選擇性大于100:1。...
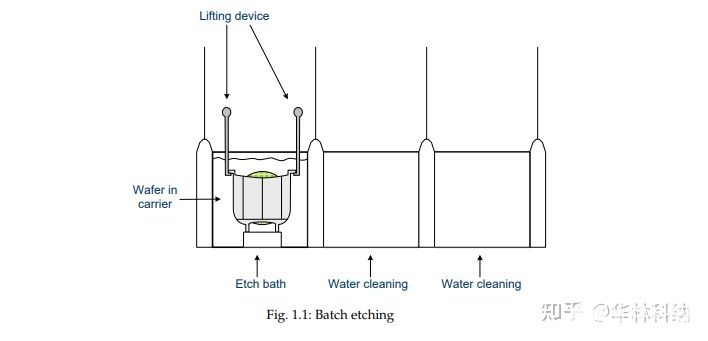
半導體制造中需要的單晶(單晶)是原子的規則排列。有多晶(許多小的單晶)和非晶硅(無序結構)。根據晶格的取向,硅片具有不同的表面結構,從而影響電荷載流子遷移率或在濕化學中的行為等各種性質、硅的各向異性腐蝕。...

在基材上涂上光刻膠。這是一種具有很高的吞吐量和潛力同質性。旋涂的原理是典型地,幾毫升光刻膠被分配到以1000轉/分的速度旋轉的基板(通常4000 rpm)。抵抗可以被解除,當基板是靜止的,然后加速到速度靜電旋涂),也可以一次涂勻晶圓已經旋轉(動態旋轉涂層)。任何過量的抗蝕劑會從基板邊緣脫落紡絲過...

1. BGA和CSP封裝技術詳解 2.?干貨分享丨BGA開路金相切片分析 (BGA Open Cross-Section) ? ? ? 審核編輯:彭靜...
從 2D 擴展到異構集成和 3D 封裝對于提高半導體器件性能變得越來越重要。近年來,先進封裝技術的復雜性和可變性都在增加,以支持更廣泛的設備和應用。在本文中,我們研究了傳統光刻方法在先進封裝中的局限性,并評估了一種用于后端光刻的新型無掩模曝光。...
避免高頻干擾的基本思路是盡量降低高頻信號電磁場的干擾,也就是所謂的串擾(Crosstalk)。可用拉大高速信號和模擬信號之間的距離,或加 ground guard/shunt traces 在模擬信號旁邊。還要注意數字地對模擬地的噪聲干擾。...
實現Chiplets封裝集成的動機有很多。為了滿足不斷增長的性能需求,芯片面積不斷增加,有些設計甚至會超出掩模版面積的限制,比如具有數百個核心的多核 CPU,或扇出非常大的交換[曹1] 電路(Switch)。...
常見的Fan-In(WLCSP)通常可以分為BOP(Bump On Pad)和RDL(Redistribution Layer)。BOP封裝結構簡單,Bump直接生長在Al pad上;如果Bump位置遠離Al pad,則需要通過RDL將Al pad與Bump相連。...

3D晶圓級封裝,包括CIS發射器、MEMS封裝、標準器件封裝。是指在不改變封裝體尺寸的前提下,在同一個封裝體內于垂直方向疊放兩個以上芯片的封裝技術,它起源于快閃存儲器(NOR/NAND)及SDRAM的疊層封裝。...
當然有的也不需要把安裝孔連接GND網絡。3、金屬螺孔可能被擠破,造成接地與不接地的零界狀態,造成系統莫民奇妙的不正常,梅花孔,不管應力如何變化,總能保持螺釘接地。...
在軸封和隔板汽封發生的動靜接觸將引起轉子溫度的不對稱,使轉子發生熱彎曲。而葉片汽封處的動靜接觸對轉子溫度影響不大,不會產生摩擦振動。...
電子封裝基本分類,數據來源:《電子封裝材料的研究現狀及趨勢》 陶瓷封裝在高致密封裝中具有較大發展潛力。陶瓷封裝屬于氣密性封裝,主要材料有Al2O3、AIN、BeO 和莫來石,具有耐濕性好、機械強度高、熱膨脹系數小和熱導率高等優點。...
單片設計每個晶圓有 30 個好的die,而小芯片 MCM 設計每個晶圓有 79 個好的die。假設所有有缺陷的die都必須扔進垃圾桶。如果沒有芯片良率收獲,單片設計的設計公司每片晶圓只能賣30個產品,而chiplet MCM設計可以賣39.5個。...
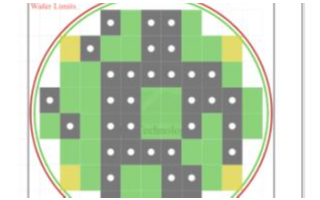
新一代智能制造將給制造業帶來革命性變化, 是真正意義上的智能制造,將從根本上引領和推進第四次工業革命,為我國實現制造業換道超車、跨越發展帶來了歷史性機遇。...
答:根據器件規格書(Datasheet)制作封裝時,一般做出來的封裝焊盤管腳長度需要做適當的補償,即適量地對器件原先的管腳加長一點,具體的補償方法,是根據器件的管腳類型來補償的,可按以下辦法:...
由于從平面 FET 過渡到 FinFET,晶體管尺寸減小了,而性能卻提高了。這種轉變是必要的,因為平面 FET 的性能在柵極長度減小時開始下降。FinFET 有助于維持擴展路徑。...