視頻簡(jiǎn)介:今天的系統(tǒng)工程師面臨的是推進(jìn)性能超越傳統(tǒng)期望值的挑戰(zhàn),這些期望包括每瓦功率的百萬次浮點(diǎn)運(yùn)算、車輛加速、以太網(wǎng)端口密度、每小時(shí)測(cè)試單位,同時(shí)縮短設(shè)計(jì)周期。不過,按效率和功率密度計(jì)算,這仍然需要更高的功率器件性能,來突破傳統(tǒng)組件封裝技術(shù)的極限。由于系統(tǒng)變得越來越密集,散熱問題變得尤其嚴(yán)重,它可能限制設(shè)計(jì)靈活性。很明顯,功率組件封裝的新方法是非常必要的。Vicor率先突破了功率器件封裝平臺(tái),它是轉(zhuǎn)換器級(jí)封裝(converter housed in package),或簡(jiǎn)稱ChiP,它實(shí)現(xiàn)了更小、更靈活的組件外形尺寸,簡(jiǎn)化了設(shè)計(jì)流程,并顯著降低了能源成本。與較早一代的組件相比,基于這一新的ChiP封裝技術(shù)的下一代組件可以使功率密度驚人地增加四倍,減少20%的功率損耗。ChiP技術(shù)使客戶能夠?qū)崿F(xiàn)前所未有的系統(tǒng)尺寸、重量和功效目標(biāo),以及優(yōu)異的產(chǎn)品性能——例如,在98%效率條件下,實(shí)現(xiàn)每立方英寸3000瓦特的功率密度。
-
以太網(wǎng)
+關(guān)注
關(guān)注
40文章
5583瀏覽量
174786 -
封裝
+關(guān)注
關(guān)注
128文章
8494瀏覽量
144780 -
功率器件
+關(guān)注
關(guān)注
42文章
1909瀏覽量
92149
發(fā)布評(píng)論請(qǐng)先 登錄
全面剖析倒裝芯片封裝技術(shù)的內(nèi)在機(jī)制、特性優(yōu)勢(shì)、面臨的挑戰(zhàn)及未來走向
SiP藍(lán)牙芯片在項(xiàng)目開發(fā)及應(yīng)用中具有什么優(yōu)勢(shì)?
負(fù)載箱在電力系統(tǒng)測(cè)試中的應(yīng)用與優(yōu)勢(shì)
倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

倒裝芯片的優(yōu)勢(shì)_倒裝芯片的封裝形式

倒裝芯片(flip chip)算先進(jìn)封裝嗎?未來發(fā)展怎么樣?

BGA封裝技術(shù)的發(fā)展 BGA封裝的優(yōu)勢(shì)與應(yīng)用
瑞沃微:一文詳解CSP(Chip Scale Package)芯片級(jí)封裝工藝

Chip天線相比較其他天線的優(yōu)勢(shì)有哪些?

晶閘管在電機(jī)調(diào)速系統(tǒng)中的應(yīng)用
探究電驅(qū)動(dòng)系統(tǒng)中碳化硅功率器件封裝的三大核心技術(shù)
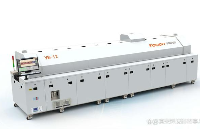
提升光模塊性能:激光錫焊技術(shù)在PCBA焊接中的優(yōu)勢(shì)
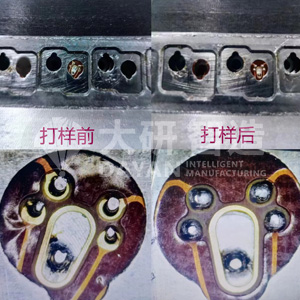





 ChiP封裝技術(shù)在系統(tǒng)設(shè)計(jì)中的優(yōu)勢(shì)介紹
ChiP封裝技術(shù)在系統(tǒng)設(shè)計(jì)中的優(yōu)勢(shì)介紹
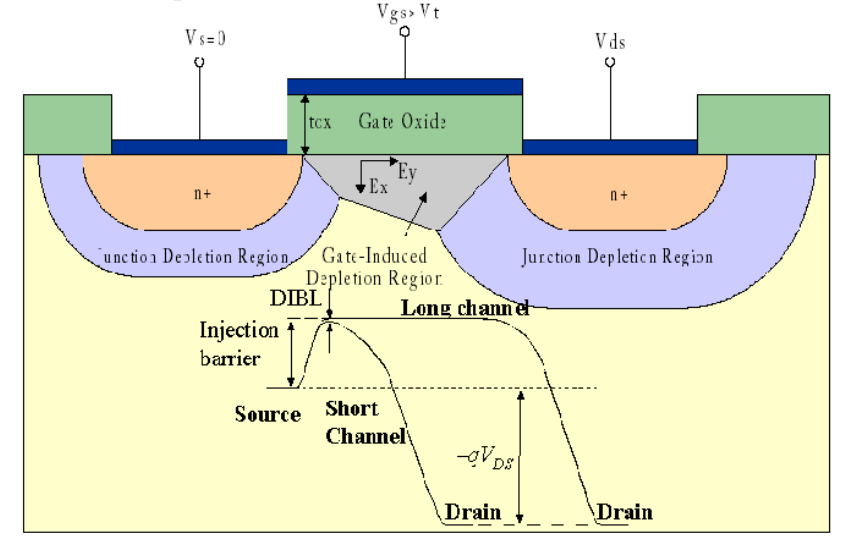











評(píng)論